
Заглавная страница Избранные статьи Случайная статья Познавательные статьи Новые добавления Обратная связь FAQ Написать работу КАТЕГОРИИ: ТОП 10 на сайте Приготовление дезинфицирующих растворов различной концентрацииТехника нижней прямой подачи мяча. Франко-прусская война (причины и последствия) Организация работы процедурного кабинета Смысловое и механическое запоминание, их место и роль в усвоении знаний Коммуникативные барьеры и пути их преодоления Обработка изделий медицинского назначения многократного применения Образцы текста публицистического стиля Четыре типа изменения баланса Задачи с ответами для Всероссийской олимпиады по праву 
Мы поможем в написании ваших работ! ЗНАЕТЕ ЛИ ВЫ?
Влияние общества на человека
Приготовление дезинфицирующих растворов различной концентрации Практические работы по географии для 6 класса Организация работы процедурного кабинета Изменения в неживой природе осенью Уборка процедурного кабинета Сольфеджио. Все правила по сольфеджио Балочные системы. Определение реакций опор и моментов защемления |
Температурные и частотные свойства p-n перехода.Содержание книги
Похожие статьи вашей тематики
Поиск на нашем сайте Свойства p- n перехода существенно зависят от температуры окружающей среды. При повышении температуры возрастает генерация пар носителей заряда – электронов и дырок, т.е. увеличивается концентрация неосновных носителей и собственная проводимость полупроводника.
Это наглядно показывают вольтамперные характеристики германиевого p - n перехода, снятые при различной температуре (рис. 8.5.1). Как видно из рисунка, при повышении температуры прямой и обратный токи растут, а p - n переход теряет свое основное свойство – одностороннюю проводимость. Зависимость от температуры обратной ветви вольтамперметной характеристики определяется температурными изменениями тока насыщения. Этот ток пропорционален равновесной концентрации неосновных носителей заряда, которая с увеличением температуры возрастает по экспоненциальному закону. По этому же закону с ростом температуры увеличивается и ток насыщения.
где I0(T) и I0(T0) – обратные точки насыщения при рассматриваемой (Т) и комнатной (Т0) температурах; ∆ Т = Т-Т0 – перепад температур; α – коэффициент, зависящий от свойств полупроводника (для германия α»0,05…0,09 К-1; для кремния α» 0,07…0,13 К-1). Для германиевых и кремневых p - n переходов обратный ток возрастает примерно в 2-2,5 раза при повышении температуры на каждые 10 оС. Прямой ток p - n перехода при нагреве возрастает не так сильно, как обратный ток. Это объясняется тем, что прямой ток возникает в основном за счет примесной проводимости. Но концентрация примесей от температуры практически не зависит. Температурная зависимость прямой ветви вольтамперной характеристики в соответствии с формулой (8.4.1) определяется изменением тока I0 и показателя экспоненты. Для германиевых приборов верхний температурный предел 70…90оС. У кремниевых приборов вследствие большей энергии, необходимой для отрыва валентного электрона от ядра атома, этот предел более высок: 120…150оС. Свойства p- n перехода зависят также от частоты приложенного напряжения. Это объясняется наличием собственной емкости между слоями полупроводника с разными типами проводимости.
При малом обратном напряжении, приложенном к p - n переходу, носители зарядов противоположных знаков находятся на небольшом расстоянии друг от друга. При этом собственная емкость p - n перехода велика. При увеличении обратного напряжения электроны все дальше отходят от дырок по обе стороны от p - n перехода, и емкость p - n перехода уменьшается. Следовательно, p-nпереход можно использовать как емкость, управляемую величиной обратного напряжения1. При прямом напряжении p- n переход, кроме барьерной емкости, обладает так называемой диффузионной емкостью Сдиф. Эта емкость обусловлена накоплением подвижных носителей заряда в n - и р -областях. Как было показано выше, при прямом напряжении в результате инжекции основные носители заряда в большом количестве диффундируют через пониженный потенциальный барьер и, не успев рекомбинировать, накапливаются в n- и p -областях. Каждому значению прямого напряжения Uпр соответствует определенная величина заряда Qдиф, накопленного в области p - n перехода. Поэтому
Диффузионная емкость не оказывает существенного влияния на работу p- n перехода, так как она всегда зашунтирована малым прямым сопротивле-нием перехода. Наибольшее практическое значение имеет барьерная емкость. В связи с этим эквивалентная схема p- n перехода (схема замещения) для пе-ременного тока имеет вид, показанный на рис. 8.5.2.
На этой схеме Ro – сопротивление толщи полупроводников n - и p -типа и выводов от них (около 1 Ом); R3 – сопротивление перехода, зависящее от величины и полярности приложенного напряжения; С – сумма барьерной и диффузионной емкостей. При обратном напряжении диффузионная емкость отсутствует и С=Сб, а R3=Rобр, т.е. имеет очень большую величину. При работе на вы-соких частотах емкостное сопротивление Хс = В настоящее время имеются полупроводниковые приборы, успешно работающие в очень широком диапазоне частот – до сотен мегагерц и выше. Это свойство p- n перехода используется в варикапах – полупроводниковых диодах с управляемой величиной емкости. Туннельный эффект. В 1958г. Японский ученый Лео Эсаки открыл явление туннельного эффекта в полупроводниках. Туннельный эффект заключается в том, что электроны проходят через потенциальный барьер p-n перехода, не изменяя своей энергии. Для получения туннельного эффекта используется полупроводниковый материал (германий, арсенид галлия) с очень большой концентрацией примесей (до 10 21 примесных атомов в 1 см 3), в то время как обычно концентрация примесей в полупроводниках не превышает 10 15 см-3. Полупроводники с таким высоким содержанием примесей называются вырождеными, а их свойства очень близки к свойствам металлов. Вследствие высокого содержания примесей в обеих областях полупроводникового кристалла ширина p - n перехода оказывается очень малой (не более 0,01 мкм), что приводит к значительному повышению напряженности электрического поля на переходе (порядка 10 8 В/м). В этих условиях имеется конечная вероятность того, что электрон, движущийся в сторону очень узкого барьера, пройдет сквозь него (как через “туннель”) и займет свободное состояние с такой же энергией по другую сторону от барьерного слоя. Чтобы подчеркнуть специфичность прохождения электронов через p- n переход, описанное явление было названо туннельным эффектом. Известно, что увеличение концентрации донорных примесей смещает уровень Ферми вверх, а увеличение концентрации акцепторных примесей – вниз относительно середины запрещенной зоны. При концентрации примесей порядка 10 21 см -3 уровень Ферми полупроводника n -типа внутри зоны проводимости, а уровень Ферми полупроводника p -типа – внутри валентной зоны. Из рис. 8.6.1,а видно, что при отсутствии внешнего напряжения уровни Ферми ЕFn и EFp совпадают, так как величина энергии на уровне Ферми должна быть одинаковой по всей структуре. Внутри p- n перехода границы энергетических зон полупроводников p- и n –типов искривляются. Вследствие того, что уровни Ферми в вырожденных полупроводниках расположены за пределами запрещенной зоны, при осуществлении контакта образуется зона перекрытия, расположенная между границей валентной зоны Еv полупроводника p -типа и границей зоны проводимости Ес полупроводника типа n –типа. В этой зоне разрешенные уровни электронного полупроводника расположены против разрешенных уровней дырочного полупроводника. Для простоты рассуждений будем считать, что все разрешенные уровни, расположенные ниже уровня Ферми, заняты электронами, а расположенные выше него – свободны.
В очень узком p- n переходе при высокой напряженности поля возникают условия для беспрепятственного туннельного прохождения электронов из одного слоя в другой сквозь потенциальный барьер. Однако для этого необходимо: чтобы против занятого электроном уровня по одну сторону барьера имелся свободный уровень за барьером. При отсутствии внешнего напряжения (U =0 на рис. 8.6.1,а) такой возможности фактически нет, так как занятым уровням в зоне проводимости полупроводника n -типа противостоят занятые уровни в валентной зоне полупроводника p -типа. В действительности столь резкой границы между областями с занятыми и свободными уровнями нет. Поэтому при комнатной температуре некоторая часть этих уровней освобождается за счет электронов, перешедших на уровни, расположенные выше уровни Ферми. Тем не менее, при отсутствии внешнего напряжения ток, проходит через p- n переход, практически отсутствует. Это объясняется тем, что встречные потоки тех немногочисленных электронов, которые все же совершают туннельные переходы, взаимно компенсируются и результирующий туннельный ток оказывается равным нулю (IT. = IТ.пр. – IТ.обр. = 0). Если к p- n переходу приложить небольшое прямое напряжение, то высота потенциального барьера и перекрытие зон уменьшатся (рис. 8.6.1,б). Энергетическая диаграмма полупроводника n –типа поднимется вверх, а полупроводника p- типа опустится вниз. При этом уровни некоторых электронов проводимости n –области расположатся против свободных уровней валентной зоны p -области. Тем самым создаются благоприятные условия для туннельного перехода электронов из электронного полупроводника в дырочный. Поэтому через p-n переход потечет туннельный ток, величина которого будет зависеть от величины приложенного прямого напряжения. Следует отметить, что при прямом напряжении через p-n переход, кроме туннельного тока, проходит и диффузионный ток Iдиф, создаваемый перемещением электронов и дырок проводимости. Следовательно, полный ток p-n перехода при туннельном эффекте составляет I = Iт.пр. – Iт.обр. +IДиф . (8.6.1) Отметим также, что диффузионный ток в случае использования вырожденных полупроводников оказывается на несколько порядков меньше тока в обычном p-n переходе. Это объясняется весьма малой концентрацией неосновных носителей из-за увеличения концентрации примесей. На рис. 8.6.2 показана вольтамперная характеристика p-n перехода с туннельным эффектом. Основная ее особенность состоит в том, что при подаче прямого напряжения, превышающего некоторое напряжение U1, прямой туннельный ток начинает резко убывать.
Наличие падающего участка характеристики (АВ на рис. 8.6.2) можно объяснить следующим образом. Увеличение прямого напряжения, с одной стороны, приводит к увеличению туннельного тока, а с другой - уменьшает напряженность электрического поля в p - n переходе. Поэтому при некотором значении прямого напряжения U2 (рис. 8.6.1,в), когда напряженность электрического поля в p - n переходе резко снижается, туннельный ток прекращается, а p-n переход приобретает обычные свойства, связанные с прохождением через него диффузионного тока (на рис. 8.6.2 кривая 1 в интервале после U2, соответствующая полному току p- n перехода, совпадает с кривой 2 диффузионного тока, показанной пунктиром). При подаче на p-n переход обратного напряжения (рис. 8.6.1, г) энергетическая диаграмма полупроводника n -типа опускается в низ, а полупроводника p -типа поднимается вверх. Ширина зоны перекрытия увеличивается, что приводит к росту обратного туннельного тока, поскольку возникают условия для свободного туннельного перехода валентных электронов p -области в зону проводимости n - области. Величина обратного тока зависит от величины обратного напряжения, с увеличением которого энергетические зоны n - и p -областей смещаются сильнее. Односторонняя проводимость p-n перехода при туннельном эффекте полностью отсутствует (рис. 8.6.2). С ростом напряжения в интервале от U1 до U2 ток падает. Следовательно, на этом участке p-n переход оказывает переменному току некоторое отрицательное сопротивление
Уменьшение тока с ростом напряжения эквивалентно сдвигу фазы между указанными величинами на 180о. Поэтому мощность переменного сигнала, равная произведению тока на напряжение, будет иметь отрицатель-ный знак. Это показывает, что отрицательное сопротивление не потребляет мощности переменного сигнала, а отдает его во внешнюю цепь. В электронике понятие “ отрицательное сопротивление ” известно давно. Так, вольтамперные характеристики с падающим участком наблюда-ются при динатронном эффекте в многоэлектродных лампах. С помощью отрицательно сопротивления можно скомпенсировать потери, вносимые в схему положительным сопротивлением, и, таким образом, в зависимости от поставленной задачи осуществить усиление, генерирование или преобразо-вание электрических сигналов. На этом явлении основано действие туннельных диодов, пригодных для усиления и генерирования СВЧ колебаний и для построения сверхбыст-родействующих импульсных устройств. Вопросы для повторения: 1. Запишите выражение для дрейфовых и диффузионных токов в p-n переходе в условиях термодинамического равновесия. 2. Нарисуйте зонную диаграмму p-n перехода в условиях термодинамического равновесия. 3. Расскажите о свойствах p-n перехода при прямом включении. Нарисуйте зонную диаграмму. 4. Расскажите о свойствах p-n перехода при обратном включении. Нарисуйте зонную диаграмму. 5. Запишите аналитическое выражение для вольтамперной характеристики и нарисуйте типичную вольтамперную характеристику p-n перехода. 6. Расскажите о причинах возникновения и механизме пробоя p-n перехода. Какие типы пробоя вы знаете? 7. Как влияет температура на свойства p-n перехода? 8. Как влияет ток высокой частоты на свойства p-n перехода? 9. Что такое туннельный эффект? Как он возникает? Проиллюстрируйте свой рассказ зонными диаграммами. 10. Что называется барьерной емкостью p-n перехода? Объясните механизм ее возникновения. Как ее можно использовать? 11. Нарисуйте вольтамперную характеристику p-n перехода с туннельным эффектом. 12. Что понимают в электронике под отрицательным сопротивлением? Резюме: В процессе изучения данной темы мы ознакомились со свойствами p-n перехода, которые лежат в основе его применения в электронной технике.
|
||||||||||||||
|
Последнее изменение этой страницы: 2017-02-07; просмотров: 5974; Нарушение авторского права страницы; Мы поможем в написании вашей работы! infopedia.su Все материалы представленные на сайте исключительно с целью ознакомления читателями и не преследуют коммерческих целей или нарушение авторских прав. Обратная связь - 216.73.216.214 (0.013 с.) |


 , (8.5.1)
, (8.5.1) При обратном напряжении, приложенном к p - n переходу, носители зарядов обоих знаков находятся по обе стороны перехода, а в области самого перехода их очень мало. Таким образом, в режиме обратного напряжения p - n переход представляет собой емкость, величина которой пропорциональна площади p- n перехода, концентрации носителей заряда и диэлектрической проницаемости материала полупроводника. Эту емкость, как мы знаем, называют барьерной (Сб).
При обратном напряжении, приложенном к p - n переходу, носители зарядов обоих знаков находятся по обе стороны перехода, а в области самого перехода их очень мало. Таким образом, в режиме обратного напряжения p - n переход представляет собой емкость, величина которой пропорциональна площади p- n перехода, концентрации носителей заряда и диэлектрической проницаемости материала полупроводника. Эту емкость, как мы знаем, называют барьерной (Сб). , (8.5.2)
, (8.5.2)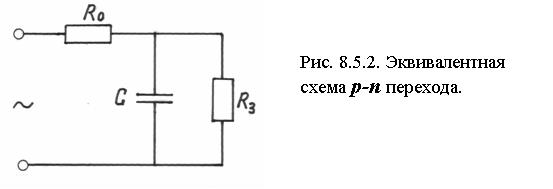
 уменьшается, и обрат-ный ток может пройти через эту емкость, несмотря на большую величину сопротивления R3=Rобр. Это нарушает нормальную работу прибора, так как p- n переход теряет свойство односторонней проводимости. Поэтому для ра-боты на высоких частотах используются в основном точечные полупровод-никовые приборы, у которых площадь p- n перехода незначительна и собст-венная емкость мала.
уменьшается, и обрат-ный ток может пройти через эту емкость, несмотря на большую величину сопротивления R3=Rобр. Это нарушает нормальную работу прибора, так как p- n переход теряет свойство односторонней проводимости. Поэтому для ра-боты на высоких частотах используются в основном точечные полупровод-никовые приборы, у которых площадь p- n перехода незначительна и собст-венная емкость мала.





