
Заглавная страница Избранные статьи Случайная статья Познавательные статьи Новые добавления Обратная связь FAQ Написать работу КАТЕГОРИИ: ТОП 10 на сайте Приготовление дезинфицирующих растворов различной концентрацииТехника нижней прямой подачи мяча. Франко-прусская война (причины и последствия) Организация работы процедурного кабинета Смысловое и механическое запоминание, их место и роль в усвоении знаний Коммуникативные барьеры и пути их преодоления Обработка изделий медицинского назначения многократного применения Образцы текста публицистического стиля Четыре типа изменения баланса Задачи с ответами для Всероссийской олимпиады по праву 
Мы поможем в написании ваших работ! ЗНАЕТЕ ЛИ ВЫ?
Влияние общества на человека
Приготовление дезинфицирующих растворов различной концентрации Практические работы по географии для 6 класса Организация работы процедурного кабинета Изменения в неживой природе осенью Уборка процедурного кабинета Сольфеджио. Все правила по сольфеджио Балочные системы. Определение реакций опор и моментов защемления |
Полупроводниковые лазеры на основе гетероструктурСодержание книги
Поиск на нашем сайте
Выходная мощность полупроводникового лазера линейно увеличивается с увеличением ширины зоны излучения (рис.2.6). Но при размерах более 100 мкм ток, протекающий через активную зону, становится неоднородным и в местах его увеличения начинается электрический пробой, приводящий к разрушению полупроводника. Для достижения более стабильного режима генерации необходимо разбить активную зону на несколько более мелких зон. Современные полупроводниковые лазеры имеют размер активной зоны ~ несколько мкм. А высокая выходная мощность достигается параллельной работой нескольких таких зон-лазеров, что стало возможным после разработки и создания полупроводниковых гетероструктур. Гетерогенная система – (от греческого слова heterogenes – разнородный), неоднородная термодинамическая система, состоящая из различных по физическим свойствам или химическому составу частей. Смежные фазы гетерогенной системы отделены друг от друга физическими поверхностями раздела, на которых скачком изменяется одно или несколько свойств системы, например, состав, или плотность, или кристаллическая структура и т. п.). Противоположностью гетерогенной системы является гомогенная (однородная) система. Граница раздела между двумя различными полупроводниками, образующими единый кристалл, называется гетеропереходом. В зависимости от типа проводимости полупроводников могут быть р — р, р — п или п — п - гетеропереходы. Важнейшее отличие гетеропереходов oт простых р — п - переходов связано со скачкообразным изменением ширины запрещенной зоны на границе раздела двух полупроводников. Величина скачка запрещенной зоны D Eg равна сумме разрывов дна зоны проводимости D Ес и потолка валентной зоны D Е v: D Eg = D Ec + D Ev. Для гетеропереходов GaAs—GaP установлено: D Ес = = 0,67 эВ, D Е v = 0,15 эВ, D Eg = 0,82 эВ. В гетеропереходах AlxGa1-xAs—GaAs разрыв валентной зоны практически отсутствует, поэтому D Eg = D Ec = 0,76 эВ. Как показано Ж. И. Алферовым с сотрудниками, для создания лазерных гетеропереходов наиболее подходящей оказалась пара полупроводников AlAs—GaAs, так как постоянные кристаллической решетки этих материалов (a1 =0,565 нм для GaAs и а2 = 0,566 нм для AlAs) весьма близки. Гетеропереход – контакт двух различных по химическому составу полупроводников. На границе раздела изменяется: ширина запрещённой зоны, подвижность носителей заряда и др. характеристики. Комбинации различных гетеропереходов и монопереходов образуют гетероструктуры. Образование гетеропереходов, требующее стыковки кристаллических решёток, возможно лишь при совпадении типа, ориентации и периода кристаллических решёток сращиваемых материалов, что является очень сложной физико-химической задачей. Кроме того, в идеальном гетеропереходе граница раздела должна быть свободна от структурных и других дефектов, а также от механических напряжений. Наиболее широко применяются монокристаллические гетеропереходы между полупроводниковыми материалами типа AIIIBV (GaAs, InAs, GaP, GaN) и их твёрдыми растворами на основе арсенидов, фосфидов и антимонидов Ga (см. рис. 2.9). Кроме того, используются полупроводники типа AIIBVI – (MgS, ZnS, CdS, ZnTe и др). Полупроводниковые лазеры, созданные на основе этих гетероструктур, позволили перекрыть широкий спектральный диапазон излучения, например, AlGaInP-лазеры излучают в диапазоне 0.6-0.8 мкм, AlGaAs-лазеры – 0.7-0.9 мкм, а InGaAsP-лазеры – 1.0-1.65 мкм.
а
б Рис. 2.9. Зависимость энергии запрещенной зоны от постоянной кристаллической решетки двойных соединений и их растворов. а – для тройных и четвертных соединений InGaAsP; б – для нитридов, селенидов
Многолетняя работа по исследованию гетероструктур была отмечена Нобелевской премией 2002 года, которой был удостоен академик РАН Ж. И. Алфёров (рис. 2.10).
Рис. 2.10. Академик РАН Жорес Иванович Алфёров Фактически исследования гетеропереходов в полупроводниках в ФТИ им.А.Ф.Иоффе РАН были начаты с предложения в 1962 г. Ж.И. Алферова и Р.Ф. Казаринова[4] нового класса инжекционных лазеров с гетеропереходами. Была рассмотрена двойная гетероструктура, в которой активной областью является материал с меньшей шириной запрещенной зоны и большей диэлектрической проницаемостью, а эмиттерами материал с большей шириной запрещенной зоны и меньшей диэлектрической проницаемостью. В такой структуре области рекомбинации, светового излучения и инверсии населенности совпадают и сосредоточены в среднем слое, являющемся потенциальной ямой, а инверсия населенности достигается инжекционным способом.
Исследования гетеропереходов в ФТИ начались с изучения процессов получения, разработки методов исследования эпитаксиальных слоев и гетеропереходов в системе GaAs-GaP. В это же время Ж.И. Алферовым с сотрудниками на основе теоретического анализа зонной модели идеального гетероперехода было показано, что при некотором значении приложенного пропускного напряжения концентрация инжектированных носителей в узкозонный материал должна превышать их равновесную концентрацию в широкозонном материале. Эта особенность инжекции в гетеропереходах получила название эффекта сверхинжекции. Однако реализация всех этих идей была проблематичной, так как не удавалось получить эффективно инжектирующий гетеропереход. Ситуация в корне изменилась в 1967 г., когда в ФТИ была разработана технология получения гетеропереходов в системе GaAs-AlGaAs методом жидкостной эпитаксии и было получено когерентное излучение[5]. Следует заметить, что реализация идеи Ж.И. Алферова на порядки улучшила основные параметры и характеристики полупроводниковых квантовых генераторов и произвела подлинную революцию в оптоэлектронике. Так в настоящее время в мире ежегодно выпускается ~ 1 млрд. полупроводниковых лазеров и практически все они – гетеролазеры или их модификации. Рассмотрим основные типы гетероструктур (рис. 2.11) в которой узкозонный полупроводник (типа GaAs) находиться в контакте с широкозонным (как правило, твердый раствор, тройное соединение AlxGa1-xAs).
Рис. 2.11. Схемы лазерных гетероструктур на основе твердых растворов AlAs-GaAs (x1, x2 , x3 – значения x в формуле твердого раствора Ga1-xAlxAs). а — простой р - n гетеропереход; б —односторонняя гетероструктура с р - n переходом в узкозонном материалеи р — р -гетеропереходом, создающим потенциальный барьер для инжектируемых электронов; в — двусторонняя гетероструктура с р — р- и р — n -гетеропереходами; г — двусторонняя гетероструктура с р — n -переходом в узкозонном материалеи двумя гетеропереходами; д —гетероструктура с раздельными электронным и оптическим ограничениями. Под гетероструктурами приведены упрощенные графики пространственного изменения ширины запрещенной зоны
В инжекционных лазерах используется несколько типов гетероструктур на основе AlxGa1-xAs—GaAs. Простейшей из них является гетероструктура с одним р — n -гетеропереходом (рис. 2.10 а), в которой р -область характеризуется большей шириной запрещенной зоны, чем n -область, поскольку для нее берется х1> х2 (Eg растет с увеличением значения х в формуле AlxGa1-xAs). Односторонняя гетероструктура состоит из р — р -гетероперехода и р — n -перехода в узкозонном материале (рис. 2.10 б). В двусторонней гетероструктуре два гетероперехода(рис. 2.10 в), а в модифицированной двойной гетероструктуре между р — р- и n — n -гетеропереходами создается узкозонный р — п- переход (рис. 2.10 г ). В гетероструктурах с раздельными оптическим и электронным ограничениями излучение распространяется в слоях х2 х3 х2 , а носители заряда рекомбинируют в более тонком слое x 3. По сравнению с простыми р — n -переходами гетероструктуры, особенно двусторонние, обладают двумя важными преимуществами, которые обеспечивают более низкий порог генерации при комнатной температуре. Во-первых, ширина запрещенной зоны в активной области двусторонней гетероструктуры меньше, чем Eg в пассивных областях. Поэтому инжектированные в активную область носители находятся в потенциальной яме. Потенциальные барьеры гетеропереходов препятствуют растеканию области рекомбинации за пределы активного слоя (электронное ограничение). В то же время в гомолазерах область рекомбинации, т. е. объем кристалла, где концентрации дырок и электронов не равна нулю (р ¹ 0 и п ¹ 0), может быть значительно больше активного слоя. Во-вторых, гетероструктуры обладают значительно лучшими волноводными свойствами, чем активный слой р — п- перехода (оптическое ограничение). Вследствие ограничения активной области потенциальными барьерами в гетеролазерах стало возможным явление суперинжекции, заключающееся в создании в активной области концентрации носителей более высокой, чем равновесная концентрация этих же носителей в эмиттере. Квазиуровень Ферми, находившийся при термодинамическом равновесии ниже дна зоны проводимости, в результате суперинжекции заходит в зону проводимости. Поэтому в гетеролазерах отпадает необходимость применять сильное легирование, которое сопровождается появлением в активной области большой концентрации дефектов.
Активная зона гомолазера неоднородна, она характеризуется градиентами концентраций электронов и дырок и зависимостью коэффициента усиления от координаты х. В гетеролазерах активный слой более однороден. Широкое распространение получили гетеролазеры с полосковым контактом, в которых активная среда создается в виде отдельной нити диаметром до 1 мкм, что обеспечивает стабильную одномодовую генерацию при весьма низком пороге, порядка миллиампера. В простейшем случае для получения полоскового лазера на выращенную гетероструктуру наносится слой изолирующего материала, например диоксида кремния SiO2. В этом слое протравливается полоска и наносится омический контакт (рис. 2.12). Второй контакт остается широким, поэтому происходит некоторое растекание тока за пределы активной области, расположенной под полосковым контактом.
Рис.2.12. Гетеролазер с полосковым контактом
Рис.2.13. Гетеролазер с полосковым контактом после обработки потоком протонов
Полосковый лазер можно также изготовить путем нанесения на поверхность гетероструктуры полоскового металлического контакта и последующей обработки всей поверхности потоком протонов. Незащищенные металлом участки становятся высокоомными из-за образования радиационных дефектов (рис. 2.13).
Схема реальной двойной гетероструктуры, соответствующая гетеролазеру с полосковым контактом рис. 2.12, изображена на рисунке 2.14.
Рис. 2.14. Пример реальной двойной гетероструктуры. 1-проводящий металлизированный слой для создания электрического контакта; 2-слой GaAs (n); 3-слой (широкозонный) Al0.3Ga0.7As (n); 4-слой узкозонный GaAs, соответствующий зоне инжекции носителей заряда (p-n-переход); 5-слой широкозонный Al0.3Ga0.7As (p); 6-слой GaAs (p); 7-непроводящий слой оксида металла для ограничения тока через p-n-переход, формирующий зону генерации излучения; 8,9-прилегающие слои для создания электрического контакта; 10-подложка с теплоотводом
Первый гетеропереход Al0,3Ga0,7As - GaAs обладает шириной запрещенной зоны 2 эВ в области твердого раствора; разность значений ширины запрещенной зоны в переходе (для GaAs Eg = 1,4 эВ) действует как барьер в основном для электронов зоны проводимости и задерживает (накапливает) инжектированные электроны в тонкой области GaAs. Это накопление электронов обеспечивает высокую скорость стимулированного испускания фотонов даже при комнатной температуре. Коэффициент преломления в области GaAs гетероперехода несколько больше; это приводит к эффекту световода и дополнительному уменьшению потерь. Другой гетеропереход GaAs - Al0,3Ga0,7As - используется при создании области n-типа. Так как постоянные решеток GaAs и AlAs почти одинаковы, электронные состояния границы раздела не возникают, и, таким образом, нет дополнительного канала безызлучательной рекомбинации. Таким образом, в отсутствие приложенного напряжения в области узкозонного полупроводника уже создаются потенциальные ямы для электронов и дырок. При приложении внешнего прямого напряжения электроны инжектируются из n-области, а дырки из p-области в центральную активную зону, где и рекомбинируют и удерживаются в этой зоне потенциальным барьером AlGaAs. А генерируемые фотоны удерживаются в этой области большим показателем преломления – т.е. здесь образуется оптический волновод. Для увеличения мощности генерации созданы многоэлементные фазированные инжекционные лазеры, или фазированные лазерные решетки. В пределах единой гетероструктуры интегрируется несколько десятков полосковых лазеров, потоки излучения которых взаимодействуют между собой, что приводит к когерентному сложению интенсивностей. Одновременно уменьшается угол расходимости излучения в плоскости гетероперехода. Жесткие фазовые соотношения между отдельными лучами устанавливаются либо за счет перекрытия электромагнитных полей соседних лазеров, либоврезультате разветвления в лазерных волноводах.
Квантоворазмерные структуры
Слои, толщина которых сравнима с длиной волны де Бройля для электронов или дырок или меньше ее, называются квантовораз-мерными. В обычных гетероструктурах толщина слоев не меньше 0,05 мкм (500 А), что значительно больше длины волны де Бройля l Б = h / p, где h – постоянная Планка, p – импульс электрона. Поэтому их свойства совпадают со свойствами объемных кристаллов.
В 80-х гг. прошлого столетия разработаны утонченные методы молекулярной, газофазовой и жидкофазовой эпитаксии, позволяющие получать высокосовершенные структуры с толщиной слоев менее 10 нм. В таких слоях возникают ограничения для движения электронов и дырок в направлении, перпендикулярном к поверхности слоя, что сопровождается изменением квантовомеханических свойств слоя.
Рис. 2.15. Возникновение потенциальной квантовой ямы в случае, когда ультратонкий слой GaAs выращивается между двумя более широкозонными барьерными слоями AlGaAs.
Когда ширина слоя ямы достаточно мала, движение электронов в квантовой яме становится квантованным в направлении роста, при этом разрешенные энергетические уровни, соответствующие движению в этом направлении, становятся дискретными. В плоскости, параллельной границам раздела, движение электронов остается неограниченным. В результате этого полная электронная волновая функция дается произведением огибающей функции (решение одномерного уравнения Шредингера) и периодических блоховских функций(обусловленных периодичностью кристаллической решетки), а также плоских волн, описывающих свободное движение в плоскости, параллельной границам раздела. Уровни энергии одномерной потенциальной ямы шириной a выражаются формулой:
В плоскости ху (потенциальной ямы) передвижение носителей не ограничивается, поэтому полную энергию носителей можно записать в виде:
где kx и ky – x и y проекции волнового вектора электрона, m * - эффективная масса. Если kx и ky непрерывны, то kz квантуется. Таким образом, если в массивном образце функция плотности состояний электрона имеет вид параболы (рис. 2.3 б), то в квантоворазмерном слое она выражается ступенчатой кривой (рис.2.16)
Рис. 2.16. Графики плотности состояний g (E) в сверхтонком слое GaAs.
Путем изготовления полупроводниковых нитей и кубиков субмикронной толщиныможно создать ограничения движению электронов в двух и трех измерениях. Тогда функция плотности состояний вообще теряет сходство с этой характеристикой для массивного образца. Квантоворазмерные структуры приводят к квантованию состояний электрона, подобно тому, как они квантуются периодическим потенциалом кристалла. Если таких слоев много (сверхрешетка или многослойная структура, рис. 2.17), то образуются зоны разрешенных состояний для к z, однако в целом квантование сохраняется.
Рис. 2.17. а — модель сверхрешетки на основе GaAs — AlAs; б — зонная структура в сверхрешетке
В квантовой нити сохраняется свободное движение только по оси y, по осям x и z энергия носителей квантуется и образуются одномерные подзоны с дискретными связанными состояниями. В квантовой точке квантуются все проекции волнового вектора, а функция плотности состояний превращается в набор d - функций (см. рис. 2.18).
а б в г Рис. 2.18. Зависимость плотности состояний D от энергии носителей в случае (а) - объемного материала, (б) – квантоворазмерного слоя, (в) – квантовой нити, г – квантовой точки.
Таким образом, чисто количественное уменьшение размеров вещества приводит к качественному изменению его квантовомеханических, а также оптических и электрических свойств. Увеличивается ширина запрещенной зоны, снимается вырождение зон для дырок, уменьшается ширина спектра излучения. Порог генерации полупроводниковых лазеров был уменьшен с 105 А/см2 для первых гомолазеров до ~ 100 А для гетеролазеров на сверхрешетках. Порог генерации лазеров на квантовых точках еще меньше, например, с фотоннокристаллическим резонатором он составляет в настоящее время 260 мкА. На рис. 2.19 приведено схематическое изображение лазера на квантовых точках, генерирующего в ближнем ИК диапазоне спектра.
Рис. 2.19. Схематическое изображение лазера на квантовых точках. LC = 1020 мкм, W = 9 мкм
Врезка снизу рис. 2.19 показывает детали структуры области 190-нанометрового волновода, находящегося между слоями Al0.85Ga0.15As сoдержащего 12 монослоев In0.5Ga0.5As квантовых точек, генерирующих лазерное излучение. Порог генерации в таком лазере составляет всего 4.1 мА (рис. 2.20).
Рис. 2.20. Зависимость выходной световой мощности от тока, текущего через структуру лазера на квантовых точках. На вставке приведен спектр излучения
Безопасность лазеров
Даже маломощные лазеры (с выходной мощностью несколько милливатт) могут быть опасны для зрения. Для видимых длин волн (400—700 нм), которые хорошо пропускаются и фокусируются хрусталиком, попадание лазерного луча в глаз, даже на несколько секунд, может привести к частичной (или полной) потере зрения. А лазеры большей мощности могут приводить даже к повреждению кожных покровов. Лазеры делятся на 4 класса безопасности, от 1 — практически безопасный, до 4, у которого даже рассеянный луч может стать причиной ожога глаза или кожи.
|
|||||||||
|
Последнее изменение этой страницы: 2021-03-10; просмотров: 619; Нарушение авторского права страницы; Мы поможем в написании вашей работы! infopedia.su Все материалы представленные на сайте исключительно с целью ознакомления читателями и не преследуют коммерческих целей или нарушение авторских прав. Обратная связь - 18.118.162.155 (0.01 с.) |


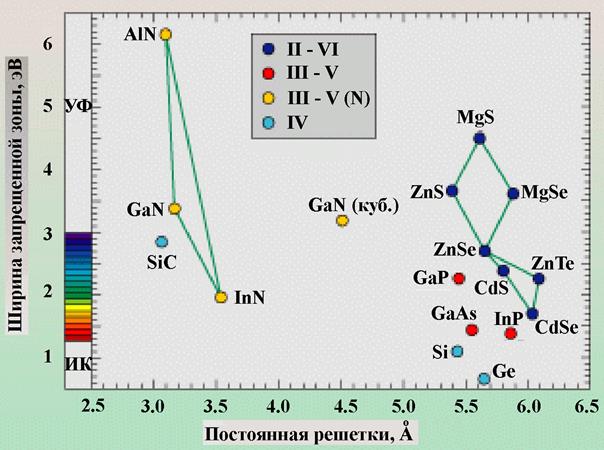

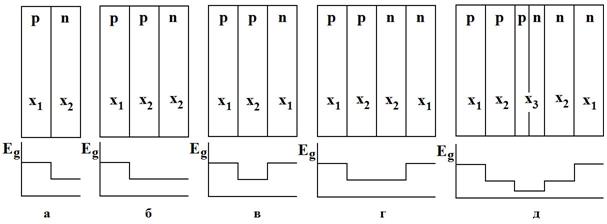
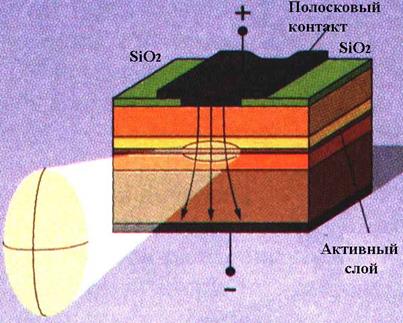
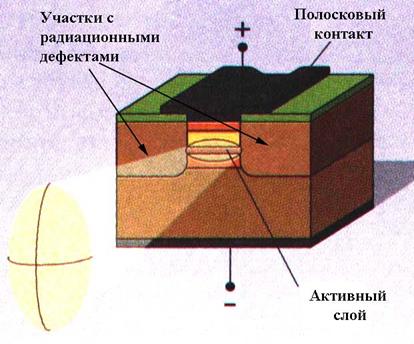
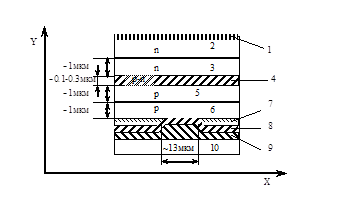
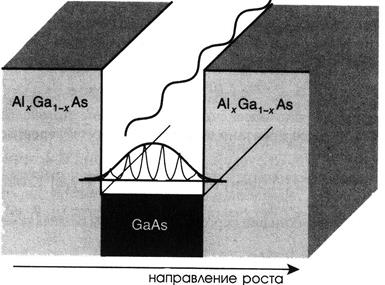
 . (2.2)
. (2.2) , (2.3)
, (2.3)