
Заглавная страница Избранные статьи Случайная статья Познавательные статьи Новые добавления Обратная связь FAQ Написать работу КАТЕГОРИИ: ТОП 10 на сайте Приготовление дезинфицирующих растворов различной концентрацииТехника нижней прямой подачи мяча. Франко-прусская война (причины и последствия) Организация работы процедурного кабинета Смысловое и механическое запоминание, их место и роль в усвоении знаний Коммуникативные барьеры и пути их преодоления Обработка изделий медицинского назначения многократного применения Образцы текста публицистического стиля Четыре типа изменения баланса Задачи с ответами для Всероссийской олимпиады по праву 
Мы поможем в написании ваших работ! ЗНАЕТЕ ЛИ ВЫ?
Влияние общества на человека
Приготовление дезинфицирующих растворов различной концентрации Практические работы по географии для 6 класса Организация работы процедурного кабинета Изменения в неживой природе осенью Уборка процедурного кабинета Сольфеджио. Все правила по сольфеджио Балочные системы. Определение реакций опор и моментов защемления |
Электронно – дырочный переходСодержание книги
Похожие статьи вашей тематики
Поиск на нашем сайте Мы уже рассматривали структуру и зонные диаграммы донорных и акцепторных полупроводников. Напомним, что в р – полупроводнике основных
Рисунок 4.2. Акцепторный (р) и донорный (n) полупроводники и их зонные диаграммы до образования контакта. носителей – дырок на много больше, чем неосновных (электронов, т.е р>> n) и уровень Ферми находится в запрещённой зоне вблизи потолка валентной зоны. В донорных полупроводниках основными носителями являются электроны, их много больше, чем дырок (n >> р) и уровень Ферми располагается в запрещённой зоне вблизи дна зоны проводимости (рис. 4.2). При отсутствии контакта, оба типа полупроводника электрически нейтральны, так как избыточный заряд подвижных носителей одного знака (дырок или электронов) компенсируется таким же зарядом неподвижных ионизированных атомов в узлах решётки. Нет в таких полупроводниках и токов – дрейфовых из – за отсутствия электрического поля, а диффузионных из – за равномерного распределения носителей по всему объёму кристаллов в результате хаотического теплового движения. Образуем контакт между - р и n – полупроводниками. Это можно сделать, например, нарастив на р – полупроводник эпитаксильную плёнку n – полупроводника (или наоборот). В результате образуется резкий симметричный (можно и несимметричный) р – n переход (см. рис. 4.3). Что же будет происходить в этом случае? На рисунке слева от границы раздела (это условная линия,
правлению с направлением диффузии дырок и равен сумме диффузионных токов электронов и дырок: Iдиф = Inдиф + Iрдиф. В результате диффузии носителей по обе стороны границы раздела двух полупроводников с различным типом проводимости создаются объёмные заряды различных знаков (рис.4.3 – г). В области n возникает положительный объёмный заряд (+ φ). Он образован положительно заряженными атомами (ионами) донорной примеси и в незначительной степени пришедшими сюда дырками. Подобно этому в области р возникает отрицательный объёмный заряд (– φ), образованный отрицательно заряженными атомами (ионами) акцепторной примеси и, отчасти, пришедшими сюда электронами. Между образовавшимися объёмными зарядами возникают контактная разность потенциалов Uкн = φn – φр и внутреннее электрическое поле с вектором напряжённости Ер- n (см. рис 4.3). Приконтактная область (около металлургической границы) обеднена подвижными носителями зарядов по двум причинам: во – первых основные носители ушли в область с противоположной проводимостью, поэтому в своей области их стало меньше; а во – вторых, пришедшие в другую область носители рекомбинировали там, образовав нейтральные атомы, что ещё уменьшило количество подвижных носителей. В результате обеднённая подвижными носителями зарядов область (запирающий слой) обладает наибольшим по всей длине образца сопротивлением и поэтому объёмный заряд и созданное им электрическое поле сосредоточены вблизи контакта полупроводников с разным типом проводимости. Эта область протяжённостью Lp-n и называется электронно – дырочным или p-n переходом. На рис. 4.3 – а размеры перехода показаны в искажённом масштабе. На самом деле ширина перехода значительно меньше протяжённости – p и – n областей. И ещё замечание относительно расположения перехода: в рассматриваемом случае переход располагается симметрично в – p и – n областях, это возможно только для переходов, образованных полупроводниками с одинаковой концентрацией примеси, т.е. при Nа = Nд. Если же Nа > Nд или Nд > Nа, то переход большей своей частью располагается в области с меньшей концентрацией примеси. Пусть, например, доноров в сто раз больше чем акцепторов, тогда ширина перехода в – р области Lp будет в сто раз больше ширины перехода в – n области Ln. Возникший в переходе потенциальный барьер, препятствует росту диффузионного тока и дырок из р- области, и электронов из n- области. Однако, не следует забывать, что кроме основных, в каждой из областей существуют неосновные подвижные носители заряда противоположного знака – электроны в р- области и дырки в n- области. Для этих, неосновных, носителей потенциальный барьер является ускоряющим, что вызывает дрейф дырок из n- области в р- область и электронов из р- области в n- область и появлению дрейфового тока I др = I рдр + I nдр (где I рдр, I nдр – токи дрейфа дырок и электронов соответственно). Этот ток растёт с ростом потенциального барьера и направлен на встречу диффузионному току. В результате полный ток через переход I р- n = Iдиф + Iдр = 0 становится равным нулю. Такое состояние перехода называется равновесным и образуется оно при формировании р – n перехода в отсутствии внешнего электрического поля. На рис. 4.4 представлена зонная диаграмма р – n перехода в равновесном состоянии.
зионное перераспределение носителей до тех пор, пока средняя энергия частиц, а следовательно, и значение уровня Ферми в обеих частях кристалла, не будут одинаковы. Как видно из рисунка, это сопровождается искривлением дна зоны проводимости и потолка валентной зоны в области перехода.
Прямое включение р – n перехода. Присоединим внешний источник напряжения Uпр плюсом к р – области и минусом к n – области (см. рис. 4.5).
слабее, разность потенциалов в переходе уменьшается (рис.4.5 – б) на величину Uпр, т.е. высота потенциального барьера понижается, возрастает диффузионный ток, так как большее число носителей может преодолеть пониженный потенциальный барьер. Ток дрейфа при этом практически не изменяется, так как он зависит главным образом от числа неосновных носителей, попадающих за счёт своих тепловых скоростей на р–n переход из р- и n- областей. Если пренебречь падением напряжения на сопротивлении р- и n- областей, то напряжение на переходе можно считать равным Uкн - Uпр. При прямом напряжении Iдиф > Iдр и поэтому полный ток через переход, т.е. прямой ток уже не равен нулю: Iпр = Iдиф – Iдр > 0. Величина потенциального барьера в равновесном состоянии зависит от ширины запрещённой зоны и для большинства материалов находится в пределах одного вольта, поэтому уже при Uпр > 1В диффузионный ток на несколько десятичных порядков больше дрейфового, т.е. прямой ток в переходе является чисто диффузионным. Зависимость тока диффузии от прямого напряжения имеет вид:
где I0 = I др = I рдр + I nдр – тепловой ток, ток насыщения неосновных носителей. Тепловой ток не зависит от величины приложенного напряжения. Полный ток перехода определяется разностью диффузионного и теплового:
Напряжение, присутствующее в последнем выражении, это прямое напряжение и берётся со знаком плюс. Так как прямое напряжение вызывает встречное движение дырок и электронов, то их концентрация в приконтактных областях возрастает, что приводит к уменьшению ширины перехода по отношению к равновесному состоянию до величины Lпр < Lp-n. Уменьшение высоты потенциального барьера (или полное его уничтожение) и ширины перехода приводит к значительному (вплоть до нуля) уменьшению сопротивления запирающего слоя (перехода). Прямой ток при этом возрастёт и будет ограничиваться только объёмным сопротивлением р- и n- областей. Рассмотрим ещё характер прямого тока в различных частях цепи: плюс источника прямого напряжения – р- область – переход – n- область – минус источника. Электроны из из n- области движутся через переход в р- область, а навстречу им движется поток дырок, т.е. через переход протекают два тока: электронный и дырочный. Во внешних проводниках движутся, конечно, только электроны. Они перемещаются в направлении от минуса источника к n- области и компенсируют убыль электронов, диффундирующих через переход в р- область. А из р- области электроны уходят по направлению к плюсу источника, и тогда в этой области образуются новые дырки. Такой процесс происходит непрерывно и, следовательно, непрерывно протекает прямой ток.
зон вследствие создания дрейфового поля в р- области, однако это поле мало по сравнению с полем в p – n переходе. При прямом смещении p – n перехода уровень Ферми оказывается различным в р- и n- областях, поэтому и осуществляется направленное перемещение носителей. Потенциальный барьер при этом уменьшается на величину приложенного прямого напряжения Uпр. Уменьшение потенциального барьера приводит к увеличению концентрации неосновных носителей за счёт их внедрения (впрыскивания) через переход. Такое впрыскивание носителей в область, где они являются неосновными, называется инжекцией носителя заряда. Инжектированные дырки диффундируют в n- область и рекомбинируют с электронами. Тоже самое происходит и с электронами, диффундирующими в р- область. Поэтому концентрация неравновесных носителей уменьшается при удалении от р – n перехода. Обратное включение р – n перехода. Подведём внешнее напряжение плюсом к n- области и минусом к р- области (рис. 4.7 -а). Источник этого напряжения Uоб создаст электрическое поле напряжённостью Еоб, совпадающее по направлению с собственным полем перехода Е р-n. В этом случае поля
величины Lоб по сравнению с шириной в равновесном состоянии Lp-n (рис. 4.7 –б). Увеличение ширины перехода, ещё большее обеднение его подвижными носителями. приводит к существенному увеличению сопротивления запирающего слоя по сравнению не только с сопротивлением прямосмещённого перехода, но и с сопротивлением перехода в равновесном состоянии. По мере увеличения внешнего обратного напряжения остаётся всё меньше подвижных носителей, способных преодолеть возрастающее тормозящее поле и поэтому диффузионный ток через переход с увеличением обратного напряжения стремится к нулю. Это видно из выражения (4.1), если учесть, что напряжение Uпр, входящее в формулу, заменяется на Uоб со знаком минус. При комнатной температуре e / kT = 39 В- 1 поэтому экспоненциальная зависимость очень сильная. Полный ток через переход равен разности диффузионного и теплового токов, поскольку направлены они в разные стороны. Практически все неосновные носители, подходящие к р – nпереходу, перемещаются в соседнюю область. Поэтому тепловой ток зависит от концентрации неосновных носителей в р- и n- областях и практически не зависит от приложенного напряжения. В связи с этим, выражение (4.2) можно считать универсальной для описания полного тока через переход как при прямом, так и при обратном включениях, если считать, что внешнее напряжение U входит со своим знаком (прямое направление положительное, обратное – отрицательное). При прямом смещении на р – n переходе экспоненциальный член быстро возрастает и единицей в фигурных скобкой можно пренебречь, поэтому полный ток через переход практически равен диффузионному току. При обратном смещении на р – n переходе экспоненциальный член стремится к нулю и ток через переход равен тепловому току.
концентрацию, поэтому плотность тока очень мала (от долей до нескольких микроампер). Явление уменьшения концентрации неосновных носителей в полупроводнике при обратном смещении вследствие ухода их через р – n переход называется экстракцией (экстракция означает «выдёргивание, извлечение» носителей заряда). Итак, электронно – дырочный переход, или р – n переход может находиться в трёх состояниях: равновесном. в прямом смещении, в обратном смещении. Особенности этих трёх состояний: • равновесное состояние – образование обеднённого носителями слоя, высокое сопротивление всей структуры, образование потенциального барьера на границе между полупроводниками разной проводимости, отсутствие тока через переход; • прямое включение (плюс внешнего источника напряжения подключён к р- области, минус к n- области) – обеднённый слой исчезает, сопротивление структуры мало, потенциальный барьер снижается, через переход течёт ток, имеющий диффузионную природу и достаточно высокую плотность (прямой ток), происходит инжекция неосновных носителей; • обратное включение (плюс внешнего источника напряжения подключён к n- области, минус к р- области) – обеднённый слой расширяется, сопротивление структуры велико, потенциальный барьер увеличивается на величину внешнего напряжения, через переход течёт очень малый тепловой (обратный) ток, происходит экстракция неосновных носителей заряда; • переход обладает односторонней проводимостью, поскольку его сопротивление при прямом включении на несколько порядков меньше сопротивления при обратном включении
Барьерная и диффузионная ёмкости р–n перехода. Область пространственного заряда электронно – дырочного переходаимеет двойной электрический слой из положительно заряженных атомов доноров и отрицательно заряженных атомов акцепторной примеси. Этот двойной электрический слой образует ёмкость, которую называют барьерной (или зарядной) ёмкостьюр–n перехода. Барьерную ёмкость можно определить по формуле для ёмкости плоского конденсатора: где Sp-n, Lp-n – площадь и ширина перехода. Зависимость зарядной ёмкости от внешнего напряжения можно получить, преобразовав последнее выражение к виду: где С0 – барьерная ёмкость перехода при U = 0. Эта зависимость приведена на рис. 4.9 где показана так называемая вольт – фарадная характеристика р–n перехода (на примере конкретного германиевого
определяется его малым прямым сопротивлением, т.е. можно сказать, что барьерная ёмкость существует только при обратном включении перехода. Кроме зарядной (барьерной) существует ещё и так называемая диффузионная ёмкость перехода. При протекании через р–n переход прямого тока около перехода в р- и n-областях происходит накопление инжектированных неравновесных носителей. Неравновесные носители образуют пространственные заряды соответствующих знаков. Эти заряды согласно закону электростатической индукции притягивают и удерживают пространственные заряды противоположных знаков, создаваемых основными носителями этих областей, концентрация которых вблизи р–n перехода повышается. Количество неравновесных носителей, например дырок в n- области, будет зависеть от величины потенциального барьера, т.е. от напряжения внешнего источника. Увеличение прямого напряжения приведёт к увеличению неравновесных и индуцированных зарядов. Изменение зарядов при изменении напряжения эквивалентно некоторой ёмкости, которая и называется диффузионной. Известно, что С = ΔQ / ΔU, где Q – заряд, накапливаемый ёмкостью. Изменение напряжения р – n переходе ΔU вызывает приращение диффузионного тока, а это приводит к увеличению неравновесных и индуцированных зарядов ΔQ. Если быстро сменить направление внешнего напряжения на противоположное (вместо прямого подать обратное), то в начальный момент во внешней цепи появится значительный обратный ток, обусловленный процессом рассасывания неравновесных носителей заряда – обратным переходом неравновесных носителей, накопленных в р- и n- областях, а затем обратный ток спадёт до теплового I0 . Большое значение обратного тока в начальный момент при смене полярности внешнего источника соответствует разряду диффузионной ёмкости. Перезарядка диффузионной ёмкости не происходит, так как она при отсутствии тока диффузии (т.е. при обратном включении перехода) перестаёт существовать. Диффузионная ёмкость прямо пропорциональна току диффузии дырок и электронов и их времени жизни (τ р, τ n):
????
Величина диффузионной ёмкости существенно больше, чем барьерной. Например, пусть для несимметричного перехода (Nа > Nд) τр = 5 мкс, Iрдиф = 10мА, тогда Сдиф = 2 мкФ. Величина же барьерной ёмкости как это видно из графика на рис. 4.9, не превышает нескольких десятков пикофарад. Вольт – амперная характеристика (ВАХ) р–n перехода описывается выражением (4.2). Зависимость тока через переход от приложенного к нему напряжения показана на рис. 4.10 и представляет собой теоретическую ВАХ. Как уже указывалось к переходу может быть приложено напряжение разных знаков – прямое и обратное, что вызывает и токи противоположных направлений, т.е. полная ВАХ располагается в первой и третьей четвертях прямоугольной системы координат Не следует забывать, что на практике прямое напряжение на 1 – 2 порядка меньше обратного, а прямой ток на 5 – 8 порядков
на выражением (4.2). На вольт – амперную характеристику сильно влияет температура, причём, при изменении температуры смещаются как прямая, так и
сняется тем, что прямой ток в основном возникает за счёт примесной проводимости, а концентрация примеси не зависит от температуры, поэтому увеличение прямого тока при увеличении температуры происходит вследствие увеличения теплового тока. С повышением температуры несколько возрастает барьерная ёмкость перехода. И хотя это никоим образом не отражается на статической ВАХ перехода, помнить об этом необходимо при работе с реальными приборами, выполненными на основе полупроводниковых р – n переходов. Пробой р – n перехода. По мере увеличения обратного напряжения, приложенного к переходу, возможно усиление напряжённости поля до величины, когда наступит электрический пробой перехода (т.е. резкое увеличение обратного тока). Возможен и так называемый тепловой пробой, когда увеличение обратного тока происходит при увеличении температуры перехода и количества генерируемых пар носителей заряда. Электрический пробой может быть двух типов – лавинный и туннельный, после снижения обратного напряжения до предпробойных величин обратный ток тоже уменьшается, т.е. электрический пробой обратим. Тепловой пробой приводит к разрушению перехода из – за перегрева и является необратимым. ВАХ р – n перехода во всём диапазоне на -
не происходит необратимых изменений (разрушения структуры вещества). Поэтому работа полупроводниковых приборов в режиме электрического пробоя допустима, более того, существуют приборы для которых участок БВ является основным рабочим режимом (стабилитроны). Механизмы электрического пробоя различны в зависимости от концентрации примесей, толщины перехода и приложенного напряжения (точнее – напряжённости электрического поля в переходе). Лавинный пробой является результатом ударной ионизации атомов кристалла. Носители заряда, попавшие в область пространственного заряда р – n перехода, под действием сильного электрического поля приобретают энергию, достаточную для ударной ионизации и приводящую к лавинному размножению числа носителей, что равносильно увеличению обратного тока перехода. Лавинный пробой возникает в относительно широких р – n переходах, толщина которых больше средней длины свободного пробега носителей между очередными столкновениями с узлами кристаллической решётки. Кроме этого условия, для возникновения лавинного пробоя необходима относительно небольшая концентрация примесей, при которой соблюдается требуемое соотношение между длиной свободного пробега и толщиной перехода. Для осуществления этого вида пробоя в реальных приборах обычно требуются напряжения более 15 В.
уровней зоны проводимости. В этих условиях, да ещё и при наличии мощного поля в узком переходе, электроны проникают через этот переход без изменения своей энергии, что и вызывает туннельный ток. Для возникновения туннельного тока достаточно обратных напряжений не более 7В, ибо при толщине перехода 10 – 6 см эти напряжения создают в переходе поле напряжённостью более 10 7 В/м. Как и в любом р – n переходе дрейфовый ток в режиме туннельного пробоя (т.е. при обратном включении перехода) отсутствует, а тепловой очень мал, поэтому для простоты на рис. 4.13 показан только туннельный ток. Области теплового пробоя соответствует на рис. 4. 12 участок ВГ. Тепловой пробой необратим так как он сопровождается разрушением структуры, поэтому при эксплуатации реальных полупроводниковых приборов этот режим недопустим. Возникает тепловой пробой из – за нарушения устойчивости теплового режима р – n перехода. Это означает, что количество теплоты, выделяющейся в переходе от нагрева его обратным током, превышает количество теплоты, отводимой от перехода. В результате температура перехода возрастает, сопротивление его уменьшается и ток увеличивается, что и приводит к перегреву перехода и его разрушению. Следует отметить, что ВАХ р – n перехода на участке ВГ указывает на то, что переход в режиме теплового пробоя имеет отрицательное дифференциальное сопротивление. Если вспомнить, что туннельные явления очень быстрые по сравнению с дрейфовыми и диффузионными, то переход в режиме теплового пробоя очень привлекателен для построения высокочастотных генераторов электромагнитных колебаний (для которых необходим элемент с ВАХ, имеющей ниспадающий участок). Однако, на практике весьма сложно обеспечить устойчивую работу полупроводникового прибора в режиме теплового пробоя, поэтому попытки создания такого СВЧ генератора не увенчались успехом. Возвращаясь к вольт – амперной характеристике р – n перехода, необходимо отметить ряд обстоятельств, связанных с отличиями характеристик реальных приборов и теоретических характеристик перехода. Эти отличия связаны с целым рядом обстоятельств: наличие объёмного сопротивления областей полупроводника и сопротивления контактов прибора с внешними цепями, термическая генерация носителей в переходе при различных значениях обратного напряжения и др. На рис. 4.14 приведены теоретическая (1) и реальная (2) ВАХ р – n перехода. Теоретическая изображена в соответствие с выражением (4.2). Для наглядности обратная характеристики изображена в более крупном масштабе, чем прямая ветвь, по току и в более мелком – по напряжению. В области малых токов теоретическая и реальная характеристики совпадают. Однако при больших значениях прямых токов и обратных напряжений
электродов. При этом напряжение на переходе будет заметно меньше напряжения, приложенного к диоду, в результате реальная характеристика идёт ниже теоретической и оказывается почти линейной. При увеличении обратного напряжения ток диода не остаётся постоянным, равным тепловому току (току экстракции) Io, как следует из соотношения (4.2), а медленно увеличивается. Одной из причин роста обратного тока является термическая генерация носителей в переходе, не учтённая в соотношении (4.2). Компоненту обратного тока через переход, зависящую от количества генерируемых в переходе носителей, иногда называют термотоком перехода. С ростом обратного напряжения вследствие расширения перехода увеличивается его объём, поэтому количество генерируемых в переходе носителей растёт и термоток перехода также увеличивается. Другой причиной роста обратного тока реального прибора является поверхностная проводимость электронно – дырочного перехода, обусловленная молекулярными и ионными плёнками различного происхождения, покрывающими выходящую наружу поверхность перехода.
|
||||||||||||||||||||||||||
|
Последнее изменение этой страницы: 2016-12-11; просмотров: 776; Нарушение авторского права страницы; Мы поможем в написании вашей работы! infopedia.su Все материалы представленные на сайте исключительно с целью ознакомления читателями и не преследуют коммерческих целей или нарушение авторских прав. Обратная связь - 216.73.216.108 (0.02 с.) |


 Рисунок 4.3. Образование р –n перехода.
Рисунок 4.3. Образование р –n перехода.
 Рисунок 4.4. Зонная диаграмма р – n перехода в равновесном состоянии.
Рисунок 4.4. Зонная диаграмма р – n перехода в равновесном состоянии.
 Рисунок4.5. Прямое включение р–n перехода.
Рисунок4.5. Прямое включение р–n перехода.
 , (4.1)
, (4.1) . (4.2)
. (4.2) Рисунок 4.6. Зонная диаграмма прямого включения р – n перехода.
Рисунок 4.6. Зонная диаграмма прямого включения р – n перехода.
 Рисунок 4.7. Обратное включение р–n перехода.
Рисунок 4.7. Обратное включение р–n перехода.
 Рисунок 4.8. Зонная диаграмма обратного включения р – n перехода.
Рисунок 4.8. Зонная диаграмма обратного включения р – n перехода.
 , (4.3)
, (4.3) , (4.4)
, (4.4)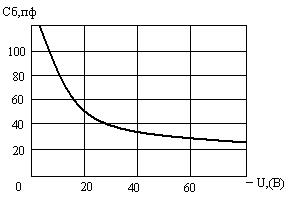 Рисунок 4.9. Вольт – фарадная характеристика р–n перехода.
Рисунок 4.9. Вольт – фарадная характеристика р–n перехода.
 . (4.5).
. (4.5). Рисунок 4.10. Теоретическая ВАХ р – n перехода.
Рисунок 4.10. Теоретическая ВАХ р – n перехода.
 Рисунок 4.11. Зависимость ВАХ ВАХ р – n перехода от температуры (1 при 200С; 2 при 500С).
Рисунок 4.11. Зависимость ВАХ ВАХ р – n перехода от температуры (1 при 200С; 2 при 500С).
 Рисунок 4.12. Полная ВАХ р – n перехода.
Рисунок 4.12. Полная ВАХ р – n перехода.
 Рисунок 4.13. Туннельный пробой р – n перехода
Рисунок 4.13. Туннельный пробой р – n перехода
 Рисунок 4.14. Теоретическая (1) и реальная (2) ВАХ р – n перехода
Рисунок 4.14. Теоретическая (1) и реальная (2) ВАХ р – n перехода



