
Заглавная страница Избранные статьи Случайная статья Познавательные статьи Новые добавления Обратная связь FAQ Написать работу КАТЕГОРИИ: ТОП 10 на сайте Приготовление дезинфицирующих растворов различной концентрацииТехника нижней прямой подачи мяча. Франко-прусская война (причины и последствия) Организация работы процедурного кабинета Смысловое и механическое запоминание, их место и роль в усвоении знаний Коммуникативные барьеры и пути их преодоления Обработка изделий медицинского назначения многократного применения Образцы текста публицистического стиля Четыре типа изменения баланса Задачи с ответами для Всероссийской олимпиады по праву 
Мы поможем в написании ваших работ! ЗНАЕТЕ ЛИ ВЫ?
Влияние общества на человека
Приготовление дезинфицирующих растворов различной концентрации Практические работы по географии для 6 класса Организация работы процедурного кабинета Изменения в неживой природе осенью Уборка процедурного кабинета Сольфеджио. Все правила по сольфеджио Балочные системы. Определение реакций опор и моментов защемления |
Реальна вольтамперная характеристика p-n переходуСодержание книги
Похожие статьи вашей тематики
Поиск на нашем сайте
При виведенні рівняння (1.37) не враховувалися такі явища, як термогенерация носіїв в замикаючому шарі переходу, поверхневі витоки струму, падіння напруги на опорі нейтральних областей напівпровідника, а також явища пробою при певних зворотних напругах. Тому експериментальна вольтамперная характеристика p-n переходу (крива 2 на рис. 1.11) відрізняється від теоретичної (крива 1). При зворотному включенні p-n переходу відмінності обумовлені генерацією носіїв зарядів і пробоєм p-n переходу. Кількість носіїв, що генеруються, пропорційно об'єму замикаючого шару, який залежить від ширини p-n переходу. Оскільки ширина замикаючого шару пропорційна При деякій зворотній напрузі спостерігається різке зростання зворотного струму. Це явище називають пробоєм p-n переходу. Існують три види пробою: тунельний, лавинний і тепловий. Тунельний і лавинний пробої є різновидами електричного пробою
Рисунок 1.11 Відмінність реальної вольтамперной характеристики p-n переходу від теоретичної.
і пов'язані із збільшенням напруженості електричного поля в переході. Тепловий пробій визначається перегрівом переходу. Тунельний пробій обумовлений прямим переходом електронів з валентної зони одного напівпровідника в зону провідності іншого, що стає можливим, якщо напруженість електричного поля в p-n переході з кремнію досягає значення 4105 ×В/см, а з германію -2105 В/см. Така велика напруженість електричного поля можлива при високій концентрації домішок в p- і n-областях, коли товщина p-n переходу стає вельми малою (див. формулу (1.31)). Під дією сильного електричного поля валентні електрони вириваються із зв'язків. При цьому утворюються парні заряди електрон-дірка, що збільшують зворотний струм через перехід. На рис. 1.10 крива 5 є зворотною гілкою вольт-амперної характеристики переходу, відповідною тунельному пробою. У широких p-n переходах, утворених напівпровідниками з меншою концентрацією домішок, вірогідність тунельного просочування електронів зменшується і вірогіднішим стає лавинний пробій. Він виникає тоді, коли довжина вільного пробігу електрона в напівпровіднику значно менше товщини p-n переходу. Якщо за час вільного пробігу електрони набувають кінетичної енергії, достатньої для іонізації атомів в p-n переході, наступає ударна іонізація, що супроводжується лавинним розмноженням носіїв зарядів. Вільні носії зарядів, що утворилися в результаті ударної іонізації, збільшують зворотний струм переходу. Збільшення зворотного струму характеризується коефіцієнтом лавинного множення М:
де UПРОБ - напругу почала пробою; m залежить від матеріалу напівпровідника. На рис 1.11 лавинному пробою відповідає крива 4. Тепловий пробій обумовлений значним зростанням кількості носіїв зарядів в p-n переході за рахунок порушення теплового режиму. Потужність Рподв, що підводиться до p-n переходу = IобрUобр витрачається на його нагрів. Теплота, що виділяється в замикаючому шарі, відводиться переважно за рахунок теплопровідності. Потужність Ротв, що відводиться від p-n переходу, пропорційна різниці температур переходу Tпер і навколишнього середовища Токр:
де Rт - тепловий опір, 0К/Вт, що визначає перепад температур, необхідний для відведення 1 Вт потужності від p-n переходу в навколишнє середовище. За поганих умов відведення теплоти від переходу можливий його розігрівши до температури, при якій відбувається теплова іонізація атомів. Носії заряду, що утворюються при цьому, збільшують зворотний струм, що приводить до подальшого розігрівання переходу. В результаті такого наростаючого процесу p-n перехід неприпустимо розігрівається і виникає тепловий пробій, що характеризується руйнуванням кристала (крива 3). Збільшення числа носіїв зарядів при нагріві p-n переходу приводить до зменшення його опору і напруги, що виділяється на ньому. Внаслідок цього на зворотній гілці вольтамперной характеристики при тепловому пробої з'являється ділянка з негативним диференціальним опором (ділянка АВ на рис. 1.11). Відмінності реальної характеристики від теоретичної на прямій гілці, в основному, обумовлені розподіленим (об'ємним) опором електронної і діркової областей r1 за межами замикаючого шару (рисунок 1.12).
Якщо опір замикаючого шару позначити rд, то кристал напівпровідника із замикаючим шаром можна представити у вигляді послідовного з'єднання резисторів rд і r1. При проходженні струму IПР на опорі r1 падає частина напруги зовнішнього джерела і на замикаючому шарі діє напруга UПЕР = UПР – IПР×r1. Рівняння вольтамперной характеристики в цьому випадку може бути записано в наступному неявному вигляді:
Рисунок 1.12 Спрощена еквівалентна схема p-n переходу з розподіленим опором напівпровідника.
Оскільки UПЕР < UПР реальна характеристика йде нижче теоретичною. Коли напруга на замикаючому шарі стає рівною контактній різниці потенціалів, замикаючий шар зникає, і подальше збільшення струму обмежується розподіленим опором напівпровідників p- і n-типу. Таким чином, в крапці З при UПР = UК вольтамперная характеристика переходить в пряму лінію.
Ємності p-n переходу
Зміна зовнішньої напруги dU на p-n переході приводить до зміни накопиченого в ньому заряду dQ. Тому p-n перехід поводиться подібно до конденсатора, ємність якого З = dQ/ dU. Залежно від фізичної природи заряду, що змінюється, розрізняють ємності бар'єрну (зарядну) і дифузійну. Бар'єрна (зарядна) ємність визначається зміною заряду іонів, що не компенсується, при зміні ширини замикаючого шару під впливом зовнішньої зворотної напруги. Тому ідеальний електронно-дірковий перехід можна розглядати як плоский конденсатор, ємність якого визначається співвідношенням
де П, d - відповідно площа і товщина p-n переходу. Із співвідношень (1.41) і (1.31) слідує
У загальному випадку залежність зарядної ємності від прикладеної до p-n переходу зворотної напруги виражається формулою
де C0 — ємність p-n переходу при UОБР = 0; g - коефіцієнт, залежний типу p-n переходу (для різких p-n переходів = 1/2, а для плавних g = 1/3). Бар'єрна ємність збільшується із зростанням NА і NД, а також із зменшенням зворотної напруги. Характер залежності СБАР = f(UОБР) показаний на рис. 1.13,а. Розглянемо дифузійну ємність. При збільшенні зовнішньої напруги, прикладеної до p-n переходу в прямому напрямі, росте концентрація инжектированных носіїв поблизу меж переходу, що приводить до зміни кількості заряду, обумовленого неосновними носіями в p- і n-областях. Це можна розглядати як прояв деякої ємності. Оскільки вона залежить від зміни дифузійної складової струму, її називають дифузійною. Дифузійна ємність є відношенням приросту інжекційного заряду dQинж до зміни напруги dUпр, що викликала його, тобто. .
Рисунок 1.13 Залежність бар'єрної (а) і дифузійної (б) місткостей p-n переходу від напруги.
Тоді дифузійна ємність, обумовлена зміною загального заряду нерівноважних дірок в n-області, визначиться по формулі
Аналогічно для дифузійної ємності, обумовленою інжекцією електронів в p-область
Рисунок 1.13 Еквівалентна схема p-n переходу.
Загальна дифузійна ємність
Залежність ємності від прямої напруги на p-n переході показана на рисунку 1.13, би. Повна ємність p-n переходу визначається сумою зарядної і дифузійної місткостей:
При включенні p-n переходу в прямому напрямі переважає дифузійна ємність, а при включенні у зворотному напрямі - зарядна. На рис. 1.14 приведена еквівалентна схема p-n переходу по змінному струму. Схема містить диференціальний опір p-n переходу rД, дифузійну ємність СДИФ, бар'єрну ємність СБАР і опір об'єму p- і n-областей r1. На підставі рівняння (1.37) можна записати:
Якщо при прямому включенні p-n переходу Uпр >> jт, то:
При кімнатній температурі (у співвідношенні (1.42) значення струму підставляється в амперах). Опір витоку rУТ враховує можливість проходження струму по поверхні кристала із-за недосконалості його структури. При прямому включенні p-n переходу СБАР << СДИФ, диференціальний опір rД ПР мало і сумірно з r1, тому еквівалентна схема приймає вигляд, показаний на рис. 1.15, а.
Рисунок 1.15 Спрощені еквівалентні схеми p-n переходу.
При зворотному зсуві rД ОБР >> r1, СБАР >> СДИФ і еквівалентна схема має вигляд, показаний на рис. 1.15, би.
|
|||||||||||
|
Последнее изменение этой страницы: 2016-06-19; просмотров: 452; Нарушение авторского права страницы; Мы поможем в написании вашей работы! infopedia.su Все материалы представленные на сайте исключительно с целью ознакомления читателями и не преследуют коммерческих целей или нарушение авторских прав. Обратная связь - 3.138.123.149 (0.009 с.) |

 , струм генерації ростиме при збільшенні зворотної напруги. Тому на реальній характеристиці при збільшенні зворотної напруги до певного значення спостерігається невелике зростання зворотного струму. Зростанню зворотного струму сприяють також струми витоку.
, струм генерації ростиме при збільшенні зворотної напруги. Тому на реальній характеристиці при збільшенні зворотної напруги до певного значення спостерігається невелике зростання зворотного струму. Зростанню зворотного струму сприяють також струми витоку.
 (1.40)
(1.40) ,
, .
.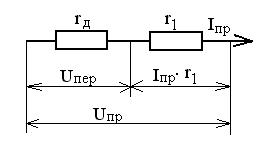
 (1.41)
(1.41) .
. ,
, Скориставшись рівнянням (1.30), можна визначити заряд инжектированных носіїв, наприклад дірок в n-області:
Скориставшись рівнянням (1.30), можна визначити заряд инжектированных носіїв, наприклад дірок в n-області:
 .
. .
. .
.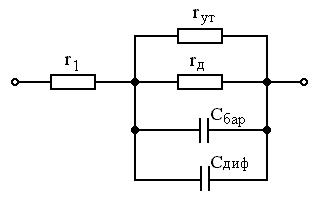
 .
. .
. .
. ;
;  .
. ; (1.42)
; (1.42)