
Заглавная страница Избранные статьи Случайная статья Познавательные статьи Новые добавления Обратная связь FAQ Написать работу КАТЕГОРИИ: ТОП 10 на сайте Приготовление дезинфицирующих растворов различной концентрацииТехника нижней прямой подачи мяча. Франко-прусская война (причины и последствия) Организация работы процедурного кабинета Смысловое и механическое запоминание, их место и роль в усвоении знаний Коммуникативные барьеры и пути их преодоления Обработка изделий медицинского назначения многократного применения Образцы текста публицистического стиля Четыре типа изменения баланса Задачи с ответами для Всероссийской олимпиады по праву 
Мы поможем в написании ваших работ! ЗНАЕТЕ ЛИ ВЫ?
Влияние общества на человека
Приготовление дезинфицирующих растворов различной концентрации Практические работы по географии для 6 класса Организация работы процедурного кабинета Изменения в неживой природе осенью Уборка процедурного кабинета Сольфеджио. Все правила по сольфеджио Балочные системы. Определение реакций опор и моментов защемления |
Елементна база електронних апаратівСодержание книги
Поиск на нашем сайте
ЕЛЕМЕНТНА БАЗА ЕЛЕКТРОННИХ АПАРАТІВ
Навчальний посібник Конспект лекцій
Вінниця 2007 Зміст
1 ОСНОВИ ТЕОРІЇ ЕЛЕКТРОПРОВІДНОСТІ......................................... 4 НАПІВПРОВІДНИКІВ............................................................................... 4 1.1 ЗАГАЛЬНІ ВІДОМОСТІ ПРО НАПІВПРОВІДНИКИ.................... 4 1.1.1 Напівпровідники з власною електропровідністю...................... 4 1.1.2 Напівпровідники з електронною електропровідністю............. 7 1.1.3 Напівпровідники з дірковою електропровідністю................... 9 1.2 СТРУМИ В НАПІВПРОВІДНИКАХ............................................. 11 1.2.1 Дрейфовий струм...................................................................... 11 1.2.2 Дифузійний струм..................................................................... 12 1.3 КОНТАКТНІ ЯВИЩА.................................................................... 15 1.3.1 Електронно-дірковий перехід в стані рівноваги..................... 15 1.3.2 Пряме включення p-n переходу.............................................. 19 1.3.3 Зворотне включення р-п-переходу.......................................... 21 1.3.4 Теоретична вольтамперная характеристика p-n переходу..... 23 1.3.5 Реальна вольтамперная характеристика p-n переходу........... 25 1.3.6 Ємності p-n переходу............................................................. 28 1.4 РІЗНОВИДИ ЕЛЕКТРИЧНИХ ПЕРЕХОДІВ............................... 30 1.4.1 Гетероперехіди........................................................................ 30 1.4.2 Контакт між напівпровідниками одного типу електропровідності 32 1.4.3 Контакт металу з напівпровідником........................................ 33 1.4.4 Омічні контакти......................................................................... 33 1.4.5 Явища на поверхні напівпровідника........................................ 34 2 НАПІВПРОВІДНИКОВІ ДІОДИ.......................................................... 37 2.1 Класифікація.................................................................................... 37 2.2 Випрямні діоди................................................................................ 37 2.3 Стабілітрони і стабістори................................................................ 38 2.4 Універсальні і імпульсні діоди........................................................ 39 2.5 Варікапи........................................................................................... 41 3 БІПОЛЯРНІ ТРАНЗИСТОРИ............................................................... 43 3.1 Принцип дії біполярного транзистора. Режими роботи............... 43 3.1.1 Загальні відомості..................................................................... 43 3.1.2 Фізичні процеси в бездрейфовом біполярному....................... 46 транзисторі при роботі в активному режимі.................................... 46 3.2 Статичні характеристики біполярних транзисторів...................... 49 3.2.1 Схема із загальною базою........................................................ 50 3.2.2 Схема із загальним емітером.................................................... 51 3.2.3 Вплив температури на статичні характеристики БТ............... 53 3.3 Диференціальні параметри біполярного транзистора.................. 54 3.4 Лінійна (малосигнальна) модель біполярного транзистора......... 55 3.5 Частотні властивості біполярного транзистора............................. 58 3.6 Способи поліпшення частотних властивостей біполярних транзисторів 59 3.7 Робота транзистора в підсилювальному режимі........................... 61 3.8 Особливості роботи транзистора в імпульсному режимі.............. 63 3.8.1 Робота транзистора в режимі посилення імпульсів малої амплітуди 63 3.8.2 Робота транзистора в режимі перемикання............................. 63 3.8.3 Перехідні процеси при перемиканні транзистора................... 64 4 ПОЛЬОВІ ТРАНЗИСТОРИ................................................................... 67 4.1 Польовий транзистор з p-n переходом.......................................... 67 4.2 Польовий транзистор з ізольованим затвором.............................. 71 (МДП-транзистор)................................................................................. 71
ОСНОВИ ТЕОРІЇ ЕЛЕКТРОПРОВІДНОСТІ НАПІВПРОВІДНИКІВ
ЗАГАЛЬНІ ВІДОМОСТІ ПРО НАПІВПРОВІДНИКИ СТРУМИ В НАПІВПРОВІДНИКАХ
Дрейфовий струм
У напівпровідниках вільні електрони і дірки знаходяться в стані хаотичного руху. Тому, якщо вибрати довільний перетин усередині об'єму напівпровідника і підрахувати число носіїв заряду, що проходять через цей перетин за одиницю часу зліва направо і справа наліво, значення цих чисел виявляться однаковими. Це означає, що електричний струм в даному об'ємі напівпровідника відсутній. При приміщенні напівпровідника в електричне поле напруженістю Е на хаотичний рух носіїв зарядів накладається складова направленого руху. Направлений рух носіїв зарядів в електричному полі обумовлює появу струму, званого дрейфовим (Рисунок 1.6, а) Із-за зіткнення носіїв зарядів з атомами кристал- лической грат їх рух у напрямі дії електричного поля
переривисто і характеризується рухливістю m. Рухливість рівна середній швидкості
Рухливість носіїв зарядів залежить від механізму їх розсіювання в кристалічній решітці. Дослідження показують, що рухливості електронів mn і дірок p мають різне значення (n > mp) і визначаються температурою і концентрацією домішок. Збільшення температури приводить до зменшення рухливості, що залежить від числа зіткнень носіїв зарядів в одиницю часу. Щільність струму в напівпровіднику, обумовленого дрейфом вільних електронів під дією зовнішнього електричного поля з середньою швидкістю, Переміщення (дрейф) дірок у валентній зоні з середньою швидкістю Підставляючи у вираз для щільності струму співвідношення для середньої швидкості електронів і дірок (1.11), одержуємо
Якщо порівняти вираз (1.12) із законом Ома j =sЕ, то питома електропровідність напівпровідника визначається співвідношенням
У напівпровідника з власною електропровідністю концентрація електронів рівна концентрації дірок (ni = pi), і його питома електропровідність визначається виразом
У напівпровіднику n-типу
У напівпровіднику р-типу
У області високих температур концентрація електронів і дірок значно зростає за рахунок розриву ковалентних зв'язків і, не дивлячись на зменшення їх рухливості, електропровідність напівпровідника збільшується по експоненціальному закону.
Дифузійний струм
Окрім теплового збудження, що приводить до виникнення рівноважної концентрації зарядів, рівномірно розподілених за об'ємом напівпровідника, збагачення напівпровідника електронами до концентрації np і дірками до концентрації pn може здійснюватися його освітленням, опромінюванням потоком заряджених частинок, введенням їх через контакт (інжекцією) і т.д. В цьому випадку енергія збудника передається безпосередньо носіям заряду і теплова енергія кристалічної решітки залишається практично постійною. Отже, надмірні носії заряду не знаходяться в тепловій рівновазі з гратами і тому називаються нерівноважними. На відміну від рівноважних вони можуть нерівномірно розподілятися за об'ємом напівпровідника (рисунок 1.6, би) Після припинення дії збудника за рахунок рекомбінації електронів і дірок концентрація надмірних носіїв швидко убуває і досягає рівноважного значення. Швидкість рекомбінації нерівноважних носіїв пропорційна надмірній концентрації дірок (pn -
де tp - час життя дірок; tn - час життя електронів. За час життя концентрація нерівноважних носіїв зменшується в 2,7 разу. Час життя надмірних носіїв складає 0,01...0,001 с. Носії зарядів рекомбінують в об'ємі напівпровідника і на його поверхні. Нерівномірний розподіл нерівноважних носіїв зарядів супроводжується їх дифузією у бік меншої концентрації. Цей рух носіїв зарядів обумовлює проходження електричного струму, званого дифузійним (рисунок 1.6, би). Розглянемо одновимірний випадок. Хай в напівпровіднику концентрації електронів n(x) і дірок p(x) є функціями координати. Це приведе до дифузійного руху дірок і електронів з області з більшою їх концентрацією в область з меншою концентрацією. Дифузійний рух носіїв зарядів обумовлює проходження дифузійного струму електронів і дірок, щільність яких визначається із співвідношень:
де dn(x) /dx, dp(x) /dx - градієнти концентрацій електронів і дірок; Dn, Dp - коефіцієнти дифузії електронів і дірок. Градієнт концентрації характеризує ступінь нерівномірності розподілу зарядів (електронів і дірок) в напівпровіднику уздовж якогось вибраного напряму (в даному випадку уздовж осі x). Коефіцієнти дифузії показують кількість носіїв заряду, що перетинають в одиницю часу одиничний майданчик, перпендикулярний до вибраного напряму, при градієнті концентрації в цьому напрямі, рівному одиниці. Коефіцієнти дифузії зв'язані з подвижностями носіїв зарядів співвідношеннями Ейнштейна:
Знак "мінус" у виразі (1.14) означає протилежну спрямованість електричних струмів в напівпровіднику при дифузійному русі електронів і дірок у бік зменшення їх концентрацій. Якщо в напівпровіднику існує і електричне поле, і градієнт концентрації носіїв, струм, що проходить, матиме дрейфову і дифузійну складові. У такому разі щільність струмів розраховується по наступних рівняннях:
КОНТАКТНІ ЯВИЩА
Ємності p-n переходу
Зміна зовнішньої напруги dU на p-n переході приводить до зміни накопиченого в ньому заряду dQ. Тому p-n перехід поводиться подібно до конденсатора, ємність якого З = dQ/ dU. Залежно від фізичної природи заряду, що змінюється, розрізняють ємності бар'єрну (зарядну) і дифузійну. Бар'єрна (зарядна) ємність визначається зміною заряду іонів, що не компенсується, при зміні ширини замикаючого шару під впливом зовнішньої зворотної напруги. Тому ідеальний електронно-дірковий перехід можна розглядати як плоский конденсатор, ємність якого визначається співвідношенням
де П, d - відповідно площа і товщина p-n переходу. Із співвідношень (1.41) і (1.31) слідує
У загальному випадку залежність зарядної ємності від прикладеної до p-n переходу зворотної напруги виражається формулою
де C0 — ємність p-n переходу при UОБР = 0; g - коефіцієнт, залежний типу p-n переходу (для різких p-n переходів = 1/2, а для плавних g = 1/3). Бар'єрна ємність збільшується із зростанням NА і NД, а також із зменшенням зворотної напруги. Характер залежності СБАР = f(UОБР) показаний на рис. 1.13,а. Розглянемо дифузійну ємність. При збільшенні зовнішньої напруги, прикладеної до p-n переходу в прямому напрямі, росте концентрація инжектированных носіїв поблизу меж переходу, що приводить до зміни кількості заряду, обумовленого неосновними носіями в p- і n-областях. Це можна розглядати як прояв деякої ємності. Оскільки вона залежить від зміни дифузійної складової струму, її називають дифузійною. Дифузійна ємність є відношенням приросту інжекційного заряду dQинж до зміни напруги dUпр, що викликала його, тобто. .
Рисунок 1.13 Залежність бар'єрної (а) і дифузійної (б) місткостей p-n переходу від напруги.
Тоді дифузійна ємність, обумовлена зміною загального заряду нерівноважних дірок в n-області, визначиться по формулі
Аналогічно для дифузійної ємності, обумовленою інжекцією електронів в p-область
Рисунок 1.13 Еквівалентна схема p-n переходу.
Загальна дифузійна ємність
Залежність ємності від прямої напруги на p-n переході показана на рисунку 1.13, би. Повна ємність p-n переходу визначається сумою зарядної і дифузійної місткостей:
При включенні p-n переходу в прямому напрямі переважає дифузійна ємність, а при включенні у зворотному напрямі - зарядна. На рис. 1.14 приведена еквівалентна схема p-n переходу по змінному струму. Схема містить диференціальний опір p-n переходу rД, дифузійну ємність СДИФ, бар'єрну ємність СБАР і опір об'єму p- і n-областей r1. На підставі рівняння (1.37) можна записати:
Якщо при прямому включенні p-n переходу Uпр >> jт, то:
При кімнатній температурі (у співвідношенні (1.42) значення струму підставляється в амперах). Опір витоку rУТ враховує можливість проходження струму по поверхні кристала із-за недосконалості його структури. При прямому включенні p-n переходу СБАР << СДИФ, диференціальний опір rД ПР мало і сумірно з r1, тому еквівалентна схема приймає вигляд, показаний на рис. 1.15, а.
Рисунок 1.15 Спрощені еквівалентні схеми p-n переходу.
При зворотному зсуві rД ОБР >> r1, СБАР >> СДИФ і еквівалентна схема має вигляд, показаний на рис. 1.15, би.
Гетероперехіди
Гетероперехід утворюється двома напівпровідниками, що розрізняються шириною забороненої зони. Параметри кристалічних решіток напівпровідників, що становлять гетероперехід, повинні бути близькі, що обмежує вибір матеріалів. В даний час найбільш дослідженими є пари: германій-арсенід галію, арсенід галлия-мышьяковидный індій, германій-кремній. Розрізняють n-p і p-n гетероперехіди (на перше місце ставиться буква, що позначає тип електропровідності напівпровідника з вужчою забороненою зоною). На основі гетероперехідів можливо також створення структур n-n і p-p.
Рисунок 1.16 Спрощена енергетична діаграма p-n гетероперехіда в рівноважному стані.
На рисунку 1.16 приведена спрощена енергетична діаграма n-p переходу між арсенідом галію р-типу (DWP = 1,5 эВ) і германієм n-типу (DWn = 0,67 эВ) в стані рівноваги (U = 0). При контакті напівпровідників відбувається перерозподіл носіїв зарядів, що приводить до вирівнювання рівнів Фермі p- і n-областей і виникненню енергетичного бар'єру для електронів n-області qUkn і. для дірок p-області qUкp, причому Uкn > Uкp.
Рисунок 1.17 Спрощена енергетична діаграма p-n гетероперехіда, включеного в прямому стані.
В стані рівноваги струм через n-p перехід рівний нулю. Оскільки потенційні бар'єри для дірок і електронів різні, при додатку до гетероперехіда прямої напруги зсуву він забезпечить ефективну інжекцію дірок з напівпровідника з більшою шириною забороненої зони (рис. 1.17).
Омічні контакти
Омічними називають контакти, опір яких не залежить від величини і напряму струму. Іншими словами, це контакти, що володіють практично лінійною вольт-амперною характеристикою. Омічні контакти забезпечують з'єднання напівпровідника з металевими струмопровідними елементами напівпровідникових приладів. Окрім лінійності вольт-амперної характеристики, ці контакти повинні мати малий опір і забезпечувати відсутність інжекції носіїв з металів в напівпровідник. Ці умови виконуються шляхом введення між напівпровідником робочої області кристала і металом напівпровідника з підвищеною концентрацією домішки (рис. 1.19). Контакт між напівпровідниками з однаковим типом електропровідності є таким, що не випрямляє і низькоомним. Метал вибирають так, щоб забезпечити малу контактну різницю потенціалів. Одним із способів отримання омічних контактів є введення в метал домішки, якій легований напівпровідник. В цьому випадку при сплаві металу з напівпровідником в контактній області утворюється тонкий шар виродженого напівпровідника, що відповідає структурі, зображеній на рис. 1.19.
Рисунок 1.19 Структура омічного контакту.
НАПІВПРОВІДНИКОВІ ДІОДИ Класифікація
Класифікація напівпровідникових діодів проводиться за наступними ознаками: - методу виготовлення переходу: сплавні, дифузійні, планарные, точкові, діоди Шотки і др.; - матеріалу: германієві, кремнієві, арсенидо-галієві і др.; - фізичним процесам, на використанні яких заснована робота діода: тунельні, лавинно-пролітні, фотодіоди, світлодіоди. діоди Ганна і др.; - призначенню: випрямні, універсальні, імпульсні, стабілітрони, детекторні, параметричні, змішувачі, СВЧ-діоди і ін. Деякі з вказаних типів діодів за призначенням будуть розглянуті в справжньому розділі, а інші - у відповідних розділах навчального посібника.
Випрямні діоди
Випрямними звичайно називають діоди, призначені для перетворення змінної напруги промислової частоти (50 або 400 Гц) в постійне. Основою діода є звичайний p-n перехід. У практичних випадках p-n перехід діода має достатню площу для того, щоб забезпечити великий прямий струм. Для отримання великих зворотних (пробивних) напруг діод звичайно виконується з високоомного матеріалу. Основними параметрами, що характеризують випрямні діоди, є (рисунок 2.1): - максимальний прямий струм Iпр max; - падіння напруги на діоді при заданому значенні прямого струму Iпр (Uпр» 0.3...0,7 В для германієвих діодів і Uпр» 0,8...1,2 В -для кремнієвих); - максимально допустима постійна зворотна напруга діода Uобр max; - зворотний струм Iобр при заданій зворотній напрузі Uобр (значення зворотного струму германієвих діодів на два -три порядки більше, ніж у кремнієвих); - бар'єрна ємність діода при подачі на нього зворотної напруги деякої величини; - діапазон частот, в якому можлива робота діода без істотного зниження випрямленого струму; - робочий діапазон температур (германієві діоди працюють в діапазоні -60...+70°С, кремнієві - в діапазоні -60...+150°С, що пояснюється малими зворотними струмами кремнієвих діодів).
Рисунок 2.1 До визначення параметрів випрямних діодів.
Випрямні діоди звичайно підрозділяються на діоди малої, середньої і великої потужності, розраховані на випрямлений струм до 0.3, від 0,3 до 10 і понад 10 А відповідно. Для роботи на високих напругах (до 1500 В) призначені випрямні стовпи, що є послідовно сполученими p-n переходами, конструктивно об'єднаними в одному корпусі. Випускаються також випрямні матриці і блоки, що мають в одному корпусі по чотири або вісім діодів, що сполучені по мостовій схемі випрямляча і мають Iпр max до 1 А і Uo6p max до 600 В. При протіканні великих прямих струмів Iпр і певному падінні напруги на діоді Uпp B йому виділяється велика потужність. Для відведення даної потужності діод повинен мати великі розміри p-n переходу, корпусу і висновків. Для поліпшення теплоотвода використовуються радіатори або різні способи примусового охолоджування (повітря або навіть водяне). Серед випрямних діодів слід виділити особливо діод з бар'єром Шотки. Цей діод характеризується високою швидкодією і малим падінням напруги (Uпp < 0,6 В). До недоліків діода слід віднести малу пробивну напругу і великі зворотні струми.
Стабілітрони і стабістори
Стабілітроном називається напівпровідниковий діод, на зворотній гілці ВАХ якого є ділянку з сильною залежністю струму від напруги (рисунок 2.2), тобто з великим значенням крутизни DI/U (DI= Icт max - Iст min). Якщо така ділянка відповідає прямій гілці ВАХ, то прилад називається стабістором. Стабілітрони використовуються для створення стабілізаторів напруги. Напруга стабілізації Uст рівна напрузі електричного (лавинного) пробою p-n переходу при деякому заданому струмі стабілізації Iст (рисунок). Стабілізуючі властивості характеризуються диференціальним опором стабілітрона rд = DU/ID, яке повинне бути можливо менше.
До До параметрів стабілітрона відносяться: напруга стабілізації Ucт, мінімальний і максимальний струми стабілізації Iст min Iст max. Промисловістю випускаються стабілітрони з параметрами: Ucт від 1,5 до 180 В, струми стабілізації від 0,5 мА до 1,4 А. Випускаються також двоханодні стабілітрони, що служать для стабілізації різнополярних напруг і є стрічно включеними p-n переходами.
Рисунок 2.2 До визначення параметрів стабілітронів.
Варікапи
Варікапом називається напівпровідниковий діод, використовуваний як електрично керована ємність з достатньо високою добротністю в діапазоні робочих частот. У ньому використовується властивість p-n-переходу змінювати бар'єрну ємність під дією зовнішньої напруги (рисунок 2.4). Основні параметри варікапа: номінальна ємність СН при заданому номінальною напругою UН (звичайно 4 В), максимальне зворотне напря- жение Uобр max і добротність Q. Для збільшення добротності варікапа використовують бар'єр Шотки; ці варикапы мають малий опір втрат, оскільки як один з шарів діода використовується метал.
Р Рисунок 2.4 Залежність ємності варікапа від напруги.
Основне застосування варикапов - електрична перебудова частоти коливальних контурів. В даний час існує декілька різновидів варикапов, вживаних в різних пристроях безперервної дії. Це параметричні діоди, призначені для посилення і генерації СВЧ-сигналів, і умножительные діоди, призначені для множення частоти в широкому діапазоні частот. Іноді в умножительных діодах використовується і дифузійна ємність. 3 БІПОЛЯРНІ ТРАНЗИСТОРИ
Загальні відомості Біполярним транзистором (БТ) називається трьохелектродний напівпровідниковий прилад з двома взаємодіючими p-n переходами, призначений для посилення електричних коливань по струму, напрузі або потужності. Слово “біполярний” означає, що фізичні процеси в БТ визначаються рухом носіїв заряду обох знаків (електронів і дірок). Взаємодія переходів забезпечується тим, що вони розташовуються достатньо близько - на відстані, меншому дифузійної довжини. Два p-n-переходи утворюються в результаті чергування областей з різним типом електропровідності. Залежно від порядку чергування розрізняють БТ типа n-p-n (або із структурою n-p-n) і типу p-n-p (або із структурою p-n-p), умовні зображення яких показані на рисунку 3.1.
Структура реального транзистора типу n-p-n зображена на рисунку 3.2. У цій структурі існують два переходи з неоднаковою площею: площа лівого переходу n1+-p менше, ніж у переходу n2-p. Крім того, у більшості БТ одна з крайніх областей (n1 з меншою площею) перетину легована набагато сильніше, ніж інша крайня область (n2).
Рисунок 3.2 Структура реального БТ типу n-p-n.
Сильнолегированная область позначена верхнім індексом “+” (n+). Тому БТ є асиметричним приладом. Асиметрія відображається і в назвах крайніх областей: сильнолегированная область з меншою площею (n1+) називається емітером, а область n2 - колектором. Відповідно область (p) називається базовою (або базою). Права область n+ служить для перехід n1+-р називають емітерним, а n2-p колекторним. Середня зниження опору колектора. Контакти з областями БТ позначені на малюнках 3.1 і 3.2 буквами: Э - емітер; Би - база; К- колектор. Основні властивості БТ визначаються процесами в базовій області, яка забезпечує взаємодію емітерного і колекторного переходів. Тому ширина базової області повинна бути малою (звичайно менше 1 мкм). Якщо розподіл домішки в базі від емітера до колектора однорідне (рівномірне), то в ній відсутнє електричне поле і носії здійснюють в базі тільки дифузійний рух. У разі нерівномірного розподілу домішки (неоднорідна база) в базі існує “внутрішнє” електричне поле, що викликає появу дрейфового руху носіїв: результуючий рух визначається як дифузією, так і дрейфом. БТ з однорідною базою називають бездрейфовыми, а з неоднорідною базою - дрейфовими. Біполярний транзистор, що є триполюсним приладом, можна використовувати в трьох схемах включення: із загальною базою (Про) (рисунок 3.3,а), загальним емітером (ОЭ) (рисунок 3.3,б), і загальним колектором (ОК) (рисунок 3.3,в). Стрілки на умовних зображеннях БТ указують (як і на рисунку 3.1) напрям прямого струму емітерного переходу. У позначеннях напруг друга буква індексу позначає загальний електрод для двох джерел живлення. У загальному випадку можливо чотири варіанти полярностей напруги переходів, що визначають чотири режими роботи транзистора. Вони одержали назви: нормальний активний режим, інверсний активний режим, режим насичення (або режим двосторонньої інжекції) і режим відсічення.
У нормальному активному режимі (НАР) на емітерному переході діє пряма напруга (напруга емітер - база UЭБ), а на колекторному переході - зворотне (напруга колектор - база UКБ). Цьому режиму відповідають полярності джерел живлення на рисунку 3.4 і напрями струмів для p-n-p транзистора. У разі n-p-n транзистора полярності напруги і напряму струмів змінюються на протилежні.
Рисунок 3.4 Фізичні процеси в БТ.
Цей режим роботи (НАР) є основним і визначає призначення і назву елементів транзистора. Емітерний перехід здійснює інжекцію носіїв у вузьку базову область, яка забезпечує практично без втрат переміщення инжектированных носіїв до колекторного переходу. Колекторний перехід не створює потенційного бар'єру для носіїв, що підійшли, стали неосновними носіями заряду в базовій області, а, навпаки, прискорює їх і тому переводить ці носії в колекторну область. “Збірна” здатність цього переходу і зумовила назву “колектор”. Колектор і емітер можуть помінятися ролями, якщо на колекторний перехід подати пряму напругу UКБ, а на емітерний -обратное UЭБ. Такий режим роботи називається інверсним активним режимом (ИАР). В цьому випадку транзистор “працює” у зворотному напрямі: з колектора йде інжекція дірок, які проходять через базу і збираються емітерним переходом, але при цьому його параметри відрізняються від первинних. Режим роботи, коли напруги на емітерному і колекторному переходах є прямими одночасно, називають режимом двосторонньої інжекції (РДИ) або менш вдало режимом насичення (РН). В цьому випадку і емітер, і колектор инжектируют носії заряду в базу назустріч один одному і одночасно кожний з переходів збирає носії, що приходять до нього від іншого переходу. Нарешті, режим, коли на обох переходах одночасно діють зворотні напруги, називають режимом відсічення (РО), оскільки в цьому випадку через переходи протікають малі зворотні струми. Слід підкреслити, що класифікація режимів проводиться по комбінації напруг переходів, В схемі включення із загальною базою (Про) вони рівні напругам джерел живлення UЭБ і UКБ. У схемі включення із загальним емітером (ОЭ) напруга на емітерному переході визначається напругою першого джерела (UЭБ = -UБЭ), а напруга колекторного переходу залежить від напруг обох джерел і за загальним правилом визначення різниці потенціалів UКБ = UКЭ + UЭБ. Оскільки UЭБ = -UБЭ, то UКБ = UКЭ - UБЭ; при цьому напругу джерел живлення треба брати з своїм знаком: позитивним, якщо до електроду приєднаний позитивний полюс джерела, і негативним - в іншому випадку. У схемі включення із загальним колектором (ОК) напруга на колекторному переході визначається одним джерелом: UКБ = -UБК. Напруга на емітерному переході залежить від обох джерел: UЭБ = UЭК + UКБ = UЭК - UБК, при цьому правило знаків колишнє. Схема із загальною базою
Сімейство вхідних характеристик схеми з Про є залежністю IЭ = f(UЭБ) при фіксованих значеннях параметра UКБ - напруги на колекторному переході (рисунок 3.5,а).
При UКБ = 0 характеристика подібна ВАХ p-n-переходу. Із зростанням зворотної напруги UКБ (UКБ < 0 для p-n-p-транзистора) унаслідок зменшення ширини базової області (ефект Эрли) відбувається зсув характеристики вгору: IЭ росте при вибраному значенні UЭБ. Якщо підтримується постійним струм емітера (IЭ = const), тобто градієнт концентрації дірок в базовій області залишається тим самим, то необхідно знизити напругу UЭБ (характеристика зрушується вліво). Слід відмітити, що при UКБ < 0 і UЭБ = 0 існує невеликий струм емітера IЭ0, який стає рівним нулю тільки при деякій зворотній напрузі UЭБ0. Сімейство вихідних характеристик схеми з Про є залежності IК = f(UКБ) при заданих значеннях параметра IЭ (рисунок 3.5,б). Вихідна характеристика p-n-p-транзистора при IЭ = 0 і зворотній напрузі |UКБ < 0| подібна зворотній гілці p-n-переходу (діода). При цьому відповідно до (3.11) IК = IКБО, тобто характеристика є зворотним струмом колекторного переходу, протікаючий в ланцюзі колектор - база. При IЭ > 0 основна частина инжектированных в базу носіїв (дірок в p-n-p транзисторі) доходить до межі колекторного переходу і створює колекторний струм при UКБ = 0 в результаті прискорюючого дії контактної різниці потенціалів. Струм можна зменшити до нуля шляхом подачі на колекторний перехід прямої напруги певної величини. Цей випадок відповідає режиму насичення, коли існують стрічні потоки инжектированных дірок з емітера в базу і з колектора в базу. Результуючий струм стане рівний нулю, коли обидва струми однакові по величині (наприклад, крапка А' на рисунок 3.5,б). Чим більший заданий струм IЭ, тим більша пряма напруга UКБ потрібна для отримання IК = 0. Область в першому квадранті на рис. 3.5,б, де UКБ < 0 (зворотне) і параметр IЭ > 0 (що означає пряму напругу UЭБ) відповідає нормальному активному режиму (НАР). Значення колекторного струму в НАР визначається формулою (3.11) IК = aIЭ + IКБО. Вихідні характеристики зміщуються вгору при збільшенні параметра IЭ. У транзисторі, що ідеалізується, не враховується ефект Эрли, тому інтегральний коефіцієнт передачі струму можна вважати постійним, не залежним від значення |UКБ|. Отже, в тому, що ідеалізується БТ вихідні характеристики опиняються горизонтальними (IК = const). Реально ж ефект Эрли при зростанні |UКБ| приводить до зменшення втрат на рекомбінацію і зростанню. Оскільки значення a близько до одиниці, те відносне збільшення а дуже мало і може бути виявлено тільки вимірюваннями. Тому відхилення вихідних характеристик від горизонтальних ліній вгору “на око” не помітно (на рисунку 3.5,б не дотриманий масштаб).
Схема із загальним емітером
Сімейство вхідних характеристик схеми з ОЭ є залежності IБ = f(UБЭ), причому параметром є напруга UКЭ (рисунок 3.6,а). Для p-n-p транзистора негативна напруга UБЭ (UБЭ < 0) означає
пряме включення емітерного переходу, оскільки UЭБ = -UБЭ > 0. Якщо при цьому UКЭ = 0 (потенціали колектора і емітера однакові), то і колекторний перехід буде включений в прямому напрямі: UКБ = UКЭ + UЭБ = UЭБ > 0. Тому вхідна характеристика при UКЭ = 0 відповідатиме режиму насичення (РН), а струм бази рівним сумі базових струмів із-за одночасної інжекції дірок з емітера і колектора. Цей струм, природно, збільшується із зростанням прямої напруги UЭБ, оскільки воно приводить до посилення інжекції в обох переходах (UКБ = UЭБ) і відповідному зростанню втрат на рекомбінацію, що визначають базовий струм. Друга характеристика на рисунку 3.6,а (UКЭ á0) відноситься до нормального активного режиму, для отримання якого напруга UКЭ повинна бути в p-n-p транзисторі негативним і по модулю перевищувати напругу UЭБ. В цьому випадку (UКБ = UКЭ + UЭБ = UКЭ - UБЭ < 0. Формально хід вхідної характеристики в НАР можна пояснити за допомогою виразу (3.14) або (3.17): IБ =(1 - a)IЭ - IКБО. При малій напрузі UБЭ інжекція носіїв практично відсутній (IЭ = 0) і струм IБ = -IКБО, тобто негативний. Збільшення прямої напруги на емітерному переході UЭБ = -UБЭ викликає зростання IЭ і величини (1 -) IЭ. Коли (1 - a) IЭ = IКБО, струм IБ = 0. При подальшому риєте UБЭ (1 - a) IЭ > IКБО і IБ міняє напрям і стає позитивним (IБ > 0) і сильно залежним від напруги переходу. Вплив UКЭ на IБ в НАР можна пояснити тим, що зростання |UКЭ| означає зростання |UКБ| і, отже, зменшення ширини базової області (ефект Эрли). Останнє супроводжуватиметься зниженням втрат на рекомбінацію, тобто зменшенням струму бази (зсув характеристики трохи вниз). Сімейство вихідних характеристик схеми з ОЭ є залежності IК = f(UКЭ) при заданому параметрі IБ (рисунок 3.6,б). Круті початкові ділянки характеристик відносяться до режиму насичення, а ділянки з малим нахилом - до нормального активного режиму. Перехід від першого режиму до другого, як вже наголошувалося, відбувається при значеннях |UКЭ|, що перевищують |UБЭ|. На характеристиках як параметр береться не напруга UБЭ, а вхідний струм IБ. Тому про включення емітерного переходу доводиться судити по значенню струму IБ, який пов'язаний з вхідною характеристикою на рисунку 3.6,а. Для збільшення IБ необхідно збільшувати |UБЭ|, отже, і межа між режимом насичення і нормальним активним режимом повинна зрушуватися у бік велики
|
|||||||||||||||||||||||||||
|
Последнее изменение этой страницы: 2016-06-19; просмотров: 705; Нарушение авторского права страницы; Мы поможем в написании вашей работы! infopedia.su Все материалы представленные на сайте исключительно с целью ознакомления читателями и не преследуют коммерческих целей или нарушение авторских прав. Обратная связь - 216.73.217.89 (0.017 с.) |


 , що набуває носіями заряду у напрямі дії електричного поля напруженістю Е = 1 В/м, тобто
, що набуває носіями заряду у напрямі дії електричного поля напруженістю Е = 1 В/м, тобто . (1.11)
. (1.11) визначається виразом.
визначається виразом. 
 створює в напівпровіднику дірковий струм, щільність якого.
створює в напівпровіднику дірковий струм, щільність якого.  Отже, повна щільність струму в напівпровіднику містить електронну jn і діркову jр складові і рівна їх сумі (n і p — концентрації відповідно електронів і дірок).
Отже, повна щільність струму в напівпровіднику містить електронну jn і діркову jр складові і рівна їх сумі (n і p — концентрації відповідно електронів і дірок). (1.12)
(1.12) .
. .
. >
>  , і його питома електропровідність з достатнім ступенем точності може бути визначена виразом
, і його питома електропровідність з достатнім ступенем точності може бути визначена виразом .
. , і питома електропровідність такого напівпровідника
, і питома електропровідність такого напівпровідника
 ) або електронів (np -
) або електронів (np -  ;
;  ,
, ; (1.13)
; (1.13)  ; (1.14)
; (1.14) ;
;  .
. ;
;  .
. (1.41)
(1.41) .
. ,
, Скориставшись рівнянням (1.30), можна визначити заряд инжектированных носіїв, наприклад дірок в n-області:
Скориставшись рівнянням (1.30), можна визначити заряд инжектированных носіїв, наприклад дірок в n-області:
 .
. .
. .
.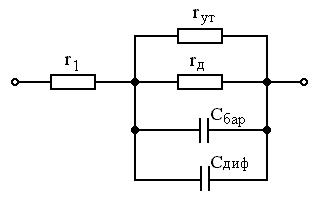
 .
. .
. .
. ;
;  .
. ; (1.42)
; (1.42)