
Заглавная страница Избранные статьи Случайная статья Познавательные статьи Новые добавления Обратная связь FAQ Написать работу КАТЕГОРИИ: ТОП 10 на сайте Приготовление дезинфицирующих растворов различной концентрацииТехника нижней прямой подачи мяча. Франко-прусская война (причины и последствия) Организация работы процедурного кабинета Смысловое и механическое запоминание, их место и роль в усвоении знаний Коммуникативные барьеры и пути их преодоления Обработка изделий медицинского назначения многократного применения Образцы текста публицистического стиля Четыре типа изменения баланса Задачи с ответами для Всероссийской олимпиады по праву 
Мы поможем в написании ваших работ! ЗНАЕТЕ ЛИ ВЫ?
Влияние общества на человека
Приготовление дезинфицирующих растворов различной концентрации Практические работы по географии для 6 класса Организация работы процедурного кабинета Изменения в неживой природе осенью Уборка процедурного кабинета Сольфеджио. Все правила по сольфеджио Балочные системы. Определение реакций опор и моментов защемления |
Механизм накопления поверхностных состоянийСодержание книги
Поиск на нашем сайте В настоящее время механизм накопления ПС значительно менее ясен, чем механизм накопления и нейтрализации заряда в оксиде. Было предложено несколько различных механизмов накопления ПС, включая прямое создание ПС ионизирующим излучением, создание ПС вследствие захвата дырок или накопление ПС посредством вторичных механизмов. Можно считать, что прямое создание ПС ионизирующим излучением не дает существенного вклада в общее накопление ПС: в экспериментах по ультрафиолетовому (УФ) облучению в вакууме было показано [54–56], что ПС могут быть созданы непроникающей радиацией. В этих экспериментах конденсаторы с тонким металлическим затвором облучались в вакууме сверху непроникающим УФ-излучением. Все излучение поглощалось в верхней части оксида и не достигало границы Si/SiO2. Однако при подаче положительного смещения наблюдалось накопление ПС, схожее со случаем воздействия проникающей радиации (высокоэнергетическое гамма-излучение). Эти эксперименты подтвердили, что напрямую ионизирующим излучением создается лишь незначительное количество ПС. Кроме того, из этих экспериментов следует, что необходимым условием накопления ПС является генерация электронно-дырочных пар в объеме оксида и последующий перенос дырок через оксид. Роль переноса дырок в накоплении ПС понятна не совсем хорошо. В п. 3.3.6 говорилось, что накопление ПС протекает в течение относительно длительного времени: от единиц до тысяч секунд. С другой стороны в случае тонких подзатворных оксидов дырки могут переноситься через оксид в течение микросекунд. Таким образом, время накопления ПС на много порядков величины больше, чем время, связанное с переносом дырок. Накопление ПС не зависит только от захвата дырок на границе. Объяснение роли переноса дырок в накоплении ПС впервые было дано в работах Свенсона и позже в работах Винокура с соавторами МакЛина [13, 57, 58]. Свенсон был первым, предложившим двухстадийную модель накопления ПС. На первой стадии генерированные радиацией дырки разрывают связи Si–H в объеме оксида, высвобождая нейтральные междоузельные атомы водорода. На второй стадии накопления, освобожденные атомы водорода свободно диффундируют к границе Si/SiO2 и разрывают связи Si–H на границе, образуя оборванные связи кремния (поверхностные состояния) и молекулярный водород. Эта модель объясняет медленное накопление ПС, однако она не согласуется с имеющимися экспериментальными данными о зависимости накопленного заряда ПС от приложенного напряжения смещения. В случае диффузионных процессов накопление ПС не должно зависеть от смещения. Указанное противоречие было разрешено Винокуром и МакЛином, также предложившими модифицированную двухстадийную модель. Первая стадия в модели Винокура и МакЛина схожа с первой стадией модели Свенсона. При подаче смещения (как положительного, так и отрицательного) генерированные радиацией дырки могут переноситься посредством перескакивания поляронов как по направлению к границе Si/SiO2, так и по направлению к границе затвор/SiO2. Перемещаясь по оксиду или захватываясь, они могут высвободить путем локального возбуждения достаточную для разрыва напряженных связей Si–O или слабых связей трехвалентного кремния с Н или ОН энергию (~ 5 эВ). Однако, в отличие от модели Свенсона, модель Винокура и МакЛина предполагает, что вместо высвобождения нейтральных атомов водорода, при разрыве связей высвобождаются заряженные ионы. В большинстве своем высвобождаемые ионы — это ионы водорода [13]. На второй стадии накопления при подаче положительного смещения ионы дрейфуют к границе Si/SiO2. Достигнув границы, они могут быстро разрывать как связи Si–H, так и связи Si–OH, образуя ПС. В этой модели кинетика накопления определяется временем дрейфа положительно заряженных ионов к границе Si/SiO2, и накопление ПС будет происходить только при положительном напряжении на затворе, что согласуется с экспериментальными данными. Величина накопления Несмотря на то, что модель Винокура и МакЛина может объяснить зависимость накопления ПС от времени, она не согласуется с экспериментальными данными по зависимости накопления ПС от электрического поля в приборах с поликремниевым затвором и в некоторых приборах с металлическим затвором. В модели Винокура и МакЛина ионы высвобождаются при транспортировке дырок через оксид посредством перескакивания поляронов. По мере того, как дырки перемещаются по объему оксида, можно ожидать [58], что повышение напряженности электрического поля приведет к повышению энергии, передаваемой дырками решетке SiO2, что повышает вероятность высвобождения иона и, следовательно, образования ПС. Таким образом, согласно модели Винокура и МакЛина, накопление ПС должно усиливаться с увеличением напряженности электрического поля. Такая зависимость наблюдалась на конденсаторах с алюминиевым затвором [46]. Однако, как указывалось в п. 3.3.6, в случае транзисторов с поликремниевым затвором накопление ПС спадает с ростом напряженности поля приблизительно по закону Е –0,6. Эта зависимость от электрического поля также наблюдалась в некоторых транзисторах с металлическим затвором [24]. Моделью, которая может объяснить такую зависимость от электрического поля, является модель «захвата дырок / переноса водорода» ((НТ)2 — hole-trapping / hydrogen transport), предложенная Шанифельтом с соавторами [44]. Согласно модели (НТ)2, при положительном смещении во время облучения дырки переносятся к границе Si/SiO2 и захватываются вблизи границы. При захвате дырок или позже при их нейтрализации высвобождаются приграничные ионы водорода, которые переносятся к границе Si/SiO2, взаимодействуют там и образуют поверхностные ловушки. Согласно модели Шанифельта, стадией, определяющей скорость накопления ПС, является скорость, с которой ионы водорода дрейфуют к границе и взаимодействуют там. В соответствии с данной моделью зависимость от электрического поля преимущественно определяется сечением захвата дырок вблизи границы. Как было показано, оно зависит от электрического поля приблизительно по закону Е –1/2. Таким образом, модель Шанифельта корректно предсказывает наблюдаемую экспериментально зависимость от электрического поля. Если накопление ПС является следствием захвата дырок вблизи границы Si/SiO2, то для существенной зависимости скорости накопления ПС от толщины подзатворного оксида не должно быть очевидных причин [13, 42, 44, 59]. За исключением очень толстых оксидов, перенос дырок заканчивается в течение миллисекунд после облучения. Таким образом, для умеренно толстых или тонких оксидов перенос дырок заканчивается до того, как начинается значительное накопление ПС. Однако если накопление ПС является результатом дрейфа ионов водорода, генерированных в объеме оксида, то чем толще будет оксид, тем дольше ионы водорода будут дрейфовать к границе Si/SiO2, и скорость накопления ПС будет зависеть от толщины подзатворного диэлектрика. На рис. 3.29 [44] показан график зависимости накопления ПС после облучения от времени для транзисторов с различными толщинами подзатворного оксида, выращенного как в сухом кислороде («сухие оксиды»), так и во влажной среде («влажные оксиды»). При облучении и отжиге подавалось постоянное электрическое поле 1 МВ/см.
Рис. 3.29. Встраивание ПС после облучения транзисторов с поликремниевым затвором: а — транзисторы с «сухим» подзатворным оксидом толщиной от 27,7 до 104 нм; б — транзисторы с «влажным» подзатворным оксидом толщиной от 23,2 до 100 нм
Из рис. 3.29 видно, что в случае транзисторов с сухими оксидами (см. рис. 3.29, а) в первом приближении нет никакой зависимости скорости накопления ПС от толщины подзатворного оксида, что говорит о справедливости модели (НТ)2. В противоположность этому в случае приборов с влажными оксидами кинетика накопления в 100-нанометровых транзисторах сильно отличается от остальных случаев (см. рис. 3.29, б). При длительном времени также наблюдаются отличия в накопленной плотности ПС для всех толщин оксидов. Если предположить, что дырки захватываются вблизи границы, то данные для влажных оксидов не согласуются ни с моделью (НТ)2, ни с моделью Винокура и МакЛина (если считать, что дырки захватываются в объеме оксида, то результаты будут согласовываться с моделью (НТ)2). В данном случае, возможно, имеет место некоторое накопление ПС вследствие захвата дырок вблизи границы и некоторое накопление вследствие дрейфа ионов водорода из объема оксида. Различные дополнительные исследования показали, что зависимость скорости накопления ПС от толщины оксида сильно меняется во времени [42, 59]. В этих работах предполагалось, что в других типах приборов, большинство ионов водорода высвобождается в объеме оксида. Понятно, что для выяснения роли захвата и переноса дырок в процессе накопления ПС требуются дополнительные исследования. Несомненно, что ионы, которые высвобождаются, приводя к образованию ПС, — это почти всегда ионы водорода. Уже давно известно или предполагается, что водород играет ключевую роль в накоплении ПС [13, 15, 16]. Было показано, что количество водорода, присутствующее в газовой среде, в которой проводится высокотемпературные операции при изготовлении приборов, сильно влияет на число радиационно-индуцированных ПС [60]. Вплоть до недавнего времени предполагалось, что при приближении протона к границе Si/SiO2 он будет нейтрализоваться электроном, туннелирующим из кремния, диффундировать к границе и разрывать связи Si–H, образуя поверхностные ловушки. Реакции для этих процессов можно записать в виде H+ + e – ® H; (3.27) H + H–SiºSi3 ® H2 + ·Si–ºSi3, (3.28) где H–SiºSi означает атом кремния, связанный с одним атомом водорода и тремя атомами кремния; ·Si–ºSi означает отрицательно заряженный ион кремния с оборванной связью (поверхностная ловушка), связанный с тремя атомами кремния. Как видно из этих уравнений, первым шагом в реакциях является превращение протона (Н+) в атомарный водород (Н). Далее образуется поверхностная ловушка, так как водород разрывает на границе связь H–Si. Однако касательно этих реакций имеются некоторые трудности. Во-первых, атомарный водород сильно химически активен в SiO2 и при транспортировке менее стабилен, чем Н+ [13, 49]. Во-вторых, Н+ имеет более низкое энергетическое состояние в SiO2, чем Н [13], а следовательно, при первой возможности Н отдаст электрон кремнию, образуя Н+. В последних теоретических расчетах [61, 62] предполагалось, что более вероятным является образование ПС путем прямого взаимодействия протонов на границе Si/SiO2 через H+ + H–SiºSi ® H2 + ·Si+ºSi. (3.29) При подаче положительного смещения положительно заряженная поверхностная ловушка ·Si+ºSi быстро переходит в отрицательно заряженное состояние при захвате электронов из инверсионного слоя в кремнии. Следует заметить, что хотя в деталях модели Винокура и МакЛина и (НТ)2 отличаются, общие положения этих двух моделей сильно схожи. В обеих этих моделях для накопления ПС необходима генерация дырок в оксиде, перенос дырок и высвобождение водорода. Эти две модели в настоящее время представляются наиболее убедительными моделями накопления ПС. Остается не ясным, где именно высвобождается водород: в объеме оксида, вблизи границы Si/SiO2 или имеет место комбинация этих двух процессов. Резюмируя, следует отметить, что детали механизмов накопления ПС все еще требуют уточнения. Однако можно отметить некоторые важные моменты. Во-первых, накопление ПС зависит от генерации электронно-дырочных пар в объеме оксида. Накопление ПС не вызывается напрямую ионизирующим излучением. Во-вторых, накопление ПС некоторым образом связано с переносом дырок и/или захватом как в объеме оксида, так и на ловушках вблизи границы Si/SiO2. В-третьих, высвобождение ионов водорода, по-видимому, во многом, если не полностью, определяет накопление ПС. В-четвертых, накопление ПС зависит от напряжения смещения, при этом при отрицательном смещении затвора наблюдается слабое накопление ПС или оно вообще отсутствует. Граничные ловушки В предыдущих разделах речь шла о двух основных типах заряда, накапливающегося при облучении в МОП-структурах — это заряд, захваченный в оксиде, и заряд поверхностных состояний. В п. 3.3.5 говорилось, что электроны, туннелирующие из кремния на ловушки в оксиде, могут нейтрализовать эти ловушки. Данный процесс может пойти и в обратном направлении, если подать отрицательное смещение. Время, необходимое для нейтрализации ловушек, зависит от удаленности ловушки от границы Si/SiO2. Таким образом, ловушки, расположенные близко к границе могут легко обмениваться зарядом с кремнием, а ловушки, удаленные от границы, могут вообще не обмениваться зарядом с кремнием. Если обмен зарядом между ловушками и кремнием происходит в пределах времени измерений, то такие ловушки по своим свойствам ближе к ПС, чем к оксидным ловушкам. Ловушки такого типа называются граничными ловушками [50] (в англоязычной литературе — border traps). Расположение в МОП-приборах граничных и оксидных ловушек, а также ПС, показано на рис. 3.30 [50]. Скорость процесса туннелирования электронов из кремния в оксид задается выражением (4.23). При увеличении расстояния от границы временные рамки процесса туннелирования возрастают экспоненциально. Таким образом, граничные ловушки могут располагаться очень близко к границе Si/SiO2. В первом приближении можно считать, что туннелирующие электроны могут пассивировать практически весь захваченный в SiO2 заряд, локализованный в пределах ~3 нм как от границы Si/SiO2, так и от границы затвор/SiO2 [13, 39, 50]. При изменении времени туннелирования на порядок это расстояние меняется в пределах ±0,25 нм. Таким образом, ловушки, удаленные от границы менее чем на ~3 нм, могут легко перезаряжаться, и они обозначаются как граничные ловушки. Данные ловушки отличаются от оксидных ловушек, которые удалены от границы более чем на 3 нм и не могут легко обмениваться зарядом с границей [50]. Однако точная граница между оксидными и граничными ловушками будет зависеть от условий изготовления приборов и частоты, на которой проводятся измерения. Следует отметить, что в роли как оксидных, так и граничных ловушек, могут выступать одни и те же центры (например, E’g-центр).
Рис. 3.30. Иллюстрация концепции граничных ловушек (граничные ловушки — это оксидные ловушки, лежащие вблизи границы раздела) [50] Эксперименты по определению количества граничных ловушек проводились на основе объединения измерений порогового напряжения и измерений по методу накачки заряда на n - и р -канальных транзисторах [63]. В некоторых случаях число граничных ловушек, измеренное на облученных МОП-транзисторах, превышало число радиационно-индуцированных ПС, т.е. в ряде приборов число граничных ловушек может быть вполне значительным. При определении того, как ведут себя ловушки, подобно граничным ловушкам или оксидным ловушкам, несомненно, важную роль играет частота измерительного сигнала.
Рис. 3.31. Величина рекомбинируемого заряда в зависимости от частоты, на которой проводятся измерения [13] (рост рекомбинируемого заряда определяется заполнением и освобождением граничных ловушек) Концепция граничных ловушек полезна для объяснения различных явлений, определяющихся дефектами, расположенными вблизи границ раздела. Например, в настоящее время имеются доказательства того, что 1/ f -шум практически полностью определяется приграничными оксидными ловушками [13, 15. 50]. В зависимости от метода измерений ловушки, расположенные в оксиде вблизи границы раздела с кремнием, могут быть определены и как оксидные ловушки, и как ПС. Таким образом, хотя речь идет об одних и тех же дефектах, в одних случаях 1/ f -шум коррелирует с количеством оксидных ловушек, а в других — с количеством ПС [13]. В последнем случае считается, что 1/ f -шум связан с количеством Pb-центров. Наилучшим образом 1/ f -шум коррелирует с числом граничных ловушек. Таким образом, если различать ПС (Pb) и граничные ловушки, то можно разобраться в некоторой путанице, имеющейся в литературных данных по 1/ f -шуму.
|
||||
|
Последнее изменение этой страницы: 2017-01-27; просмотров: 439; Нарушение авторского права страницы; Мы поможем в написании вашей работы! infopedia.su Все материалы представленные на сайте исключительно с целью ознакомления читателями и не преследуют коммерческих целей или нарушение авторских прав. Обратная связь - 216.73.216.137 (0.012 с.) |

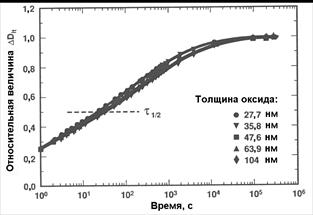 а
а
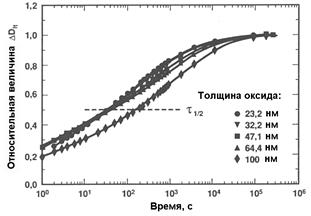 б
б