
Заглавная страница Избранные статьи Случайная статья Познавательные статьи Новые добавления Обратная связь FAQ Написать работу КАТЕГОРИИ: ТОП 10 на сайте Приготовление дезинфицирующих растворов различной концентрацииТехника нижней прямой подачи мяча. Франко-прусская война (причины и последствия) Организация работы процедурного кабинета Смысловое и механическое запоминание, их место и роль в усвоении знаний Коммуникативные барьеры и пути их преодоления Обработка изделий медицинского назначения многократного применения Образцы текста публицистического стиля Четыре типа изменения баланса Задачи с ответами для Всероссийской олимпиады по праву 
Мы поможем в написании ваших работ! ЗНАЕТЕ ЛИ ВЫ?
Влияние общества на человека
Приготовление дезинфицирующих растворов различной концентрации Практические работы по географии для 6 класса Организация работы процедурного кабинета Изменения в неживой природе осенью Уборка процедурного кабинета Сольфеджио. Все правила по сольфеджио Балочные системы. Определение реакций опор и моментов защемления |
Иерархическая структура конструкции ПМС.Содержание книги Похожие статьи вашей тематики
Поиск на нашем сайте
На все конструкции устройств, в том числе микросхем, их элементы, компоненты, детали, узлы и т.п. распространяются законы существования, развития и изменения объектов материального мира. Один из законов говорит об органической связи явлений и предметов, об их зависимости друг от друга и взаимной обусловленности. Конструкцию современного электронного устройства следует рассматривать как некоторое структурное образование, отдельные части которого находятся в иерархической соподчиненности (связи). Под иерархической соподчиненностью в конструкции понимается последовательное объединение простых, конструктивно законченных единиц (элементов, компонентов, интегральных микросхем, узлов и т.п.) в более сложные. На рис. I приведена иерархическая структура конструкции ПМС в металлостеклянном корпусе.
Резисторы ПМС Резисторы ПМС формируются на основе слоев биполярного транзистора: эмиттерного и базового (диффузионные резисторы), коллекторного (эпитаксиального), а также на основе слоев, полученных ионным легированием. В ПМС, выполненных по совмещенной технологии, используются пленочные резисторы. Широкое использование диффузионных резисторов в ПМС определяется возможностью формирования их в едином технологическом процессе одновременно с змиттерными или базовыми областями биполярных транзисторов. Это существенно снижает количество операций изготовления ПМС и упрощает технологический процесс. а) б)
Рис. 2. Эскиз конструкции(а) и эквивалентная схема(б) диффузионного резистора на базовом слое.
На рис.2, а, б показаны конструкция диффузионного резистора на основе базового p -слоя и его эквивалентная схема. Наличие паразитных элементов и связей в диффузионном резисторе (см. рис. 2, б) приводит к определенным схемотехническим ограничениям. Так, паразитный р-п-р транзистор должен быть всегда включен в режиме отсечки. В этом режиме эмиттерный и базовый р-п переходы смещены в обратном направлении и транзистор закрыт. В противном случае, при включении эмиттерного перехода паразитного р-п-р транзистора в прямом направлении ток не потечет через резистор, а будет шунтироваться с усилением паразитным транзистором и уходить в пластину. Наличие паразитных емкостей С1 и С2 р-п переходов, имеющихся в структуре резистора (см. рис. 2, а), ухудшает частотные свойства диффузионных резисторов. Действительно, с ростом частоты w уменьшаются емкостные сопротивления I /wC1 и I /wC2. В результате переменная составляющая тока с ростом частоты будет уходить в подложку, не проходя через резистор из-за его шунтирования емкостями С1 и С2.
Рис. 3. Эскиз конструкции диффузионного резистора на эмиттерном слое.
Рис. 4. Эскиз конструкции резистора на коллекторном (эпитаксиальном) слое.
Рис. 5. Эскиз конструкции пинч-резистора (поджатого) на базовом слое.
На риc. З приведена конструкция диффузионного резистора на эмиттерном п+- слое. На п+- слое изготавливаются низкоомные резис торы, их применение ограничивается низким пробивным напряжением (5 - 7 В) р-п перехода эмиттер-база. Пробивное напряжение резисторов (см. рис.2) на базовом слое составляет 30 - 100 В. Находит применение и конструкция резистора на коллекторном (эпитаксиальном) слое, показанная на рис. 4. На рис. 5, 6 приведены конструкции пинч-резисторов на базовом и коллекторном слоях. У пинч-резисторов уменьшение площади поперечного сечения осуществляется за счёт их поджатия выше расположенным слоем, отделённым от тела резистора обратно-смещённым р-п переходом. В результате, можно существенно повысить значение удельного поверхностного электрического сопротивления rs.такого резистора (табл. 1).
Рис.6. Эскиз конструкции пинч-резистора, выполненного на коллекторном слое.
Рис.7. Эскиз конструкции резистора, сформированного ионным легированием (имплантацией) примеси n -типа в базовый слой.
Конструкция резистора, полученного ионным легированием, показана на рис. 7. Технология процесса ионного легирования (ионной имплантации) позволяет получать тонкие слои с высокими значениями удельного поверхностного электрического сопротивления rs. В табл.1 даны типичные значения толщин слоев, удельных поверхностных электрических сопротивлений и допусков на номинал резисторов ПМС, конструкции которых приведены на рис. 2-7. Общими недостатками полупроводниковых резисторов ПМС являются низкая точность и сложные эквивалентные схемы, отражающие наличие в их конструкциях паразитных элементов и связей.
Таблица 1 Основные параметры резисторов ПМС
Конденсаторы ПМС В конструкциях диффузионных конденсаторов ПМС в полезных целях используются ёмкости обратно смещенных р-п переходов - барьерные (зарядные) емкости: эмиттер-база, база-коллектор и коллектор-пластина. Емкость р-п перехода при прямом смещении называется диффузионной, на практике она в полезных целях не используется, так как при прямом смещении диффузионная емкость шунтируется малым сопротивлением р-п перехода. На рис.8 приведены варианты конструкций диффузионных конденсаторов ПМС, использующих емкость обратно-смещенного р-п. перехода.
Рис. 8. Варианты конструкций диффузионных конденсаторов: С1 – на переходе коллектор-пластина, С2 – на переходе база-коллектор, С3 – на переходе эмиттер-база и С4 – на переходе коллектор-пластина со скрытым слоем.
В качестве примера, на рис. 9 приведена эквивалентная схема диффузионного конденсатора на р-п переходе база-коллектор (С2 на рис. 8).
Рис. 9. Эквивалентная схема диффузионного конденсатора на основе р-п перехода база-коллектор.
На рис. 10, а, б приведена конструкция интегрального МДП (металл-диэлектрик-полупроводник) конденсатора, называемого также конденсатором с диэлектриком, и его эквивалентная схема. Верхняя обкладка такого конденсатора представляет собой металлическую плёнку, нижняя – участок низкоомного полупроводника n+, между обкладками находится диэлектрическая плёнка (обычно двуокиси кремния). Такие конденсаторы, наряду с диффузионными, также находят применение в ПМС.
Рис. 10. Конструкция МДП-конденсатора (а) и его эквивалентная схема (б).
Из рассмотрения приведённых эквивалентных схем конденсаторов (см. рис. 9 и рис. 10, б) видно, что с ростом частоты электрического сигнала сопротивление паразитного конденсатора С2 будет уменьшаться, в результате произойдет нежелательное ответвление переменной составляющей тока в p -пластину. Для уменьшения этого эффекта емкость конденсатора С2 стремятся минимизировать. Сопротивления Rэпит. сл (см. рис. 9) и Rсл. n+ (см. рис. 10, б) снижают добротность конденсаторов, поэтому их тоже стремятся уменьшить. В ПМС, изготовленных по совмещенной технологии, наряду с полупроводниковыми, используются тонкопленочные элементы - конденсаторы и резисторы. У тонкопленочных конденсаторов и резисторов, которые формируются на поверхности защитного окисла, практически отсутствуют паразитные элементы и: связи. По сравнению с полупроводниковыми элементами у них меньше допуск на номинал ёмкости, но изготовление тонкопленочных резисторов и конденсаторов усложняет технологический процесс изготовления ПМС. В табл. 2 приведены параметры конденсаторов ПМС различных конструкций.
Элементы коммутации К элементам коммутации (ЭК) ПМС относятся проводники, диффузионные перемычки и контактные площадки (КП). Элементы ПМС электрически соединены между собой с помощью металлических пленочных проводников, чаще всего алюминиевых (алюминиевой разводкой), расположенных на поверхности покрывающего поверхность пластины окисла. В качестве соединительных проводников в ПМС используются также низкоомные слои n+ или р+, расположенные под защитным окислом в объеме полупроводникового кристалла.
Таблица 2 Основные параметры конденсаторов ПМС
Для изоляции двух пересекающихся пленочных проводников используются диффузионные перемычки (рис. 11), в которых один проводник расположен на поверхности окисла, а другой "подныривает" под него в виде участка p- или n+ -слоя. Участок n+ -слоя применяется редко ввиду малого пробивного напряжения n+-р перехода (перехода эмиттер-база) (см. табл. 2).
Рис. 11. Конструкция диффузионной перемычки.
Диффузионная перемычка по существу является низкоомным диффузионным резистором. Различают следующие разновидности контактных площадок: - внутренние, предназначенные для электрического соединения выводов (активных слоев) элементов ПМС, находящихся под защитным окислом, с пленочными металлическими проводниками (см. рис. 11); - внешние, предназначенные для электрического соединения выводов кристалла с внешними выводами корпуса с помощью золотых или алюминиевых проводников (рис. 12).
Рис. 12. Конструкция внешней контактной площадки: 1 - пленочный проводник; 2 - контактная площадка; 3 - гибкий проводник; 4 - изолирующий р-п переход.
Для предотвращения замыкания контактной площадки на р -пластину в случае нарушения целостности окисла при термокомпрессионной приварке вывода к площадке под каждой контактной площадкой формируют изолированную область (п -"карман"). Таким образом, каждая внешняя контактная площадка снабжается двойной изоляцией. В тех случаях, когда внешняя контактная площадка формируется на "толстом" окисле, область изоляции в виде п -"кармана" под ней не делают.
Диоды ПМС Диоды ПМС можно сформировать на любом из р-п переходов транзистора. Наиболее удобны для этой цели р-п переходы биполярного транзистора эмиттер-база и база-коллектор. Пять возможных вариантов диодного включения биполярного транзистора, представляющие разновидности конструкций диодов ПМС, приведены на рис. 13:
Рис. 13. Структуры диодов ПМС, реализованные на базе структуры биполярного транзистора: а) БК-Э; б) ЭБ-К; в) ЭК-Б; г) Э-Б; д) К-Б.
В представленных на рис. 13 вариантах используются: переход база-эмиттер с коллектором, закороченным на базу (а); переход коллектор-база с эмиттером, закороченным на базу (б); параллельное включение обоих переходов (в); переход эмиттер-база с разомкнутой цепью коллектора (г); переход база-коллектор с разомкнутой цепью эмиттера (д). Основные параметры диодов ПМС даны в табл. 3. Таблица 3 Параметры диодов ПМС, выполненных на базе структуры биполярного транзистора
При правильном выборе варианта диодного включения биполярного транзистора возможно получение оптимального сочетания параметров диода. Наилучшими вариантами диодного включения биполярного транзистора являются БК-Э и Б-Э.
Биполярные транзисторы ПМС В ПМС биполярный п-р-п транзистор является основным (базовым) схемным элементом. У п-р-п транзисторов быстродействие, частотные и усилительные параметры при прочих равных условиях лучше, чем у р-п-р транзисторов. Это объясняется тем, что подвижность электронов выше, чем дырок, что предопределяет более высокое быстродействие. Концентрация примеси в эмиттере достигается большей при легировании кремния донорами, чем при легировании акцепторами, что предопределяет более высокие коэффициенты инжекции эмиттера и усиления п-р-п транзистора. Существуют различные конструкции биполярных транзисторов ПMC. На рис. 14 приведена простейшая конструкция биполярного транзистора п+-р-п. Эмиттер транзистора сильно легируют (до п+) для получения максимального коэффициента инжекции электронов из эмиттера в базу при прямом включении р-п перехода эмиттер-база.
Рис. 14. Эскиз конструкции биполярного транзистора ПМС: 1 - эмиттер; 2 - база; 3 - коллектор; 4 - скрытый сдой: 5 - п+ -область под контактом к коллектору.
Под коллектором располагают низкоомный слой n + - так называемый скрытый слой, предназначенный для уменьшения сопротивления коллектора транзистора и повышения за счёт этого его быстродействия. При контакте полупроводника n -типа с трехвалентным алюминием, который является акцептором в кремнии и германии, последний может диффундировать в коллектор с образованием непосредственно под контактом области p -типа и паразитного р-п перехода. Для предотвращения образования паразитного перехода под контактом к коллектору область под этим контактом легируют до n+. В этом случае, если алюминий и продиффундирует в коллектор, концентрация доноров в нем будет заведомо больше, чем акцепторов, и поэтому область p- типаи, соответственно, паразитный р-п переход под контактом к коллектору не образуются. Транзисторы средней и большой мощности работают в режимах высоких плотностей эмиттерного тока (200 - 3000 А/см2). Конструкции мощных транзисторов разрабатываются с учетом эффекта оттиснения эмиттерного тока. Этот эффект заключается в том, что плотность тока в центре эмиттера существенно ниже плотности тока по его периферии (см. рис. 15).
Рис. 15. Иллюстрация эффекта «оттиснения эмиттерного тока».
Падение напряжения на эмиттерном р-п переходе в центре эмиттера всегда меньше, чем у краёв эмиттера, на величину, равную падению напряжения на омическом сопротивлении базы вследствие протекания базового тока:
В современных транзисторах толщина базы составляет примерно 0,3 – 0,7 мкм, длина базы может составлять несколько десятков мкм, поэтому сопротивление базы будет достаточно большим. Плотность тока эмиттера экспоненциально возрастает с напряжением на р-п переходе:
где jT - температурный потенциал; Отсюда видно, что падение напряжения на длине базы в несколько jT приведет к различию в величинах плотности тока Iэ(0) и Iэ(l/2) на один-два порядка. Максимальная плотность тока всегда будет на краю эмиттера. Возрастание эмиттерного тока вызовет возрастание базового тока, увеличение падения напряжения вдоль базы и еще большее перераспределение тока между центром и краями эмиттера, т.е. ток эмиттера оттеснится от его центра к периферийным участкам. Поэтому для повышения мощности транзистора необходимо увеличивать не общую площадь Fэ эмиттера, а отношение периметра P эмиттера к его площади. Необходимо учитывать, что существует оптимальное отношение P/FЭ. На рис.16. схематически приведены различные формы эмиттеров мощных транзисторов с большими значениями отношения P/FЭ - П-образная, прямоугольные, соединённые металлизацией в виде гребёнки (гребенчатые), древовидная, елочная.
Рис. 16. Формы эмиттеров биполярных транзисторов средней и большой мощности: П-образного (а); гребенчатого (б); древовидного (в); елочного (г).
Транзисторы ПМС c ёлочными эмиттерами способны пропускать в одном импульсе ток до l А. В логических схемах транзисторно-транзисторной логики (ТТЛ) используются многоэмиттерные транзисторы, имеющие несколько эмиттеров, работающих на общие базовый и коллекторный слои (рис. 17).
Рис. 17. Конструкция многоэмиттерного транзистора: 1 - эмиттеры; 2 - базовый проводник Бп; 3 - базовый резистор r'b; 4 - базовый контакт Бк; 5 - база; 6 - коллектор; 7 - подложка.
Эмиттеры многоэмиттерного транзистора находятся на разных расстояниях от базового контакта (см. рис. 17), что приводит к различию в сопротивлениях эмиттерно-базовых цепей. Для выравнивания этих сопротивлений база снабжается проводником Бп. В TТЛ-схемах для снижения входных токов необходимо минимальное значение коэффициента усиления β ’ многоэмиттерного транзистора в инверсном режиме. С этой целью базовый контакт и эмиттеры должны быть отнесены друг от друга на некоторое расстояние. Формируется дополнительное омическое сопротивление базы Из эквивалентной схемы многоэмиттерного транзистора (рис. 18) видно, что диод VD1 шунтирует p-n переход коллектор-база инверсного транзистора. В результате уровень инжекции неосновных носителей из коллектора в базу и эмиттеры будет незначительным и инверсные коэффициенты усиления транзистора β’ (по каждому из эмиттеров) уменьшатся до 0,001 – 0,005.
Рис. 18. Эквивалентная схема многоэмиттерного транзистора:
Транзисторы с барьерами Шотки отличаются повышенным быстродействием. Они используются в быстродействующих схемах пороговой логики ТТЛШ. У транзисторов, работающих в режиме насыщения, в области базы и коллектора накапливается объемный заряд. Время рассасывания tp этого заряда при переходе из режима насыщения в режим отсечки является важным параметром, определяющим быстродействие ряда схем пороговой логики. Для снижения tp транзисторы можно легировать золотом, уменьшающим время жизни неосновных носителей, что в свою очередь приводит к нежелательному снижению коэффициента усиления транзистора, требует дополнительных технологических операций, расхода золота и снижает воспроизводимость параметров транзисторов. Для уменьшения tp без указанных отрицательных последствий коллекторный переход транзистора можно шунтировать диодом (то есть p-n переходом). Однако в этом случае в самом диоде скапливается объемный заряд, кроме того, усложняется конструкция ПМС. Дляшунтирования коллекторного перехода наиболее перспективны диоды с барьером Шотки (рис. 19). При контакте полупроводника с металлом в зависимости от соотношения работ выхода металла и полупроводника и уровня легирования полупроводника в области контакта может образоваться слой, обогащенный основными носителями, обедненный и инверсный слой (барьер Шотки). Диод о барьером Шотки обладает выпрямляющими свойствами, имеет падение напряжения в открытом состоянии (при прямом смещении) примерно 0,35 В, что вдвое ниже, чем для диода на p-n переходе, и весьма малое время выключения: На рис. 20 приведена конструкция транзистора с диодом Шотки (транзистора Шотки). Диод Шотки возникает за счет распространения базового контакта на область коллектора. В контакте высокоомная n- область - металл образуется инверсный слой (рис. 20). Перед обычными транзисторами транзистор Шотки имеет следующие преимущества: - в режиме насыщения отсутствует инжекция неосновных носителей заряда из коллектора в базу; - заряд носителей в коллекторной области не накапливается; - увеличивается быстродействие транзистора; - повышается коэффициент усиления транзистора, так как последний не легируется золотом. К числу недостатков транзисторов Шотки следует отнести: - повышение емкости коллекторного перехода за счет прибавления емкости диода; - увеличение падения напряжения между коллектором и эмиттером транзистора в режиме насыщения примерно с 0,2 до 0,4 В.
Рис. 19. Упрощенная эквивалентная схема транзистора Шотки.
Рис. 20. Эскиз конструкции транзистора Шотки.
МДП-транзисторы ПМС. На рис. 21 приведён эскиз конструкции униполярного (полевого) транзистора типа МДП, то есть металл-диэлектрик-полупроводник. Принцип работы МДП-транзистора основан на модуляции сопротивления проводящего канала между истоком и стоком под действием изменения потенциала затвора.
Рис. 21. Эскиз конструкции (а) и схемотехническое обозначение (б) п-канального МДП–транзистора с индуцированным каналом: И – исток; С – сток; З – затвор.
МДП-транзисторы по сравнению с биполярными имеют более высокое входное сопротивление, меньший уровень шумов, меньшую потребляемую мощность, большую устойчивость к перегрузкам по току. Технология МДП ИС проще, чем технология ИС на биполярных транзисторах, а следовательно и стоимость их ниже. Интегральная плотность у МДП ИС выше, чем у ИС на биполярных транзисторах. Основными недостатками МДП-транзисторов по сравнению с биполярными являются: меньшее быстродействие, худшая технологическая воспроизводимость параметров и большая временная нестабильность. В соответствии с типом электропроводности канала различают n-канальные (рис. 21, а) и p-канальные (рис. 22, а) МДП-транзисторы. У n-канальных транзисторов быстродействие и частотные характеристики выше, чем у р- канальных, так как подвижность электронов больше, чем подвижность дырок. Наряду с полевыми транзисторами с управляющими переходами, о которых будет сказано ниже, МДП-транзисторы являются униполярными приборами, поскольку работа их основана на использовании носителей заряда только одного типа, а именно - основных. Инжекция в МДП- и полевых транзисторах с управляющими переходами не используется. Исток и сток в униполярных транзисторах, в принципе, обратимы и их можно поменять местами при включении транзисторов в схему.
а) б)
Рис. 22.Структура (а) и условное обозначение (б) р-канального МДП-транзистора с индуцированным каналом.
В МДП-ИС для реализации диодов и пассивных элементов (резисторов или конденсаторов) используются МДП-структуры. При использовании МДП-транзистора в качестве резистора необходимый номинал последнего достигается подачей на затвор определенного потенциалаи выполнением канала с определёнными (расчётными) геометрическими размерами. Такой МДП-транзистор называется нагрузочным. Конденсаторы в МДП ИС используют емкость затвор - подзатворный диэлектрик – пластина (МДП-конденсатор) или барьерную емкость р-п перехода сток (исток) – пластина (диффузионный конденсатор). МДП ИС, у которых в объеме кристалла сформированы п- и p-канальные транзисторы, называются комплементарными (рис. 23). Цифровые схемы на комплементарных МДП-транзисторах (КМДП ИС) потребляют мощность только в моменты переключений электрических сигналов и не потребляют ее в статическом режиме.
Рис. 23. Комплементарные МДП транзисторы: 1 - исток; 2 - сток-3 - затвор; 4 - подзатворный диэлектрик.
Действительно, при подаче на вход схемы, составленной из двух транзисторов комплементарной структуры (рис. 24), сигнала положительной или отрицательной полярности один из транзисторов всегда будет включен, а другой выключен. Поэтому ток в цепи источника питания с напряжением Uи.п будет практически отсутствовать (один из транзисторов выключен) и потребляемая мощность в статическом режиме будет пренебрежимо мала. Эта особенность КМДП ИС выгодно отличает их от микросхем на биполярных транзисторах.
Рис. 24. Схема инвертора на основе КМДП структуры.
|
||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
Последнее изменение этой страницы: 2017-02-09; просмотров: 901; Нарушение авторского права страницы; Мы поможем в написании вашей работы! infopedia.su Все материалы представленные на сайте исключительно с целью ознакомления читателями и не преследуют коммерческих целей или нарушение авторских прав. Обратная связь - 18.223.108.134 (0.011 с.) |


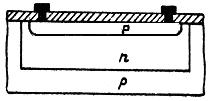


























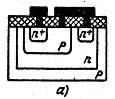

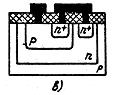
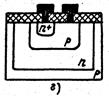





 .
. .
. В; k- постоянная Больцмана; Т - температура.
В; k- постоянная Больцмана; Т - температура.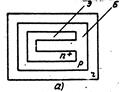





 Омза счёт специально сделанного отростка, через который выполняется контакт к (рис. 17). Падение напряжения на этом отростке порядка 0,1 В приводит к уменьшению β ’.
Омза счёт специально сделанного отростка, через который выполняется контакт к (рис. 17). Падение напряжения на этом отростке порядка 0,1 В приводит к уменьшению β ’.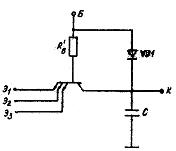
 - базовый резистор; VD1 – диод под базовым контактом на основе p-n перехода коллектор – база; Сп – емкость p-n перехода коллектор – подложка.
- базовый резистор; VD1 – диод под базовым контактом на основе p-n перехода коллектор – база; Сп – емкость p-n перехода коллектор – подложка. нс.
нс.