
Заглавная страница Избранные статьи Случайная статья Познавательные статьи Новые добавления Обратная связь FAQ Написать работу КАТЕГОРИИ: ТОП 10 на сайте Приготовление дезинфицирующих растворов различной концентрацииТехника нижней прямой подачи мяча. Франко-прусская война (причины и последствия) Организация работы процедурного кабинета Смысловое и механическое запоминание, их место и роль в усвоении знаний Коммуникативные барьеры и пути их преодоления Обработка изделий медицинского назначения многократного применения Образцы текста публицистического стиля Четыре типа изменения баланса Задачи с ответами для Всероссийской олимпиады по праву 
Мы поможем в написании ваших работ! ЗНАЕТЕ ЛИ ВЫ?
Влияние общества на человека
Приготовление дезинфицирующих растворов различной концентрации Практические работы по географии для 6 класса Организация работы процедурного кабинета Изменения в неживой природе осенью Уборка процедурного кабинета Сольфеджио. Все правила по сольфеджио Балочные системы. Определение реакций опор и моментов защемления |
По курсу «Физические основы микроэлектроники»Содержание книги
Поиск на нашем сайте Симонов Б.М.
Учебно-методическое пособие для выполнения практических занятий По курсу «Физические основы микроэлектроники»
Утверждено редакционно-издательским советом института
Москва 2007 Содержание Стр.
Введение 3 Методические указания к практическим занятиям, примеры решения задач и задания для самостоятельного решения 5 1. Распределение носителей заряда по энергиям в полупроводниках 5 2. Расчет концентраций носителей заряда в полупроводниках 7 3. Электропроводность полупроводников 12 4. Параметры и характеристики p-n переходов 15 5. Расчет барьерной емкости p-n переходов 17 6. Расчет диффузионной ёмкости p-n переходов транзисторов и диодов. Вольт-амперная характеристика диода 21 7. Расчёт параметров и характеристик диодов 24 8. Расчёт параметров и характеристик биполярных транзисторов 36 9. Расчёт h-параметров биполярного транзистора в схеме включения с общей базой 48 10. Расчёт результирующего примесного распределения и точки инверсии поля в базе в структуре планарно-эпитаксиального биполярного транзистора 52 11. Расчёт параметров МДП – транзисторов 59 Приложение 1. Ответы и решения 66 Аннотация 73
Введение Для современных изделий электронной техники, среди которых важнейшее значение имеют изделия элементной базы (интегральные схемы (ИС), дискретные навесные элементы (компоненты) и прочие изделия), на основе которых строится электронная аппаратура различного назначения, основано на использовании физических явлений и процессов, протекающих в изделиях полупроводниковой, плёночной и функциональной электроники. В настоящем учебно-методическом пособии для практических занятий студентов приведены основные расчётные соотношения и типовые алгоритмы решения задач по различным разделам полупроводниковой электроники и микроэлектроники. Рассмотрены физические явления, лежащие в основе работы изделий микроэлектроники, принципы построения и функционирования транзисторов, диодов, резисторов, конденсаторов, даны сведения о материалах, используемых для изготовления изделий МЭ. Наряду с разобранными решениями типовых задач, сопровождаемыми лаконично изложенными теоретическими материалами по темам, даны задачи и материалы для самостоятельного решения. Материалы данного учебно-методического пособия можно использовать при изучении материала курса, при подготовке к практическим занятиям, при решении конкретных задач, выполнении расчётов, для лучшего освоения важнейших разделов дисциплины. Данное пособие предназначено для студентов второго курса дневного и вечернего отделений факультетов ЭТМО и ИМЭ, изучающих дисциплины «Физические основы микроэлектроники», «Физические основы элементной базы ЭВС», «Твердотельная электроника и микроэлектроника». Оно может быть использовано для закрепления и углубления материалов других учебных курсов, в том числе «Технология и конструирование интегральных микросхем», «Физико-химические основы технологии микроэлектроники» и других. Пособие может быть также использовано студентами и инженерно-техническими работниками при выполнении расчётов в рамках курсового и дипломного проектирования или при выполнении заданий по производственной практике. Выбор тем для практических занятий достаточно широк. Он, прежде всего, обусловлен практическими задачами и потребностями, возникающими при обучении студентов в институте. Современный подход к рассматриваемым вопросам, представленные варианты заданий для практических занятий, разобранные примеры решения типовых задач, задачи для самостоятельного решения и методические указания к ним обуславливают полезность данного учебно-методического пособия для студентов, изучающих курсы «Физические основы микроэлектроники, «Физические основы элементной базы ЭВС», «Твердотельная электроника и микроэлектроника». Методические указания к практическим занятиям, примеры решения задач и задания для самостоятельного решения. Для решения задач необходимо ознакомиться с теоретическим материалом, изложенным в рекомендованных учебных и учебно-методических пособиях [1-4]. Ниже представлен учебно-методический материал, разбитый по отдельным темам. Пример решения задачи. Задача 2.1. Известно, что кристалл кремния в качестве легирующей примеси содержит 10-4 атомных процентов мышьяка As. Затем он равномерно легируется Требуется определить, какой тип электропроводности будет у полупроводника? Рассчитать концентрации основных и неосновных носителей заряда при температуре Т=300К. Решение. Мышьяк – элемент 5-ой группы, поэтому он является донором в кремнии. Известно |2|, что атомная концентрация кремния составляет Концентрация примеси Дополнительное легирование
Легирование атомами бора (3-я группа) превращает кремний из n-типа в р-тип, т.к. концентрация акцепторов Результирующая концентрация акцепторов будет:
Полупроводник будет р-типа электропроводности с результирующей концентрацией
Концентрация основных носителей заряда, т.е. в полупроводнике р-типа дырок
Для расчета концентрации неосновных носителей заряда - электронов в полупроводнике р-типа воспользуемся выражением [2]:
В этом выражении Найдем концентрацию неосновных носителей заряда
Задачи для самостоятельного решения. Требуется решить одну из задач, соответствующую указанному преподавателем номеру варианта. При решении воспользоваться следующими данными [3]: Атомная концентрация в кремнии Собственная концентрация носителей заряда при температуре Т=300 К в кремнии Вариант 1. Кристалл кремния содержит Вариант 2. Кристалл германия содержит Вариант 3. Кристалл кремния содержит Вариант 4. Кристалл германия содержит Вариант 5. Кристалл кремния содержит Вариант 6. Кристалл германия содержит Вариант 7. Кристалл кремния содержит Вариант 8. Кристалл германия содержит Вариант 9. Кристалл кремния содержит Вариант 10. Кристалл германия содержит
Методические указания. Заданный характер распределения по координате концентрации легирующей примеси характерен для p-n перехода база-коллектор транзисторных структур. Поскольку в области перехода можно считать
Полное напряжение на переходе определяется с учетом контактной разности потенциалов
Толщина обедненного слоя при полном напряжении на переходе 7,3 В:
Закон изменения заряда в случае линейного плавного перехода будет повторять закон изменения концентрации. Поскольку в области перехода
Учитывая, что
Расчет C, d и Q при других значениях приложенного к переходу напряжения проводится аналогично. Задача 5.4 (для самостоятельного решения). Дано: высота потенциального барьера ступенчатого (резкого) p-n перехода в кремнии
Таблица 5.2 Варианты заданий к задаче 5.4
Методические указания. Дифференциальное сопротивление p-n перехода определим исходя из основного уравнения вольт-амперной характеристики диода
Дифференцируем это выражение (6.1) по напряжению, получаем
Выражение (6.1) запишем в виде
тогда (6.2) можно представить следующим образом
Дифференциальное сопротивление p-n перехода
Задача 7.1. Воспользовавшись данными справочной литературы, рассмотреть параметры и характеристики диода 2Д510А. Рассчитать и построить характеристики: - зависимости сопротивления постоянному току и сопротивления переменному току (при малом сигнале) от прямого и обратного напряжения при температуре Т = 298 К; - зависимость обратного тока от обратного напряжения на диоде; - зависимость ёмкости диода при обратном напряжении от величины обратного напряжения; Определить величины температурных коэффициентов ТКUпрям и ТКUобр (при прямом и обратном напряжении) в рабочем температурном диапазоне диода. Определить сопротивление базы диода при температуре Т = 298 К. Построить эквивалентную высокочастотную (ВЧ) схему диода и указать значения параметров входящих в её состав элементов.
Решение. Используем справочные данные из [10]. Паспортные параметры диода. Электрические параметры: Постоянное прямое напряжение при Iпр= 200 мА более, В: при 298 и 398 К …………………………………………………………….. 1,1 при 213 К …………………………………………………………………… 1,5
Постоянный обратный ток при Uпр= 50 В, не более, мкА при 298 и 213 К ……………………………………………………………. 5 при 398 К …………………………………………………………………… 150
Заряд переключения при Iпр= 50 мА, Uобр. = 10 В, не более, пКл ……………….400
Общая ёмкость диода при Uобр= 0 В, не более, пФ ………………………………4
Время восстановления обратного тока при Iпр= 50 мА, Uобр. = 10 В, не более, нс ……………………………………………………………… 4
Предельные эксплуатационные данные: Постоянное, импульсное обратное напряжение (любой формы и периодичности), В…………………………………………………………………… 50
Импульсное обратное напряжение при длительности импульса (на уровне 50 В) не более 2 мкс и скважности не менее 10, В……………………………………… 70
Постоянный или средний прямой ток, мА: при температуре от 213 до 323 К ………………………………………… 200 при 393 К ………………………………………………………………….. 100
Импульсной прямой ток при длительности импульса τи ≤ 10 мкс (без превышения среднего значения прямого тока), мА: при температуре от 213 до 323 К ………………………………………… 1500 при 393 К ………………………………………………………………….. 500
Максимальная температура перехода, К 423 Рабочий интервал температур окружающей среды, К от 213 до 393
И величины её элементов. Воспользовавшись [1-4], нарисуем эквивалентную ВЧ схему диода. Малосигнальная высокочастотная эквивалентная схема диода при обратном смещении представлена на рис. 7.12.
Рис. 7.12. Малосигнальная ВЧ эквивалентная схема диода.
Величины элементов схемы при Uобр = 5 В:
Задача 7.2 (для самостоятельного решения). Выбрать из справочника какой-либо диод (по согласованию с преподавателем) и провести для него расчёты, аналогичные представленным в настоящем разделе. Электрические параметры.
Коэффициент шума при ƒ = 1,6 МГц, Uкб= 5 В, IЭ= 1 мАне более, дБ ………… 3
Коэффициент передачи тока H21э в режиме малого сигнала при Uкб= 5 В, IЭ= 1 мА, ƒ = 50 – 1000 Гц………………………………60 – 180
Модуль коэффициента передачи тока H21э при Uкб= 5 В, IЭ= 5 мА, ƒ = 20 МГц не менее …………………………... 8
Постоянная времени цепи обратной связи при Uкб= 5 В, IЭ= 5 мА, ƒ = 5 МГц не более, пс ………………………….…300
Входное сопротивление в схеме с общей базой при Uкб= 5 В, IЭ= 1 мА,Ом ……………………………………………………38
Выходная проводимость в схеме с общей базой при Uкб= 5 В, IЭ= 1 мА, ƒ = 50 – 1000 Гцне более, мкСм 3 …………………….. Ёмкость коллектора при Uкб= 5 В, ƒ = 5 МГцне более, пФ …………………………4
Определение g – параметров. Величины g-параметров в рабочей точке определим путём пересчёта матриц:
g-параметры: g11э= 1,4 мСм, g12э= - 0,4*10 –6 g21э= 0,15, g22э= 4,1*10 –3 Ом
Методические указания. Определение h – параметров возможно в следующей последовательности. Рассмотрим эту последовательность применительно к первому варианту задания.
Из выражения
Теперь определим h22 из выражения
Поскольку
Для других вариантов задания h – параметры рассчитываются аналогично.
10. Расчёт результирующего примесного распределения и точки инверсии поля в базе в структуре планарно-эпитаксиального биполярного транзистора. Результирующее примесное распределение в структуре плоскостного (планарно-эпитаксиального) биполярного транзистора (ПЭТ) представляет собой алгебраическую сумму распределений примеси в каждой из трёх областей: эмиттерной, базовой и коллекторной [1-4]. Учитывая различие в типе проводимости областей транзистора, результирующее распределение запишем в виде:
(10.1) где NЭ(x), NК(x) и NБ(x) – распределение примеси в эмиттерной, коллекторной и базовой областях, соответственно (рис.10.1). Координата x направлена вглубь полупроводниковой пластины, у поверхности x = 0.
а) б)
Рис. 10.1. Структура ПЭТ (а) и распределение концентрации легирующей примеси в структуре планарно-эпитаксиального транзистора (б).
в то время как:
При расчёте результирующего примесного распределения NЭ(x) апроксимируется тремя erfc функциями, поскольку при высоком уровне легирования в эмиттерной области D Э является функцией концентрации донорной примеси. При этом на каждом из трёх участков эмиттерной области D Э принимается постоянным, независимым от концентрации примеси. Результирующее распределение примеси как функция от x представлено на рис. 10.2, а, б. На рис. 10.2, б распределение в базовой области представляет собой зеркальное отражение распределения на рис. 10.2, a, т.е. взято по модулю.
а) б)
доноров, Nа – концентрация акцепторов, Nрез = | Nд – Nа | - результирующая концентрация.
точке x = xт, называемой точкой инверсии. На участке xэ < x < xт поле замедляет, на участке xт < x < xк – ускоряет. Таким образом, положение точки инверсии влияет на усилительные свойства транзистора. Стремятся при проектировании сделать замедляющий участок коротким. Определяется xт из условия
(10.6)
(10.7) Распишем последовательно дифференциалы в левой и правой частях равенства (10.6):
 Обозначим: Обозначим:
Из (10.6), учитывая (10.7) – (10.8), получаем (10.9), которое перепишем в более удобном для выполнения расчётов виде
Плученное уравнение (10.10) является трансцедентным, решение данного уравнения (10.12) может быть выполнено, например, графическим путём. В результате решения данного уравнения определим значение xТ. Задача. Исходные данные: NSЭ – поверхностная концентрация области эмиттера; DЭ – коэффициент диффузии эмиттера; TЭ – время эмиттерной диффузии; xЭ – глубина эмиттера; NSБ – поверхностная концентрация базы; DБ – коэффициент диффузии базы; tБ – время диффузии базового слоя; xК – толщина коллектора. Размерности: [NSЭ], [NSБ] = см-3; [DЭ], [DБ] = см2/с; [tЭ, tБ ] = с; [xЭ, xК]= мкм. Пример решения задачи: Численные значения исходных данных: NSЭ = 1×1021 см-3; DЭ = 2×10-13 см2/с; tЭ = 3600с; xЭ = 1,5мкм; NSБ = 3×1018 см-3; DБ = 2×10-12 см2/с; tБ = 104с; xК = 3мкм; Требуется определить положение точки инверсии поля в базе биполярного транзистора xТ. Решение.
Значение xТ найдём графическим решением уравнения (10.10).
h = exp (b – a)· xT2
Для построения зависимостей x = f(xТ) и h = (xТ), составим таблицу рассчитанных значений (табл. 10.1). Вначале делаем расчет коэффициентов A, а, B и b. Затем задаёмся значениями хТ и рассчитываем значения функций x = f(xТ) и h = (xТ).:
Таблица 10.1 Зависимость значений x, h от xТ
На основании данных табл. 10.1 строим графические зависимости x(xТ) и h(xТ). Построенные зависимости представлены на рис. 10.3.
Пересечение построенных зависимостей x = f(xТ) и h = (xТ).:даёт значение xт, равное ~ 1,5мкм
Рис. 10.3. Зависимости коэффициентов x и h от xт.
Задача 10.2 (для самостоятельного решения). Заданы: NSЭ, DЭ, tЭ, xЭ, NSБ, DБ, tБ, xк. Численные значения этих параметров по вариантам даны в табл. 10.2. Требуется определить точку инверсии xТ.
Таблица 10.2 Исходные данные для решения задачи (по вариантам).
Продолжение табл. 10.2
Методические указания. Следует определить для режима насыщения
Затем можно найти длину канала L из выражений:
Зная длину канала, можно найти ширину канала Z:
где
В режиме насыщения
или
Умножив обе части на
приравниваем выражения (11.3) и (11.2):
и находим
Задача 11.2. (для самостоятельного решения). Дано:Крутизна МДП – транзистора | ||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
| Поделиться: |


 фосфором Р и после этого равномерно легируется
фосфором Р и после этого равномерно легируется  бором В. Вслед за этим термический отжиг полностью активирует все примеси.
бором В. Вслед за этим термический отжиг полностью активирует все примеси. .
. атомных процента означает
атомных процента означает  относительных единиц, кремний легирован мышьяком
относительных единиц, кремний легирован мышьяком  .
. .
. будет превосходить концентрацию доноров
будет превосходить концентрацию доноров  , т.е. потому что
, т.е. потому что  >
>  .
. .
. , как следует из изложенного, равна
, как следует из изложенного, равна  . То есть
. То есть .
. ;
; – собственная концентрация,
– собственная концентрация,  , т.е. зависит от температуры. При заданной температуре Т=300 К
, т.е. зависит от температуры. При заданной температуре Т=300 К  в кремнии [2].
в кремнии [2]. .
. , в германии
, в германии  .
. .
. атомных процентов бора. Затем он равномерно легируется бором
атомных процентов бора. Затем он равномерно легируется бором  , после этого равномерно легируется мышьяком
, после этого равномерно легируется мышьяком  . После этого все примеси активируются термическим отжигом. Какой тип электропроводности будет у полупроводника? Рассчитать концентрации основных и неосновных носителей заряда при Т=300К. Нарисовать энергетическую диаграмму.
. После этого все примеси активируются термическим отжигом. Какой тип электропроводности будет у полупроводника? Рассчитать концентрации основных и неосновных носителей заряда при Т=300К. Нарисовать энергетическую диаграмму. , после этого равномерно легируется бором
, после этого равномерно легируется бором  . После этого все примеси активируются термическим отжигом. Какой тип электропроводности будет у полупроводника? Рассчитать концентрации основных и неосновных носителей заряда при Т=300К. Нарисовать энергетическую диаграмму.
. После этого все примеси активируются термическим отжигом. Какой тип электропроводности будет у полупроводника? Рассчитать концентрации основных и неосновных носителей заряда при Т=300К. Нарисовать энергетическую диаграмму. атомных процентов мышьяка. Затем он равномерно легируется бором
атомных процентов мышьяка. Затем он равномерно легируется бором  , после этого равномерно легируется фосфором
, после этого равномерно легируется фосфором  . После этого все примеси активируются термическим отжигом. Какой тип электропроводности будет у полупроводника? Рассчитать концентрации основных и неосновных носителей заряда при Т=300К. Нарисовать энергетическую диаграмму.
. После этого все примеси активируются термическим отжигом. Какой тип электропроводности будет у полупроводника? Рассчитать концентрации основных и неосновных носителей заряда при Т=300К. Нарисовать энергетическую диаграмму. атомных процентов фосфора. Затем он равномерно легируется мышьяком
атомных процентов фосфора. Затем он равномерно легируется мышьяком  , после этого равномерно легируется бором
, после этого равномерно легируется бором  . После этого все примеси активируются термическим отжигом. Какой тип электропроводности будет у полупроводника? Рассчитать концентрации основных и неосновных носителей заряда при Т=300К. Нарисовать энергетическую диаграмму.
. После этого все примеси активируются термическим отжигом. Какой тип электропроводности будет у полупроводника? Рассчитать концентрации основных и неосновных носителей заряда при Т=300К. Нарисовать энергетическую диаграмму. атомных процентов бора. Затем он равномерно легируется фосфором
атомных процентов бора. Затем он равномерно легируется фосфором  , после этого равномерно легируется бором
, после этого равномерно легируется бором  , после этого равномерно легируется бором
, после этого равномерно легируется бором  . После этого все примеси активируются термическим отжигом. Какой тип электропроводности будет у полупроводника? Рассчитать концентрации основных и неосновных носителей заряда при Т=300К. Нарисовать энергетическую диаграмму.
. После этого все примеси активируются термическим отжигом. Какой тип электропроводности будет у полупроводника? Рассчитать концентрации основных и неосновных носителей заряда при Т=300К. Нарисовать энергетическую диаграмму. атомных процентов мышьяка. Затем он равномерно легируется фосфором
атомных процентов мышьяка. Затем он равномерно легируется фосфором  , после этого равномерно легируется бором
, после этого равномерно легируется бором  , после этого равномерно легируется бором
, после этого равномерно легируется бором  . После этого все примеси активируются термическим отжигом. Какой тип электропроводности будет у полупроводника? Рассчитать концентрации основных и неосновных носителей заряда при Т=300К. Нарисовать энергетическую диаграмму.
. После этого все примеси активируются термическим отжигом. Какой тип электропроводности будет у полупроводника? Рассчитать концентрации основных и неосновных носителей заряда при Т=300К. Нарисовать энергетическую диаграмму. атомных процентов фосфора. Затем он равномерно легируется мышьяком
атомных процентов фосфора. Затем он равномерно легируется мышьяком  , после этого равномерно легируется бором
, после этого равномерно легируется бором  . После этого все примеси активируются термическим отжигом. Какой тип электропроводности будет у полупроводника? Рассчитать концентрации основных и неосновных носителей заряда при Т=300К. Нарисовать энергетическую диаграмму.
. После этого все примеси активируются термическим отжигом. Какой тип электропроводности будет у полупроводника? Рассчитать концентрации основных и неосновных носителей заряда при Т=300К. Нарисовать энергетическую диаграмму. , после этого равномерно легируется бором
, после этого равномерно легируется бором  . После этого все примеси активируются термическим отжигом. Какой тип электропроводности будет у полупроводника? Рассчитать концентрации основных и неосновных носителей заряда при Т=300К. Нарисовать энергетическую диаграмму.
. После этого все примеси активируются термическим отжигом. Какой тип электропроводности будет у полупроводника? Рассчитать концентрации основных и неосновных носителей заряда при Т=300К. Нарисовать энергетическую диаграмму. , то данный переход относится к классу линейно-плавных переходов. Емкость такого перехода
, то данный переход относится к классу линейно-плавных переходов. Емкость такого перехода .
. будет равно сумме приложенного напряжения и
будет равно сумме приложенного напряжения и  .
.
 .
. и
и  , можно записать
, можно записать .
. и
и  . Площадь p-n перехода 4
. Площадь p-n перехода 4  . Относительная диэлектрическая проницаемость кремния
. Относительная диэлектрическая проницаемость кремния  =12. Варианты заданий даны в табл.5.2.
=12. Варианты заданий даны в табл.5.2.










 ; (6.1)
; (6.1) . (6.2)
. (6.2) ,
, . (6.3)
. (6.3) .
.


 ;
; находим:
находим: Ом.
Ом.
 Ом
Ом  .
. , то отсюда найдём
, то отсюда найдём 


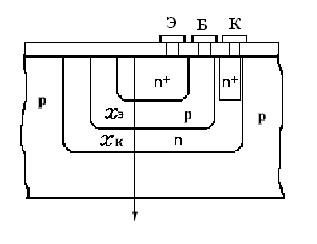












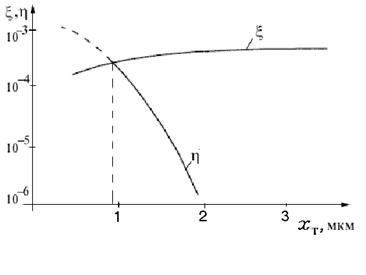

 , зная
, зная  и
и  (см. рис. 11.2),
(см. рис. 11.2),  ;
;
 ;
;  ;
;  ,
, .
. ,
, , ( 11.1 )
, ( 11.1 ) нормированная (приведенная) крутизна;
нормированная (приведенная) крутизна; ( 11.2 )
( 11.2 )
 .
. и подставив значение
и подставив значение  (11.1), получим
(11.1), получим ( 11.3 )
( 11.3 )

 , разность напряжений
, разность напряжений 


