
Заглавная страница Избранные статьи Случайная статья Познавательные статьи Новые добавления Обратная связь КАТЕГОРИИ: ТОП 10 на сайте Приготовление дезинфицирующих растворов различной концентрацииТехника нижней прямой подачи мяча. Франко-прусская война (причины и последствия) Организация работы процедурного кабинета Смысловое и механическое запоминание, их место и роль в усвоении знаний Коммуникативные барьеры и пути их преодоления Обработка изделий медицинского назначения многократного применения Образцы текста публицистического стиля Четыре типа изменения баланса Задачи с ответами для Всероссийской олимпиады по праву 
Мы поможем в написании ваших работ! ЗНАЕТЕ ЛИ ВЫ?
Влияние общества на человека
Приготовление дезинфицирующих растворов различной концентрации Практические работы по географии для 6 класса Организация работы процедурного кабинета Изменения в неживой природе осенью Уборка процедурного кабинета Сольфеджио. Все правила по сольфеджио Балочные системы. Определение реакций опор и моментов защемления |
Принцип работы МДП-полевых транзисторов. Эффект поля.
В МДП-полевых транзисторах, в отличие с управляющим р-п -переходом, затвор выполнен в виде металлической пленки, изолированный от канала тонким слоем диэлектрика, поэтому иногда эти транзисторы называют полевыми транзисторами с изолированным затвором. На рисунке 9.1, а приведена структура МДП-транзистора с
а) б) Рис.9.1. Структура МДП полевого транзистора с каналом п -типа проводимости (а) и р-типа проводимости (б)
каналом п -типа проводимости. Транзистор создается на основе слаболегированной кремниевой подложки р -типа. На поверхности подложки создаются две сильнолегированные истоковая и стоковая области п+- типа, причем эти области обратимы, т.е. любая из них может использоваться в качестве истока и стока. Расстояние между этими областями, называемое длиной канала L, составляет от десятых долей до нескольких микрометров. На поверхности канала затем методом термического окисления формируется слой двуокиси кремния SiO2, толщиной порядка 0,1 мкм. На слой диэлектрика SiO2 и на поверхность истоковой и стоковой областей наносится тонкий слой металлической пленки обычно алюминиевая для формирования омических выводов затвора, истока и стока. Если область канала имеет тип проводимости как и подложка, т.е. он р -типа, то канал при отсутствии напряжения на затворе является непроводящим и ток стока будет отсутствовать. Однако, при некотором положительном напряжении на затворе, называемым пороговым, в канале индуцируется электронная проводимость и канал становится проводящим. Такие транзисторы называются транзисторами с индуцированным каналом. Если же область канала легирован донорами, то он становится проводящим даже при напряжении на затворе равным нулю, то такие транзисторы называются транзисторами со встроенным каналом. Если в качестве подложки использовать кремний п -типа проводимости, то аналогично можно получить МДП-транзистор с каналом р -типа проводимости (рис.9.1, б) Как видно из рисунка 9.1, затворы транзисторов имеют МДП-структуру. Принцип работы таких транзисторов основан на явлении эффекта поля, наблюдаемого в МДП-структурах. Явление состоит в изменение проводимости полупроводника в МДП-структурах на границе с диэлектриком в зависимости от величины и полярности приложенного на неё напряжения.
Рассмотрим более подробно явление эффекта поля в МДП-структуре. Для создания такой структуры с одной стороны полупроводниковой пластины кремния (3) формируется омический контакт (4), а на другой поверхности методом окисления наносится тонкий слой диэлектрической пленки SiO2(2), на поверхность которой в свою очередь прижимается металлический электрод (1) (рис..8.2).
Рис.9.2. Структура металл-диэлектрик- полупроводник
Рассмотрим полупроводник п -типа проводимости. Предположим вначале, что поверхностные состояния в полупроводнике отсутствуют. При приложении к такой структуре внешнего напряжения VВ в слое диэлектрика создается сильное электрическое поле, которое оказывает заметное влияние на зарядовое состояние поверхности полупроводника на границе с диэлектриком. Так, например если к металлическому электроду приложено положительная полярность внешнего напряжения, а к омическому контакту – отрицательная полярность, то электроны из приповерхностной области будут выталкиваться полем в объем полупроводника. Это приводит к обеднению приповерхностной области полупроводника основными носителями – электронами. Такой режим работы МДП-структуры называется режимом обеднения полупроводника основными носителями тока. Поверхность полупроводника при этом заряжается положительно за счет нескомпенсированных ионов донорной примеси и дырками, втянутыми на поверхность внешним полем из объема. Обеднение приповерхностной области приводит к уменьшению поверхностной проводимости полупроводника. С ростом внешнего поля обеднение основными носителями растет, проводимость уменьшается. Однако при некотором внешнем поле число втянутых к поверхности дырок может превышать число электронов – наступает инверсия поверхностной проводимости: проводимость полупроводника п -типа становится проводимостью р -типа. На поверхности полупроводника на границе с диэлектриком возникает инверсионный дырочный слой. Напряжение, при котором происходит инверсия проводимости, называется пороговым напряжением. При дальнейшем росте внешнего поля концентрация дырок у поверхности возрастает, т.е. полупроводник обогащается неосновными носителями заряда, что приводит к росту поверхностной проводимости. Таким образом, поверхностная проводимость в зависимости от величины внешнего поля проходит через минимум. На.рисунке 9.3 приведен график зависимости поверхностной
Рис.9.3. Зависимость поверхностной проводимости полупроводника МДП –структуры от величины внешнего потенциала.
проводимости
где п i – собственная концентрация носителей тока. Как видно из (9.1), минимум кривой с ростом степени легирования пп – смещается влево. При обратной полярности внешней разности потенциалов поверхность полупроводника под диэлектриком обогащается основными носителями заряда – электронами, которые втягиваются внешним полем из объема к поверхности. Возникает режим обогащения полупроводника основными носителями заряда. В результате поверхностная проводимость будет возрастать. На рисунке 9.3 этому соответствует область кривой при положительных потенциалах Для полупроводника р -типа проводимости характер зависимости При наличии поверхностных состояний эффект поля ослабляется. Это объясняется тем, что заряд на поверхностных состояниях экранирует внешнее электрическое поле и оно проникает в полупроводник на меньшую глубину. С ростом концентрации поверхностных состояний изменение поверхностной проводимости в эффекте поля уменьшается. 9.2. МДП-полевой транзистор с индуцированным каналом п -типа. Приведенная на рисунке 9.1 структура МДП-полевого транзистора соответствует транзистору с индуцированным каналом. Между стоком и затвором канал в этом транзисторе отсутствует. Поэтому, если даже приложит между стоком и затвором напряжение VСИ > 0 (рис. 9.4, а), то при VЗИ = 0 ток стока будет практически
а) б)
Рис. 9.4. Структура МДП транзисторов с индуцированными каналами п -типа (а) и р-типа (б) и их электрическая схема включения. отсутствовать, так как на пути тока у стоковой области создается обратно включенный р-п переход. Если теперь приложить напряжение VЗИ > 0, то под действием электрического поля затвора к приповерхностной области полупроводника под диэлектриком затвора начинают втягиваться из глубины полупроводника неосновные носители заряда – электроны. С ростом напряжения VЗИ при его значении VЗИ = VЗИпор происходит инверсия проводимости: в приповерхностной области затвора проводимость полупроводника из р -типа становится п -типа проводимости. Таким образом, между стоком и истоком индуцируется канал (на рисунке 9.4 граница индуцированного канала с подложкой обозначен штриховой линией) и в цепи стока потечет ток истока IC, обусловленный дрейфовым движением электронов от истока к стоку.
Из общих рассуждений следует, что ток стока зависит как от напряжения на затворе VЗИ, так и от напряжения на стоке VСИ. Отсюда следует, что работа этого транзистора как и транзистора с управляющим р-п переходом, будет описываться двумя семействами характеристик: стоко-затворной На рисунке 9.5, а представлены стоко-затворные (передаточные) и на рисунке 9.5, б – выходные вольтамперные характеристики МДП-транзистора с индуцированным каналом п -типа. Как видно из рисунка 9.5, а при VЗИ > VЗИпор ток стока растет, что обусловлен обогащением канала транзистора с ростом VЗИ неосновными носителями тока и увеличением его проводимости. Рост напряжения VСИ смещает характеристику вправо в сторону увеличения тока стока. Выходные характеристики (рис. 9.5, б) аналогичны характеристикам полевых транзисторов с управляющим р-п переходом. При малых напряжениях VСИ ток стока практически линейно растет с ростом VСИ - имеем омический участок. Однако при некотором VСИ = VСИгр наступает участок насыщения тока стока. Как и в случае полевых транзисторов с управляющим р-п переходом,
а) б) Рис.9.5. Статические стоко-затворные (а) и выходные (стоковые) (б) характеристики МДП полевого транзистора с индуцированным каналом п -типа.
насыщение тока стока обусловлено сужением и дальнейшим перекрытием канала в стоковом конце за счет расширения р-п перехода в область канала. Действительно, за счет протекания тока стока вдоль канала создается распределенное падение напряжения V(x), которое максимально в стоковом конце и равно VСИ. Это напряжение, суммируясь с напряжением VЗИ, смещает р-п переход в обратном направлении, что и сужает ширину канала. Механизм протекания тока стока через перекрытый канал в стоковом конце практически такой же, как и в полевых транзисторов с управляющим р-п переходом (см.раздел 8.2). В случае МДП-транзистора с индуцированным каналом р -типа (рис. 9.4, б) имеем аналогичные физические процессы и статические вольтамперные характеристики, только меняются термины электроны на дырки и наоборот, а также меняются полярности приложенных напряжений на электродах и направление тока стока.
|
|||||||
|
Последнее изменение этой страницы: 2021-05-27; просмотров: 122; Нарушение авторского права страницы; Мы поможем в написании вашей работы! infopedia.su Все материалы представленные на сайте исключительно с целью ознакомления читателями и не преследуют коммерческих целей или нарушение авторских прав. Обратная связь - 3.21.233.41 (0.008 с.) |



 как функция от потенциала
как функция от потенциала  , представляющего собой часть внешней разности потенциала, определяющего эффект поля. Минимум кривой, как показывают расчеты, определяется формулой:
, представляющего собой часть внешней разности потенциала, определяющего эффект поля. Минимум кривой, как показывают расчеты, определяется формулой: , (9.1)
, (9.1) сохраняется, однако меняется полярность потенциала и минимум кривой с ростом легирования смещается вправо.
сохраняется, однако меняется полярность потенциала и минимум кривой с ростом легирования смещается вправо.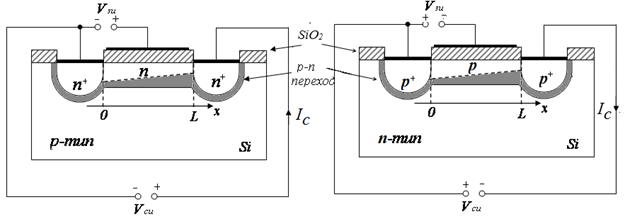
 при
при  и выходной
и выходной  при
при  .
.




