
Заглавная страница Избранные статьи Случайная статья Познавательные статьи Новые добавления Обратная связь FAQ Написать работу КАТЕГОРИИ: ТОП 10 на сайте Приготовление дезинфицирующих растворов различной концентрацииТехника нижней прямой подачи мяча. Франко-прусская война (причины и последствия) Организация работы процедурного кабинета Смысловое и механическое запоминание, их место и роль в усвоении знаний Коммуникативные барьеры и пути их преодоления Обработка изделий медицинского назначения многократного применения Образцы текста публицистического стиля Четыре типа изменения баланса Задачи с ответами для Всероссийской олимпиады по праву 
Мы поможем в написании ваших работ! ЗНАЕТЕ ЛИ ВЫ?
Влияние общества на человека
Приготовление дезинфицирующих растворов различной концентрации Практические работы по географии для 6 класса Организация работы процедурного кабинета Изменения в неживой природе осенью Уборка процедурного кабинета Сольфеджио. Все правила по сольфеджио Балочные системы. Определение реакций опор и моментов защемления |
Свойства диэлектрических пленокСодержание книги
Поиск на нашем сайте
Во время окисления часть растущей диэлектрической пленки формируется за счет Si подложки. Поскольку Si подложка, как правило легирована, то на границе раздела между SiО2 и Si происходит перераспределение примеси. Явление перераспределения примеси получила название сегрегации. Для количественной характеристики данного явления вводится коэффициент сегрегации (m), показывающий во сколько раз растворимость примеси в кремнии больше, чем в окисле, одно из важных свойств окислов. m(p)=10 следовательно во время окисления происходит выдавливание Р из пленки SiО2 и обогащение им поверхности Si пластины. m(p)=0,3 следовательно при окислении атомы В обедняют поверхность Si и переходят в окисел.
Наибольший интерес с точки зрения электрофизических характеристик имеют структуры Si – SiО2 – Ме, является основой большинства современных интегральных МС. Электрофизические характеристики данных структур в основном определяются зарядовым состоянием окисной пленки и границей раздела Si–SiО2. рассмотрим классификацию зарядов, присутствующих в данной структуре.
Qit заряд на поверхностных состояниях, возникает на границе раздела Si подложки с SiО2 и обусловлен нарушением кристаллической решетки на поверхности Si. Энергетически поверхностные состояния располагаются в запретной зоне кремния. В зависимости от расположения поверхностного состояния в 33 Si они могут быть как акцепторными так и донорными. В зависимости от прикладываемого напряжения к Ме электроду поверхностное состояние способно, как накапливать так и отдавать свой заряд. Перезарядка поверхностного состояния, как правило отрицательно влияет на электрофизические характеристики п/п приборов, поэтому на практике стараются min плотность поверхностного состояния Qf фиксированный «+» заряд. Локализованый в приповерхностной области пленки SiО2 с нарушенной стехиометрией (SiОх х Qm подвижный заряд окисла, всегда «+». Данный заряд располагается по всему объёма окисла и обусловлен наличием ионов щелочных Ме (Li, Na, K), а так же ионами Н2. Современные методы окисления позволяют min подвижные «+» заряды и свести к min влияние на электрофизические параметры п/п. Q0t заряд, накапливающийся на исходные ловушечные центры в объёме пленки SiО2. В зависимости от энергетического расположения центров на них может накапливаться, как «+», так и «-» заряд. Накопление данного заряда в основном происходит при стрессовых воздействиях на структуры Si–SiО2–Ме (радиационного поля). Qt заряд, накапливается на ловушечные центры, возникающие в окисле в процессе стрессовых воздействий. Основными методами контроля зарядовых характеристик Si–SiО2–Ме является метод изменения ВФХ (вольт-фарадных характеристик). Данный метод заключается в измерении емкости данной структуры в зависимости от приложенного напряжения. В зависимости от частоты сигнала, на которой производится измерение емкости структуры различают ВЧ и НЧ ВФХ. В технологии производства ИМС наибольшее распространение получил метод ВЧ ВФХ, измерение емкости, в которых обычно проводится на частоте от 100кГц до 1 МГц. Упрощенная схема для измерения ВЧ ВФХ, использующих емкостной делитель имеет вид.
Выделение сигнала пропорционально емкости МДП структуры происходит на емкостном делителе Cи
Заряд на поверхностных состояниях приводит к уменьшению наклона ВФХ.
0 – исходная (теоретическая) 1 – с «+» зарядом
Фиксирующий положение заряд приводит к смещению ВФХ в область отрицательных напряжений
0 – исходная (теоретическая) 1 – с «+» зарядом Подвижный «+» заряд. Для контроля величины Qm в технологии производства ИМС обычно используют метод термополевой обработки ТПО. Который заключается в выдержке МДП при повышенной температуре и +U на затворе. В результате такой выдержки большая часть Qm накапливается на границе раздела Диэлектрик-п/п, затем структуру охлаждают и отключают внешнее поле.
Контроль величины Qm обычно проводят, измеряя ВФХ до и после ТПО обработки. Для минимизации величины Qm в подзатворном диэлектрике МДП ИМС часто применяют 2-хслойные диэлектрики.
Интегральная характеристика зарядного состояния диэлектрической пленки при контроле ее параметров методом ВФХ является напряжение отсечки.
|
||||
|
Последнее изменение этой страницы: 2017-02-19; просмотров: 373; Нарушение авторского права страницы; Мы поможем в написании вашей работы! infopedia.su Все материалы представленные на сайте исключительно с целью ознакомления читателями и не преследуют коммерческих целей или нарушение авторских прав. Обратная связь - 18.119.253.198 (0.005 с.) |

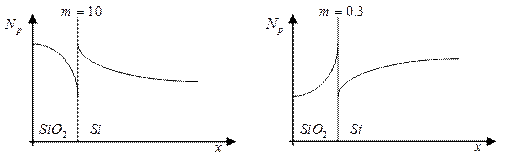

 (min достижения плотность состояния).
(min достижения плотность состояния). (1…2)). Толщина SiОх ≈50
(1…2)). Толщина SiОх ≈50  . На практике при современных способах получения пленки SiО2 фиксируемых заряд имеет небольшую величину и не оказывает электрофизического влияния на характеристики п/п прибора.
. На практике при современных способах получения пленки SiО2 фиксируемых заряд имеет небольшую величину и не оказывает электрофизического влияния на характеристики п/п прибора.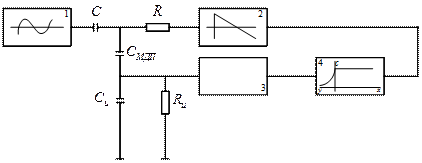


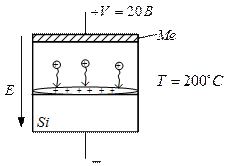
 Метод ВФХ в технологии ИМС используется не только для контроля диэлектрических пленок, но и для оценки чистоты и качества технологического оборудования, а так же качества исходных п/п пластин.
Метод ВФХ в технологии ИМС используется не только для контроля диэлектрических пленок, но и для оценки чистоты и качества технологического оборудования, а так же качества исходных п/п пластин.




