
Заглавная страница Избранные статьи Случайная статья Познавательные статьи Новые добавления Обратная связь КАТЕГОРИИ: ТОП 10 на сайте Приготовление дезинфицирующих растворов различной концентрацииТехника нижней прямой подачи мяча. Франко-прусская война (причины и последствия) Организация работы процедурного кабинета Смысловое и механическое запоминание, их место и роль в усвоении знаний Коммуникативные барьеры и пути их преодоления Обработка изделий медицинского назначения многократного применения Образцы текста публицистического стиля Четыре типа изменения баланса Задачи с ответами для Всероссийской олимпиады по праву 
Мы поможем в написании ваших работ! ЗНАЕТЕ ЛИ ВЫ?
Влияние общества на человека
Приготовление дезинфицирующих растворов различной концентрации Практические работы по географии для 6 класса Организация работы процедурного кабинета Изменения в неживой природе осенью Уборка процедурного кабинета Сольфеджио. Все правила по сольфеджио Балочные системы. Определение реакций опор и моментов защемления |
Транзистор как четырехполюсникСтр 1 из 4Следующая ⇒
Биполярные транзисторы 3.1. Устройство и принцип действия Транзистором обычно называют полупроводниковый электропреобразовательный прибор с двумя или более электронно-дырочными переходами, предназначенный для усиления электрических сигналов. Структура его содержит три области с чередующимся типом электропроводности p-n-p или n-p-n (рис. 3.1), а условное обозначение показано на рис. 3.2.
Рис. 3.1 Рис. 3.2 Одна из крайних областей называется эмиттером (Э) и служит инжектором основных носителей в среднюю область, другая крайняя область предназначена для экстракции носителей из средней области и носит название коллектора (К). Средняя область называется базой (Б), является управляющей и образует два электронно-дырочных перехода − эмиттерный и коллекторный. Эмиттерный переход является управляющим по отношению к коллекторному, при этом инжектированные через эмиттерный переход носители могут дойти до коллекторного перехода через управляющую область. Рассмотрим работу транзистора структуры p-n-p в активном режиме (АР), т.е. когда эмиттерный переход смещён в прямом направлении, а коллекторный – в обратном (рис. 3.3).
Рис. 3.3
В результате снижения потенциального барьера эмиттерного перехода происходит инжекция дырок в область базы и затем, вследствие возникшего градиента концентрации, – диффузионное движение в сторону коллекторного перехода. Часть носителей рекомбинирует в области базы и на её поверхности, а остальные дырки доходят до коллекторного перехода и втягиваются под воздействием ускоряющего поля U кб в область коллектора, т.е. происходит их экстракция. При этом в область коллектора поступает такое же количество электронов от источника U кб. Таким образом, через эмиттерный и коллекторный переход протекают токи I Э и I К соответственно, направления которых в выводе базы противоположны. Ширина базы транзистора выбирается такой, чтобы время жизни носителей в базе было больше их времени пребывания в базе, поэтому их рекомбинация невелика, и ток коллектора незначительно отличается от тока эмиттера. Рассмотрим эти процессы более подробно. В активном режиме в транзисторе типа p-n-p протекают следующие процессы: – инжекция основных носителей области эмиттера дырок через эмиттерный переход в область базы, а электронов из базы в область эмиттера;
– диффузионное перемещение инжектированных в базу дырок, – экстракция дырок, подошедших к коллекторному переходу под воздействием его ускоряющего поля в область коллектора. Каждый из перечисленных процессов характеризуется соответствующим параметром. В транзисторе типа n-p-n механизм инжекции и диффузии носителей сохраняется тот же, что и в транзисторе типа p-n-p, но рабочий ток создаётся в этом транзисторе не дырками эмиттерной области, а электронами. В транзисторах обычно концентрация примесей, а, следовательно, и основных носителей в эмиттерной области значительно больше, чем в области базы. Поэтому в транзисторе типа p-n-p
Полный ток через эмиттерный переход
где I э р − дырочный ток, I э n − электронный ток, I эо −− обратный ток эмиттерного перехода. Основную часть полного тока составляет дырочный, созданный
Учитывая, что толщина базы
В этом выражении Коллекторное напряжение Токи I эри I к р пропорциональны градиентам концентрации соответственно при х = 0 и x = Из уравнения непрерывности можно найти коэффициент переноса:
где Lp б – диффузионная длина дырок в базе. Чтобы получить большие значения При значениях Экстракция неосновных носителей базы через коллекторный переход характеризуется коэффициентом, указывающим на эффективность коллектора:
Интегральным коэффициентом передачи эмиттерного тока называется отношение
Из изложенного выше следует, что
Распределение токов в цепях транзистора типа p-n-p в общем В эмиттерной области вдали от перехода, где инжектированные электроны полностью рекомбинируют, ток принимает чисто дырочный характер, а во внешней цепи он будет создаваться электронами. Ток через коллекторный переход I к состоит из тока экстракции неравновесных дырок из базы в коллектор через переход:
и тока экстракции неосновных носителей области коллектора (электронов) через переход, т.е. обратного тока коллекторного перехода двух дополнительных токов: электронного, направленного электрическим полем в переходе в сторону базы, и дырочного, направленного в сторону коллектора и возникающих при наличии лавинного умножения носителей в результате ударной ионизации в коллекторном переходе. По величине эти токи одинаковы. Таким образом, результирующий ток в коллекторной области
Ток, протекающий через вывод базы, равен разности эмиттерного и коллекторного токов:
Из полученной формулы следует, что ток базы может изменять свое направление. При малых значениях входного напряжения
Коэффициент передачи по току, приводимый в справочниках, чаще всего является дифференциальным параметром:
Он связан со статическим следующим соотношением, которое получается при дифференцировании выражения (3.10):
Их отличие незначительно, и с достаточной точностью можно считать статический коэффициент равным дифференциальному:
Несмотря на то, что
где
Кроме рассмотренного активного режима работы (АР), транзистор в ряде случаев может работать в режиме отсечки (РО) или в режиме насыщения (РН). В режиме отсечки оба перехода смещены в обратном направлении и через них протекают обратные токи, обусловленные процессами тепловой генерации носителей в объеме полупроводника в областях объёмного заряда и на невыпрямляющих контактах, а также токи утечки. При больших напряжениях происходит лавинное размножение носителей. В режиме насыщения в прямом направлении включен не только эмиттерный, но и коллекторный переход. Основными процессами в этом режиме являются накопление носителей в базе и их интенсивная рекомбинация. В режиме насыщения ток базы может быть сравним с током эмиттера. В некоторых случаях используется инверсный режим работы, т.е. такой, когда эмиттерный переход смещается в обратном направлении, а коллекторный – в прямом, т.е. функции коллектора и эмиттера меняются местами. В зависимости от того, какой вывод транзистора при использовании его в схеме является общим для входной и выходной цепи, различают три схемы включения: с общей базой, с общим эмиттером и общим коллектором (рис 3.4, а, б, в).
Рис. 3.4 Для оценки усилительных свойств транзистора чаще всего, как это мы видели, используется такой параметр как коэффициент передачи по току Для схемы с общей базой (рис. 3.4, а) Схемас общим эмиттером (рис. 3.4, б) характеризуется коэффициентом передачи по току Третьей схемой включения является схема с общим коллектором (рис. 3.4, в), имеющая самое высокое входное (десятки килоом – мегаомы), самое низкое выходное сопротивление (единицы – десятки ом), не изменяет фазу передаваемого сигнала. Коэффициент передачи по току примерно такой же, как в схеме с общим эмиттером, однако данная схема не даёт усиления по напряжению, поэтому называют её еще эмиттерный повторитель. Коэффициент передачи по напряжению Кu = 0,90…0,99.
Чаще всего в усилителях используется схема с общим эмиттером, которая даёт наиболее высокое усиление по мощности. Связь между коэффициентами передачи по току для разных схем включения устанавливается с помощью следующих выражений: – для схемы с общей базой:
– с общим эмиттером:
– для схемы с общим коллектором:
Другие формулы пересчета имеют вид:
В справочниках приводится обычно коэффициент передачи по току для схемы включения либо с общей базой, либо для схемы с общим эмиттером, поэтому в случае необходимости используют формулы пересчета. Работа транзистора В режиме переключения Транзисторы часто используют в переключающих и импульсных схемах. При этом от транзистора требуется, как правило, неискаженное воспроизведение усиленного импульса на выходе. Работа транзистора в качестве усилителя малых импульсных сигналов в принципе ничем не отличается от работы транзистора как усилителя малых синусоидальных сигналов. Импульс можно представить в виде суммы ряда гармонических составляющих и, зная частотные свойства транзистора, определить искажения формы импульса, которые могут иметь место при усилении. Рассмотрим работу транзистора как усилителя больших импульсных сигналов. В таких случаях нельзя использовать малосигнальные параметры транзистора, а также его обычные эквивалентные схемы. Кроме того, транзистор в переключающих и импульсных схемах часто работает не только в активном режиме, но и в режимах отсечки и насыщения.
3.9.1. Схема с общей базой Рассмотрим процессы, происходящие в транзисторе, включенном по схеме с общей базой, при подаче через эмиттер импульса тока длительностью tимп в прямом направлении с последующим измением полярности (рис. 3.22, а).
Рис. 3.22 В исходном состоянии транзистор находится в режиме отсечки, т. е. эмиттерный и коллекторный переходы закрыты. После подачи на эмиттер импульса тока в прямом направлении ток коллектора появляется не сразу из-за конечного времени передвижения инжектированных носителей заряда до коллекторного перехода и наличия барьерных емкостей (рис. 3.22, б ). Время, на которое появление коллекторного тока отстает от эмиттерного, называют временем з а д е р ж к и t 3. Процесс установления тока коллектора характеризуется длительностью переднего фронта импульса t ф1 (рис. 3.22, б ). Завремя переднего фронта импульса тока коллектора в базе транзистора происходит накопление неосновных носителей заряда, что можно пояснить с помощью рис. 3.22, в,где показаны кривые распределения неосновных носителей в базе транзистора в различные моменты времени. Напряжение на эмиттерном переходе растет медленно из-за заряда емкости эмиттерного перехода, что соответствует увеличению со временем ординаты, отсекаемой кривыми распределения неосновных носителей со стороны эмиттерного перехода. Градиент концентрации неосновных носителей около эмиттера, соответствующий величине инжекционной составляющей тока, растет со временем в связи с уменьшением емкостной составляющей тока эмиттера. В процессе накопления неосновных носителей в базе транзистора происходит увеличение тока коллектора. Однако ток коллектора не может возрастать неограниченно, так как в практически осуществляемых схемах в цепь коллектора включается сопротивление нагрузки. Действительно, на сопротивление нагрузки приходится какая-то часть напряжения источника питания выходной цепи транзистора, в результате чего доля напряжения, приходящаяся на коллекторный переход, уменьшается по мере увеличения тока коллектора. При определенных токе эмиттера и напряжении на эмиттере концентрация неосновных носителей в базе около коллектора может превысить равновесное значение, что будет соответствовать изменению знака напряжения на коллекторном переходе, т. е. переходу транзистора в режим насыщения. В этот момент (кривая 4 на рис. 3.22, в ) ток коллектора определяется сопротивлением нагрузки и ЭДС источника питания в цепи коллектора I к макс≈ U ип / R К . (3.43) Значение тока коллектора определяется не только ЭДС источника EКБ питания в цепи коллектора, но и падением напряжения на объемном сопротивлении базы при прохождении по нему тока. При прохождении через эмиттер тока в прямом направлении падение напряжения на объемном сопротивлении базы, как видно из рис. 3.23, должно складываться с ЭДС источника питания в коллекторной цепи:
Рис. 3.23 После входа транзистора в режим насыщения процесс накопления неосновных носителей заряда в базе и коллекторе транзистора еще некоторое время продолжается. Длительность переднего фронта импульса тока коллектора зависит от амплитуды импульса прямого тока эмиттера и от частотных свойств транзистора. В момент изменения направления тока эмиттера происходит
Одновременно начинается процесс рассасывания неосновных носителей заряда, накопленных в области базы транзистора. В первый момент после изменения направления тока эмиттера концентрация неосновных носителей в базе около p-n -переходов эмиттера и коллектора велика. Поэтому сопротивления этих p-n -переходов для обратных токов малы. Значит, величина обратного тока эмиттера и тока коллектора после переключения определяется сопротивлениями во внешних цепях. Концентрация неосновных носителей в базе около р-п- переходов не может мгновенно уменьшиться до нуля. Это соответствовало бы бесконечно большим величинам градиентов концентрации неосновных носителей заряда в базе около p-n -переходов и бесконечно большим токам, чего практически быть не может из-за конечных величин сопротивлений во внешних цепях транзистора. До тех пор, пока в процессе рассасывания концентрации неосновных носителей около р-n- переходов не достигнут нуля, обратные токи через соответствующие p-n -переходы будут оставаться постоянными, т. е. токи эмиттера и коллектора будут неизменными, пока транзистор находится в режиме насыщения. Время, в течение которого транзистор находится в режиме насыщения после окончания импульса прямого тока эмиттера, называют временем рассасывания( Значения времени рассасывания Увеличить быстродействие транзистора, работающего в качестве Однако наряду с высоким быстродействием такие транзисторы обладают 3.9.2. Схема с общим эмиттером В транзисторе, включенном по схеме с общим эмиттером, при работе на импульсах с большой амплитудой происходят те же процессы накопления неосновных носителей заряда в базе и их рассасывания. На рис. 3.24, а, б показаны временные зависимости тока базы и тока коллектора при включении транзистора по схеме с общим эмиттером.
Рис. 3.24
Особенностью временной зависимости в этом случае, по сравнению с аналогичной зависимостью для схемы с общей базой, является скачкообразное увеличение тока коллектора при перемене направления входного тока базы с
Рис. 3.25 Транзисторов от температуры 3.10.1. Зависимость параметров от температуры Для анализа влияния температуры на параметры и характеристики биполярного транзистора приведем эквивалентную схему замещения (рис. 3.26, а, б) в области низких частот для схемы включения с общей базой и общим эмиттером соответственно. а б Рис. 3.26 На этих схемах: r э – сопротивление эмиттера
r к – сопротивление коллектора:
Сопротивление базы
где
Все рассмотренные параметры физической эквивалентной схемы замещения транзистора определённым образом зависят от температуры. Сопротивление эмиттерного перехода транзистора зависит от температуры следующим образом:
где k –постоянная Больцмана;
q – заряд электрона;
Из выражения (3.51) следует, что с ростом температуры при постоянстве тока эмиттера сопротивление r Эвозрастает. Диффузионное сопротивление базы определяется выражением где β– коэффициент передачи по току в схеме с общим эмиттером, который при неизменном токе эмиттера также увеличивается с возрастанием температуры. Сопротивление коллектора бездрейфового транзистора в случае резкого электронно-дырочного перехода:
где U КБ – напряжение, приложенное между базой и коллектором; W – толщина базы;
Для дрейфового транзистора:
Для того чтобы выяснить влияние температуры на сопротивление коллекторного перехода, необходимо рассмотреть температурную зависимость параметров, входящих в выражения (3.53, 3.54). Известно, что
где α– коэффициент передачи по току в схеме с общей базой, который определяется выражением:
Здесь γ – коэффициент инжекции (эффективность эмиттера); αп – коэффициент переноса; С увеличением температуры несколько возрастает коэффициент переноса Ток эмиттера связан с температурой следующей зависимостью:
где
Поскольку qU ЭБ < Δ E, то с увеличением температуры ток эмиттера возрастает по экспоненциальному закону и особенно заметно изменяется при высоких температурах. Коллекторный переход является несимметричным и его толщина определяется следующим образом:
где Поскольку обычно U КБ >> φк, то основное влияние на толщину перехода оказывает изменение концентрации носителей под влиянием температуры. Так как концентрация носителей увеличивается с ростом температуры, то толщина перехода падает. Таким образом, учитывая сказанное, можно ожидать, что при не очень высокой температуре наиболее значительное влияние будет оказывать увеличение параметра β, что вызовет увеличение сопротивления коллекторного перехода, а при более высокой температуре будет наблюдаться уменьшение r к вследствие преобладающего влияния возрастания тока эмиттера. Обратный ток коллекторного перехода:
При
Для германиевого перехода Зависимость рассмотренных параметров физической эквивалентной схемы от температуры приведена на рис. 3.27. Рис. 3.27 H-параметры связаны с параметрами физической эквивалентной схемы выражениями:
На практике обычно возникает обратная задача – по известным h -параметрам найти физические параметры:
Температурная зависимость h -параметров показана на рис. 3.28, а, б.
а
б Рис. 3.28 3.10.2. Температурная зависимость характеристик транзистора С ростом температуры ток эмиттера, как это видно из формулы (3.57), значительно увеличивается, и входная характеристика для схемы включения с общей базой принимает вид, показанный на рис. 3.29.
Рис. 3.29 Смещение характеристик составляет примерно (– 1…2) мВ/°С. Выходной ток – ток коллектора I к определяется выражением:
Откуда при постоянстве тока эмиттера абсолютное изменение тока коллектора:
Относительное изменение:
Поскольку изменение коэффициента
Рис. 3.30 Для схемы включения с общим эмиттером входным током является ток базы, который приближённо определяется из формул Эберса–Молла следующим образом:
где α N – коэффициент передачи эмиттерного тока при нормальном включении транзистора; α I – коэффициент передачи коллекторного тока при инверсном включении;
I ЭБК и I КБК – обратные токи эмиттерного и коллекторного переходов соответственно. Входные характеристики, снятые при разных температурах, пересекаются, так как отдельные члены, входящие в выражение (20), по разному зависят от температуры (рис. 3.31).
Рис. 3.31 Ток коллектора для схемы включения с общим эмиттером записывается в виде
Относительная нестабильность тока коллектора при I Б = const составляет:
т.е. увеличивается по сравнению со схемой включения с общей базой примерно в (β+1) раз. Из этого выражения видно, что дрейф выходных характеристик транзистора, включенного по схеме с ОЭ, составляет очень большую величину. Если, например, в диапазоне температур в схеме с ОБ дрейф выходных характеристик будет иметь величину несколько процентов, то для схемы с ОЭ этот дрейф будет составлять несколько сотен процентов. На рис. 3.32 приведены выходные характеристики транзистора для схемы с ОЭ, исследованные при нескольких значениях температур.
Рис. 3.32
|
|||||||||
|
Последнее изменение этой страницы: 2017-01-24; просмотров: 221; Нарушение авторского права страницы; Мы поможем в написании вашей работы! infopedia.su Все материалы представленные на сайте исключительно с целью ознакомления читателями и не преследуют коммерческих целей или нарушение авторских прав. Обратная связь - 3.133.131.168 (0.147 с.) |


 концентрация неосновных носителей определяется из условия:
концентрация неосновных носителей определяется из условия: .
. , (3.1)
, (3.1) . (3.2)
. (3.2)
 гораздо меньше диффузионной длины дырок в базе L pб после преобразований получим:
гораздо меньше диффузионной длины дырок в базе L pб после преобразований получим: , (3.3)
, (3.3) и
и  − удельные электрические проводимости соответственно базы и эмиттера;
− удельные электрические проводимости соответственно базы и эмиттера;  − диффузионная длина электронов в области эмиттера. Таким образом, для получения высокого значения коэффициента инжекции
− диффузионная длина электронов в области эмиттера. Таким образом, для получения высокого значения коэффициента инжекции  , приближающегося к единице, необходимо выполнить три условия: во-первых,
, приближающегося к единице, необходимо выполнить три условия: во-первых,  , пропорциональное квадрату их диффузионной длины
, пропорциональное квадрату их диффузионной длины  , должно быть велико. В транзисторах можно получить коэффициент инжекции порядка 0,995 и выше. Выражение (3.3) действительно лишь для малых концентраций инжектированных носителей.
, должно быть велико. В транзисторах можно получить коэффициент инжекции порядка 0,995 и выше. Выражение (3.3) действительно лишь для малых концентраций инжектированных носителей. в основном падает на коллекторном переходе, имеющем большое обратное сопротивление. Падением напряжения в базовой области в первом приближении можно пренебречь и считать движение инжектированных дырок, которые являются в базе неравновесными носителями, чисто диффузионным, возникающим благодаря наличию градиента концентрации дырок в базе dp/dx. Параметром, характеризующим перенос неравновесных неосновных носителей в базе, служит коэффициент переноса αп (или иначе эффективность переноса), определяемый как отношение тока I к р неосновных носителей, подошедших к коллекторному переходу, к току I э р неосновных носителей, инжектированных из эмиттера в базу (т. е. дырок в p-n-p -транзисторе):
в основном падает на коллекторном переходе, имеющем большое обратное сопротивление. Падением напряжения в базовой области в первом приближении можно пренебречь и считать движение инжектированных дырок, которые являются в базе неравновесными носителями, чисто диффузионным, возникающим благодаря наличию градиента концентрации дырок в базе dp/dx. Параметром, характеризующим перенос неравновесных неосновных носителей в базе, служит коэффициент переноса αп (или иначе эффективность переноса), определяемый как отношение тока I к р неосновных носителей, подошедших к коллекторному переходу, к току I э р неосновных носителей, инжектированных из эмиттера в базу (т. е. дырок в p-n-p -транзисторе):  . (3.4)
. (3.4) , (3.5)
, (3.5) , приближающиеся к единице, следует уменьшить вероятность рекомбинации неосновных носителей в базе, для чего нужно, во-первых, уменьшить толщину базы w б и, во-вторых, увеличить диффузионную длину дырок в базе Lp б. Последнее достигается уменьшением концентрации донорных примесей, а, следовательно, и электронов в базе. Неравновесные носители заряда – дырки, подошедшие к коллекторному переходу, экстрагируются его ускоряющим электрическим полем в область коллектора. Можно считать, что все внешнее обратное коллекторное напряжение
, приближающиеся к единице, следует уменьшить вероятность рекомбинации неосновных носителей в базе, для чего нужно, во-первых, уменьшить толщину базы w б и, во-вторых, увеличить диффузионную длину дырок в базе Lp б. Последнее достигается уменьшением концентрации донорных примесей, а, следовательно, и электронов в базе. Неравновесные носители заряда – дырки, подошедшие к коллекторному переходу, экстрагируются его ускоряющим электрическим полем в область коллектора. Можно считать, что все внешнее обратное коллекторное напряжение  прикладывается к переходу, и падением напряжения в областях коллектора и базы можно пренебречь.
прикладывается к переходу, и падением напряжения в областях коллектора и базы можно пренебречь. = I К / I К Р , где I К – полный, управляемый ток через коллекторный переход. В плоскостных транзисторах обычного типа
= I К / I К Р , где I К – полный, управляемый ток через коллекторный переход. В плоскостных транзисторах обычного типа  ≈ 1. Коэффициент
≈ 1. Коэффициент  оказывается больше единицы в так называемых лавинных транзисторах, в которых осуществляется умножение потока носителей внутри коллекторного перехода в результате многократных столкновений c атомами решетки.
оказывается больше единицы в так называемых лавинных транзисторах, в которых осуществляется умножение потока носителей внутри коллекторного перехода в результате многократных столкновений c атомами решетки. (3.6)
(3.6) (3.7)
(3.7) через эмиттерный переход равен
через эмиттерный переход равен . (3.8)
. (3.8) (3.9)
(3.9) . При более точном рассмотрении ток
. При более точном рассмотрении ток  >
>  этим током по сравнению с электронной составляющей можно пренебречь;
этим током по сравнению с электронной составляющей можно пренебречь; . (3.10)
. (3.10) . (3.11)
. (3.11) ток
ток  меньше
меньше  , не зависящего от
, не зависящего от  , и направление тока
, и направление тока  будет противоположно, показанному на рис. 3.3. При используемых на практике значениях
будет противоположно, показанному на рис. 3.3. При используемых на практике значениях 
 (3.12)
(3.12) при U КБ = const. (3.13)
при U КБ = const. (3.13) . (3.14)
. (3.14) . (3.15)
. (3.15) < 1, транзистор является усилительным прибором, так как коэффициент усиления по мощности:
< 1, транзистор является усилительным прибором, так как коэффициент усиления по мощности: , (3.16)
, (3.16) – дифференциальное сопротивление обратносмещенного коллекторного перехода;
– дифференциальное сопротивление обратносмещенного коллекторного перехода; – дифференциальное сопротивление прямосмещенного эмиттерного перехода.
– дифференциальное сопротивление прямосмещенного эмиттерного перехода. а б в
а б в .
. = I к / I б, составляющим величину от нескольких десятков до нескольких сотен единиц. Коэффициент усиления по напряжению –десятки – сотни, фаза усиливаемого сигнала изменяется на противоположную. Входное сопротивление находится в пределах от сотен ом до единиц килоом, выходное – десятков – сотен килоом.
= I к / I б, составляющим величину от нескольких десятков до нескольких сотен единиц. Коэффициент усиления по напряжению –десятки – сотни, фаза усиливаемого сигнала изменяется на противоположную. Входное сопротивление находится в пределах от сотен ом до единиц килоом, выходное – десятков – сотен килоом. (3.17)
(3.17) ; (3.18)
; (3.18) . (3.19)
. (3.19) ;
; 


 . (3.44)
. (3.44)
 . (3.45)
. (3.45) на рис. 3.22, б ). В некоторый момент времени концентрации неосновных носителей в базе около p-n- переходов коллектора и эмиттера достигают нуля. С этого момента токи коллектора и эмиттера будут уменьшаться со временем, так как процесс рассасывания неосновных носителей продолжается и уменьшается абсолютное значение градиентов концентрации неосновных носителей около соответствующих р-n- переходов. Изменения в распределении неосновных носителей заряда в базе транзистора в различные моменты времени процесса рассасывания показаны на рис. 3.22 г. Скорость уменьшения тока коллектора в процессе рассасывания характеризуется длительностью заднего фронта
на рис. 3.22, б ). В некоторый момент времени концентрации неосновных носителей в базе около p-n- переходов коллектора и эмиттера достигают нуля. С этого момента токи коллектора и эмиттера будут уменьшаться со временем, так как процесс рассасывания неосновных носителей продолжается и уменьшается абсолютное значение градиентов концентрации неосновных носителей около соответствующих р-n- переходов. Изменения в распределении неосновных носителей заряда в базе транзистора в различные моменты времени процесса рассасывания показаны на рис. 3.22 г. Скорость уменьшения тока коллектора в процессе рассасывания характеризуется длительностью заднего фронта  .
.
 до
до  . Входному току
. Входному току  по отношению к общему эмиттерному выводу (рис. 3.25).
по отношению к общему эмиттерному выводу (рис. 3.25).


 ; (3.48)
; (3.48)
 . (3.49)
. (3.49) (3.50)
(3.50) – распределённое омическое сопротивление базы;
– распределённое омическое сопротивление базы; – диффузионное сопротивление базы.
– диффузионное сопротивление базы. , (3.51)
, (3.51) – температура в градусах Кельвина;
– температура в градусах Кельвина; – величина тока эмиттера.
– величина тока эмиттера. , (3.52)
, (3.52) (3.53)
(3.53) – толщина коллекторного перехода.
– толщина коллекторного перехода. (3.54)
(3.54) (3.55)
(3.55) , (3.56)
, (3.56) – эффективность коллектора.
– эффективность коллектора. , так как увеличивается на небольшую величину диффузионная длина носителей
, так как увеличивается на небольшую величину диффузионная длина носителей  , что приводит к некоторому возрастанию коэффициента передачи по току α, а увеличение αприводит к возрастанию β. Изменение αсоставляет (0,03 … 0,05)% на 1°С.
, что приводит к некоторому возрастанию коэффициента передачи по току α, а увеличение αприводит к возрастанию β. Изменение αсоставляет (0,03 … 0,05)% на 1°С. (3.57)
(3.57) – ток насыщения эмиттерного перехода;
– ток насыщения эмиттерного перехода; – ширина запрещённой зоны.
– ширина запрещённой зоны. (3.58)
(3.58) − концентрация примесей в слаболегированной области; φк − контактная разность потенциалов.
− концентрация примесей в слаболегированной области; φк − контактная разность потенциалов. (3.59) где
(3.59) где  ,коэффициент
,коэффициент  .
. ,
,  для германия и
для германия и  для кремния. Если перейти от основания е к основанию 2, то получим:
для кремния. Если перейти от основания е к основанию 2, то получим: , (3.60) где
, (3.60) где  – температура удвоения тока насыщения.
– температура удвоения тока насыщения. , для кремниевого – 4,5 К.
, для кремниевого – 4,5 К.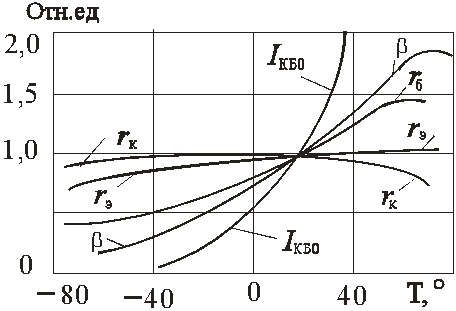
 (3.61)
(3.61) 

 (3.62)
(3.62)


 . (3.63)
. (3.63) . (3.64)
. (3.64) (3.65)
(3.65) невелико, а отношение
невелико, а отношение  составляет величину порядка
составляет величину порядка  , то температурный дрейф выходных характеристик для схемы включения с общей базой оказывается незначительным (рис. 3.30).
, то температурный дрейф выходных характеристик для схемы включения с общей базой оказывается незначительным (рис. 3.30).
 (3.66)
(3.66) – тепловой потенциал;
– тепловой потенциал;
 (3.67)
(3.67) , (3.68)
, (3.68)



