
Заглавная страница Избранные статьи Случайная статья Познавательные статьи Новые добавления Обратная связь КАТЕГОРИИ: ТОП 10 на сайте Приготовление дезинфицирующих растворов различной концентрацииТехника нижней прямой подачи мяча. Франко-прусская война (причины и последствия) Организация работы процедурного кабинета Смысловое и механическое запоминание, их место и роль в усвоении знаний Коммуникативные барьеры и пути их преодоления Обработка изделий медицинского назначения многократного применения Образцы текста публицистического стиля Четыре типа изменения баланса Задачи с ответами для Всероссийской олимпиады по праву 
Мы поможем в написании ваших работ! ЗНАЕТЕ ЛИ ВЫ?
Влияние общества на человека
Приготовление дезинфицирующих растворов различной концентрации Практические работы по географии для 6 класса Организация работы процедурного кабинета Изменения в неживой природе осенью Уборка процедурного кабинета Сольфеджио. Все правила по сольфеджио Балочные системы. Определение реакций опор и моментов защемления |
Концентрация электронов и дырок в области
Пространственного заряда
Рассчитаем, как меняется концентрация электронов и дырок в области пространственного заряда. Для определенности рассмотрим полупроводник n ‑типа. В условиях термодинамического равновесия концентрация основных n n0 и неосновных p n0 носителей выражается следующим образом (3.1):
поскольку E C – F + q j 0n = E g/2. Обозначим
Для области пространственного заряда объемное положение уровня Ферми j (x) меняется от точки к точке: j (x) = j 0n – ψ (x), как и концентрация основных n n0(x) и неосновных p 0n(x) носителей. С учетом зависимости j (x) = j 0n – y (x) выражения для концентраций будут:
Величины n s и p s – концентрации электронов и дырок на поверхности – носят названия поверхностных концентраций:
Образование и зонная диаграмма р-n перехода
Электронно‑дырочным, или p ‑ n переходом, называют контакт двух полупроводников одного вида с различными типами проводимости (электронным и дырочным). Классическим примером p ‑ n перехода являются: nSi – pSi, nGe – pGe. Рассмотрим контакт двух полупроводников n ‑ и p ‑типа. Величина работы выхода Ф определяется расстоянием от уровня Ферми до уровня вакуума. Термодинамическая работа выхода в полупроводнике p ‑типа Ф p всегда больше, чем термодинамическая работа выхода Ф n в полупроводнике n ‑типа:
При контакте полупроводников n ‑ и p ‑типов вследствие различного значения токов термоэлектронной эмиссии (из-за разных значений работы выхода) поток электронов из полупроводника n ‑типа в полупроводник p ‑типа будет больше. Электроны из полупроводника n ‑типа будут при переходе в полупроводник p -типа рекомбинировать с дырками. Вследствие несбалансированности токов в полупроводнике n ‑типа возникнет избыточный положительный заряд, а в полупроводнике p ‑типа – отрицательный. Положительный заряд обусловлен ионизованными донорами, отрицательный заряд – ионизованными акцепторами. Вследствие эффекта поля произойдет изгиб энергетических зон в полупроводниках n ‑ и p ‑типов, причем в полупроводнике p -типа на поверхности термодинамическая работа выхода будет уменьшаться, а в полупроводнике n ‑типа на поверхности термодинамическая работа выхода будет увеличиваться. Условию термодинамического равновесия соответствуют равные значения токов термоэлектронной эмиссии с поверхности полупроводников p ‑ и n ‑типов, а следовательно, и равные значения термодинамической работы выхода.
На рисунке 3.3 приведены зонные диаграммы, иллюстрирующие этапы формирования электронно‑дырочного перехода [1]. Граница областей донорной и акцепторной примеси в полупроводнике получила название металлургического p ‑ n перехода. Границу, где уровень Ферми пересекает середину запрещенной зоны, называют физическим p ‑ n переходом.
Рис. 3.3. Схема, иллюстрирующая образование p ‑ n перехода 3.4. Распределение свободных носителей в p ‑ n переходе
Рассмотрим несимметричный p ‑ n переход, будем считать, что концентрация акцепторов больше, чем концентрация доноров N A > N D; в этом случае для объемного положения уровня Ферми получаем j n < j p. В условиях равновесия (V G= 0) высота потенциального барьера p ‑ n перехода будет: Рассмотрим распределение свободных носителей – электронов и дырок в области пространственного заряда p ‑ n перехода. Для квазинейтрального объема полупроводников
Для области пространственного заряда эти соотношения трансформируются таким образом, что j 0p и j 0n становятся зависимыми от координаты x, то есть j 0p(x) и j 0n(x). Следовательно, и концентрации электронов и дырок в области пространственного заряда тоже будут зависеть от координаты x: p p(x), n p(x), n n(x), p n(x).
Рассмотрим, как меняется концентрация основных и неосновных носителей в ОПЗ полупроводника p -типа. В p ‑ n -переходе величина j p квазилинейно уменьшается, поэтому концентрация дырок p p будет экспоненциально убывать. Уровень Ферми совпадает с серединой запрещенной зоны у физического p ‑ n перехода (j p = 0), в этой точке концентрация дырок становится равной собственной концентрации, т.е. p p = n i.
Рис. 3.4. p‑n -переход в равновесных условиях: а) распределение равновесных носителей; б) диаграмма, иллюстрирующая распределение доноров и акцепторов
Для электронов аналогично получаем, что величина концентрации электронов n p(x) возрастает экспоненциально и также равна собственной концентрации в области физического p ‑ n перехода. Аналогично меняется концентрация основных n n(x) и неосновных p n(x) носителей в ОПЗ полупроводника n -типа. На рис. 3.4 показано распределение концентрации носителей в несимметричном p ‑ n переходе в логарифмическом масштабе и схема p ‑ n перехода. Таким образом, из рис. 3.4. следует, что в несимметричных p ‑ n -переходах физические и металлургические p ‑ n -переходы пространственно не совпадают. Распределение концентрации основных и неосновных носителей симметрично относительно линии, соответствующей собственной концентрации n i.
3.5. Поле и потенциал в p ‑ n переходе
Связь электрического поля и потенциала в p ‑ n переходе описывается уравнением Пуассона. В одномерном приближении это уравнение имеет вид:
где y (x)– зависимость потенциала от координаты; r (x) – плотность объемного заряда; e s – диэлектрическая проницаемость полупроводника; e 0 – диэлектрическая постоянная. Для рассмотрения этого уравнения выберем начало координат в области металлургического p ‑ n -перехода. При этом донорный полупроводник будет находиться в области x > 0 (в дальнейшем обозначим цифрой I), а акцепторный – в области x < 0 (в дальнейшем обозначим цифрой II). Заряд в области пространственного заряда p ‑ n перехода для полупроводника n ‑типа обусловлен зарядом ионизованных доноров с плотностью N D+, для полупроводника p ‑типа – зарядом ионизованных акцепторов с плотностью N A+. Поэтому для области I для области I
для области II
Знак минус в выражениях (3.8 и 3.9) указывает, что направление электрического поля противоположно направлению оси x. Электрическое поле Е максимально на металлургической границе p ‑ n перехода (x = 0), линейно спадает по области пространственного заряда и равно нулю на границах ОПЗ – квазинейтральный объем полупроводника (x = W n; x = W p):
Максимальная величина электрического поля E max будет равна:
Для нахождения распределения потенциала (а следовательно, и зависимости потенциальной энергии от координаты) проинтегрируем уравнение (10) при следующих граничных условиях: x = W, y (W) = 0. Получаем:
Используя граничные условия
Подставляя полученные значения константы в соотношение (3.12), получаем для распределения потенциала y (x) в области x < 0.
Проводя аналогичное интегрировнаие для области x > 0, получаем:
Используя граничные условия
Подставляя полученные значения константы в соотношение (3.13), получаем для распределения потенциала y (x) в области x > 0:
Таким образом, закон изменения потенциала y в p ‑области (отсчет идет от уровня в квазинейтральной области):
и наоборот, в n ‑области:
На рис. 3.5 приведена диаграмма, иллюстрирующая распределение электрического поля и потенциала в p ‑ n -переходе, рассчитанная по соотношениям (3.8), (3.9), (3.12) и (3.14).
Рис. 3.5. Диаграмма, иллюстрирующая распределение электрического поля и потенциала в p ‑ n переходе: а) структура p ‑ n перехода; б) распределение электрического поля в ОПЗ; в) распределение потенциала в ОПЗ
На металлургической границе p ‑ n перехода при x = 0 значение потенциала y 1 + y 2 = D j 0= j n0 + j p0, или
Согласно уравнению электронейтральности в замкнутых системах величины положительного и отрицательного заряда на единицу площади должны быть равны:
Следовательно,
Несложные преобразования позволяют получить выражение для ширины обедненных областей W p и W n в p ‑ и n ‑областях соответственно:
Из предыдущих формул легко видеть, что с ростом легирования p ‑области ширина p ‑ n перехода W p в акцепторной части полупроводника уменьшится. Полная ширина p ‑ n перехода W, равная W = W p + W n, будет:
Для несимметричных p + ‑ n переходов (концентрация акцепторов существенно больше концентрации доноров) ширина обедненной области в полупроводнике p ‑типа будет существенно меньше, чем ширина обедненной области в полупроводнике n ‑типа:
Таким образом, вся обедненная область p + ‑ n перехода сосредоточена в области с низким значением легирующей концентрации W = W n. 3.6. Вольт‑амперная характеристика р‑n-перехода
Получим вольт-амперную характеристику p ‑ n перехода. Для этого запишем уравнение непрерывности в общем виде:
Будем рассматривать стационарный случай Рассмотрим ток в квазинейтральном объеме полупроводника n -типа справа от обедненной области p ‑ n перехода (x > 0). Темп генерации G в квазинейтральном объеме равен нулю: G = 0. Электрическое поле E тоже равно нулю: E = 0. Дрейфовая компонента тока также равна нулю: I E = 0, следовательно, ток диффузионный
Воспользуемся следующим соотношением, связывающим коэффициент диффузии, длину диффузии и время жизни неосновных носителей: D t = L p2. С учетом отмеченных выше допущений уравнение непрерывности имеет вид:
Граничные условия для диффузионного уравнения в p - n переходе имеют вид: при x = 0,
Решение дифференциального уравнения (3.20) с граничными условиями (3.20 а) имеет вид:
Соотношение (3.21) описывает закон распределения инжектированных дырок в квазинейтральном объеме полупроводника n ‑типа для электронно-дырочного перехода (рис. 3.6). В токе p ‑ n -перехода принимают участие все носители, пересекшие границу ОПЗ с квазинейтральным объемом p ‑ n -перехода. Поскольку весь ток диффузионный, подставляя (3.21) в выражение для тока, получаем (рис. 3.7):
Рис. 3.6. Распределение неравновесных инжектированных из эмиттера носителей по квазинейтральному объему базы p ‑ n перехода
Соотношение (3.22) описывает диффузионную компоненту дырочного тока p ‑ n перехода, возникающую при инжекции неосновных носителей при прямом смещении. Для электронной компоненты тока p ‑ n -перехода аналогично получаем:
При V G = 0 дрейфовые и диффузионные компоненты уравновешивают друг друга. Следовательно,
Полный ток p ‑ n -перехода является суммой всех четырех компонент тока p ‑ n -перехода:
Выражение в скобках имеет физический смысл обратного тока p ‑ n перехода. Действительно, при отрицательных напряжениях V G < 0 ток дрейфовый и обусловлен неосновными носителями. Все эти носители уходят из цилиндра длиной L n со скоростью L n/ t p. Тогда для дрейфовой компоненты тока получаем:
Если требуется реализовать условие односторонней инжекции (например, только инжекции дырок), то из соотношения (23) следует, что нужно выбрать малое значение концентрации неосновных носителей n p0 в p ‑области. Отсюда следует, что полупроводник p ‑типа должен быть сильно легирован по сравнению с полупроводником n ‑типа: N A >> N D. В этом случае в токе p ‑ n -перехода будет доминировать дырочная компонента (рис. 3.7).
Рис. 3.7. Токи в несимметричном p ‑ n -nереходе при прямом смещении
Таким образом, ВАХ p ‑ n -перехода имеет вид (рис. 3.8):
Плотность тока насыщения J s равна:
Рис. 3.8. Вольт‑амперная характеристика идеального p ‑ n перехода
Вольт‑амперная характеристика идеального p ‑ n -перехода имеет ярко выраженный несимметричный вид. В области прямых напряжений ток p ‑ n перехода диффузионный и экспоненциально возрастает с ростом приложенного напряжения. В области отрицательных напряжений ток p ‑ n перехода – дрейфовый и не зависит от приложенного напряжения. Зависимость обратного тока насыщения от температуры выражается следующим уравнением:
где Eg0=eUg0 - ширина запрещенной зоны при Т=0 К; UT= kT/e – температурный потенциал. Для германия h=1; m=2; Ug0=0,785 B. Для кремния h=2; m=1,5; Ug0=1,21 B.
3.7. Емкость p ‑ n перехода Любая система, в которой при изменении потенциала j меняется электрический заряд Q, обладает емкостью. Величина емкости С определяется соотношением: Для p ‑ n -перехода можно выделить два типа зарядов: заряд в области пространственного заряда ионизованных доноров и акцепторов Q B и заряд инжектированных носителей в базу из эмиттера Q p. При различных смещениях на p ‑ n переходе при расчете емкости будет доминировать тот или иной заряд. В связи с этим для емкости p ‑ n перехода выделяют барьерную емкость C B и диффузионную емкость C D. Барьерная емкость C B – это емкость p ‑ n -перехода при обратном смещении V G < 0, обусловленная изменением заряда ионизованных доноров в области пространственного заряда. Величина заряда ионизованных доноров и акцепторов Q B на единицу площади для несимметричного p ‑ n -перехода равна:
Дифференцируя выражение (3.27
Из уравнения (3.28) следует, что барьерная емкость C B представляет собой емкость плоского конденсатора, расстояние между обкладками которого равно ширине области пространственного заряда W. Поскольку ширина ОПЗ зависит от приложенного напряжения V G, то и барьерная емкость также зависит от приложенного напряжения. Численные оценки величины барьерной емкости показывают, что ее значение составляет десятки или сотни пикофарад. Диффузионная емкость C D – это емкость p ‑ n -перехода при прямом смещении V G > 0, обусловленная изменением заряда Q p инжектированных носителей в базу из эмиттера Q p.
Зависимость барьерной емкости С B от приложенного обратного напряжения V G используется для приборной реализации. Полупроводниковый диод, реализующий эту зависимость, называется варикапом. Максимальное значение емкости варикап имеет при нулевом напряжении V G. При увеличении обратного смещения емкость варикапа уменьшается. Функциональная зависимость емкости варикапа от напряжения определяется профилем легирования базы варикапа. В случае однородного легирования емкость обратно пропорциональна корню из приложенного напряжения V G. Задавая профиль легированияв базе варикапа N D(x), можно получить различные зависимости емкости варикапа от напряжения C (V G) – линейно убывающие, экспоненциально убывающие.
|
|||||||||
|
Последнее изменение этой страницы: 2021-03-09; просмотров: 148; Нарушение авторского права страницы; Мы поможем в написании вашей работы! infopedia.su Все материалы представленные на сайте исключительно с целью ознакомления читателями и не преследуют коммерческих целей или нарушение авторских прав. Обратная связь - 3.129.249.141 (0.123 с.) |
 ,
, , тогда
, тогда . (3.1)
. (3.1) ,
, ,
, . (3.2)
. (3.2) . (3.3)
. (3.3) .
.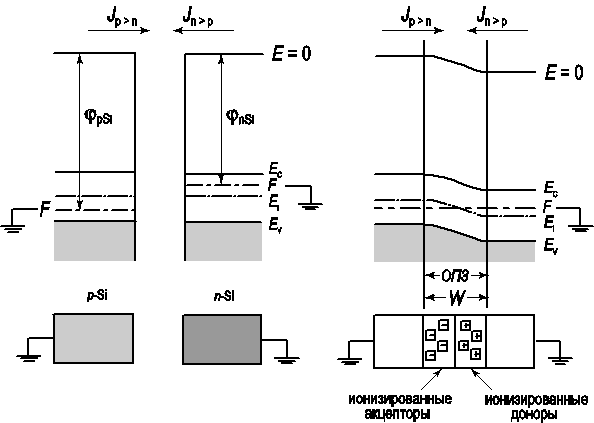
 . (3.4)
. (3.4)
 . (3.5)
. (3.5) (3.6)
(3.6)
 , (3.7)
, (3.7) , для области II
, для области II  . Будем решать уравнение Пуассона отдельно для областей I и II. После интегрирования уравнения Пуассона получаем:
. Будем решать уравнение Пуассона отдельно для областей I и II. После интегрирования уравнения Пуассона получаем: , (3.8)
, (3.8) . (3.9)
. (3.9) . (3.10)
. (3.10) . (3.11)
. (3.11) . (3.12)
. (3.12) , находим константу интегрирования:
, находим константу интегрирования: .
. .
. . (3.13)
. (3.13) ; для константы интегрирования в этой области получаем:
; для константы интегрирования в этой области получаем: ,
, . (3.14)
. (3.14) , x < 0,
, x < 0, , x > 0.
, x > 0.
 . (3.15)
. (3.15) .
. . (3.16)
. (3.16) .
.
 . (3.17)
. (3.17) . (3.18)
. (3.18) .
. .
. .
. . Темп рекомбинации R при малом уровне инжекции описывается соотношением:
. Темп рекомбинации R при малом уровне инжекции описывается соотношением: . (3.19)
. (3.19) . (3.20)
. (3.20) ; при x → ∞,
; при x → ∞,  . (3.20 а)
. (3.20 а) . (3.21)
. (3.21) . (3.22)
. (3.22)
 .
. .
. . (3.23)
. (3.23) .
.
 . (3.24)
. (3.24) . (3.25)
. (3.25)
 ,
, .
. . (3.26)
. (3.26) . (3.27)
. (3.27)
 . (3.28)
. (3.28) ,
, ,
, .
.


