
Заглавная страница Избранные статьи Случайная статья Познавательные статьи Новые добавления Обратная связь КАТЕГОРИИ: ТОП 10 на сайте Приготовление дезинфицирующих растворов различной концентрацииТехника нижней прямой подачи мяча. Франко-прусская война (причины и последствия) Организация работы процедурного кабинета Смысловое и механическое запоминание, их место и роль в усвоении знаний Коммуникативные барьеры и пути их преодоления Обработка изделий медицинского назначения многократного применения Образцы текста публицистического стиля Четыре типа изменения баланса Задачи с ответами для Всероссийской олимпиады по праву 
Мы поможем в написании ваших работ! ЗНАЕТЕ ЛИ ВЫ?
Влияние общества на человека
Приготовление дезинфицирующих растворов различной концентрации Практические работы по географии для 6 класса Организация работы процедурного кабинета Изменения в неживой природе осенью Уборка процедурного кабинета Сольфеджио. Все правила по сольфеджио Балочные системы. Определение реакций опор и моментов защемления |
Расчет топологии n-p-n транзистораСтр 1 из 6Следующая ⇒
Рис. 4. Параметры топологии и структуры транзистора Все транзисторы проектируются исходя из минимального размера Dmin, за исключением многоэмиттерных, для которых следует добиваться минимума коэффициента передачи тока базы в инверсном режиме - BR (необходимо получить значение BR < 0.1) этот параметр рассчитывается по формуле [6]:
где: M – число эмиттеров, SЭ = LЭdЭ, - площадь эмиттера, SБ = LБZБ, - общая площадь базы,
Остальные параметры рассчитываются по следующим формулам: Ток насыщения:
Коэффициент усиления тока базы в нормальном режиме:
где η =2...4 – коэффициент, учитывающий градиент примеси в базе.
Сопротивление базы:
Сопротивление коллектора:
RC=RC 1 +RC 2
Время пролета базы:
Емкости рассчитываются по формуле:
Cp-n – ёмкость p-n перехода при нулевом смещении, S S - общая площадь p-n – перехода, первое слагаемое – плоское дно, второе слагаемое – цилиндрические боковые части, третье слагаемое – сферические угловые части, значения концентраций NД, NА берутся вблизи p-n перехода, VB - потенциальный барьер p-n – перехода при нулевом смещении.
Диоды
В качестве диодов в ПИМС используют транзисторные n-p-n структуры в диодном включении. В быстродействующих схемах в качестве диода используют эмиттерный p-n – переход, при этом коллекторный переход закорочен. При необходимости применения диода с более высоким рабочим напряжением (до 60 В) используют коллекторный p-n – переход. Эмиттерную область в такой структуре обычно не формируют, что позволяет существенно уменьшить размеры диода. На характеристики диода в конкретной схеме существенное влияние могут оказывать паразитные элементы: p-n-p транзистор, емкость диода СД и емкость изоляции СИ. В следующей таблице приведены типовые параметры наиболее часто применяемых диодов при rК = 0.5 Ом×см, rБП = 200 Ом/□, rЭ = 2.2 Ом/□ (поверхностное сопротивление эмиттерной области), SЭ = 300 мкм2, SБ = 2000 мкм2.
При расчете диода используются те же исходные данные, что для биполярного транзистора. Топология синтезируется с учетом заданного максимального тока диода IДMAX, или исходя из заданного минимального размера. Затем рассчитывают основные параметры: барьерную емкость CД(UД), максимальное обратное напряжение UДMAX, обратный тепловой ток IД0, прямое падение напряжения UД(IД). Порядок расчета диода следующий: 1. Выбор варианта реализации диода 2. Расчет параметров: La, LД, BN 3. Синтез топологии – определение размеров: M, ZЭ, RБ, ZБ 4. Расчет параметров: CД(UД), UДmax, IД0, UД(IД)
Примечание. Поскольку в ПИМС в качестве диодов используются транзисторы в диодном включении (см. выше), то для этого можно использовать один из спроектированных ранее транзисторов, при расчете схемы с помощью SPICE кодируется такое включение транзистора.
Резисторы
Тонкопленочные резисторы
Резисторы тонкоплёночные – тонкие резистивные плёнки, нанесённые на диэлектрическую подложку. Концы плёнки замыкаются на контактные площадки, имеющие высокую проводимость (металлы). Используются в гибридных ИС (резисторы напыляются на подложку, транзисторы – наклеиваются).
Рис. 5. Сопротивление резистора прямоугольной конфигурации
Рис. 6. Тонкая резистивная пленка в форме квадрата
Сопротивление двух квадратов одинаковы, т.е. квадрат с любой стороной “ a ” имеет одно и то же сопротивление. Такое сопротивление называется поверхностным (RS), оно зависит только от толщины и материала плёнки:
Размерность поверхностного сопротивления: Ом×см×(см/см2)=Ом, т.е. просто размерность сопротивления, но, чтобы подчеркнуть, что это – сопротивление пленки квадратной формы, используется название размерности «ом на квадрат», обозначается: Ом/□. Сопротивление линейного резистора
определяется количеством квадратов со стороной w, которые уместятся на длине l. Для повышения сопротивления используют более сложную топологию резистора - меандр (змейку). Для изменения толщины d надо менять технологию. В интегральной технологии d по всей площади одинакова, следовательно, можно менять только длину и ширину.
Рис. 7. Резистор сложной конфигурации
Сопротивление резистора сложной конфигурации:
где: Можно показать, что Резистор, показанный на рис. 7 имеет 6 изломов (N ИЗЛ). Материалы тонкоплёночных резисторов – сплавы с высоким сопротивлением, например нихром.
Диффузионные резисторы
Диффузионные резисторы – формируются в полупроводниковой подложке с помощью методов диффузии или ионной имплантации.
Рис. 8. Диффузионный резистор
Чтобы использовать диффузионную область в качестве резистора, необходимо сместить в обратном направлении отделяющий ее p-n переход. Для этого подложку (n-тип) надо подключить к самому высокому потенциалу в схеме, т.е. к положительному источнику питания Е+. В данной конструкции всегда существует паразитный ток утечки. При необходимости реализовать сопротивление большего номинала делается контур с изгибами (типа «меандр»).
где При использовании полупроводниковой технологии нельзя реализовать резисторы произвольного номинала; существуют ограничения сверху и снизу, Rmin и Rmax. Обычно RS p-слоя меняется от 100...300 Ом/□. Как правило, минимальная ширина резистора w min не менее 2...3 минимальных размеров. Уменьшить w min невозможно из-за несовершенства технологического процесса. Оценим:
l min = w min = 10 мкм.
Размер кристалла микросхемы (чипа) ~ 2´2 мм => l max=1 мм (меандр). Для минимального:
На практике часто надо реализовать сопротивление большего номинала. 1. Сжатый резистор (pinch, пинч-резистор)
Рис. 9. Сжатый резистор
Поверхностное сопротивление сжатого p слоя, между слоями n и n+: RS =1...3 кОм/□.
2. Используется ионная имплантация с тонкими слоями
Рис. 10. Имплантация с тонкими слоями
Тонкий p слой (xjp ~ 0,2...0,8 мкм) имеет большое поверхностное сопротивление RS =104 Ом/□.
Для малых сопротивлений (1...50 Ом) используются высоколегированные области (эмиттерный n+ - слой):
Рис. 11. Высоколегированная (эмиттерная) область
В схемах малой степени интеграции используется однослойная металлизация – слой алюминия на поверхности окисла, который формирует контакты к элементам ИС и межсоединения. В этом случае возможны ситуации, когда не удается избежать пересечения проводников. В этом случае используется так называемый «подныр»: один проводник остается алюминиевой шиной, а второй проходит под ним по низкоомному резистору. Эквивалентная электрическая схема диффузионного резистора, ограниченного обратно смещённым p-n переходом показана на рис. 12. Емкости рассчитываются по формуле:
Cp-n – ёмкость p-n перехода при нулевом смещении, S S - общая площадь p-n перехода, первое слагаемое – плоское дно, второе слагаемое – цилиндрические боковые части, третье слагаемое – сферические угловые части.
Рис. 12. Эквивалентная схема резистора
Рис. 13. Размеры резистора, 1,2 – контактные окна.
МДП транзисторы
Рис. 14. Структура МДП транзистора
Пороговое напряжение UЗИ ПОР – при котором концентрация электронов в канале около поверхности Si - SiO2 равна концентрации дырок в подложке p-типа, т.е. канал образуется, если UЗ > UПОР.
Рис. 15. Выходная характеристика
В линейной (крутой, триодной) области:
Формула верна для UЗ >UПОР, UC<UЗ–UПОР, при UC=0 IC=0 Если UC мало и выполняется неравенство
При UC=UЗ-UПОР канал вблизи стока исчезает и транзистор работает в области насыщения (пологой, пентодной) с перекрытым каналом Подставим это значение в формулу для IC:
т.е. в области насыщения ток стока IC от напряжения на стоке UC не зависит. С увеличением UC канал вблизи стока перекрывается больше и больше: так как расширяется обедненный слой стокового p-n перехода, следовательно, длина канала L уменьшается, следовательно, ток IC растет, характеристики в области насыщения имеют небольшой наклон. Крутизна:
Удельная крутизна: Оценим:
В PSpice используется параметр, называемый коэффициент крутизны:
kp является параметром микросхемы в целом, а не отдельного транзистора, так как
|
|||||||||||||||||||||||||||
|
Последнее изменение этой страницы: 2016-08-12; просмотров: 380; Нарушение авторского права страницы; Мы поможем в написании вашей работы! infopedia.su Все материалы представленные на сайте исключительно с целью ознакомления читателями и не преследуют коммерческих целей или нарушение авторских прав. Обратная связь - 18.119.133.228 (0.049 с.) |
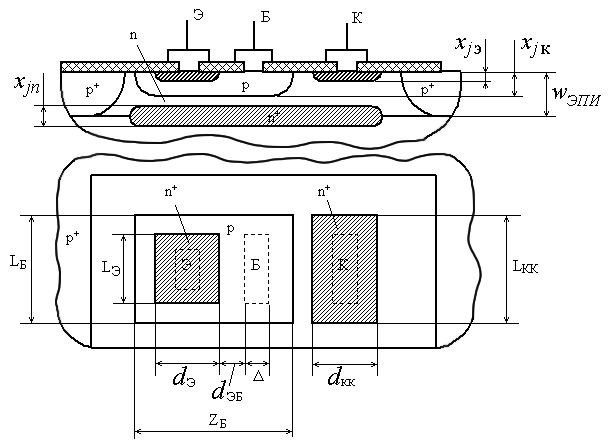

 .
.
 ,
,



 ; N =min(NД (xj), NА (xj));
; N =min(NД (xj), NА (xj)); - для коллекторного p-n – перехода,
- для коллекторного p-n – перехода, - для эмиттерного p-n – перехода,
- для эмиттерного p-n – перехода,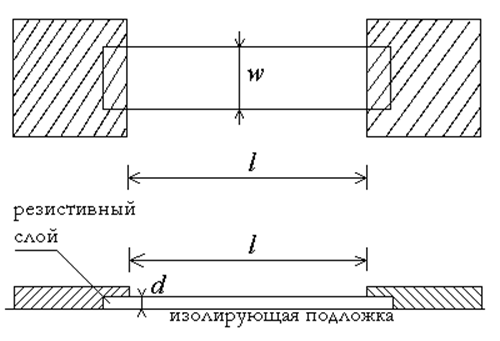
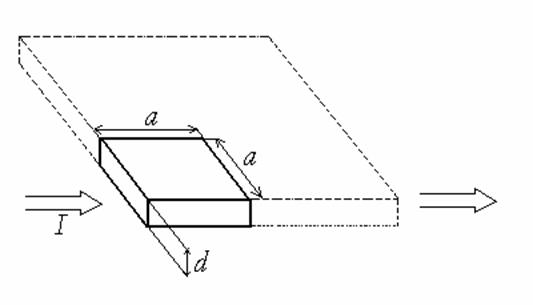


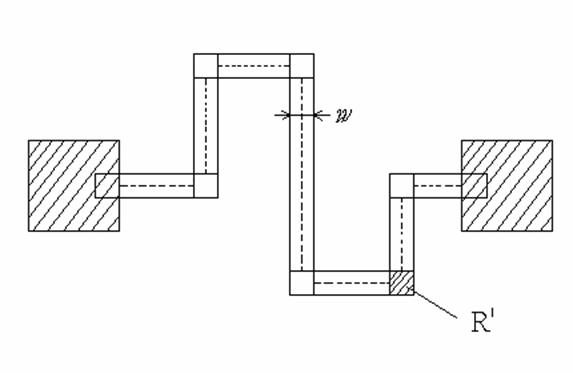
 .
. - сопротивление излома;
- сопротивление излома;  - длина прямоугольных участков.
- длина прямоугольных участков. .
.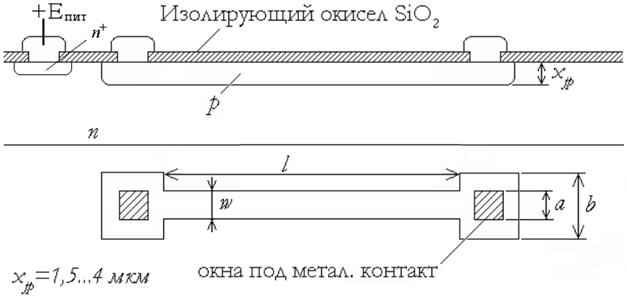

 - сопротивление контактных площадок. КП = 0,5...1 =
- сопротивление контактных площадок. КП = 0,5...1 =  - даны в справочниках.
- даны в справочниках. , Rmin =100 Ом/□
, Rmin =100 Ом/□  =100 Ом. (Rmin =50...100 Ом). Rmax=RSmax
=100 Ом. (Rmin =50...100 Ом). Rmax=RSmax  =300
=300  =30 кОм. (Rmax=30...50 кОм).
=30 кОм. (Rmax=30...50 кОм).
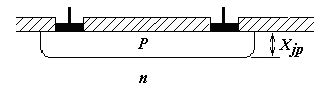
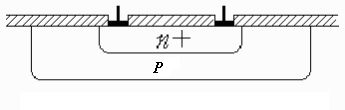
 .
.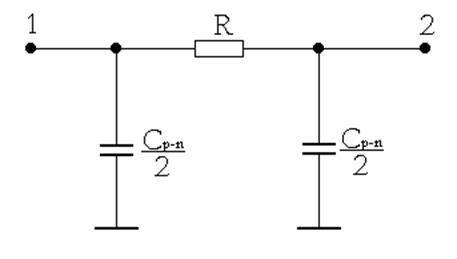
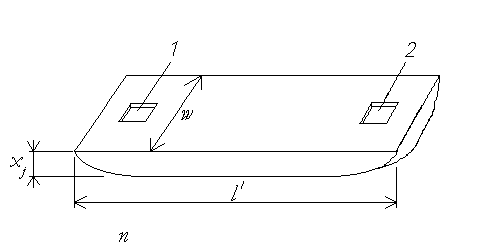
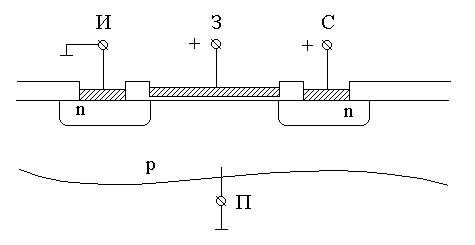
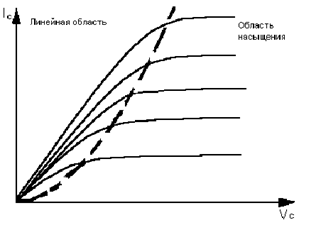

 , тогда:
, тогда: т.е. Ic - линейная функция Uc, здесь: W - ширина канала, L - длина канала, µns-подвижность электронов вблизи поверхности(0,5 µn – в глубине). eOX - диэлектрическая проницаемость окисла, l OX - толщина окисла,
т.е. Ic - линейная функция Uc, здесь: W - ширина канала, L - длина канала, µns-подвижность электронов вблизи поверхности(0,5 µn – в глубине). eOX - диэлектрическая проницаемость окисла, l OX - толщина окисла, - удельная емкость структуры затвор – канал, Ф/м2,
- удельная емкость структуры затвор – канал, Ф/м2,  .
.




 - является параметром транзистора.
- является параметром транзистора.

 .
.


