
Заглавная страница Избранные статьи Случайная статья Познавательные статьи Новые добавления Обратная связь КАТЕГОРИИ: ТОП 10 на сайте Приготовление дезинфицирующих растворов различной концентрацииТехника нижней прямой подачи мяча. Франко-прусская война (причины и последствия) Организация работы процедурного кабинета Смысловое и механическое запоминание, их место и роль в усвоении знаний Коммуникативные барьеры и пути их преодоления Обработка изделий медицинского назначения многократного применения Образцы текста публицистического стиля Четыре типа изменения баланса Задачи с ответами для Всероссийской олимпиады по праву 
Мы поможем в написании ваших работ! ЗНАЕТЕ ЛИ ВЫ?
Влияние общества на человека
Приготовление дезинфицирующих растворов различной концентрации Практические работы по географии для 6 класса Организация работы процедурного кабинета Изменения в неживой природе осенью Уборка процедурного кабинета Сольфеджио. Все правила по сольфеджио Балочные системы. Определение реакций опор и моментов защемления |
Исследование механизма и кинетики процесса термического окисления кремнияСтр 1 из 9Следующая ⇒
ФИЗИКО-ХИМИЧЕСКИЕ ОСНОВЫ МИКРО- И НАНОЭЛЕКТРОНИКИ. Лабораторный практикум
Рекомендовано УМО по образованию в области информатики и радиоэлектроники в качестве пособия для специальностей 1-36 04 01 «Программно-управляемые электронно-оптические системы», 1-39 03 01 «Электронные системы безопасности», 1-39 02 02 «Проектирование и производство программно-управляемых электронных средств», 1-39 02 01 «Моделирование и компьютерное проектирование радиоэлектронных средств»
Минск БГУИР 2015
УДК 621.3.049.77(076.5) ББК 32.844.1Я73 Ф50
Р е ц е н з е н т ы: кафедра микро- и нанотехники Белорусского национального технического университета (протокол № 3 от 26.11.2014);
декан физического факультета Белорусского государственного университета, доктор физико-математических наук, профессор В. М. Анищик
Включает лабораторные работы по изучению кинетики и механизмов термического окисления кремния и ионного распыления твердых тел, физических процессов в выпрямляющих контактах металл-полупроводник и в плазме тлеющего разряда, механизмов токопереноса и размерного эффекта в тонких металлических пленках. Предназначен для закрепления и углубления теоретических знаний студентов, получения практических навыков при работе с измерительным и исследовательским оборудованием.
УДК 621.3.049.77 (076.5) ББК 32.844.1я73
ISBN 978-985-543-156-6 © УО «Белорусский государственный университет информатики и радиоэлектроники», 2015
СОДЕРЖАНИЕ
Лабораторная работа №1.ИССЛЕДОВАНИЕ МЕХАНИЗМА И КИНЕТИКИ ПРОЦЕССА ТЕРМИЧЕСКОГО ОКИСЛЕНИЯ КРЕМНИЯ …………………...4 Лабораторная работа №2 ИССЛЕДОВАНИЕ ВЫПРЯМЛЯЮЩЕГО КОНТАКТА МЕТАЛЛ–ПОЛУПРОВОДНИК…………………………………...19
Лабораторная работа №3. ИССЛЕДОВАНИЕ МЕХАНИЗМА И КИНЕТИКИ ПРОЦЕССА ИОННОГО РАСПЫЛЕНИЯ…………………….30
Лабораторная работа №4 ИССЛЕДОВАНИЕ ПЛАЗМЕННОГО РАЗРЯДА В ВАКУУМНОЙ КАМЕРЕ………………………………………….43
Лабораторная работа №5. ИЗУЧЕНИЕ РАЗМЕРНОГО ЭФФЕКТА В ТОНКИХ МЕТАЛЛИЧЕСКИХ ПЛЕНКАХ…………………………………………………54
Лабораторная работа №1
ПОРЯДОК ВЫПОЛНЕНИЯ РАБОТЫ 1. Внимательно ознакомиться с описанием лабораторной работы и инструкцией по эксплуатации установки «Изоприн». 2. Получить шесть кусочков разрезанной кремниевой подложки. 3. Для удаления естественного оксида полученные образцы освежить в растворе плавиковой кислоты. 4. Промыть пластины дистиллированной водой и просушить. 5. Подготовить печь к работе и вывести ее на нужный температурный режим (950–1000 °С). 6. Разогреть барботер до 90–95 °С. 7. Шесть кусочков кремния с помощью пинцета разместить на кварцевой лодочке. 8. С помощью кварцевого толкателя задвинуть лодочку с образцами в рабочую зону реактора. 9. Через каждые 10, 20, 30, 40, 50 и 60 мин (по секундомеру) с помощью кварцевого толкателя извлечь лодочку из реактора, снять пинцетом по одному образцу и определить толщину полученного оксида. 10. На основании полученных данных построить кинетическую кривую (изотерму) в следующих координатах: – толщина d SiО2, мкм – время t, мин; – lg d SiО2 – lg t. 11. По углу наклона α в логарифмических координатах определить показатель степени n в уравнении по формуле n = tgα и сделать вывод о характере окисления (линейный, параболический и т. д.).
СОДЕРЖАНИЕ ОТЧЕТА 1. Цель работы. 2. Основные теоретические сведения. 3. Схема экспериментальной установки. 4. Таблица экспериментальных данных. 5. Графические зависимости: d SiО2, мкм – время t, мин и lg d SiО2 – lg t. 6. Анализ полученных результатов и выводы.
КОНТРОЛЬНЫЕ ВОПРОСЫ 1. Каковы назначение и свойства пленок диоксида кремния? 2. Какие существуют методы формирования пленок SiO2? 3. В чем состоят физико-химические основы процесса термического окисления кремния? 4. Каковы механизмы роста оксидных пленок на кремнии? 5. В чем заключается кинетики термического окисления по соотношению Дила – Гроува? 6. Каковы законы роста оксидных пленок при термическом окислении кремния?
7. В чем суть окисления в парах воды, сухом и влажном кислороде? 8. Как влияют легирующие примеси на скорость термического окисления кремния? 9. Как влияет ориентация кремния на скорость окисления? 10. Как влияет давление окислителя на скорость роста термического окисла? 11. В чем заключается роль хлора в процессе термического окисления кремния? 12. Какие технологическое оборудование и оснастка применяются для проведения процессов термического окисления?
Литература 1. Технология изделий интегральной электроники: учеб. пособие / Л. П. Ануфриев [и др.]; под общ. ред. А. П. Достанко и Л. И. Гурского. – Минск: Алмафея, 2010. – 536 с.: ил. 2. Готра, З. Ю. Технология микроэлектронных устройств. Справочник / З. Ю. Готра. – М.: Радио и связь. – 1991. – 528 с. 3. Коледов, Л. А. Технология и конструкции микросхем, микро-процессоров и микросборок: учебник для вузов/ Л. А.Коледов. – М.: Радио и связь, 1989. – 400 с. 4. Крапухин, В. В. Технология материалов электронной техники. Теория процессов полупроводниковой технологии /В. В. Крапухин, И. А. Соколов, Г. Д. Кузнецов. – М.: МИСИС, 1995. – 496 с.
Лабораторная работа №2
ИССЛЕДОВАНИЕ ВЫПРЯМЛЯЮЩЕГО КОНТАКТА МЕТАЛЛ – ПОЛУПРОВОДНИК Цель работы: изучение физических процессов, протекающих в контактах металл–полупроводник, основных механизмов токопереноса, методов определения основных электрофизических параметров контакта, применения контактов металл–полупроводник.
теоретические сведения Знакомство с контактами металл–полупроводник началось более ста лет тому назад. В 1874 г. Карл Ф. Браун обнаружил зависимость общего сопротивления сульфидов металлов от полярности приложенного напряжения. В его опытах сопротивление контакта медь–сульфид железа отличалось в пределах 30 % в зависимости от направления протекания тока, т. е. наблюдалось выпрямление тока. И хотя механизм выпрямления еще не был понятен, в ранних экспериментах по радиосвязи в качестве детектора широко использовались именно точечные контакты металлических иголок с сульфидами металлов. В 1931 г. немецкий ученый В. Шоттки разработал первую приемлемую теорию выпрямления для контактов. Поэтому такой контакт чаще называется контакт Шоттки или контакт с барьером Шоттки. Было доказано, что при прохождении тока падение потенциала, приложенного к контакту, сосредотачивается почти целиком на самом контакте, что указывает на существование некоторого потенциального барьера. Рассмотрим энергетическую диаграмму контакта полупроводника n -типа с металлом. Пусть термодинамическая работа выхода из металла А Мбудет больше, чем из полупроводника А П, т. е. А М > А П (рис. 2.1). В этом случае поток электронов из полупроводника в металл J ПМ в начальный момент времени будет больше, чем из металла в полупроводник J МП. Поэтому металл заряжается отрицательно, а полупроводник n -типа положительно, и возникает контактная разность потенциалов, которая будет препятствовать дальнейшему переходу электронов из полупроводника в металл. В то же время поток электронов из металла в полупроводник будет возрастать. Через некоторое время потоки J МП и J ПМ и уровни Ферми металла и полупроводника выравниваются. Контактная разность потенциалов, определяемая как φ K = АМ – АП, создает изгиб зон в приповерхностной области полупроводника. Вследствие этого концентрация электронов в приповерхностной области уменьшается, и ее сопротивление увеличивается. Эту область называют по разному: барьерной областью, областью пространственного заряда (ОПЗ) или обедненной областью. Ее ширина d определяется так же как и в случае р - n -перехода. В результате вышеуказанных процессов на границе металл-полупроводник возникает потенциальный барьер величиной q φB. На практике барьер чаще характеризуется высотой барьера φB, которая измеряется в электрон-вольтах. Если же А М < А П или для образования контакта будет исполь-зоваться полупроводник р -типа, зоны будут изгибаться в обратную сторону.
Рис. 2.1. Энергетические зоны металла и полупроводника
Термин невыпрямляющий (омический) говорит о том, что на границе раздела отсутствует потенциальный барьер для потока основных носителей. Для лучшего понимания процесса переноса носителей через границу раздела можно отметить, что дырки ведут себя подобно пузырькам, а электроны – наоборот, как тяжелые шарики. Исходя из приведенных выше энергетических диаграмм, можно простым выбором металла с нужной работой выхода получить или омический или выпрямляющий контакты. Однако экспери-ментально было найдено, что высота потенциального барьера практически не зависит от А М. Американский ученый Дж. Бардин объяснил это влиянием поверхностных зарядов на полупроводнике, которые эффективно экранируют объем полупроводника от металла и нивелируют высоту барьера. В модели Бардина предполагается также существование тонкого диэлектрического слоя между металлом и полупроводником. Это предположение хорошо соответствует реальной ситуации для контактов, изготовленных осаждением тонкой металлической пленки на травленную поверхность полупроводника, на котором всегда присутствует оксидный слой толщиной 1,0–2,0 нм. Поэтому для большинства металлов высота потенциального барьера составляет 0,6–0,8 эВ. ПОРЯДОК ВЫПОЛНЕНИЯ РАБОТЫ 1. Получить у лаборанта диод Шоттки или тестовую структуру и подсоединить их к измерительному стенду. 2. Поставить переключатель 4 в положение «Прямая ветвь ВАХ». Измерить токи через контакт металл–полупроводник в зависимости от приложенного напряжения. Напряжение должно варьироваться от 0 до 1,5 В с шагом 0,1 В.
3. Поставить переключатель 4 в положение «Обратная ветвь ВАХ». Измерить токи через контакт металл–полупроводник в зависимости от приложенного напряжения. Напряжение должно варьироваться от 0 до U обр с шагом 1 В. U обр – это обратное напряжение, при котором ток через контакт достигает значения 50 мкА. 4. Построить по экспериментальным значениям ВАХ контакта. 5. Построить в полулогарифмическом масштабе прямую ветвь ВАХ. 6. По методике, представленной на рис. 2.5, определить ток насыщения I0 и коэффициент идеальности n. 7. По формуле (2.5) рассчитать высоту барьера контакта.
СОДЕРЖАНИЕ ОТЧЕТА 1. Цель работы. 2. Основные расчетные формулы. 3. Схема измерения характеристик контакта. 4. График ВАХ контакта. 5. Результаты расчетов φВ, n, U обр. 6. Анализ полученных результатов, выводы.
КОНТРОЛЬНЫЕ ВОПРОСЫ 1. Каков механизм образования потенциального барьера? 2. От чего зависит высота барьера? 3. Какие существуют механизмы токопереноса через контакт металл–полупроводник? 4. Что такое показатель идеальности? 5. Какие методы определения φВ и n вы знаете? 6. В чем заключаются преимущества контактов с барьером Шоттки перед р - n -переходами? 7. Каковы области применения контактов с барьером Шоттки? 8. В чем состоит принцип работы полевого транзистора с барьером Шоттки на арсениде галлия?
ЛИТЕРАТУРА 1. Зи, С. М. Физика полупроводниковых приборов / С. М. Зи – М.: Мир, 1984. – 456 с.: ил. 2. Родерик, Э. Х. Контакты металл–полупроводник / Э. Х. Родерик. – М.: Радио и связь, 1982. – 208 с.: ил. 3. Ланин, В. Л. Формирование токопроводящих контактных соединений в изделиях электроники / В. Л. Ланин, А. П. Достанко, Е. В. Телеш. – Изд. центр БГУ, 2007. – 574 с.
Лабораторная работа №3
ТЕОРЕТИЧЕСКИЕ СВЕДЕНИЯ
Ионным распылением (иногда называют «катодное распыление») материалов называется процесс бомбардировки мишени из распыляемого материала быстрыми ионами, в результате чего с поверхности мишени выбиваются атомы и осаждаются на расположенные вблизи подложки. Ионная бомбардировка сопровождается эмиссией с поверхности вещества различного рода частиц. Это, в первую очередь, атомы вещества, электроны (ионно-электронная эмиссия), частицы, входящие в состав бомбардирующего ионного пучка (обратное рассеяние ионов), и, наконец, фотоны (ионно-люминесценция). Для описания процесса ионного распыления предлагается несколько моделей, основанных на двух механизмах. Согласно первому механизму распыленные атомы возникают в результате сильного локального разогрева поверхности мишени самим падающим ионом (модель «горячего пятна») либо быстрой вторичной частицей (модель «теплового клина»). Второй механизм состоит в передаче импульса падающего иона атомам решетки материала мишени, которые в свою очередь могут передавать импульс атомам решетки, вызвав тем самым каскад столкновений (модель столкновений).
На рис. 3.1 представлена схема механизма распыления мишени. В случае, когда поверхностный атом получит энергию, достаточную для разрыва связи с ближайшими соседями, и направление этого импульса к поверхности, то атом мишени перейдет в паровую фазу. Ионное распыление начинается в тот момент, когда энергия ионов становится больше некоторого значения пороговой энергии распыления Е пор. Чтобы оторвать атом от поверхности вещества, необходимо затратить энергию (пороговая энергия смещения Е см). Значение Е см лежит в интервале (1,6 – 4,8)·10–8 Дж, что составляет 10–30 эВ. Если для вещества известно Е см, то легко определить пороговую энергию распыления:
где M 1 – масса иона; M 2 – масса атома вещества мишени.
Рис. 3.1. Схема механизма распыления мишени
Для ионов Аr+, распыляющих поверхность, значения Е пор колеблются в зависимости от вещества мишени в интервале 7– 40 эВ. Следует отметить, что при энергии выше определенного значения (назовем ее энергией имплантации ионов) распыление отсутствует из-за относительно глубокого внедрения бомбардирующего иона в мишень. Вся энергия в этом случае расходуется на радиационные искажения решетки мишени. Основной характеристикой ионного распыления является коэффициент распыления S – число атомов, выбиваемых из мишени одним падающим ионом. Коэффициент распыления не является обычно целым числом и должен рассматриваться как среднестатистическое значение. В соответствии с определением
где N A – число распыленных атомов вещества; N 0 – число бомбардирующих ионов. Коэффициент распыления находится в корреляционной зависимости от многих параметров (около двадцати). Основными из них являются: – энергия ионов Е i; – заряд и масса ионов Zi и Мi соответственно; – угол падения ионов α; – кристаллографическая ориентация материала мишени; – шероховатость, температура мишени; – величина импульса иона; – энергия связи атомов вещества с поверхностью; – плотность тока ионов на мишени; – величина дозы облучения мишени; – вид материала мишени; – давление газа в вакуумной камере. Коэффициент распыления согласно теории Зигмунда сложным образом зависит от кинетической энергии ионов (3.4). На рис. 3.2 представлена зависимость величины S от энергии бомбардирующих ионов. При энергиях, лежащих ниже порогового значения, не происходит сколь-нибудь существенного распыления. При возрастании энергии падающих частиц выше этого уровня величина S растет суперлинейно, потом линейно, проходит широкий максимум в области килоэлектронвольт и начинает медленно спадать при достаточно больших энергиях, в области которых наблюдается не распыление материала мишени, а имплантация (внедрение) ионов в мишень. Исходя из предположения, что основной вклад в процесс распыления вносит первое столкновение иона с атомом мишени, была предложена простая формула для расчета величины S:
где λ– cредняя длина свободного пробега ( К – коэффициент, характеризующий физическое состояние мишени; М 1 и М 2 – массы иона и атома мишени соответственно; Ei – энергия иона; d – диаметр столкновения иона и атома; n 0 – концентрация атомов в мишени. Значение К определяется путем сравнения расчетной кривой с экспери-ментальными данными. Зигмундом была предложена полуэмпирическая формула для расчета коэффициента распыления:
где E св – энергия связи поверхностных атомов мишени; Z 1 и Z 2– заряды иона и атома мишени соответственно. Для технологии ионного распыления интересно знать зависимости коэффициента распыления от различных параметров процесса, т. к. от величины S зависит и скорость нанесения пленок (V H):
где j – плотность тока падающего ионного потока; ρ – плотность материала мишени.
Рис. 3.2 Зависимость коэффициента распыления от энергии бомбардирующих ионов
На рис. 3.3 представлена зависимость величины S для некоторых металлов от энергии ионов. Для ионов с энергией 0,5–6 кэВ коэффициент распыления линейно зависит от энергии, т. е. S = кЕ, а для Е > 6 кэВ линейность нарушается.
Рис. 3.3 Зависимости коэффициента распыления некоторых металлов от энергии бомбардирующих ионов
Если распыление мишени производится ионным пучком, то наблюдается сильная зависимость коэффициента распыления от угла падения ионов (рис. 3.4). Для многих материалов зависимость S от угла падения α, может быть записана в виде:
S (α) = S (0)cosα, (3.7)
где S (0)– коэффициент распыления при нормальном падении ионов.
Рис. 3.4. Зависимость коэффициента распыления от угла падения бомбардирующих ионов
Рост S при увеличении угла падения ионов α объясняется тем, что при α ≠ 0 длина пробега и число столкновений иона с атомами в приповерх-ностном слое мишени возрастает в 1 / cos α раз. Зависимость величины S от температуры мишени может быть довольно сложной. Она зависит от того, как изменяется структура мишени с увеличением температуры. Поскольку на структуру мишени при этом начинает влиять отжиг дефектов, который восстанавливает повреждения решетки, производимые падающим ионом до того, как в это место попадает следующий ион, то температура может снижать величину S. Если же повышение температуры мишени влечет за собой фазовые превращения, как, например, в железе при 906 °С ОЦК решетка переходит в ГЦК, то характер зависимости S от Т может при этом измениться. Угловое распределение распыленных частиц очень часто имеет первостепенное значение для практических целей получения качественных тонких пленок. В отличие от процесса испарения угловое распределение при катодном распылении не подчиняется строго закону косинуса. Только при распылении аморфных или поликристаллических мишеней распределение выбитых атомов по углам вылета с поверхности близко к косинусоидальному. При распылении монокристаллических мишеней картина несколько иная (рис. 3.5).
Рис. 3.5. Распределение распыленных частиц, выбитых из монокристалла Мо
В распределении выбитых атомов по углам вылета появляются направления, в которых число выбитых атомов больше, чем в других. Установлено, что в направлении наиболее плотной упаковки атомов в кристаллической решетке наблюдается преимущественное распыление атомов. Это можно объяснить следующим образом: вдоль направления плотной упаковки атомов существует возможность фокусировки импульса иона (образование так называемого «фокусона»). Давление в вакуумной камере складывается из парциальных давлений рабочего и остаточных газов. Присутствие остаточных газов, обычно химически активных (кислород, азот, пары воды, вакуумных масел), снижает коэффициент распыления вследствие образования на поверхности образца пленок химических соединений, особенно оксидов. Распыляемые атомы мишени, испытывая столкновения с молекулами или атомами рабочего газа, могут возвращаться на мишень. Обратное рассеяние существенно, когда масса распыленного атома меньше массы газовой частицы. Обратная диффузия возрастает с ростом давления рабочего газа. Например, при давлениях более 1–1,2 Па величина S уменьшается. Плотность ионного тока на мишень не может прямо влиять на коэффициент распыления, но при низких плотностях тока (j < 100 мкА/см2) может наблюдаться снижение S из-за наличия хемосорбированных газов, которые затрудняют распыление. Состояние поверхности мишени (кристаллографическое и химическое) сильно сказывается на коэффициенте распыления в начале процесса, но при длительном распылении, когда раскрыты внутренние участки объема мишени и нет нерегулярного воздействия остаточных газов, это влияние ослабевает. Экспериментально установлена зависимость величины S от атомного номера элемента материала мишени. На величину S существенное влияние оказывает также масса распыляющих ионов. Коэффициенты распыления максимальны для ионов инертных газов и минимальны для элементов, расположенных в центральных столбцах периодической системы (Al, Ti, Zr, Hf и редкоземельные элементы). Весьма интересным является тот факт, что коэффициенты распыления изменяются значительно сильнее в зависимости от природы ионов (в сто и более раз), чем в зависимости от природы атомов мишени (в 10 раз). Коэффициент распыления может достигать довольно высоких значений. Так для пары Al–Hg+ он составляет 50 атом/ион. В технологии очень часто встречаются не только с распылением простых мишеней. Процесс распыления сплавов, а также соединений более сложен, чем распыление мишеней из простых веществ. Кинетическая энергия бомбардирующих ионов неодинаково распределяется между компонентами сложной мишени. В результате происходит преимущественное распыление какого-либо компонента и, следовательно, нарушается стехиометрия состава распыляемой поверхности мишени за счет обеднения ее хорошо распыляемым элементом. Распыление сплавов и соединений имеет особое значение, т. к. способность переносить сложный по составу материал с мишени на поверхность подложки является основным преимуществом ионных методов нанесения тонких пленок по сравнению с другими методами. Стехиометрия состава пленок сохраняется даже в случае распыления материалов, состоящих из компонентов с сильно различающимися парциальными коэффициентами распыления. Единственное требование для обеспечения заданной стехио-метрии пленок – хорошее охлаждение мишени для исключения диффузии компонентов из объема. Поток распыленного материала с установившейся стехиометрией по составу компонентов формируется следующим образом. Поверхность мишени обедняется ионами с высоким коэффициентом распыления до количества, компенсирующего различие в скоростях распыления различных компонентов. Если диффузия не обеспечивает пополнение из объема поверхности обедненным компонентом, состав будет установившимся, постоянным. Если коэффициенты распыления всех компонентов близки, то установившееся состояние достигается после удаления всего лишь нескольких слоев. Если через SA, KA, CA обозначить соответственно коэффициент распыления, поверхностную концентрацию и объемную концентрацию компонента A, а через SB, KB, CB – компонента В, то установление равновесия поверхностной концентрации можно охарактери-зовать соотношением
Из него следует, что распыление компонентов будет происходить со скоростями, пропорциональными объемным концентрациям их в материале. Таким образом, при распылении многокомпонентных материалов могут быть обеспечены условия для получения пленок требуемого состава. Как отмечалось, состав распыленных частиц при ионном распылении слагается из атомов и ионов основного вещества, ионов, атомов и молекул примесей и газов, содержащихся в мишени, химических соединений материала мишени, рабочего и остаточного газов. Так, при распылении тантала обнаружено, что основная часть (94 %) распыленных частиц является нейтральными атомами металла и около 1 % составляют положительные ионы Та+, TaN+,TaO+, TaO2+, Ta2O+, Ta2 O2+. Надо отметить, что по сравнению с термическим испарением количество ионизованных частиц чрезвычайно велико. Энергетический спектр распыленных атомов и ионов металла определяется условиями распыления: природой и энергией первичных ионов, природой распыляемого металла и углом вылета атомов из мишени. Величина анергии распыленных частиц колеблется от 0,5 до 200 эВ со средним значением порядка 5 эВ, что в терминах температуры для частиц соответствует 58 000 °С. На рис. 3.6 представлены энергетические спектры атомов Ag и Zr, распыляемых ионами криптона с энергией 1200 эВ.
Рис. 3.6. Энергетические спектры атомов Ag и Zr, распыляемых ионами криптона с энергией 1200 эВ
Таким образом, основными особенностями конденсации пленок, наносимых ионным распылением, являются повышенная кинетическая энергия атомов и относительно высокое содержание заряженных частиц и ионов инертного газа в общем потоке. Кинетика конденсации пленки при этом имеет следующие особенности. Вследствие значительной энергии конденсирующихся атомов их подвижность на подложке высокая, что способствует увеличению плотности центров зародышеобразования и уменьшению размеров кристаллов, при этом пленка становится сплошной при меньшей толщине по сравнению с методом термического нанесения. Увеличение плотности центров зародышеобразования происходит также вследствие возникновения радиационных дефектов в поверхностном слое подложки. Осажденные пленки обладают высокой адгезией к подложке, т. к. энергия осаждаемых атомов достаточна для образования хемосорбционных связей. Для конденсации пленок при ионном распылении характерно также повышенное содержание в их составе атомов примесных остаточных газов. Благодаря ионизации атомы этих газов интенсивно проникают в пленку вещества и замуровываются или адсорбируются в ней.
ПОРЯДОК ВЫПОЛНЕНИЯ РАБОТЫ
1. Получить у лаборанта подложку из кремния и металлическую мишень. Измерить размер мишени (диаметр или длину и ширину) с помощью линейки. 2. С помощью пинцета закрепить подложку на подложкодержателе. 3. Закрепить подложкодержатель на карусели, а мишень – на мишенедержателе. 4. После достижения вакуума в камере не хуже 4·10–5 мм рт.ст. осуществить напыление металлической пленки на подложку в течение заданного преподавателем времени. В процессе напыления контролировать ускоряющее напряжение и ток на мишени по приборам на блоке питания БП-94. Примечание. Процесс откачки вакуумной камеры и напыления должен проводиться инженером или лаборантом. 5. После завершения напыления напустить воздух в камеру и извлечь подложку с нанесенной металлической пленкой. 6. С помощью микроскопа интерферометра МИИ-4 измерить толщину металлической пленки и рассчитать скорость нанесения. 7. Рассчитать коэффициент распыления металла мишени, используя формулу (3.6).
СОДЕРЖАНИЕ ОТЧЕТА
1. Введение (постановка задачи и определение цели работы). 2. Основные теоретические сведения. 3. Упрощенная схема ионного источника. 4. Таблица экспериментальных данных с результатами расчетов. 6. Анализ полученных результатов. 7. Выводы.
КОНТРОЛЬНЫЕ ВОПРОСЫ
1. В чем заключается механизм ионного распыления? 2. Как определить пороговую энергию распыления? 3. Что такое коэффициент распыления? 4. От каких параметров зависит величина коэффициента распыления? 5. Чем отличается процесс распыления аморфных и монокристалли-ческих мишеней? 6. Каковы основные особенности конденсации пленок при ионном распылении? 7. В чем заключаются особенности кинетики конденсации пленок при ионном распылении?
ЛИТЕРАТУРА
1. Распыление твердых тел ионной бомбардировкой. Физическое распыление одноэлементных твердых тел; пер с англ; / под ред. Р. Бериша. –М.: Мир, 1984. – 336 с. 2. Вендик, О. Г. Корпускулярно-фотонная технология/ О. Г. Вендик, Ю. Н. Горин, В. З. Попов. – М.: Высш. школа, 1984. – 239 с. 3. Ивановский, Г. Ф. Ионно-плазменная обработка материалов/ Г. Ф. Ивановский, В. И. Петров. – М.: Радио и связь, 1986. – 232 с. Лабораторная работа №4 ТЕОРЕТИЧЕСКИЕ СВЕДЕНИЯ Плазма – состояние вещества, при котором в веществе присутствуют электроны, ионы, нейтральные атомы и молекулы. Газ переходит в состояние плазмы, если некоторые из составляющих его атомов (молекул) лишились одного или нескольких электронов, т. е. превратились в положительные ионы. Основные характеристики плазмы: температура, плотность (число свободных электронов (ионов) в единице объема), степень ионизации (отношение числа ионизованных частиц к общему числу частиц), квазинейтральность (плотность отрицательных зарядов равна плотности положительных зарядов). Плазма также характеризуется ярким свечением. Для получения плазмы используют электрический газовый разряд. Газовый разряд представляет собой газовый промежуток, к которому приложена разность потенциалов. В промежутке образуются заряженные частицы, которые движутся в электрическом поле, т. е. создают ток. Для поддержания тока в плазме нужно, чтобы отрицательный электрод (катод) испускал в плазму электроны. Эмиссию электронов с катода можно обеспечивать различными способами, например, нагреванием катода до достаточно высоких температур (термоэмиссия), облучением катода каким-либо коротковолновым излучением (рентгеновские лучи, γ-излучение), способным выбивать электроны из металла (фотоэффект). Такой разряд, создаваемый внешними источниками, называется несамостоятельным. К самостоятельным разрядам относятся искровой, дуговойитлеющий разряды, которые принципиально отличаются друг от друга по способам образования электронов у катода или в межэлектродном промежутке. Искровой разряд. Если постепенно увеличивать напряжение между двумя электродами, находящимися в атмосферном воздухе и имеющими такую форму, что электрическое поле между ними не слишком сильно отличается от однородного (например, два плоских электрода с закругленными краями или два достаточно больших шара), то при некотором напряжении возникает электрическая искра. Она имеет вид ярко светящегося канала, соединяющего оба электрода. Электрическая искра возникает в том случае, если электрическое поле в газе достигает некоторого определенного значения Е к (критическая напряжен-ность поля или напряженность пробоя), которая зависит от рода газа и его состояния. Чем больше расстояние между электродами, тем большее напряжение между ними необходимо для наступления искрового пробоя газа. Это напряжение называется напряжением пробоя. Возникновение пробоя объясняется следующим образом. В газе всегда есть некоторое число ионов и электронов, возникающих от случайных причин. Однако, число их настолько мало, что газ практически не проводит электричества. При достаточно большой напряженности поля кинетическая энергия, накопленная ионом в промежутке между двумя соударениями, может оказаться достаточной, чтобы ионизировать нейтральную молекулу при соударении. В результате образуется новый электрон и положительно заряженный остаток – ион. Механизм лавинной ионизации показан на рис. 4.1. Такой процесс ионизации называют ударной ионизацией, а ту работу, которую нужно затратить, чтобы произвести отрыв электрона от атома – работой ионизации. Работа ионизации зависит от строения атома и поэтому различна для разных газов. Образовавшиеся под влиянием ударной ионизации электроны и ионы увеличивают число зарядов в газе, причем в свою очередь они приходят в движение под действием электрического поля и могут произвести ударную ионизацию новых атомов. Таким образом, процесс усиливает сам себя, и ионизация в газе быстро достигает очень большой величины. Явление аналогично снежной лавине, поэтому этот процесс был назван ионной лавиной. Образование ионной лавины и есть процесс искрового пробоя, а то минимальное напряжение, при котором возникает ионная лавина, есть напряжение пробоя. Таким образом, при искровом пробое причина ионизации газа заключается в разрушении атомов и молекул при соударениях с ионами (ударная ионизация). Величина Е к увеличивается с увеличением давления. При малой длине разрядного промежутка искровой разряд вызывает специфическое разрушение анода, называемое эрозией. Это явление было использовано в электроискровом методе резки, сверления и других видах точной обработки металла.
Рис. 4.1. Механизм лавинной ионизации при искровом разряде
Дуговой разряд. В настоящее время электрическую дугу, горящую при атмосферном давлении, чаще всего получают между специальными угольными электродами, изготовленными прессованием порошкообразного графита и связующих веществ (дуговые угли). Наиболее горячим местом дуги является углубление, образующееся на положительном эл
|
|||||||||||||
|
Последнее изменение этой страницы: 2021-05-12; просмотров: 94; Нарушение авторского права страницы; Мы поможем в написании вашей работы! infopedia.su Все материалы представленные на сайте исключительно с целью ознакомления читателями и не преследуют коммерческих целей или нарушение авторских прав. Обратная связь - 3.14.253.221 (0.165 с.) |
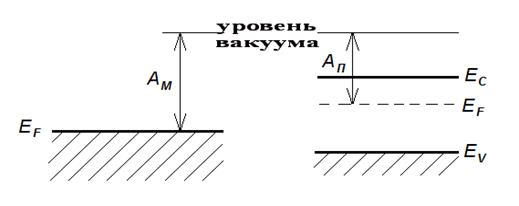
 (3.1)
(3.1)
 , (3.2)
, (3.2) , (3.3)
, (3.3) ); (3.4)
); (3.4) , (3.5)
, (3.5) , нм/с, (3.6)
, нм/с, (3.6)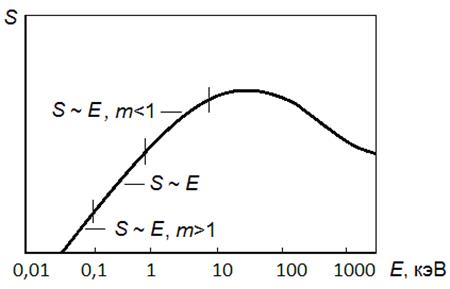
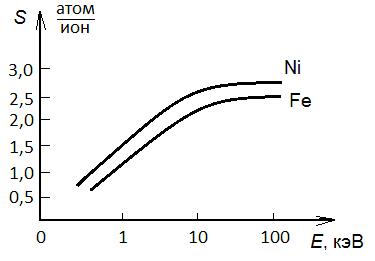

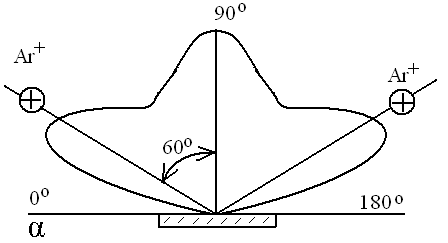
 . (3.8)
. (3.8)