
Заглавная страница Избранные статьи Случайная статья Познавательные статьи Новые добавления Обратная связь КАТЕГОРИИ: ТОП 10 на сайте Приготовление дезинфицирующих растворов различной концентрацииТехника нижней прямой подачи мяча. Франко-прусская война (причины и последствия) Организация работы процедурного кабинета Смысловое и механическое запоминание, их место и роль в усвоении знаний Коммуникативные барьеры и пути их преодоления Обработка изделий медицинского назначения многократного применения Образцы текста публицистического стиля Четыре типа изменения баланса Задачи с ответами для Всероссийской олимпиады по праву 
Мы поможем в написании ваших работ! ЗНАЕТЕ ЛИ ВЫ?
Влияние общества на человека
Приготовление дезинфицирующих растворов различной концентрации Практические работы по географии для 6 класса Организация работы процедурного кабинета Изменения в неживой природе осенью Уборка процедурного кабинета Сольфеджио. Все правила по сольфеджио Балочные системы. Определение реакций опор и моментов защемления |
Вивчаємо домішкову провідність напівпровідників
До цього було розглянуто електричний струм у чистих напівпровідниках. У таких напівпровідниках кількість вільних електронів і дірок є однаковою. Проте якщо в чистий напівпровідник додати невелику кількість домішки, то картина дещо зміниться.
Рис. 23.4. Додавання арсену до чистого розплавленого сіліцію. Арсен, як відомо,— п'ятивалентний елемент. Чотири валентні електрони атома Арсену утворять парні електронні зв'язки із сусідніми атомами Силіцію. П'ятому ж валентному електрону зв'язку не вистачить, при цьому він буде так слабко пов'язаний з атомом Арсену, що легко стане вільним. У результаті кожний атом домішки дасть один вільний електрон, а вакантне місце (дірка) при цьому не утвориться. Домішки, атоми яких легко віддають електрони, називаються донорними домішками (від латин. сїопаге — дарувати, жертвувати). Якщо в силіцій додати невелику кількість тривалентного елементу, наприклад Індію, то характер провідності напівпровідника зміниться. Оскільки атом Індію має три валентні електрони, то він може встановити ковалентний зв'язок тільки з трьома сусідніми атомами Силіцію (рис. 23.5).
Для встановлення зв'язку з четвертим атомом електрона не вистачить, і цей відсутній електрон Індій «запозичить»
Л3 Контактні та поверхневі явища у напівпровідниках КОНТАКТНЫЕ ЯВЛЕНИЯ В ПОЛУПРОВОДНИКАХ - неравновесные электронные явления, возникающие при прохождении электрич. тока через контакт полупроводника с металлом или электролитом или через контакт двух различных полупроводников (гетеропереход)либо через границу двух областей одного и того же полупроводника с разным типом носителей заряда (см. р - п-переход)и разной их концентрацией.
Рис. 1. Изгиб зон на контакте металл - электронный полупроводник с запорным слоем: - уровень Ферми;
Приведение в контакт двух разл. материалов сопровождается перетеканием носителей (для определённости электронов) из одного в другой и образованием контактной разности потенциалов VK. Напряжённость поля контактной разности потенциалов плавно убывает в глубь полупроводника, вызывая приконтактный изгиб краёв энергетич. зон (валентной зоны и зоны проводимости). Направление изгиба и его величина зависят от знака и величины VK, определяемой разностью работ выхода, а также от знака и концентрации локализованных на поверхности раздела зарядов (адсорбированные ионы, заряженные поверхностные дефекты и др., см. ниже). Выпрямляющие контакты. На контакте металла с электронным полупроводником изгиб зон вверх (рис. 1) означает, что приконтактный слой полупроводника имеет дефицит электронов и, следовательно, пониженную проводимость (обеднённый слой,запорный слой, слой IIIоттки). При достаточно сильном обеднении электрич. сопротивление этого слоя доминирует над сопротивлением нейтрального объёма полупроводника, так что последним можно пренебречь. Величина сопротивления слоя сильно зависит отнапряжения, приложенного к нему. Это приводит к большой нелинейности вольт-амперной характеристики (ВАХ) слоя и, в частности, к её сильной асимметрии относительно знака приложенного напряжения: сопротивление на обратной ветви ВАХ на много порядков величины превышает сопротивление на прямой ветви (эффект выпрямления). Прямая ветвь ВАХ соответствует такому внеш. напряжению, когда его поле уменьшает поле контактной разности потенциалов и сужает слой. На рис. 1 это соответствует положит. потенциалу на металле. Обратная ветвь ВАХ отвечает сложению полей внеш. источника и VK (отрицат. потенциал на металле). При этом обеднённый слой расширяется с ростом внеш. напряжения. Нелинейность ВАХ и эффект выпрямления тока на контакте металл-полупроводник используются в диодах Шоттки.
Омические контакты. При изгибе зон вниз (рис. 2) приконтактный слой имеет избыток электронов (антизапорный слой,обогащённый слой). Ввиду повышенной проводимости он не вносит заметный вклад в сопротивление длинного образца. Поэтому контакты с обогащённым слоем могут служить омич. контактами в полупроводниковых приборах. При больших плотностях тока омич. поведение контактов нарушается из-за монополярной инжекцииэлектронов, напр., из металла в полупроводник (см. Инжекция носителей заряда в полупроводниках). Инжекция становится заметной, если плотность тока
где n - концентрация электронов основных носителей заряда в полупроводнике, D - их коэф.диффузии, RD - дебаевский радиус экранирования, е - элементарный заряд. С ростом тока проводимость полупроводника всё более определяется инжектированными электронами, рост концентрации к-рых ограничивается их объёмным зарядом (токи, ограниченные пространств. зарядом). В результате проводимость образца становится существенно нелинейной. Электрич. сопротивление омич. контакта с обогащённым слоем увеличивается при наличии диэлектрич. прослойки Д между металлом и полупроводником (напр., окисла металла, рис. 3). Из-за туннельной проницаемости прослойки проводимость её при малых толщинах
Рис. 2. Контакт с обогащённым (антизапорным) слоем.
Рис. 3. Контакт с обогащённым слоем и диэлектрическим зазором.
Поэтому для создания омич. контактов часто предпочитают сильно легированные приконтактные области полупроводника, образующие с основным его объёмом изотопный гомопереход, напр. п+-п (рис. 4), где переход образован сильно (п+)и слабо (п) легированными областями. Такой переход обладает теми же свойствами, что и контакт металл - полупроводник с антизапорным слоем. Свойства такого омич. контакта не зависят от изгиба зон непосредственно у металла.
Биполярные явления. Если в полупроводнике происходит генерация неосновных носителей, напр. дырок, или если они инжектируются в образец с помощью др. контакта, то возникают т. н. биполярные контактные явления. Контакты с обогащённым слоем (рис. 2, 3, 4) обедняются дырками, ибо то электрич. поле, к-рое способствует обогащению электронами, выносит из слоя дырки. Электрич. поле тока в обогащённом слое мало по сравнению с электрич. полем в объёме. Поэтому ток дырок почти не проходит сквозь обогащённый слой. Если направление тока электронов таково, что дырки в поле этого тока движутся из объёма к контакту, то из-за непропускания их слоем происходит их накопление перед контактом. Возникает т. н. аккумуляционный слой, обогащённый дырками, в к-рый для их нейтрализации из обогащённого слоя инжектируются электроны. С ростом плотности тока j через контакт толщина аккумуляционного слоя (lj=Dn/j)убывает, а концентрация дырок в нём быстро растёт. Когда она достигает и превосходит равновесную концентрацию электронов, сжатие аккумуляционного слоя сменяется его расширением до размера длины амбиполярной диффузии за время жизни носителей.
При противоположном направлении тока поле выносит дырки в толщу полупроводника. Возникает э к с к л ю з и я - удаление дырок от контакта; область эксклюзии простирается от контакта в глубь полупроводника на расстояние, растущее с ростом j и приближённо совпадающее с длиной дрейфа электронов в поле за время их жизни. Эксклюзия дырок сопровождается уходом такого же кол-ва электронов в контакт, так что область эксклюзии - область обеднения носителями обоих знаков. Макс, обеднение и наиб, значение электрич. поля достигаются на границе с обогащённым слоем. В образце с носителями обоих знаков, ограниченном с двух сторон омич. контактами для основных носителей, одновременно происходит эксклюзия у одного из контактов и аккумуляция у другого. При достаточно больших j область эксклюзии простирается на всю длину образца - вплоть до аккумуляционного слоя у др. контакта. В случае фотогенерации неосновных носителей говорят о токовом выносе фотоносителей из образца на один из контактов. Контакты с обеднённым слоем (рис. 1) в равновесном случае обогащены неосновными носителями (поле, к-рое вытесняет осн. носители, втягивает неосновные). При прохождении тока в обратном направлении происходит экстракция (извлечение, вытягивание) в контакт неосновных носителей из приконтактной части образца, протяжённость к-рой определяется длиной диффузии неосновных носителей. Экстракция - слаботоковое явление на обратной ветви ВАХ, тогда как эксклюзия - сильнотоковый эффект. Эти эффекты смыкаются лишь в собственном полупроводнике. Экстракция неосновных носителей обратно смещённым обеднённым слоем используется в коллекторах биполярных транзисторов.
Если через контакт с обогащённым слоем пропускать ток в прямом направлении, происходит инжекция неосновных носителей из контакта. Заряд инжектированных носителей нейтрализуется зарядом осн. носителей, приходящих в область инжекции из объёма полупроводника или из др. контакта (напр., омич. контакта в диодах, базового контакта в транзисторах). При слабых токах область инжекции простирается, как и область экстракции, примерно на длину диффузии неосновных носителей. С ростом j эта область растягивается за счёт дрейфа носителей в поле большого прямого тока, охватывая постепенно весь образец. Если экстракция неосновных носителей осуществляется любым обратно смещённым контактом с обеднённым ими слоем, то эффективная их инжекция возможна лишь при высокой эмиссионной способности контакта. В случае контакта металл - электронный полупроводник инжекция дырок достигается при столь большом изгибе зон вверх, что у металла валентная зона становится ближе к уровню Ферми
Рис. 5. Контакт с инверсионным слоем (с физическим р-n -переходом).
Рис. 6. Контакт с металлургическим р-n -переходом. Для получения стабильных выпрямляющих и инжектирующих контактов в полупроводнике создают специально легированный слой с противоположным объёму типом проводимости (рис. 6). Высокая эмиссионная способность образующегося т. н. металлургич. р - n -перехода достигается, если дырочный слой легирован акцепторами значительно сильнее, чем объём полупроводника донорами (р+ -n-переход или n + - р-переход). Инжекция неосновных носителей лежит в основе работы эмиттеров биполярных транзисторов. Двойная инжекция (одновременная инжекция с двух сторон дырок и электронов) происходит в образцах полупроводника, ограниченных с одной стороны р+- n -контактом, а с другой п + р-контактом (p + nn +-диоды или р+- рп+ -диоды). Рост концентрации электронов и дырок в средней части образцов ограничен только скоростью рекомбинации носителей. Инжекция, ограниченная рекомбинацией, более эффективна, чем инжекция, ограниченная пространственным зарядом. Реальные контакты. Инжекция и экстракция неосновных носителей контактом с обеднённым слоем эффективны лишь в случае, когда контакт не является дополнит. источником рекомбинации или генерации носителей, т. е. если потоки носителей каждого типа переносятся через обеднённый слой без "потерь" и "приобретений". Последние обусловлены тремя причинами. 1) Поверхностная рекомбинация и генерация через центры, локализованные на границе металл - полупроводник или диэлектрич. прослойка - полупроводник. Это же происходит и в тонкой приконтактной области, где концентрация центров рекомбинации существенно выше, чем в объёме полупроводника, из-за дефектной структуры этой области и из-за диффузии сюда примесей из металла или окисла.
2) Скорость термич. генерации и рекомбинации носителей в обеднённом слое через глубокие уровни (расположенные вблизи середины запрещённой зоны) выше по сравнению с теми же процессами в объёме полупроводника (механизм Са - Нойса - Шокли). Напр., отношение скоростей термич. генерации в обеднённом слое и объёме порядка Wn/2lniT, где n - концентрация основных носителей, W - толщина слоя, l - длина диффузии носителей, пi - концентрация собственных носителей. В Ge, Si и др. полупроводниках, как правило, W<l, но в легированных полупроводниках 3) Туннельная (полевая) генерация и рекомбинация носителей в обеднённых слоях. В отличие от объёма полупроводника, где возможны только вертикальные переходы между рекомбинационными уровнями
Рис. 7. Рекомбинационные и генерационные переходы электронов в нейтральном объёме полупроводника:
Высокий темп генерации и рекомбинации носителей в обеднённом слое ухудшает выпрямляющие и инжекционные свойства такого контакта. При обратном смещении он становится источником генерации неравновесных носителей, а прямом смещении - источником их рекомбинации. Для контактов с очень высокой скоростью рекомбинации также применяют термин "омический", подразумевая контакт, на к-ром при любых j поддерживаются равновесные значения концентрации носителей. Инжекционные свойства таких контактов проявляются лишь при очень больших j, тем больших, чем выше скорость рекомбинации в нём.
Рис. 8. Туннельные и комбинированные переходы в областях с наклоном энергетических зон.
Потенциал электрического поля приводит к изменению энергии электронов в полупроводнике создавая изгиб зон. Тут возможно несколько ситуаций: обогащение, обеднение и инверсия. Согласно законам статистики полупроводников, если в глубине полупроводника концентрация электронов n0, то вблизи поверхности концентрация будет определяться изгибом зон:
где js – изгиб зон, связанный с тем, что поверхностные состояния заряжаясь, создают потенциал. Если этот потенциал таков, что основные носители заряда притягиваются в приповерхностную зону, это называется обогащением. Если основные носители заряда отталкиваются зарядом поверхности, их концентрация вблизи поверхности меньше чем в глубине полупроводника, реализуется ситуация обеднения. Возможна ситуация, когда изгиб зон настолько велик, что вблизи поверхности происходит инверсия типа проводимости. Скажем, объемный полупроводник n- типа, а в результате инверсии, приповерхностный его слой обладает p- типом проводимости. На рисунке 8.2 приведена ситуация обеднения концентрации электронов на поверхности, видно что вблизи поверхности полупроводник n типа становится почти собственным полупроводником.
Рисунок 8.2. Иллюстрация изгиба зон (ситуация обеднения). Простейший для анализа случай – обеднение. Решая уравнение Пуассона, можно найти распределение электрического поля и потенциала в области пространственного заряда. Рассмотрим, как спадает напряженность электрического поля вглубь полупроводника. Из курса электродинамики известна связь между потенциалом j и объемной плотностью заряда r (уравнение Пуассона):
Обратим внимание, что в случае неоднородного электрического поля, вклад в объемную плотность заряда r* вносят и связанные заряды. Связанные электроны и ядра поляризуются, создавая дипольный момент. Вклад связанных зарядов заключается в том, что полупроводник обладает отличной от единицы статической диэлектрической проницаемостью e. Так как задача одномерна, то:
Объемная плотность заряда создается электронами, дырками, положительно заряженными донорными примесями (которые отдали электрон), и отрицательно заряженными акцепторными примесями (которые захватили электрон). То есть:
Рассмотрим случай полупроводника n-типа. Пусть концентрация доноров в глубине (далеко от поверхности) остается еще много больше концентрации свободных электронов, то есть примесь далека от истощения и уровень Ферми лежит несколько выше энергии доноров. Пусть поверхностные состояния являются акцепторными, то есть поверхность захватывает электроны из объема полупроводника, и, зарядившись отрицательно, создает потенциальный барьер js для электронов. Концентрация электронов к поверхности уменьшается, концентрация дырок растет, но не превышает концентрации электронов (не реализуется ситуация инверсии). Тогда уравнение 7.2 существенно упрощается. Концентрация дырок и электронов у поверхности близка к собственной концентрации, и, таки образом, на много порядков меньше концентрации доноров. Акцепторы нами преднамеренно не вводились, и их концентрация равна нулю (конечно в реальном полупроводнике всегда есть фоновые примеси акцепторного типа, но их концентрация мала по сравнению с концентрацией преднамеренно введённых доноров - скажем 1016 см-3для германия, кремния либо арсенида галлия), и ими можно пренебречь. Значит, объемная плотность заряда обусловлена, в основном положительным зарядом доноров (с которых ушли электроны). На энергетической диаграмме это те доноры, энергетический уровень которых находятся выше уровня Ферми (рисунок 8.2). Предположим также, что концентрация доноров не зависит от координаты (полупроводник легирован однородно).
Решение тривиально, напряженность электрического поля в пределах ОПЗ изменяется линейно, и, в соответствии с граничными условиями для потенциала:
Отсюда размер ОПЗ W и максимальная напряженность электрического поля (вблизи границы) равны:
Л4 Оптичні і фотоелектричні явища у напівпровідниках
|
||||||||||
|
Последнее изменение этой страницы: 2021-01-08; просмотров: 139; Нарушение авторского права страницы; Мы поможем в написании вашей работы! infopedia.su Все материалы представленные на сайте исключительно с целью ознакомления читателями и не преследуют коммерческих целей или нарушение авторских прав. Обратная связь - 3.149.233.72 (0.035 с.) |



 - край зоны про
- край зоны про  водимости;
водимости;  край валентной зоны.
край валентной зоны. (1)
(1) А) становится пренебрежимо большой. В прослойке, а также на границе окисел-полупроводник, как правило, возникают центры захвата носителей заряда, поле к-рых наряду с полем контактной разности потенциалов управляет приконтактным изгибом зон, существенно изменяя его величину, а иногда и знак (см. МДП-структура).Это приводит к нестабильности и невоспроизводимости омич. контактов металл-полупроводник.
А) становится пренебрежимо большой. В прослойке, а также на границе окисел-полупроводник, как правило, возникают центры захвата носителей заряда, поле к-рых наряду с полем контактной разности потенциалов управляет приконтактным изгибом зон, существенно изменяя его величину, а иногда и знак (см. МДП-структура).Это приводит к нестабильности и невоспроизводимости омич. контактов металл-полупроводник.


 чем зона проводимости (рис. 5), т. е. там образуется инверсионный слой (р-слой); около контакта возникает т. н. физический р - n -переход.
чем зона проводимости (рис. 5), т. е. там образуется инверсионный слой (р-слой); около контакта возникает т. н. физический р - n -переход.
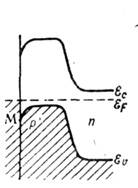
 , что делает этот механизм существенным.
, что делает этот механизм существенным. ,
,  в запрещённой зоне и состояниями в разрешённых зонах, сопровождающиеся поглощением энергии при генерации и её выделением при рекомбинации (рис. 7), в обеднённых слоях ввиду изгиба зон возможны горизонтальные переходы (рис. 8). Они обусловлены туннелированием из состояний в разрешённых зонах на уровни рекомбинационных центров или даже непосредственно между валентной зоной и зоной проводимости (межзонное, или зиннеровское, туннелирование). С участием рекомбинационных центров возможен комбинированный процесс, включающий горизонтальные и вертикальные переходы. При этом полное энерговыделение или энергопоглощение на одну пару электрон- дырка меньше ширины запрещённой зоны
в запрещённой зоне и состояниями в разрешённых зонах, сопровождающиеся поглощением энергии при генерации и её выделением при рекомбинации (рис. 7), в обеднённых слоях ввиду изгиба зон возможны горизонтальные переходы (рис. 8). Они обусловлены туннелированием из состояний в разрешённых зонах на уровни рекомбинационных центров или даже непосредственно между валентной зоной и зоной проводимости (межзонное, или зиннеровское, туннелирование). С участием рекомбинационных центров возможен комбинированный процесс, включающий горизонтальные и вертикальные переходы. При этом полное энерговыделение или энергопоглощение на одну пару электрон- дырка меньше ширины запрещённой зоны 

 - край зоны проводимости;
- край зоны проводимости;  - край валентной зоны;
- край валентной зоны;  - комбинационные уровни.
- комбинационные уровни.
 8.1
8.1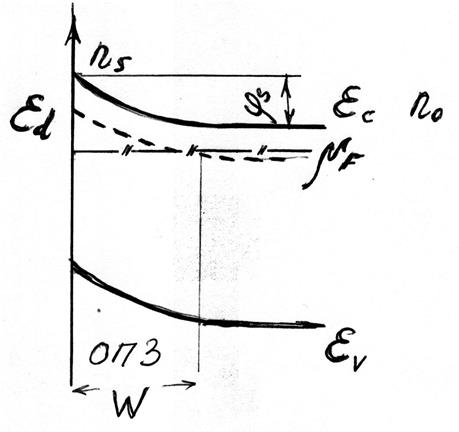
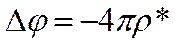

 8.2
8.2



 8.3
8.3


