
Заглавная страница Избранные статьи Случайная статья Познавательные статьи Новые добавления Обратная связь КАТЕГОРИИ: ТОП 10 на сайте Приготовление дезинфицирующих растворов различной концентрацииТехника нижней прямой подачи мяча. Франко-прусская война (причины и последствия) Организация работы процедурного кабинета Смысловое и механическое запоминание, их место и роль в усвоении знаний Коммуникативные барьеры и пути их преодоления Обработка изделий медицинского назначения многократного применения Образцы текста публицистического стиля Четыре типа изменения баланса Задачи с ответами для Всероссийской олимпиады по праву 
Мы поможем в написании ваших работ! ЗНАЕТЕ ЛИ ВЫ?
Влияние общества на человека
Приготовление дезинфицирующих растворов различной концентрации Практические работы по географии для 6 класса Организация работы процедурного кабинета Изменения в неживой природе осенью Уборка процедурного кабинета Сольфеджио. Все правила по сольфеджио Балочные системы. Определение реакций опор и моментов защемления |
Особенности построения интегральных резисторовСтр 1 из 5Следующая ⇒
ВВЕДЕНИЕ Среди работ по созданию электронного устройства проектирование аналоговых схем является наиболее сложным и трудоемким процессом. Обширный набор параметров, который постоянно нужно контролировать, и крайне высокая восприимчивость полученных результатов к изменению граничных условий делают аналоговое проектирование видом искусства, а не наукой. Источники опорного напряжения (ИОН) требуют обдуманного и тщательного физического проектирования с целью того, чтобы достичь от реализуемого нами устройства необходимых характеристик. Проектирование топологии блока также можно назвать физическим проектированием. Характеристики схемы сильно зависимы от реализации, именно поэтому дизайнеру необходимо обращать особое внимание на защиту блоков от негативных факторов, которые отрицательно влияют на работу всей схемы, таких как шумы, влияние механического напряжения и его градиента, помехи, температурный градиент, включение паразитного тиристора и так далее. Так же, важное значение имеет согласованность элементов. Согласованные интегральные элементы (транзисторы, резисторы, конденсаторы, дифференциальные пары) являются неотъемлемой частью каждого ИОН, потому что оказывают большое влияние на характеристики всей схемы. И так как опорное напряжение непосредственно зависит от соотношения резисторов, топологу следует учитывать особенности построения интегральных резисторов и обеспечить их согласование. Источник опорного напряжения осуществляет выходное напряжение, которое не зависит от напряжения питания, температуры и прочих внешних факторов. Напряжение питания для него является входным напряжением. От точности и правильности работы ИОН зависит работа целиком всей схемы. Подобные параметры, как построение согласованных элементов, особенности построения интегральных резисторов, правила расположения аналоговых блоков относительно друг друга являются значимыми методы борьбы с шумами и помехами. Они зависят от большого числа различных факторов. Таким образом разработчику при проектировании топологии стоит уделять большое внимание на влияние большого количества эффектов на функциональность устройства, кроме того, грамотно оценивать изменение ключевых параметров схемы при выборе какой-то определенной топологической конструкции.
Для проведения практических этапов работы используется система автоматизированного проектирования Cadence IC 6.1.6. В представленной дипломной работе разработано несколько вариантов топологии ИОН с использованием напряжения ширины запрещённой зоны. Целью работы является проведение исследования по влиянию топологических правил согласования элементов массива на характеристики устройства и выбор оптимальной топологии устройства.
ГЛАВА I. ОСОБЕННОСТИ КОНСТРУКЦИИ И СОГЛАСОВАНИЯ ЭЛЕМЕНТОВ АИС. Интегральная технология предоставляет возможность получить высокую степень согласованности однотипных элементов. Тем не менее, для этого может потребоваться применение определенных топологических методов, которые уменьшат негативные факторы рассогласования, что сопровождаются по ходу процесса эксплуатации, а также изготовления микросхемы.
Диффузия рядом с каналом. Глубокая диффузия может оказывать влияние на близлежащие согласуемые транзисторы. Концы частей диффузий выходят далеко за пределы своих переходов на большие расстояния, и избыток примеси, который они приносят вместе с собой, может сдвинуть пороговое напряжение и изменить проводимость находящихся рядом транзисторов. Одним из примеров такой глубокой диффузии являются глубокие N+ канавки БиКМОП процесса. Все подобные диффузии и канавки должны располагаться на расстоянии, как минимум, в два раза больше глубины соответствующих переходов, вдали от согласуемых каналов. Карманы также относятся к глубокой диффузии. Карманы N типа не должны располагаться рядом с согласованными n-канальными транзисторами для предотвращения того, чтобы хвост распределения примеси кармана не пересекался с каналами согласованных транзисторов. p-канальные транзисторы необходимо размещать вдали от краев кармана, в котором они находятся, для предотвращения обратной диффузии при возможных вариациях примеси подложки. Во всех случаях расстояние от активной области затворов до глубокой диффузии равно удвоенной глубине перехода или больше, и должно ограничивать их взаимодействие до незначительного уровня.
Рисунок 7 - Расстояние между границей кармана и активными областями затворов
Градиент толщины окисла Другой важной категорией рассогласований с большим радиусом действия являются градиенты. Величина рассогласования, вызванного градиентом, зависит от разделения эффективных центров, согласуемых устройств.
Как видно из формулы 7 влияние градиента на согласование зависит как от величины градиента, так и от расстояния между центрами согласуемых устройств. Градиенты, которые влияют на МОП согласование: градиент толщины окисла, градиент напряжений и градиент температуры. Толщина выращенной пленки окисла зависит от температуры и структуры окисляющей среды, в которой она образуется. Транзисторы, размещенные вблизи друг от друга, имеют очень схожую толщину оксида, в то время как транзисторы, размещенные на большем расстоянии друг от друга, имеют значительные различия в толщине оксида. Эти различия оказывают непосредственное влияние на согласование пороговых напряжений.
Градиенты напряжения После корпусирования в кристалле возникают дополнительные механические напряжения, которые не были учтены при изменении работы в процессе и настройки на пластине. Механические напряжения могут приводить к рассогласованию элементов в прецизионных блоках. Следующие рекомендации помогают свести к минимуму воздействие механического напряжения. Ниже представлены рекомендации, которые могут помочь уменьшить влияние механического напряжения и его градиента: § Рисунок 8 - Допустимые места расположения согласованных элементов на кристалле § при выборе геометрии кристалла. необходимо учитывать, что удлиненный кристалл имеет более высокие уровни напряжений, чем квадратный кристалл той же площади. В то же время, кристаллы с большей площадью имеют более высокий уровнь напряжения; § ориентировать согласованные элементы вдоль осей с минимальной пьезочувствительностью; § обеспечить механическое согласование между пластиковым корпусом и кристаллом, используя полиамидные смолы для покрытия кристалла во время герметизации и корпусировании; § использовать специальные пластмассы для корпусов с пониженными механическими напряжениями.
Выводы по главе I: 1. Рассмотрены и проанализированы особенности проектирования конструкции и согласования элементов АИС, влияющие на выход годных прецизионных аналоговых ИМС; 2. Проектирование топологии ИОН с использованием напряжения ширины запрещённой зоны требует специальных знаний и приемов; 3. При построении топологии схем, необходимо помнить о эффектах, которые могут повысить рассогласованность элементов, такие как: случайные статистические флуктуации, технологические искажения, диффузия рядом с каналом, градиенты напряжения и толщины окисла и так далее.
Сравнение результатов В главах описанных выше проведено моделирование паразитных элементов двух вариантов топологий ИОН с использованием напряжения запрещенной зоны. Для того, чтобы исследовать, как влияет согласование элементов на полученные результаты, необходимо сравнить таблицы 2 и 3 с эталонными значениями из таблицы 1.
Составим таблицу 4, в которой сравним результаты моделирования паразитных элементов двух топологий по среднему значению. Таблица 4 – Сравнение результатов моделирования схемы, топологии №1 и топологии №2.
Сравнивая результаты из таблицы выше, мы наглядно видим, что результаты моделирования паразитных элементов топологии №2 близки к результатам, полученным для схемы ИОН с использованием ширины запрещенной зоны. Значения характеристик для топологии №1 почти в 1,5 раза выше эталонных значений. Хоть площадь топологии №1 на 10% меньше, чем площадь, занимаемая топологией №2, в качестве оптимального варианта для схемы ИОН с использованием ширины запрещенной зоны, был выбран второй вариант топологии. Так как она удовлетворяет своими выходными значениями и является топологически, верно, спроектированной. Анализируя данные, полученные в результате исследований, можно сделать вывод, что рассогласование даже нескольких массивов элементов схемы, в данном случае дифференциальной пары и биполярных транзисторов, сделанных в пользу минимизации свободного пространства, сильно влияет на изготовление годных интегральных схем. Поэтому дизайнеру во время проектирования массивов элементов и разводки топологии, всегда необходимо учитывать правила согласования.
Выводы по главе IV: 1. Спроектирована топология ИОН с использованием напряжения ширины запрещенной зоны №2, в которой массивы элементов собраны с учётом правил согласования; 2. Выполнена экстракция и моделирование паразитных элементов топологии ИОН с использованием напряжения ширины запрещенной зоны №2 методом Монте-Карло; 3. В топологии №2 присутствует большое количество свободных пространств, которые появляются из-за необходимости расположения массивов транзисторов симметрично относительно оси Y;
4. Занимаемая площадь топологии №1 на 10% меньше, чем площадь занимаемая топологией №2; 5. Результаты моделирования схемы и топологии №2 по параметру напряжение ИОН при 27oC составляют 1.224 В и 1.277 В. Отличие между ними составляют сотые вольт, что является незначительным. Поэтому, можно сделать вывод, что топология №2 спроектирована верно; 6. Для того чтобы получать правильно спроектированные топологии, дизайнеру необходимо делать выбор в пользу согласованного расположения элементов внутри топологии с учётом всех правил симметрии.
ЗАКЛЮЧЕНИЕ В ходе данной работы было спроектировано несколько вариантов топологии ИОН с использованием напряжения ширины запрещённой зоны. Проведены экстракция и моделирование паразитных элементов, для того чтобы наглядно выяснить, как влияет согласование элементов на результаты выходных характеристик. В эскизной топологии №1 транзисторы расположены в разных осях симметрии, массив конденсаторов разбит на 3 столбца, элементы внутри дифференциальной пары и биполярных транзисторов не имеют общего центра и не замешаны, за счёт этих изменений достигается минимально занимаемая площадь топологии. Вокруг всех блоков элементов присутствуют охранные кольца. Пустоты топологии ИОН с использованием напряжения ширины запрещённой зоны заполнены специальной топологической сеткой. Основным недостатком данной топологии является рассогласованное расположение элементов. Топология №2 создана с учётом всех правила топологического проектирования: массивы элементов расположены симметрично относительно оси Y, МОП-транзисторы выстроены друг под другом, конденсаторы организованы в единый массив, транзисторы и разводка металлов внутри дифференциальной пары сделаны симметрично. Вокруг топологии располагается защитное охранное кольцо, которое защищает схему от возможного влияния шумов по подложке. Основным недостатком данной топологии является: большое количество свободного пространства, которое заполнено топологической сеткой. Общая занимая площадь топологии №2 почти на 10% больше, чем у топологии №1. Исследование разных вариантов топологий позволяет сделать фактические выводы, основанные на результатах моделирования. Сравнивая оба варианта по среднему значению, можно наглядно увидеть, что результаты моделирования паразитных элементов топологии №2 близки к результатам для схемы ИОН с использованием ширины запрещенной зоны. Значения топологии №1 почти в 1,5 раза выше эталонных значений. На основании этого можно сделать заключении, что рассогласование элементов внутри массивов сильно влияют на выход годных интегральных схем. Подводя итог исследования по выбранной теме дипломной работы, можно отметить, что выбор оптимальной топологической конструкции для схемы не является тривиальной задачей. Улучшая одни параметры схемы, там самым ухудшаются другие ее параметры. Поэтому перед топологом возникает вопрос в выборе тех или иных основных параметров, которые наиболее значимы для конкретной схемы. В данном случае, этими параметрами являются согласованность всех элементов топологии и симметричное расположение массивов вокруг общей оси. Это объясняет выбор топологии №2 в схеме ИОН с использованием ширины запрещенной зоны в качестве оптимальной.
ПРИЛОЖЕНИЕ 1
ПРИЛОЖЕНИЕ 2
ВВЕДЕНИЕ Среди работ по созданию электронного устройства проектирование аналоговых схем является наиболее сложным и трудоемким процессом. Обширный набор параметров, который постоянно нужно контролировать, и крайне высокая восприимчивость полученных результатов к изменению граничных условий делают аналоговое проектирование видом искусства, а не наукой. Источники опорного напряжения (ИОН) требуют обдуманного и тщательного физического проектирования с целью того, чтобы достичь от реализуемого нами устройства необходимых характеристик. Проектирование топологии блока также можно назвать физическим проектированием. Характеристики схемы сильно зависимы от реализации, именно поэтому дизайнеру необходимо обращать особое внимание на защиту блоков от негативных факторов, которые отрицательно влияют на работу всей схемы, таких как шумы, влияние механического напряжения и его градиента, помехи, температурный градиент, включение паразитного тиристора и так далее. Так же, важное значение имеет согласованность элементов. Согласованные интегральные элементы (транзисторы, резисторы, конденсаторы, дифференциальные пары) являются неотъемлемой частью каждого ИОН, потому что оказывают большое влияние на характеристики всей схемы. И так как опорное напряжение непосредственно зависит от соотношения резисторов, топологу следует учитывать особенности построения интегральных резисторов и обеспечить их согласование. Источник опорного напряжения осуществляет выходное напряжение, которое не зависит от напряжения питания, температуры и прочих внешних факторов. Напряжение питания для него является входным напряжением. От точности и правильности работы ИОН зависит работа целиком всей схемы. Подобные параметры, как построение согласованных элементов, особенности построения интегральных резисторов, правила расположения аналоговых блоков относительно друг друга являются значимыми методы борьбы с шумами и помехами. Они зависят от большого числа различных факторов. Таким образом разработчику при проектировании топологии стоит уделять большое внимание на влияние большого количества эффектов на функциональность устройства, кроме того, грамотно оценивать изменение ключевых параметров схемы при выборе какой-то определенной топологической конструкции. Для проведения практических этапов работы используется система автоматизированного проектирования Cadence IC 6.1.6. В представленной дипломной работе разработано несколько вариантов топологии ИОН с использованием напряжения ширины запрещённой зоны. Целью работы является проведение исследования по влиянию топологических правил согласования элементов массива на характеристики устройства и выбор оптимальной топологии устройства.
ГЛАВА I. ОСОБЕННОСТИ КОНСТРУКЦИИ И СОГЛАСОВАНИЯ ЭЛЕМЕНТОВ АИС. Интегральная технология предоставляет возможность получить высокую степень согласованности однотипных элементов. Тем не менее, для этого может потребоваться применение определенных топологических методов, которые уменьшат негативные факторы рассогласования, что сопровождаются по ходу процесса эксплуатации, а также изготовления микросхемы.
Особенности построения интегральных резисторов Интегральные резисторы выполняются на основе тонких пленок проводящих материалов. Сопротивление интегральных резисторов способно изменяться в процессе использования из-за следующих факторов: 1) насыщения скорости носителей заряда в полях высокой напряженности; 2) саморазогрева; 3) модуляция проводимости проходящими по резистору шинами. 4) влияние конечных размеров зерен; 5) модуляция обедненной области p-n-перехода в диффузионных резисторах; Для того, чтобы рассчитать сопротивление резистора нужно учитывать сопротивление контактов. Потенциальный барьер между материалом резистора и материалом проводника создает сопротивление контакта, которое определяется уравнением 1:
где Lc и Wc — длина и ширина контакта, Rs — поверхностное сопротивление материала резистора, ρc — удельное сопротивление контакта. С целью того, чтобы получить сопротивление от 50 мОм до 5 Ом применяются металлические резисторы(рис.1). Они используются для построения датчиков тока балансировки мощных транзисторов.
Рисунок 1 – Металлический резистор Данный резистор должен находиться над плоским полевым окислом, во избежание ступенек, которые изменяют поверхностное сопротивление. Чтобы не нарушать плоскостность, под металлическим резистором не нужно допускать никаких структур и проводников. Над самим резистором может допускаться наличие второго металла. Чтобы получить поверхностное сопротивление от 20 до 50 Ом/кв, используются диффузионные резисторы на основе областей стока и истока(рис.2). Они уступают по основным характеристикам поликремневым резисторам, за исключением большей рассеиваемой мощности. Именно по этой причине их применяют в цепях рассеивания избыточной мощности. При этом, необходимо применять во внимание низкие пробивные напряжения диффузионных резисторов, а также, если это потребуется, то секционировать их и располагать в отдельных карманах.
Рисунок 2 – Диффузионный резистор Резисторы на основе кармана или пинч-резисторы, имеют поверхностное сопротивление обычно от 1,5 до 1,7 кОм/кв(рис.3). Их используют в таком случае, если технологический процесс не дает возможности сделать высокоомный поликремний.
Рисунок 3 – Резисторы на основе кармана В совмещенных интегральных схемах сверху слоя защитного диэлектрика сформировываются тонкопленочные резисторы, которые представляют собой полоску из высокоомного материала. Они имеют такие превосходства, как низкий температурный коэффициент сопротивления, высокую точность изготовления, высокую граничную частоту, из-за того, что маленькие паразитные параметры. Из недостатков, допускается отметить: потребность дополнительных технологических операций, а также, дополнительных мер защиты интегральных схем от внешних влияний.
1.2. Особенности построения интегральных конденсаторов. Все конденсаторы, применяемые в интегральных схемах, представляют собой конденсаторы с параллельными обкладками, которые состоят из двух проводящих слоев, называемых электродами, они разделены изолирующим слоем - диэлектриком (рис. 4).
Рисунок 4 – Конструкция простого конденсатора с параллельными обкладками В простой параллельной плате конденсатора, предполагается, что два электрода имеют одинаковые размеры и расположены прямо напротив друг друга. Значение такого простого конденсатора с параллельными обкладками можно вычислить, используя следующее приближенное уравнение:
где C - емкость в пикофарадах (пФ), A - площадь любого электрода в микронах, r- толщина диэлектрика в Ангстремах (Å), а эпсилон - безразмерная постоянная, называемая относительной диэлектрической проницаемостью. Главные типы диэлектриков, которые применяются в интегральных конденсаторах – это окисел кремния (SiO2), а также нитрид кремния (Si3N4). Порой возможно чередование слоев SiO2 и Si3N4 между обкладками конденсатора. Тонкие нитридные пленки, как правило, формируют не очень большие участки с точечными отверстиями недостаточной толщины, что понижает диэлектрическую прочность пленки. Некоторые процессы заключают слой нитрида между двумя слоями оксида, для получения композитного диэлектрика, что меньше подвергается формированию точечных отверстий. Эффективная относительная диэлектрическая проницаемость композитного диэлектрика оксид-нитрид может быть вычислена по формуле 3:
Рисунок 5 – Конденсатор на основе МОП-структуры Другой электрод состоит либо из металла, либо из легированного поликремния. Если в МОП-конденсаторе используется оксид затвора, то данную структуру называют конденсатором на подзатворном диэлектрике. Несмотря большое множество названий, все эти структуры являются вариациями одного из самых популярных конденсаторов - тонкопленочного. Его величина может изменяться из-за модуляции напряжения в его электродах, при этом, его максимально возможная емкость зависит исключительно от диэлектрика. Другим типом интегрального конденсатора является конденсатор на р-n переходе, который использует область обеднения, окружающую переход с обратным смещением, в качестве диэлектрика(рис.6). Разрешающая способность и диэлектрическая прочность кремния примерно в 3 раза выше, чем у оксида, именно поэтому соединительные конденсаторы могут получать высокие емкости на единицу площади.
Рисунок 6 – Структурная схема интегрального конденсатора на основе р-n перехода: 1, 2 – омические контакты. Отличительной особенностью интегрального конденсатора является наличие значительных паразитных составляющих. Это паразитное сопротивление обкладок на подложку и паразитная емкость нижней обкладки. Характеристики конденсаторов полупроводниковых микросхем невысокие, а для получения больших емкостей необходимо использовать значительную площадь схемы. Поэтому при проектировании электрической схемы полупроводниковой микросхемы стремятся исключить конденсаторы.
1.3 Причины рассогласования. Случайные рассогласования берут начало из микроскопических колебаний размеров, толщины оксидов и других параметров, которые влияют на значения компонентов. Хоть эти статистические флуктуации не могут быть полностью устранены, их влияние может быть минимизировано путем правильного выбора значений компонентов и размеров устройства. Систематические несоответствия возникают из - за технологических отклонений, контактных сопротивлений, неравномерного течения тока, диффузионных взаимодействий, механических напряжений, температурных градиентов и множества других причин. Основная цель проектирования согласованных компонентов состоит в том, чтобы сделать их нечувствительными к различным источникам систематических ошибок.
1.4 Случайные статистические флуктуации. В случае поликремневого резистора, края слоя Poly проявляют микроскопические неровности, которые придают им слегка неравномерный вид. Некоторые из этих неровностей происходят из-за гранулярности поликремния, в то время как другие происходят из-за несовершенства фоторезиста. Гранулярность поликремния также вызывает различие толщины и резистивности поликремния. Существует несколько типов флуктуаций: 1. Периферийные - флуктуации, которые происходят только по краям устройства, потому что они масштабируются с периферией устройства. 2. Площадийные - флуктуации, которые происходят по всему устройству, потому что они масштабируются с областью устройства. Природа этих отношений масштабирования может быть выведена из статистических аргументов. Случайное рассогласование, обусловленное периферическими и площадными флуктуациями, имеет стандартное отклонение
где Для достаточно больших конденсаторов площадной член доминирует, и случайное рассогласование становится обратно пропорциональным квадратному корню емкости. Большинство согласованных конденсаторов точно следуют соотношению обратного квадратного корня, поэтому удвоение размера пары конденсаторов приводит к уменьшению несоответствия примерно на 30%. При согласовании конденсаторов разных величин преобладает величина меньшего конденсатора, а не большего.
где
Уравнение 6A представляет крайний случай, когда площадные флуктуации доминируют над периферийными флуктуациями, в то время как уравнение 1B показывает обратное. Фактическая ситуация находится где-то между этими случаями, хотя, как правило, преобладают площадийные флуктуации. До тех пор, пока мы берем большую из двух ширин из заданных уравнений, согласование нового резистора
1.5 Технологические искажения. Геометрические размеры топологических фигур в технологических слоях никогда точно не совпадают с размерами фигур на фотошаблонах, поскольку размеры сжимаются или расширяются во время фотолитографии, травления, диффузии и имплантации. Разница между нарисованной геометрической шириной и ее фактической измеренной шириной составляет смещение процесса. Смещения процесса могут привести к серьезным систематическим несоответствиям в плохо спроектированных компонентах. Размер, форма и ориентация МОП транзисторов влияют на их согласование. Большие транзисторы согласовываются более точно, чем малые, потому что увеличение площади затвора помогает минимизировать влияние локализованных флуктуаций. Длинноканальные транзисторы согласуются более точно, чем короткоканальные, потому что более длинные каналы уменьшают вариацию ширины линии и модуляцию длины канала. Транзисторы, ориентированные в одинаковом направлении, согласовываются лучше, чем ориентированные в разных направлениях, из-за анизотропной структуры монокристаллического кремния.
1.6 Вариации скорости травления поликремния. Скорости травления поликремневых и диффузионных областей в локальных областях кристалла зависят от взаимного расположения элементов. Это может привести к рассогласованию в эффективных ширинах и длинах согласованных транзисторов. Изменения в скорости травления в МОП-транзисторах обычно меньшие, чем в поликремневых резисторах, потому что поликремневые затворы не лежат так близко друг к другу, как сегменты поликремневого резистора. Если использовать транзисторы с длиной канала больше минимальной, то можно достичь среднего или точного согласования по току, используя при этом фиктивные элементы, чтобы гарантировать однородное травление. Отсутствие фиктивных элементов может привести к рассогласованию по току на 1% или более. Расстояние между фиктивными и рабочими затворами должно точно соответствовать расстоянию между рабочими затворами. При этом не допускается размещение контактов над рабочими затворами МОП-транзисторов.
Диффузия рядом с каналом. Глубокая диффузия может оказывать влияние на близлежащие согласуемые транзисторы. Концы частей диффузий выходят далеко за пределы своих переходов на большие расстояния, и избыток примеси, который они приносят вместе с собой, может сдвинуть пороговое напряжение и изменить проводимость находящихся рядом транзисторов. Одним из примеров такой глубокой диффузии являются глубокие N+ канавки БиКМОП процесса. Все подобные диффузии и канавки должны располагаться на расстоянии, как минимум, в два раза больше глубины соответствующих переходов, вдали от согласуемых каналов. Карманы также относятся к глубокой диффузии. Карманы N типа не должны располагаться рядом с согласованными n-канальными транзисторами для предотвращения того, чтобы хвост распределения примеси кармана не пересекался с каналами согласованных транзисторов. p-канальные транзисторы необходимо размещать вдали от краев кармана, в котором они находятся, для предотвращения обратной диффузии при возможных вариациях примеси подложки. Во всех случаях расстояние от активной области затворов до глубокой диффузии равно удвоенной глубине перехода или больше, и должно ограничивать их взаимодействие до незначительного уровня.
Рисунок 7 - Расстояние между границей кармана и активными областями затворов
|
|||||||||||||||||||||||||||||||||||||
|
Последнее изменение этой страницы: 2021-07-18; просмотров: 202; Нарушение авторского права страницы; Мы поможем в написании вашей работы! infopedia.su Все материалы представленные на сайте исключительно с целью ознакомления читателями и не преследуют коммерческих целей или нарушение авторских прав. Обратная связь - 18.191.5.239 (0.085 с.) |

 (7)
(7) 
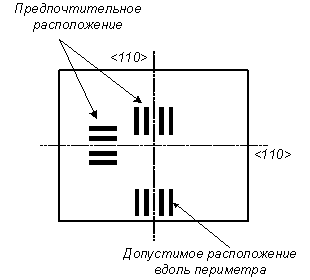
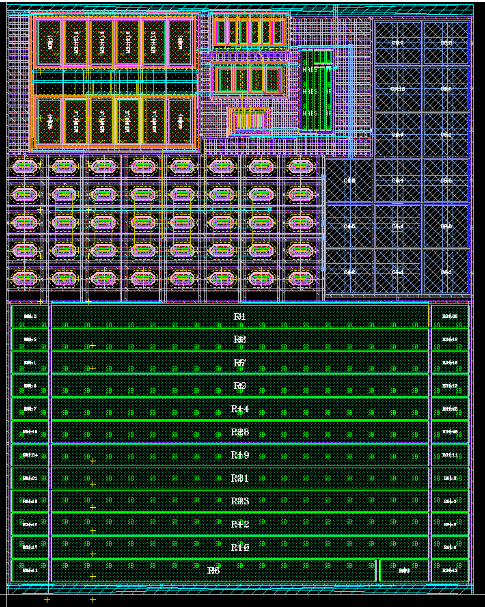
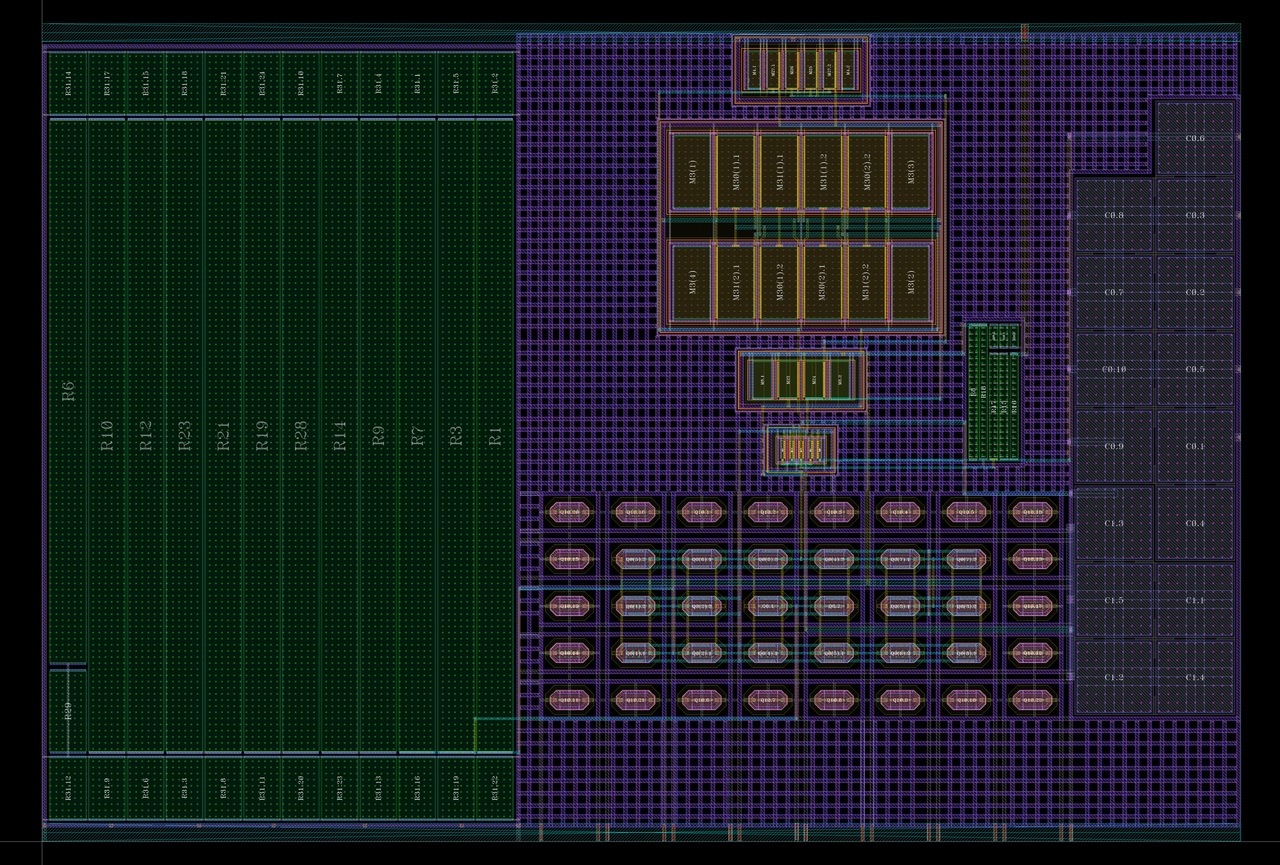
 , (1)
, (1)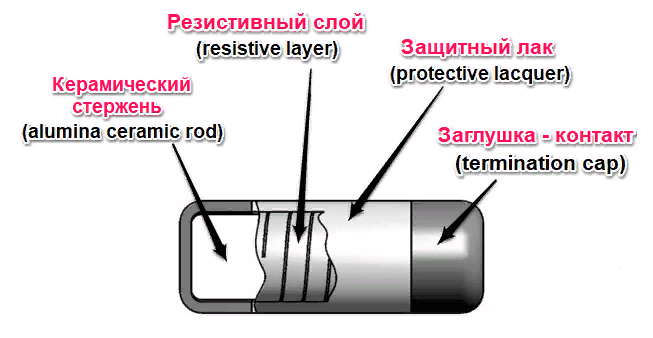
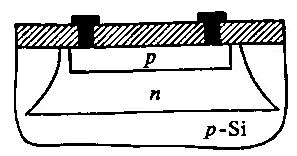
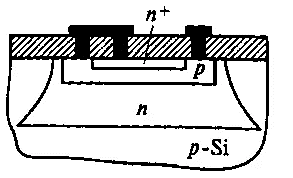
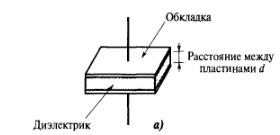
 , (2)
, (2) (3)
(3)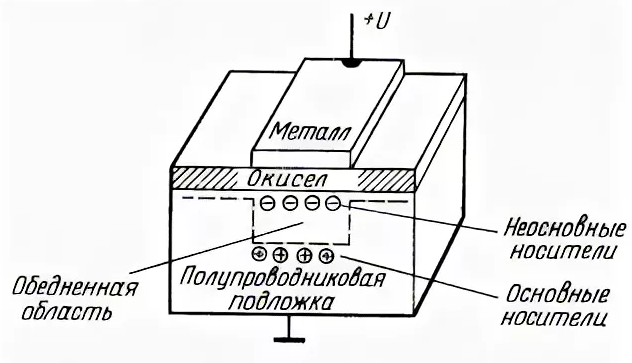
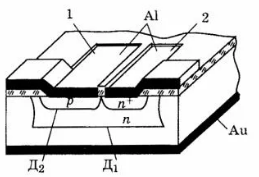
 , равное:
, равное: , (4)
, (4) и
и  -константы, представляющие вклады площадных и периферийных флуктуаций соответственно.
-константы, представляющие вклады площадных и периферийных флуктуаций соответственно. , равное:
, равное: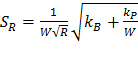 , (5)
, (5) требует ширины
требует ширины  , чтобы получить определенную степень соответствия. Ширина
, чтобы получить определенную степень соответствия. Ширина  , необходимая для получения одинаковой степени соответствия для сопротивления
, необходимая для получения одинаковой степени соответствия для сопротивления  , равна большему из двух следующих значений:
, равна большему из двух следующих значений: (6А)
(6А) (6В)
(6В)


