
Заглавная страница Избранные статьи Случайная статья Познавательные статьи Новые добавления Обратная связь КАТЕГОРИИ: ТОП 10 на сайте Приготовление дезинфицирующих растворов различной концентрацииТехника нижней прямой подачи мяча. Франко-прусская война (причины и последствия) Организация работы процедурного кабинета Смысловое и механическое запоминание, их место и роль в усвоении знаний Коммуникативные барьеры и пути их преодоления Обработка изделий медицинского назначения многократного применения Образцы текста публицистического стиля Четыре типа изменения баланса Задачи с ответами для Всероссийской олимпиады по праву 
Мы поможем в написании ваших работ! ЗНАЕТЕ ЛИ ВЫ?
Влияние общества на человека
Приготовление дезинфицирующих растворов различной концентрации Практические работы по географии для 6 класса Организация работы процедурного кабинета Изменения в неживой природе осенью Уборка процедурного кабинета Сольфеджио. Все правила по сольфеджио Балочные системы. Определение реакций опор и моментов защемления |
Порядок выполнения лабораторных работ
1. Студент допускается к выполнению очередной лабораторной работы при наличии подготовленного в соответствии с требованиями протокола этой работы и сдачи коллоквиума. Для сдачи коллоквиума необходимо знать цель и задачи лабораторной работы, необходимые теоретические сведения, устройство лабораторной установки, объем и порядок выполнения работы. 2. После получения допуска к выполнению экспериментальной части работы студент собирает испытательную электрическую схему. До подачи напряжения на испытательную схему студент должен убедиться в правильности ее сборки. 3. Подготовив схему макета к работе и проверив соответствие значений ее выходных сигналов расчетным данным, студент сообщает об этом преподавателю. 4. После этого задаются требуемые по программе исследований режимы работы испытательной электрической схемы и производятся необходимые при этом измерения, по окончании которых результаты предъявляются преподавателю. С разрешения преподавателя испытательная электрическая схема разбирается, рабочее место приводится в порядок, лабораторные стенды и другое оборудование сдается преподавателю или лаборанту. 5. После завершения экспериментальной части работ оформленный протокол результатов исследований предъявляется преподавателю для проверки и утверждения. Протоколы всех работ хранятся у студента до их защиты. 6. При подготовке к защите лабораторных работ необходимо ответить на контрольные вопросы, которые приводятся в методических указаниях к лабораторным работам. Отчет по выполненной работе, представляемый во время защиты лабораторной работы, должен содержать таблицы и графики экспериментальных исследований, временные диаграммы напряжений (токов) в исследуемом полупроводниковом приборе или в элементах схемы исследуемого электронного устройства, анализ и сравнение полученных экспериментальных результатов с теоретическими.
Список рекомендуемой литературы
1. Белов Г.А. Электроника и микроэлектроника: учеб. пособие для вузов / − Чебоксары, 2001. ‑ 378 с. 2. Белов Г.А. Электронные цепи и микросхемотехника: учеб. пособие для вузов / − Чебоксары, 2004. ‑ 780 с. 3. Забродин Ю.С. Промышленная электроника /− М.: Высш. шк., 1982. ‑ 496 с.
4. Степаненко И.П. Основы микроэлектроники: учеб. пособие для вузов / – М.: Сов. радио, 1980. ‑ 248 с. 5. Преснухин Л.Н. и др. Расчет элементов цифровых устройств: учебное пособие / Л.Н. Преснухин, Н.В.Воробьев, А.А.Шишкевич; Под ред.Л.Н.Преснухина.-2-е изд., перераб.и доп.-М: – Высш. шк., 1991. ‑ 526 с. Лабораторная работа 1 Исследование полупроводниковых диодов Цельработы – изучение принципа действия полупроводниковых диодов, ознакомление с методами исследования их характеристик, исследование переходных процессов в диоде, определение времени жизни неосновных свободных носителей электрического заряда в базовой области кристалла диода, сопротивления этой области, контактной разности потенциалов
Теоретические сведения Свойства p-n- перехода. Принцип действия большинства полупроводниковых приборов основан на использовании свойств p - n -перехода, образующегося в окрестности металлургической границы раздела p - и n -структур кристалла полупроводника (рис. 1). Области p - и n - типов создаются в результате введения в кристалл полупроводника соответственно трех- и пятивалентных химических элементов.
В полупроводнике p -типа при этих же значениях температуры вероятность перехода валентных электронов атомов основного материала кристалла полупроводника к атомам примеси (акцептора) также близка к единице. Эти электроны участвуют в образовании ковалентной связи атомов примеси с атомами кристалла, что приводит к образованию ионов из атомов примеси путем такого захвата электрона. В этом случае образовавшиеся вакансии в ковалентных связях атомов основного материала кристалла могут перемещаться в результате перехода к ним валентных электронов от других ковалентных связей атомов полупроводника. Поэтому эти вакансии рассматриваются как свободные носители электрического заряда положительного знака и называются дырками.
К полупроводниковым приборам, содержащим один p - n -переход, относятся: выпрямительный и импульсный диоды, стабилитрон, туннельный диод, варикап. Внешние выводы от p - и n -областей в этих приборах называются соответственно анодом (А) и катодом (К). Область p - n -перехода толщиной В равновесном состоянии (при отсутствии внешнего электрического напряжения между анодом и катодом) обеспечивается равенство встречнонаправленных потоков диффузионного и дрейфового движения свободных носителей заряда через p - n -переход, т.к. в этом режиме ток во внешней цепи отсутствует. Такому равновесному состоянию соответствует некоторое начальное значение толщины ( Электрическое поле p - n -перехода, создаваемое неподвижными ионами примесей, является для свободных носителей электрического заряда потенциальным барьером, высота которого равна значению перепада электрического потенциала в пределах толщины p - n -перехода. Для резкого p - n -перехода, когда на металлургической границе раздела p - и n -структур концентрация атомов примесей меняется скачкообразно от уровня (N a) концентрации атомов акцептора в p -структуре до уровня (N д) концентрации атомов донора в n -структуре, высота потенциального барьера (контактная разность потенциалов) определяется формулой где Так как в диапазоне рабочих значений температур (T ≈ 300 K) практически все атомы примесей ионизированы, то при выполнении условия
где Для концентраций электронов и дырок в невырожденном полупроводнике справедливо равенство (закон действующих масс):
С учетом этого равенства выражение (1) для высоты потенциального барьера принимает вид
Обычно разница в значениях концентраций легирующих примесей в p - и n -областях составляет несколько порядков. Такой p - n -переход называется несимметричным. При этом область кристалла с меньшей концентрацией примесей называется базой, а с большей – эмиттером. В дальнейшем предполагаем, что Толщина p - n -перехода определяется формулой где
Численное значение концентрации свободных носителей заряда в области p - n -перехода близко к уровню их концентрации в собственном полупроводнике. Поэтому эту область p - n -структуры называют обедненным свободными носителями электрического заряда слоем. Другое название области p - n -перехода – область объемного заряда (ООЗ) ионов акцепторных и донорных примесей. Статическая вольт-амперная характеристика диода. Статическая вольт-амперная характеристика (ВАХ) идеализированного p - n -перехода описывается формулой Шокли и имеет вид где Формула (3) получена с учетом только процессов диффузии (экстракции) основных (неосновных) свободных носителей электрического заряда через p - n -переход при U >0 (U <0). График ВАХ идеализированной p - n -структуры имеет вид кривой 1 на рис. 2. При увеличении модуля отрицательного внешнего напряжения (U <0) обратный ток через p - n -структуру достигает наибольшего возможного значения, равного ВАХ идеализированного p - n -перехода в соответствии с (3) может быть представлена также в виде
Из (4) следует, что дифференциальное сопротивление идеализированного p - n -перехода при
Отличие прямой ветви графика ВАХ реальных структур (рис. 2, кривая 2) от характеристики, описываемой (3), обусловлено в основном наличием составляющей тока, возникающей в результате рекомбинации свободных носителей электрического заряда в p- n -переходе, и возникновением падения напряжения на сопротивлении
По мере увеличения прямого тока Отличие обратной ветви графика реальной ВАХ от характеристики, описываемой (3), обусловлено наличием составляющей тока, создаваемой процессом термогенерации свободных носителей заряда в области p - n -перехода ( У германиевой структуры обратный ток определяется в основном токами График обратной ветви реальной p - n -структуры имеет три характерных участка: ОА, АВ, ВС. На участке AB при сравнительно малом увеличении напряжения наблюдается резкое увеличение обратного тока p - n -перехода. Этот режим работы В основе туннельного пробоя лежит туннельный эффект, т.е. «просачивание» электронов без изменения своей энергии сквозь потенциальный барьер p - n -перехода. Вероятность туннельного эффекта возрастает при уменьшении толщины потенциального барьера (толщины p - n -перехода). Поэтому туннельный пробой присущ сильнолегированным p - n -структурам. Лавинный пробой заключается в том, что под действием сильного электрического поля в p - n -переходе свободные носители электрического заряда на длине свободного пробега приобретают энергию, достаточную для ионизации атомов кристалла. При этом возникает явление ударной ионизации атомов кристалла, что приводит к лавинообразному нарастанию концентрации свободных носителей заряда. Лавинный пробой характерен для слаболегированных p - n -структур.
В процессе увеличения обратного напряжения на p - n -переходе и соответствующего возрастания обратного тока происходит нарастание нагрева кристалла, что сопровождается усилением процесса термогенерации свободных носителей заряда. По этой причине при некотором значении этого напряжения происходит лавинообразное увеличение обратного тока, завершающееся явлением теплового пробоя p - n -перехода. При тепловом пробое происходит разрушение структуры кристалла (участок ВС кривой 2 на рис. 2). Из формулы (4) видно, что меньшим значениям тока С ростом температуры ток
Электрическая емкость p-n -структуры. При изменении напряжения При изменении приложенного к p - n -структуре напряжения происходит изменение количества как пространственно разделенного электрического заряда в ООЗ, так и количества положительного и отрицательного зарядов квазинейтральных p - и n - областей вблизи ООЗ. Поэтому емкость p - n -структуры состоит из двух составляющих Значение барьерной дифференциальной составляющей емкости резкого p - n -перехода определяется формулой где S – площадь поверхности границы раздела p - и n -областей; Значение диффузионной дифференциальной составляющей емкости при приложении прямого напряжения определяется где При Статические параметры диодов. Полупроводниковые диоды применяются для выпрямления переменного тока (выпрямительные диоды), детектирования напряжения высокочастотного колебания (высокочастотные диоды), стабилизации напряжения (стабилитроны), модуляции сигнала высокой частоты (варикапы), преобразования формы импульсов (импульсные диоды) и генерации колебаний (туннельные диоды). Выпрямительные диоды характеризуются следующими основными параметрами:
Кремниевые диоды характеризуются по сравнению с германиевыми большим допустимым рабочим значением температуры (120 оС против 55 оС), большим допустимым обратным значением напряжения (1000 В против 300 В) и меньшим значением обратного тока. Однако кремниевые диоды имеют большее прямое падение напряжения (1 В против 0,3 В). Отличие параметров кремниевых диодов объясняется более широкой запрещенной зоной энергетической диаграммы полупроводника, чем у германиевых диодов. Значения предельно допустимых параметров выпускаемых промышленностью выпрямительных диодов находятся в следующих пределах: Стабилитроны изготавливают из кремния. В рабочем режиме они находятся в состоянии электрического пробоя p - n -перехода, когда при изменении его обратного тока
Значения предельно допустимых параметров выпускаемых промышленностью стабилитронов:
Электрическая модель диода. Диод можно представить в виде эквивалентной электрической схемы (рис. 5), в которой p - n -переход представлен в виде идеализированного диода
Реакция диода на воздействие импульса прямого тока прямоугольной формы. Схема проведения исследований (рис. 6): импульсы прямого тока периодически поступают на исследуемый диод VD от генератора прямоугольных импульсов G2 через вспомогательный разделительный диод VD5 и резистор R2. Диод VD5 необходим для устранения действия на испытываемый диод VD выброса напряжения отрицательной полярности с выхода генератора импульсов G2.
Пусть в момент времени В последующие моменты времени по мере нарастания заряда емкости
Начальное значение сопротивления базы После завершения переходного процесса отпирания диода в момент времени Значение сопротивления базы С этого момента начинается процесс уменьшения избыточной концентрации неосновных свободных носителей электрического заряда в базе вследствие их рекомбинации (рис. 8). При этом на границе между p - n -переходом и базой ( Отсюда определяется время жизни где Измерение начального значения остаточного напряжения
где
С увеличением амплитуды импульса прямого тока значение
Реакция открытого диода на воздействие запирающего напряжения. Исследование переходных процессов в диоде при смене полярности напряжения проводится по схеме на рис. 9.
Прямой ток в исследуемом диоде VD создается источником G1 постоянного напряжения. Значение силы этого тока изменяется регулированием выходного напряжения источника
Переходный процесс изменения тока исследуемого диода наблюдается с помощью осциллографа. Для этого на его вход подается напряжение с шунта RS. В исходном состоянии на исследуемый диод подано прямое напряжение Характер переходного процесса изменения режима работы диода зависит от сопротивления токоограничивающего резистора R1. Если это сопротивление мало, то после момента
Если значение токоограничивающего сопротивления
(рис. 10, в). Поэтому в течение этого времени остается постоянным градиент концентрации дырок Процесс спада тока происходит в течение времени Значение градиента концентрации дырок в базе при Среднее время жизни дырок в базе и длительность времени
Значения
|
|||||||||||||||||||||||||||
|
Последнее изменение этой страницы: 2021-05-12; просмотров: 41; Нарушение авторского права страницы; Мы поможем в написании вашей работы! infopedia.su Все материалы представленные на сайте исключительно с целью ознакомления читателями и не преследуют коммерческих целей или нарушение авторских прав. Обратная связь - 18.189.193.172 (0.09 с.) |
 В полупроводнике n -типа при значениях температуры, близких к 300 К, вероятность того, что пятый валентный электрон атома примеси (донора) становится свободным носителем отрицательного электрического заряда, близка к единице. Поэтому почти все атомы примеси ионизированы в результате потери электрона.
В полупроводнике n -типа при значениях температуры, близких к 300 К, вероятность того, что пятый валентный электрон атома примеси (донора) становится свободным носителем отрицательного электрического заряда, близка к единице. Поэтому почти все атомы примеси ионизированы в результате потери электрона. образуется вблизи металлургической границы раздела p - и n -областей кристалла в результате диффузии свободных носителей электрического заряда из-за наличия перепада их концентраций в этой области. При этом в пределах p - n -перехода возникает двойной электрический слой нескомпенсированных зарядов ионов атомов примесей, что приводит к появлению в этой области электрического поля, противодействующего процессу указанного диффузионного движения свободных носителей заряда через p - n -переход. Это электрическое поле создает дрейфовое движение свободных носителей заряда через p - n -переход.
образуется вблизи металлургической границы раздела p - и n -областей кристалла в результате диффузии свободных носителей электрического заряда из-за наличия перепада их концентраций в этой области. При этом в пределах p - n -перехода возникает двойной электрический слой нескомпенсированных зарядов ионов атомов примесей, что приводит к появлению в этой области электрического поля, противодействующего процессу указанного диффузионного движения свободных носителей заряда через p - n -переход. Это электрическое поле создает дрейфовое движение свободных носителей заряда через p - n -переход. ) p - n -перехода.
) p - n -перехода. , (1)
, (1) и
и  (
( и
и  ) – концентрации дырок (электронов) в p - и n -структурах кристалла в равновесном состоянии;
) – концентрации дырок (электронов) в p - и n -структурах кристалла в равновесном состоянии;  – тепловой потенциал,
– тепловой потенциал,  ;
;  – постоянная Больцмана;
– постоянная Больцмана;  – заряд электрона;
– заряд электрона;  – абсолютная температура.
– абсолютная температура. ,
,  справедливы соотношения
справедливы соотношения и
и  ,
,  и
и  – концентрации электронов и дырок в собственном (беспримесном) полупроводнике.
– концентрации электронов и дырок в собственном (беспримесном) полупроводнике. .
. .
. , т.е. p -область будет являться эмиттером.
, т.е. p -область будет являться эмиттером. , (2)
, (2) – относительная диэлектрическая проницаемость материала кристалла;
– относительная диэлектрическая проницаемость материала кристалла;  – приложенное к p - n -переходу внешнее напряжение. Если пренебречь падением напряжения в p - и n -областях, то
– приложенное к p - n -переходу внешнее напряжение. Если пренебречь падением напряжения в p - и n -областях, то  , где
, где  и
и  − потенциалы анода и катода полупроводникового прибора.
− потенциалы анода и катода полупроводникового прибора. , (3)
, (3) – тепловой ток p - n -перехода (ток насыщения). Значение
– тепловой ток p - n -перехода (ток насыщения). Значение  . При U >0 и U >0,1 В в выражении (3) можно пренебречь единицей по сравнению с экспоненциальным слагаемым. Следовательно, прямой ток (при U >0) значительно больше обратного тока (при U <0). Это означает, что p - n -переход обладает свойством односторонней проводимости (вентильным свойством).
. При U >0 и U >0,1 В в выражении (3) можно пренебречь единицей по сравнению с экспоненциальным слагаемым. Следовательно, прямой ток (при U >0) значительно больше обратного тока (при U <0). Это означает, что p - n -переход обладает свойством односторонней проводимости (вентильным свойством). . (4)
. (4)

 . (5)
. (5)
 базовой области кристалла. С учетом
базовой области кристалла. С учетом  . (6)
. (6) происходит уменьшение
происходит уменьшение  ), и существованием поверхностного тока утечки (
), и существованием поверхностного тока утечки ( ) в области p - n -перехода кристалла.
) в области p - n -перехода кристалла. . У кремниевой структуры обратный ток определяется в основном токами
. У кремниевой структуры обратный ток определяется в основном токами  .
.

 , где
, где  – барьерная составляющая емкости, обусловленная изменением заряда в ООЗ;
– барьерная составляющая емкости, обусловленная изменением заряда в ООЗ;  – диффузионная составляющая емкости, обусловленная изменением заряда в квазинейтральной области кристалла вблизи ООЗ в результате явлений инжекции в эту область или экстракции из этой области неосновных свободных носителей электрического заряда. Инжекция происходит при
– диффузионная составляющая емкости, обусловленная изменением заряда в квазинейтральной области кристалла вблизи ООЗ в результате явлений инжекции в эту область или экстракции из этой области неосновных свободных носителей электрического заряда. Инжекция происходит при  .
. , (7)
, (7) ;
;  – значение разделенного заряда в ООЗ.
– значение разделенного заряда в ООЗ. , (8)
, (8) – среднее время жизни неосновных свободных носителей заряда (дырок) в базовой n -области p - n -структуры;
– среднее время жизни неосновных свободных носителей заряда (дырок) в базовой n -области p - n -структуры;  , а при
, а при  .
. – наибольшее допустимое среднее значение прямого тока, характеризующее допустимую мощность тепловых потерь в диоде и измеряемое в однополупериодной схеме выпрямления. Значение этого тока зависит от особенностей конструкции диода, температуры окружающей среды, условий и параметров системы его охлаждения;
– наибольшее допустимое среднее значение прямого тока, характеризующее допустимую мощность тепловых потерь в диоде и измеряемое в однополупериодной схеме выпрямления. Значение этого тока зависит от особенностей конструкции диода, температуры окружающей среды, условий и параметров системы его охлаждения; – наибольшее допустимое значение обратного напряжения;
– наибольшее допустимое значение обратного напряжения; – среднее значение прямого падения напряжения при протекании прямого тока в однополупериодной схеме выпрямления;
– среднее значение прямого падения напряжения при протекании прямого тока в однополупериодной схеме выпрямления; – среднее значение обратного тока в однополупериодной схеме выпрямления при обратном напряжении, равном
– среднее значение обратного тока в однополупериодной схеме выпрямления при обратном напряжении, равном  – допустимая температура корпуса прибора.
– допустимая температура корпуса прибора. в широком диапазоне напряжение
в широком диапазоне напряжение  на нем изменяется незначительно.Их параметрами являются:
на нем изменяется незначительно.Их параметрами являются: – относительный температурный коэффициент изменения напряжения стабилизации;
– относительный температурный коэффициент изменения напряжения стабилизации;  , где
, где  – изменение напряжения стабилизации при изменении температуры на
– изменение напряжения стабилизации при изменении температуры на  по отношению к заданной температуре
по отношению к заданной температуре  ,
,  – минимальное и максимальное допустимое значение тока рабочего участка ВАХ стабилитрона;
– минимальное и максимальное допустимое значение тока рабочего участка ВАХ стабилитрона;  – дифференциальное сопротивление стабилитрона на рабочем участке ВАХ,
– дифференциальное сопротивление стабилитрона на рабочем участке ВАХ,  .
. , ВАХ которого описывается формулой Шокли. Сопротивление
, ВАХ которого описывается формулой Шокли. Сопротивление  соответствует сопротивлению базовой области реального диода. Конденсатор
соответствует сопротивлению базовой области реального диода. Конденсатор  является емкостью p - n -перехода. Емкость между внешними выводами диода, определяемая геометрическими параметрами элементов корпуса диода, равна
является емкостью p - n -перехода. Емкость между внешними выводами диода, определяемая геометрическими параметрами элементов корпуса диода, равна  . Обычно
. Обычно  .
.



 на диод поступает прямоугольный импульс прямого тока i (t) с амплитудой
на диод поступает прямоугольный импульс прямого тока i (t) с амплитудой  (рис. 7). Напряжение
(рис. 7). Напряжение  базовой области диода в этот момент времени равно
базовой области диода в этот момент времени равно  , где
, где  – сопротивление базы в момент времени
– сопротивление базы в момент времени  увеличивается. По мере накопления избыточных неосновных свободных носителей электрического заряда в базе её сопротивление
увеличивается. По мере накопления избыточных неосновных свободных носителей электрического заряда в базе её сопротивление 
 можно определить, измеряя начальное падение напряжения
можно определить, измеряя начальное падение напряжения  на диоде VD:
на диоде VD:  .
. происходит срез импульса тока (ток через диод прекращается). В этот момент времени напряжение на диоде скачком снижается до уровня
происходит срез импульса тока (ток через диод прекращается). В этот момент времени напряжение на диоде скачком снижается до уровня  . Это остаточное (послеинжекционное) напряжение обусловлено наличием в базе избыточных зарядов диффузионной составляющей емкости p - n -перехода.
. Это остаточное (послеинжекционное) напряжение обусловлено наличием в базе избыточных зарядов диффузионной составляющей емкости p - n -перехода. в открытом состоянии диода определяется измерением падения напряжения
в открытом состоянии диода определяется измерением падения напряжения  на диоде, возникающего в момент
на диоде, возникающего в момент  .
. ) градиент концентрации остается равным нулю, т.к. ток через диод равен нулю. По мере уменьшения концентрации этих зарядов происходит изменение напряжения
) градиент концентрации остается равным нулю, т.к. ток через диод равен нулю. По мере уменьшения концентрации этих зарядов происходит изменение напряжения  .
. неосновных свободных носителей электрического заряда (дырок) в n -базе диода:
неосновных свободных носителей электрического заряда (дырок) в n -базе диода: ,
, (рис. 7). Здесь
(рис. 7). Здесь  – момент времени, когда количество избыточных свободных носителей заряда в базе уменьшается практически до нуля.
– момент времени, когда количество избыточных свободных носителей заряда в базе уменьшается практически до нуля. на диоде при достаточно больших значениях прямого тока позволяет найти контактную разность потенциалов
на диоде при достаточно больших значениях прямого тока позволяет найти контактную разность потенциалов  p - n -пере-хода. Это следует из соотношения для концентрации неосновных носителей заряда в n -базе на границе p - n -перехода (
p - n -пере-хода. Это следует из соотношения для концентрации неосновных носителей заряда в n -базе на границе p - n -перехода ( ,
,
 стремится к значению
стремится к значению  , поэтому при импульсах тока достаточно большой амплитуды. Из этой формулы следует, что
, поэтому при импульсах тока достаточно большой амплитуды. Из этой формулы следует, что  .
.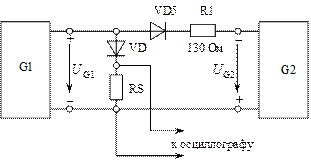
 . Импульсы напряжения отрицательной полярности подаются периодически на исследуемый диод VD от генератора G2 через резистор R1 и разделительный диод VD5.
. Импульсы напряжения отрицательной полярности подаются периодически на исследуемый диод VD от генератора G2 через резистор R1 и разделительный диод VD5.
 от источника напряжения G1. В некоторый момент времени
от источника напряжения G1. В некоторый момент времени  < 0 в результате появления очередного импульса напряжения на выходе генератора G2 (рис. 10, а).
< 0 в результате появления очередного импульса напряжения на выходе генератора G2 (рис. 10, а). быстро уменьшается до нуля в результате интенсивной их экстракции из этой области. В глубине базы (
быстро уменьшается до нуля в результате интенсивной их экстракции из этой области. В глубине базы ( ) концентрация
) концентрация  происходит в результате процессов их экстракции (движения в сторону эмиттера) и рекомбинации в базе.
происходит в результате процессов их экстракции (движения в сторону эмиттера) и рекомбинации в базе.
 значительна, то при подаче импульса обратного напряжения
значительна, то при подаче импульса обратного напряжения  в цепи будет протекать практически неизменный по значению обратный ток p - n -перехода:
в цепи будет протекать практически неизменный по значению обратный ток p - n -перехода:
 на границе базы и p - n -перехода.
на границе базы и p - n -перехода. и сопровождается уменьшением указанного градиента концентрации дырок.
и сопровождается уменьшением указанного градиента концентрации дырок. = 0 и
= 0 и  определяется тангенсом угла наклона
определяется тангенсом угла наклона  касательной к графику распределения концентрации дырок в сечении кристалла с координатой
касательной к графику распределения концентрации дырок в сечении кристалла с координатой  вблизи p - n -перехода. Дальнейшее уменьшение концентрации дырок в глубине базы начиная с момента
вблизи p - n -перехода. Дальнейшее уменьшение концентрации дырок в глубине базы начиная с момента  ведет к уменьшению градиента концентрации и соответственно обратного тока через диод.
ведет к уменьшению градиента концентрации и соответственно обратного тока через диод. ,в течение которого выполняется условие
,в течение которого выполняется условие  ,связаны соотношением
,связаны соотношением .
. ,
,  определяются исходя из осциллограммы напряжения на шунте RS.
определяются исходя из осциллограммы напряжения на шунте RS.


