
Заглавная страница Избранные статьи Случайная статья Познавательные статьи Новые добавления Обратная связь КАТЕГОРИИ: ТОП 10 на сайте Приготовление дезинфицирующих растворов различной концентрацииТехника нижней прямой подачи мяча. Франко-прусская война (причины и последствия) Организация работы процедурного кабинета Смысловое и механическое запоминание, их место и роль в усвоении знаний Коммуникативные барьеры и пути их преодоления Обработка изделий медицинского назначения многократного применения Образцы текста публицистического стиля Четыре типа изменения баланса Задачи с ответами для Всероссийской олимпиады по праву 
Мы поможем в написании ваших работ! ЗНАЕТЕ ЛИ ВЫ?
Влияние общества на человека
Приготовление дезинфицирующих растворов различной концентрации Практические работы по географии для 6 класса Организация работы процедурного кабинета Изменения в неживой природе осенью Уборка процедурного кабинета Сольфеджио. Все правила по сольфеджио Балочные системы. Определение реакций опор и моментов защемления |
Кафедра «Компьютерные технологии в проектировании и производстве»Стр 1 из 18Следующая ⇒
Кафедра «Компьютерные технологии в проектировании и производстве»
ФИЗИЧЕСКИЕ ОСНОВЫ МИКРО И НАНОЭЛЕКТРОНИКИ Пособие для студентов, обучающихся по направлению 210200 «Конструирование и технология электронных средств» Дневной формы обучения
Нижний Новгород Составитель В.Д.Садков
УДК 621.396.6.001.2 (077)
Физические основы микро и наноэлектроники. Пособие для студентов, обучающихся по направлению 210200 - «Конструирование и технология электронных средств» дневной формы обучения/ НГТУ; Н.Новгород, 2012, - 97 с. .
Учебное пособие посвящено физическим основам полупроводников, контактным явлениям между полупроводниками различной проводимости и между полупроводником и металлом. Рассматриваются принципы работы, характеристики и параметры полупроводниковых приборов: диодов, биполярных и полевых транзисторов различной структуры.
Редактор Э.Б.Абросимова
Научный редактор С.М. Никулин
Подписано в печать 27.03.2012.Формат 60 x 84 1/16.Бумага газетная. Печать офсетная. Усл. печ. л. 1,5. Уч.- изд. л. 1,4. Тираж 100 экз. Заказ Нижегородский государственный технический университет им. Р.Е. Алексеева. Типография НГТУ. 603950, Нижний Новгород, ул. Минина, 24.
© Нижегородский государственный технический университет им Р.Е. Алексеева, 2012.
Введение……………………………………………………… 1 Основы теории электропроводности полупроводников....... 1.1 Общие сведения о полупроводниках.................................... 1.1.1 Полупроводники с собственной проводимостью.............. 1.1.2 Полупроводники с электронной проводимостью............. 1.1.3 Полупроводники с дырочной проводимостью.................. 1.2 Токи в полупроводниках.................................................... 1.2.1 Дрейфовый ток................................................................... 1.2.2 Диффузионный ток........................................................... 1.3 Контактные явления........................................................... 1.3.1 Электронно-дырочный переход в состоянии равновесия 1.3.2 Прямое включение p-n перехода...................................... 1.3.3 Обратное включение p-n перехода................................. 1.3.4 Теоретическая характеристика p-n перехода........................... 1.3.5 Реальная характеристика p-n перехода............................ 1.3.6 Ёмкости p-n перехода...................................................... 1.4 Разновидности p-n переходов..........................................
1.4.1 Гетеропереходы........................................................... 1.4.2 Контакт между полупроводниками одного типа проводимости 1.4.3 Контакт металла с полупроводником.......................................... 1.4.4 Омические контакты................................................................... 1.4.5 Явления на поверхности полупроводника.............................. 2 Полупроводниковые диоды..................................................... 2.1 Классификация....................................................................... 2.2 Выпрямительные диоды....................................................... 2.3 Стабилитроны и стабисторы................................................. 2.4 Универсальные и импульсные диоды................................... 2.5 Варикапы.............................................................................. 3 Биполярные транзисторы........................................................... 3.1 Принцип действия биполярного транзистора. Режимы работы..... 3.1.1 Общие сведения.............................................................................. 3.1.2 Физические процессы в бездрейфовом биполярном транзисторе 3.2 Статические характеристики биполярных транзисторов......... 3.2.1 Схема с общей базой............................................................... 3.2.2 Схема с общим эмиттером........................................................ 3.2.3 Влияние температуры на статические характеристики БТ..... 3.3 Дифференциальные параметры биполярного транзистора.................. 3.4 Линейная (малосигнальная) модель биполярного транзистора...... 3.5 Частотные свойства биполярного транзистора................................... 3.6 Способы улучшения частотных свойств биполярных транзисторов. 3.7 Работа транзистора в усилительном режиме...................................... 3.8 Особенности работы транзистора в импульсном режиме.................. 3.8.1 Работа транзистора в режиме усиления импульсов малой амплитуды 3.8.2 Работа транзистора в режиме переключения................................. 3.8.3 Переходные процессы при переключении транзистора.............. 4 Полевые транзисторы.............................................................. 4.1 Полевой транзистор с p-n переходом........................................ 4.2 Полевой транзистор с изолированным затвором (МДП-ранзистор)... Литература.............................................................................................. ВВЕДЕНИЕ Главы учебного пособия посвящены физическим основам полупроводников, контактным явлениям между полупроводниками различной проводимости и между полупроводником и металлом. Рассматриваются принципы работы, характеристики и параметры полупроводниковых приборов: диодов, биполярных и полевых транзисторов различной структуры.
Для освоения дисциплины «Физические основы микро и наноэлектроники» достаточно знаний по общеобразовательным и общетехническим предметам в объёме, предусмотренном учебными программами. После изучения данной дисциплины студент должен получить базовую подготовку, необходимую для успешного освоения специальных радиотехнических курсов и последующего решения профессиональных задач, связанных с рациональным выбором электронных приборов и режимов их работы в радиоэлектронной аппаратуре. Подробное рассмотрение физических основ явлений, принципов работы, параметров, характеристик и моделей приборов направлено на развитие у студентов умения самостоятельно решать задачи моделирования, анализа и синтеза радиоэлектронных устройств при их проектировании и эксплуатации. Однако в учебном пособии отсутствуют сведения о большой и постоянно обновляемой номенклатуре электронных приборов. Необходимый материал по этим вопросам можно найти в справочниках, каталогах и других изданиях.
ПОЛУПРОВОДНИКОВ ТОКИ В ПОЛУПРОВОДНИКАХ
Дрейфовый ток
В полупроводниках свободные электроны и дырки находятся в состоянии хаотического движения. Поэтому, если выбрать произвольное сечение внутри объема полупроводника и подсчитать число носителей заряда, проходящих через это сечение за единицу времени слева направо и справа налево, значения этих чисел окажутся одинаковыми. Это означает, что электрический ток в данном объеме полупроводника отсутствует. При помещении полупроводника в электрическое поле напряженностью Е на хаотическое движение носителей зарядов накладывается составляющая направленного движения. Направленное движение носителей зарядов в электрическом поле обусловливает появление тока, называемого дрейфовым (рис. 1.6, а) Из-за столкновения носителей зарядов с атомами кристаллической решетки их движение в направлении действия электрического поля прерывисто и
характеризуется подвижностью m. Подвижность равна средней скорости
Подвижность носителей зарядов зависит от механизма их рассеивания в кристаллической решетке. Исследования показывают, что подвижности электронов mn и дырок mp имеют различное значение (mn > mp) и определяются температурой и концентрацией примесей. Увеличение температуры приводит к уменьшению подвижности, что зависит от числа столкновений носителей зарядов в единицу времени. Плотность тока в полупроводнике, обусловленного дрейфом свободных электронов под действием внешнего электрического поля со средней скоростью Перемещение (дрейф) дырок в валентной зоне со средней скоростью
Подставляя в выражение для плотности тока соотношение для средней скорости электронов и дырок (1.11), получаем
Если сравнить выражение (1.12) с законом Ома j =σЕ, то удельная электропроводность полупроводника определяется соотношением
У полупроводника с собственной электропроводностью концентрация электронов равна концентрации дырок (ni = pi), и его удельная электропроводность определяется выражением
В полупроводнике n -типа
В полупроводнике р -типа
В области высоких температур концентрация электронов и дырок значительно возрастает за счет разрыва ковалентных связей и, несмотря на уменьшение их подвижности, электропроводность полупроводника увеличивается по экспоненциальному закону.
Диффузионный ток
Кроме теплового возбуждения, приводящего к возникновению равновесной концентрации зарядов, равномерно распределенных по объему полупроводника, обогащение полупроводника электронами до концентрации np и дырками до концентрации pn может осуществляться его освещением, облучением потоком заряжённых частиц, введением их через контакт (инжекцией) и т. д. В этом случае энергия возбудителя передается непосредственно носителям заряда и тепловая энергия кристаллической решетки остается практически постоянной. Следовательно, избыточные носители заряда не находятся в тепловом равновесии с решеткой и поэтому называются неравновесными. В отличие от равновесных, они могут неравномерно распределяться по объему полупроводника (рис. 1.6, б) После прекращения действия возбудителя за счет рекомбинации электронов и дырок концентрация избыточных носителей быстро убывает и достигает равновесного значения. Скорость рекомбинации неравновесных носителей пропорциональна избыточной концентрации дырок (pn -
где tp - время жизни дырок; tn - время жизни электронов. За время жизни концентрация неравновесных носителей уменьшается в е раз (≈ 2,7 раза). Время жизни избыточных носителей составляет 0,01...0,001 с. Носители зарядов рекомбинируют в объеме полупроводника и на его поверхности. Неравномерное распределение неравновесных носителей зарядов сопровождается их диффузией в сторону меньшей концентрации. Это движение носителей зарядов обусловливает прохождение электрического тока, называемого диффузионным (рис. 1.6, б).
Рассмотрим одномерный случай. Пусть в полупроводнике концентрации электронов n(x) и дырок p(x) являются функциями координаты. Это приведет к диффузионному движению дырок и электронов из области с большей их концентрацией в область с меньшей концентрацией. Диффузионное движение носителей зарядов обусловливает прохождение диффузионного тока электронов и дырок, плотности которых определяются из соотношений:
где dn(x)/dx, dp(x)/dx - градиенты концентраций электронов и дырок; Dn, Dp - коэффициенты диффузии электронов и дырок. Градиент концентрации характеризует степень неравномерности распределения зарядов (электронов и дырок) в полупроводнике вдоль какого-то выбранного направления (в данном случае вдоль оси x). Коэффициенты диффузии показывают количество носителей заряда, пересекающих в единицу времени единичную площадку, перпендикулярную к выбранному направлению, при градиенте концентрации в этом направлении, равном единице. Коэффициенты диффузии связаны с подвижностями носителей зарядов соотношениями Эйнштейна:
Знак "минус" в выражении (1.14) означает противоположную направленность электрических токов в полупроводнике при диффузионном движении электронов и дырок в сторону уменьшения их концентраций. Если в полупроводнике существует и электрическое поле, и градиент концентрации носителей, проходящий ток будет иметь дрейфовую и диффузионную составляющие. В таком случае плотности токов рассчитываются по следующим уравнениям:
КОНТАКТНЫЕ ЯВЛЕНИЯ Гетеропереходы Гетеропереход образуется двумя полупроводниками, различающимися шириной запрещенной зоны. Параметры кристаллических решеток полупроводников, составляющих гетеропереход, должны быть близки, что ограничивает выбор материалов. В настоящее время наиболее исследованными являются пары: германий-арсенид галлия, арсенид галлия-мышьяковидный индий, германий-кремний. Различают n-p и p-n гетеропереходы (на первое место ставится буква, обозначающая тип электропроводности полупроводника с более узкой запрещенной зоной). На основе гетеропереходов возможно также создание структур n-n и p-p.
Рис. 1.16 Упрощенная энергетическая диаграмма p-n гетероперехода в равновесном состоянии. На рис. 1.16 приведена упрощенная энергетическая диаграмма n-p перехода между арсенидом галлия р -типа (ΔWP = 1,5 эВ) и германием n -типа (ΔWn = 0,67 эВ) в состоянии равновесия (U = 0). При контакте полупроводников происходит перераспределение носителей зарядов, приводящее к выравниванию уровней Ферми p - и n -областей и возникновению энергетического барьера для электронов n -области q×Ukn и. для дырок p -области q×Uкp, причем Uкn > Uкp.
Рис. 1.17 Упрощенная энергетическая диаграмма p-n гетероперехода, включенного в прямом состоянии.
В состоянии равновесия ток через n-p переход равен нулю. Поскольку потенциальные барьеры для дырок и электронов различны, при приложении к гетеропереходу прямого напряжения смещения он обеспечит эффективную инжекцию дырок из полупроводника с большей шириной запрещенной зоны (рис. 1.17). Омические контакты Омическими называют контакты, сопротивление которых не зависит от величины и направления тока. Другими словами, это контакты, обладающие практически линейной вольтамперной характеристикой. Омические контакты обеспечивают соединение полупроводника с металлическими токопроводящими элементами полупроводниковых приборов. Кроме линейности вольтамперной характеристики, эти контакты должны иметь малое сопротивление и обеспечивать отсутствие инжекции носителей из металлов в полупроводник. Эти условия выполняются путем введения между полупроводником рабочей области кристалла и металлом полупроводника с повышенной концентрацией примеси (рис. 1.19). Контакт между полупроводниками с одинаковым типом электропроводности является невыпрямляющим и низкоомным. Металл выбирают так, чтобы обеспечить малую контактную разность потенциалов. Одним из способов получения омических контактов является введение в металл примеси, которой легирован полупроводник. В этом случае при сплавлении металла с полупроводником в контактной области образуется тонкий слой вырожденного полупроводника, что соответствует структуре, изображенной на рис. 1.19.
Рис. 1.19 Структура омического контакта. ПОЛУПРОВОДНИКОВЫЕ ДИОДЫ Классификация Классификация полупроводниковых диодов производится по следующим признакам: - методу изготовления перехода: сплавные, диффузионные, планарные, точечные, диоды Шоттки и др.; - материалу: германиевые, кремниевые, арсенид-галлиевые и др.; - физическим процессам, на использовании которых основана работа диода: туннельные, лавинно-пролетные, фотодиоды, светодиоды. диоды Ганна и др.; - назначению: выпрямительные, универсальные, импульсные, стабилитроны, детекторные, параметрические, смесительные, СВЧ-диоды и др. Некоторые из указанных типов диодов по назначению будут рассмотрены в настоящей главе, а другие - в соответствующих разделах учебного пособия. Выпрямительные диоды Выпрямительными обычно называют диоды, предназначенные для преобразования переменного напряжения промышленной частоты (50 или 400 Гц) в постоянное. Основой диода является обычный p-n переход. В практических случаях p-n переход диода имеет достаточную площадь для того, чтобы обеспечить большой прямой ток. Для получения больших обратных (пробивных) напряжений диод обычно выполняется из высокоомного материала. Основными параметрами, характеризующими выпрямительные диоды, являются (рисунок 2.1): - максимальный прямой ток Iпр max; - падение напряжения на диоде при заданном значении прямого тока Iпр (Uпр» 0.3...0,7 В для германиевых диодов и Uпр» 0,8...1,2 В - для кремниевых); - максимально допустимое постоянное обратное напряжение диода Uобр max; - обратный ток Iобр при заданном обратном напряжении Uобр (значение обратного тока германиевых диодов на два -три порядка больше, чем у кремниевых); - барьерная емкость диода при подаче на него обратного напряжения некоторой величины; - диапазон частот, в котором возможна работа диода без существенного снижения выпрямленного тока; - рабочий диапазон температур (германиевые диоды работают в диапазоне -60...+70°С, кремниевые - в диапазоне -60...+150°С, что объясняется малыми обратными токами кремниевых диодов).
Рис. 2.1. К определению параметров выпрямительных диодов. Выпрямительные диоды обычно подразделяются на диоды малой, средней и большой мощности, рассчитанные на выпрямленный ток до 0.3, от 0,3 до 10 и свыше 10 А соответственно. Для работы на высоких напряжениях (до 1500 В) предназначены выпрямительные столбы, представляющие собой последовательно соединенные p-n переходы, конструктивно объединенные в одном корпусе. Выпускаются также выпрямительные матрицы и блоки, имеющие в одном корпусе по четыре или восемь диодов, соединенные по мостовой схеме выпрямителя и имеющие Iпр max до 1 А и Uo6p max до 600 В. При протекании больших прямых токов Iпр и определенном падении напряжения на диоде Uпp B нем выделяется большая мощность. Для отвода данной мощности диод должен иметь большие размеры p-n перехода, корпуса и выводов. Для улучшения теплоотвода используются радиаторы или различные способы принудительного охлаждения (воздушное или даже водяное). Среди выпрямительных диодов следует выделить особо диод с барьером Шоттки. Этот диод характеризуется высоким быстродействием и малым падением напряжения (Uпp < 0,6 В). К недостаткам диода следует отнести малое пробивное напряжение и большие обратные токи. Стабилитроны и стабисторы Стабилитроном называется полупроводниковый диод, на обратной ветви ВАХ которого имеется участок с сильной зависимостью тока от напряжения (рис. 2.2), т.е. с большим значением крутизны DI/DU (DI= Icт max - Iст min). Если такой участок соответствует прямой ветви ВАХ, то прибор называется стабистором. Стабилитроны используются для создания стабилизаторов напряжения. Напряжение стабилизации Uст равно напряжению электрического (лавинного) пробоя p-n перехода при некотором заданном токе стабилизации Iст (рис.2.2). Стабилизирующие свойства характеризуются дифференциальным сопротивлением стабилитрона rд = DU/DI, которое должно быть возможно меньше.
К параметрам стабилитрона относятся: напряжение стабилизации Ucт, минимальный и максимальный токи стабилизации Iст min Iст max. Промышленностью выпускаются стабилитроны с параметрами: Ucт от 1,5 до 180 В, токи стабилизации от 0,5 мА до 1,4 А. Выпускаются также двуханодные стабилитроны, служащие для стабилизации разнополярных напряжений и представляющие собой встречно включенные p - n переходы. Рис. 2.2 К определению параметров стабилитронов. Варикапы Варикапом называется полупроводниковый диод, используемый в качестве электрически управляемой емкости с достаточно высокой добротностью в диапазоне рабочих частот. В нем используется свойство p-n -перехода изменять барьерную емкость под действием внешнего напряжения (рис. 2.4). Основные параметры варикапа: номинальная емкость СН при заданном номинальным напряжением UН (обычно 4 В), максимальное обратное напряжение Uобр max и добротность Q. Для увеличения добротности варикапа используют барьер Шоттки; эти варикапы имеют малое сопротивление потерь, так как в качестве одного из слоев диода используется металл.
Рис. 2.4 Зависимость емкости варикапа от напряжения. Основное применение варикапов - электрическая перестройка частоты колебательных контуров. В настоящее время существует несколько разновидностей варикапов, применяемых в различных устройствах непрерывного действия. Это параметрические диоды, предназначенные для усиления и генерации СВЧ-сигналов, и умножительные диоды, предназначенные для умножения частоты в широком диапазоне частот. Иногда в умножительных диодах используется и диффузионная емкость. БИПОЛЯРНЫЕ ТРАНЗИСТОРЫ Общие сведения Биполярным транзистором (БТ) называется трехэлектродный полупроводниковый прибор с двумя взаимодействующими p-n переходами, предназначенный для усиления электрических колебаний по току, напряжению или мощности. Слово “биполярный” означает, что физические процессы в БТ определяются движением носителей заряда обоих знаков (электронов и дырок). Взаимодействие переходов обеспечивается тем, что они располагаются достаточно близко - на расстоянии, меньшем диффузионной длины. Два p-n -перехода образуются в результате чередования областей с разным типом электропроводности. В зависимости от порядка чередования различают БТ типа n-p-n (или со структурой n-p-n) и типа p-n-p (или со структурой p-n-p), условные изображения которых показаны на рис. 3.1.
Структура реального транзистора типа n-p-n изображена на рис. 3.2. В этой структуре существуют два перехода с неодинаковой площадью: площадь левого перехода n1+-p меньше, чем у перехода n2-p. Кроме того, у большинства БТ одна из крайних областей (n1 с меньшей площадью) сечения легирована гораздо сильнее, чем другая крайняя область (n2).
Рис. 3.2 Структура реального БТ типа n-p-n. Сильнолегированная область обозначена верхним индексом “+” (n+). Поэтому БТ является асимметричным прибором. Асимметрия отражается и в названиях крайних областей: сильнолегированная область с меньшей площадью (n1+) называется эмиттером, а область n2 - коллектором. Соответственно область (p) называется базовой (или базой). Правая область n+ служит для переход n1+-р называют эмиттерным, а n2-p коллекторным. Средняя снижения сопротивления коллектора. Контакты с областями БТ обозначены на рисунках 3.1 и 3.2 буквами: Э - эмиттер; Б - база; К- коллектор. Основные свойства БТ определяются процессами в базовой области, которая обеспечивает взаимодействие эмиттерного и коллекторного переходов. Поэтому ширина базовой области должна быть малой (обычно меньше 1 мкм). Если распределение примеси в базе от эмиттера к коллектору однородное (равномерное), то в ней отсутствует электрическое поле и носители совершают в базе только диффузионное движение. В случае неравномерного распределения примеси (неоднородная база) в базе существует “внутреннее” электрическое поле, вызывающее появление дрейфового движения носителей: результирующее движение определяется как диффузией, так и дрейфом. БТ с однородной базой называют бездрейфовыми, а с неоднородной базой - дрейфовыми. Биполярный транзистор, являющийся трехполюсным прибором, можно использовать в трех схемах включения: с общей базой (ОБ) (рис. 3.3,а), общим эмиттером (ОЭ) (рис. 3.3,б), и общим коллектором (ОК) (рис. 3.3,в). Стрелки на условных изображениях БТ указывают (как и на рис. 3.1) направление прямого тока эмиттерного перехода. В обозначениях напряжений вторая буква индекса обозначает общий электрод для двух источников питания. В общем случае возможно четыре варианта полярностей напряжения переходов, определяющих четыре режима работы транзистора. Они получили названия: нормальный активный режим, инверсный активный режим, режим насыщения (или режим двухсторонней инжекции) и режим отсечки.
В нормальном активном режиме (НАР) на эмиттерном переходе действует прямое напряжение (напряжение эмиттер - база UЭБ), а на коллекторном переходе - обратное (напряжение коллектор - база UКБ). Этому режиму соответствуют полярности источников питания на рис. 3.4 и направления токов для p-n-p транзистора. В случае n-p-n транзистора полярности напряжения и направления токов изменяются на противоположные. Этот режим работы (НАР) является основным и определяет назначение и название элементов транзистора. Эмиттерный переход осуществляет инжекцию носителей в узкую базовую область, которая обеспечивает практически без потерь перемещение инжектированных носителей до коллекторного перехода.
Рис. 3.4 Физические процессы в БТ. Коллекторный переход не создает потенциального барьера для подошедших носителей, ставших неосновными носителями заряда в базовой области, а, наоборот, ускоряет их и поэтому переводит эти носители в коллекторную область. “Собирательная” способность этого перехода и обусловила название “коллектор”. Коллектор и эмиттер могут поменяться ролями, если на коллекторный переход подать прямое напряжение UКБ, а на эмиттерный -обратное UЭБ. Такой режим работы называется инверсным активным режимом (ИАР). В этом случае транзистор “работает” в обратном направлении: из коллектора идет инжекция дырок, которые проходят через базу и собираются эмиттерным переходом, но при этом его параметры отличаются от первоначальных. Режим работы, когда напряжения на эмиттерном и коллекторном переходах являются прямыми одновременно, называют режимом двухсторонней инжекции (РДИ) или менее удачно режимом насыщения (РН). В этом случае и эмиттер, и коллектор инжектируют носители заряда в базу навстречу друг другу и одновременно каждый из переходов собирает носители, приходящие к нему от другого перехода. Наконец, режим, когда на обоих переходах одновременно действуют обратные напряжения, называют режимом отсечки (РО), так как в этом случае через переходы протекают малые обратные токи. Следует подчеркнуть, что классификация режимов производится по комбинации напряжений переходов, В схеме включения с общей базой (ОБ) они равны напряжениям источников питания UЭБ и UКБ. В схеме включения с общим эмиттером (ОЭ) напряжение на эмиттерном переходе определяется напряением первого источника (UЭБ = -UБЭ), а напряжение коллекторного перехода зависит от напряжений обоих источников и по общему правилу определения разности потенциалов UКБ = UКЭ + UЭБ. Так как UЭБ = -UБЭ, тo UКБ = UКЭ - UБЭ; при этом напряжение источников питания надо брать со своим знаком: положительным, если к электроду присоединен положительный полюс источника, и отрицательным - в другом случае. В схеме включения с общим коллектором (ОК) напряжение на коллекторном переходе определяется одним источником: UКБ = -UБК. Напряжение на эмиттерном переходе зависит от обоих источников: UЭБ = UЭК + UКБ = UЭК - UБК, при этом правило знаков прежнее. Схема с общей базой Семейство входных характеристик схемы с ОБ представляет собой зависимость IЭ = f(UЭБ) при фиксированных значениях параметра UКБ - напряжения на коллекторном переходе (рис. 3.5,а). При UКБ = 0 характеристика подобна ВАХ p-n -перехода. С ростом обратного напряжения UКБ (UКБ < 0 для p-n-p -транзистора) вследствие уменьшения ширины базовой области (эффект Эрли) происходит смещение характеристики вверх: IЭ растет при выбранном значении UЭБ. Если поддерживается постоянным ток эмиттера (IЭ = const), т.е. градиент концентрации дырок в базовой области остается прежним, то необходимо понизить напряжение UЭБ, (характеристика сдвигается влево). Следует заметить, что при UКБ < 0 и UЭБ = 0 существует небольшой ток эмиттера IЭ0, который становится равным нулю только при некотором обратном напряжении UЭБ0.
Семейство выходных характеристик схемы с ОБ представляет собой зависимости IК = f(UКБ) при заданных значениях параметра IЭ (рис. 3.5,б). Выходная характеристика p-n-p -транзистора при IЭ = 0 и обратном напряжении | UКБ < 0| подобна обратной ветви p-n -перехода (диода). При этом в соответствии с (3.11) IК = IКБО, т.е. характеристика представляет собой обратный ток коллекторного перехода, протекающий в цепи коллектор - база. При IЭ > 0 основная часть инжектированных в базу носителей (дырок в p-n-p транзисторе) доходит до границы коллекторного перехода и создает коллекторный ток при UКБ = 0 в результате ускоряющего действия контактной разности потенциалов. Ток можно уменьшить до нуля путем подачи на коллекторный переход прямого напряжения определенной величины. Этот случай соответствует режиму насыщения, когда существуют встречные потоки инжектированных дырок из эмиттера в базу и из коллектора в базу. Результирующий ток станет равен нулю, когда оба тока одинаковы по величине (например, точка А ' на рисунок 3.5,б). Чем больше заданный ток IЭ, тем большее прямое напряжение UКБ требуется для получения IК = 0. Область в первом квадранте на рис. 3.5,б, где UКБ < 0 (обратное) и параметр IЭ > 0 (что означает прямое напряжение UЭБ) соответствует нормальному активному режиму (НАР). Значение коллекторного тока в НАР определяется формулой (3.11) IК = aIЭ + IКБО. Выходные характеристики смещаются вверх при увеличении параметра IЭ. В идеализированном транзисторе не учитывается эффект Эрли, поэтому интегральный коэффициент передачи тока a можно считать постоянным, не зависящим от значения | UКБ |. Следовательно, в идеализированном БТ выходные характеристики оказываются горизонтальными (IК = const). Реально же эффект Эрли при росте | UКБ | приводит к уменьшению потерь на рекомбинацию и росту a. Так как значение a близко к единице, то относительное увеличение а очень мало и может быть обнаружено только измерениями. Поэтому отклонение выходных характеристик от горизонтальных линий вверх “на глаз” не заметно (на рис. 3.5,б не соблюден масштаб). Схема с общим эмиттером Семейство входных характеристик схемы с ОЭ представляет собой зависимости IБ = f(UБЭ), причем параметром является напряжение UКЭ (рис. 3.6,а). Для p-n-p транзистора отрицательное напряжение UБЭ (UБЭ < 0) означает
прямое включение эмиттерного перехода, так как UЭБ = -UБЭ > 0. Если при этом UКЭ = 0 (потенциалы коллектора и эмиттера одинаковы), то и коллекторный переход будет включен в прямом направлении: UКБ = UКЭ + UЭБ = UЭБ > 0. Поэтому входная характеристика при UКЭ = 0 будет соответствовать режиму насыщения (РН), а ток базы равным сумме базовых токов из-за одновременной инжекции дырок из эмиттера и коллектора. Этот ток, естественно, увеличивается с ростом прямого напряжения UЭБ, так как оно приводит к усилению инжекции в обоих переходах (UКБ = UЭБ) и соответствующему возрастанию потерь на рекомбинацию, определяющих базовый ток. Вторая характеристика на рис. 3.6,а (UКЭ = 0) относится к нормальному активному режиму, для получения которого напряжение UКЭ должно быть в p-n-p транзисторе отрицательным и по модулю превышать напряжение UЭБ. В этом случае (UКБ = UКЭ + UЭБ = UКЭ - UБЭ < 0. Формально ход входной характеристики в НАР можно объяснить с помощью выражения (3.14) или (3.17): IБ =(1 - a) IЭ - IКБО. При малом напряжении UБЭ инжекция носителей практически отсутствует (IЭ = 0) и ток IБ = -IКБО, т.е. отрицателен. Увеличение прямого напряжения на эмиттерном переходе UЭБ = -UБЭ вызывает рост IЭ и величины (1 - a) IЭ. Когда (1 - a) IЭ = IКБО, ток IБ = 0. При дальнейшем росте UБЭ (1 - a) IЭ > IКБО и IБ меняет направление и становится положительным (IБ > 0) и сильно зависящим от напряжения перехода. Влияние UКЭ на IБ в НАР можно объяснить тем, что рост | UКЭ | означает рост | UКБ | и, следовательно, уменьшение ширины базовой области (эффект Эрли). Последнее будет сопровождаться снижением потерь на рекомбинацию, т.е. уменьшением тока базы (смещение характеристики незначительно вниз). Семейство выходных характеристик схемы с ОЭ представляет собой зависимости IК = f(UКЭ) при заданном параметре IБ (рис. 3.6,б).
|
||||||||||||||||||||||||||||
|
Последнее изменение этой страницы: 2017-02-06; просмотров: 144; Нарушение авторского права страницы; Мы поможем в написании вашей работы! infopedia.su Все материалы представленные на сайте исключительно с целью ознакомления читателями и не преследуют коммерческих целей или нарушение авторских прав. Обратная связь - 18.220.136.165 (0.087 с.) |
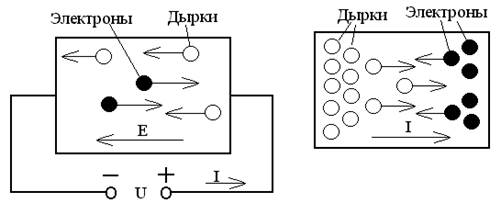
 , приобретаемой носителями заряда в направлении действия электрического поля напряженностью Е = 1 В/м, т. е.
, приобретаемой носителями заряда в направлении действия электрического поля напряженностью Е = 1 В/м, т. е. . (1.11)
. (1.11) , определяется выражением
, определяется выражением  .
. создает в полупроводнике дырочный ток, плотность которого
создает в полупроводнике дырочный ток, плотность которого  . Следовательно, полная плотность тока в полупроводнике содержит электронную jn и дырочную jр составляющие и равна их сумме (n и p — концентрации соответственно электронов и дырок).
. Следовательно, полная плотность тока в полупроводнике содержит электронную jn и дырочную jр составляющие и равна их сумме (n и p — концентрации соответственно электронов и дырок). . (1.12)
. (1.12) .
. .
. >
>  , и его удельная электропроводность с достаточной степенью точности может быть определена выражением
, и его удельная электропроводность с достаточной степенью точности может быть определена выражением .
. , и удельная электропроводность такого полупроводника
, и удельная электропроводность такого полупроводника
 ) или электронов (np -
) или электронов (np -  ;
;  ,
, ; (1.13)
; (1.13) , (1.14)
, (1.14) ;
;  .
. ;
;  .
.