
Заглавная страница Избранные статьи Случайная статья Познавательные статьи Новые добавления Обратная связь КАТЕГОРИИ: ТОП 10 на сайте Приготовление дезинфицирующих растворов различной концентрацииТехника нижней прямой подачи мяча. Франко-прусская война (причины и последствия) Организация работы процедурного кабинета Смысловое и механическое запоминание, их место и роль в усвоении знаний Коммуникативные барьеры и пути их преодоления Обработка изделий медицинского назначения многократного применения Образцы текста публицистического стиля Четыре типа изменения баланса Задачи с ответами для Всероссийской олимпиады по праву 
Мы поможем в написании ваших работ! ЗНАЕТЕ ЛИ ВЫ?
Влияние общества на человека
Приготовление дезинфицирующих растворов различной концентрации Практические работы по географии для 6 класса Организация работы процедурного кабинета Изменения в неживой природе осенью Уборка процедурного кабинета Сольфеджио. Все правила по сольфеджио Балочные системы. Определение реакций опор и моментов защемления |
Инжекционный полупроводниковый лазер на гомопереходе
В принципе накачку полупроводниковых лазеров можно осуществлять различными методами, однако, до сих пор наиболее эффективным является использование полупроводника в виде диода, в котором возбуждение происходит за счет тока, протекающего в прямом направлении p-n перехода. Для объяснения принципа работы полупроводниковых инжекционных лазеров здесь ограничимся рассмотрением физических процессов на гомопереходе, который образуется в плоскости контакта двух одноименных полупроводников с p и n - типами проводимости. Как уже было отмечено, у вырожденных полупроводников квазиуровни Ферми EFn и EFp находятся ответственно внутри разрешенных зон (EFn - квазиуровень Ферми для электронов в зоне проводимости, EFp - квазиуровень Ферми для дырок в валентной зоне). Если полупроводник n и p -типа привести в контакт, то произойдет встречная диффузия и рекомбинация электронов из n - области и дырок из p - области до наступления равновесия, когда квазиуровни Ферми совместятся, т.е. EFn=EFp=EF. При этом возле границы электронно-дырочного перехода в n - области останется положительный объемный заряд ионизированных доноров, а в p - области в результате отхода дырок - отрицательный объемный заряд ионизированных акцепторов. Эти пространственные заряды образуют двойной электрический слой, электрическое поле которого препятствует дальнейшей диффузии и рекомбинации электронов и дырок - устанавливается равновесие. Падение напряжения на границе p - и n -областей называется потенциальным барьером p - n - перехода. Если к p - n -переходу приложить электрическое напряжение (в прямом или обратном направлении), то равновесие нарушится. При приложении напряжения величиной U в прямом направлении высота потенциального барьера понизится на значение энергии eU, или что то же самое - два квазиуровня Ферми теперь становятся разделенными энергетическими промежутками ∆E=eU. Зонная структура р - п -перехода полупроводника при смещении в прямом направлении показана на рис 4.3. При этом, как видно из рисунка, взаимное расположение уровней удовлетворяют условию квантового усиления (EFn-EFp)>Eg, т.е. в области квантового перехода возникает инверсное распределение населенностей.
Рис.4.3. Диаграмма энергетических зон р-n – перехода в отсутствии смещения (а) и при смещении в прямом направлении (б).
По существу, при смещении в прямом направлении происходит инжекция в активный слой электронов из зоны проводимости материала п -типа и дырок из валентной зоны материала р - типа. Как только электрон достигает материала р - типа он становится не основным носителем и диффундирует до тех пор, пока не рекомбинирует с дыркой в валентной зоне. Таким образом, физические процессы в p-n переходе происходящие в инжекционном лазере можно описать следующим образом. После подачи на лазерный диод напряжения в прямом направлении необходимой величины наступает инверсная населенность зонных состояний. При этом через p - n переход потечет прямой ток, и будет происходить мощная излучательная рекомбинация носителей при переходах "зона - зона" или "примесный уровень - зона". Эффективность этого процесса в лазерных диодах достаточно высока и достигает до 30%. Через некоторое время взаимодействие электронов и дырок приведет их в равновесное состояние, при этом уровни Ферми совместятся. Приложение следующего импульса напряжения приводит к повторению процесса. Как видно из рис.4.1(б) световые кванты с энергией от hvmax до hvmin поглощаться не будут, т.к. нижние состояния свободны, верхние заселены. Одновременно эти кванты могут стимулировать рекомбинацию. В результате будет иметь место усиление света в полосе частот Dn =nmax-nmin. Ширина этой полосы определяется степенью вырождения (DE) и шириной запрещенной зоны (Еg). На рис.4.4. приведена конструкция лазера на арсениде галлия с р - п -переходом. Кристалл полупроводникового лазера имеет размеры порядка 500´400´100 мкм. Изготовление оптического резонатора таких размеров связано с технологическими трудностями. Поэтому для обеспечения необходимой для генерации обратной связи две выходные плоскости полупроводникового кристалла делают параллельными друг другу (обычно это достигается посредством скалывания вдоль кристаллографических осей). Так как показатель преломления у полупроводникового кристалла, как правило, большой и равняется, например для GaAsn = 3,6, то на поверхности раздела полупроводник - воздух обеспечивается достаточный для лазерной генерации коэффициент отражения (около 35%). Толщина р - п – перехода равна нескольким микрометрам, что является причиной сравнительно большого угла расходимости выходного излучения полупроводниковых лазеров. Следовательно, лазерный пучок довольно далеко проникает в p- и n- области, где испытывает сильное поглощение. Это является главной причиной, почему пороговая плотность тока при комнатной температуре в лазере на гомопереходе оказывается высокой. Например, при 77 0К для этих лазеров значение Jпор»(2 - 3)×102 А/см2, а при комнатных температур пороговая плотность тока возрастает до 105 А/см2. Непрерывная генерация в этих лазерах достигается при охлаждении кристалла до температуры жидкого азота, т.е. до 77 0К. Вследствие этого лазер не может работать в непрерывном режиме при комнатной температуре (или выйдет из строя через очень короткое время!). Однако пороговая плотность тока в диодном лазере быстро уменьшается с понижением рабочей температуры. Это обусловлено тем, что с понижением температуры величина fc(1-fv) - увеличивается, а fv(1-fc) уменьшается. Поэтому усиление [которое зависит от разности fc(1-fv) - fv(1-fc)] быстро возрастает. Вследствие этого лазеры на гомопереходе могут работать в непрерывном режиме только при низких температурах. Это является серьезным недостатком данного типа лазеров и наложило ограничения на возможности их практического применения.
4.3 Инжекционный полупроводниковый лазер Существенное снижение пороговой плотности тока и, следовательно, получение непрерывной генерации при комнатной температуре возможно при использовании гетероструктур, которые могут быть изготовлены как одинарные, двойные или многократные. Гетероструктура возникает при наращивании монокристаллического слоя одного полупроводника на монокристаллической подложке другого полупроводника, т.е. при контакте двух различных по химическому составу и по ширине запрещенной зоны полупроводников. Такое наращивание без существенного нарушения монокристальности всего образца в целом возможно только для тех полупроводниковых материалов, кристаллические решетки которых почти не отличаются друг от друга. Обычно это осуществляется при изопериодическом замещении методом эпитаксиального роста. Примерами являются пары GaAs-AlxGa1-x As, GaAs-GaAsxP1-x,CdTe-CdSe и т.п. Односторонние гетероструктуры (ОГС) являются комбинацией р - п – перехода и гетероперехода, расположенного вблизи р - п – перехода. ОГС создается гетероэпитаксиальным наращиванием с последующей диффузией примеси в подложку для образования р - п – перехода. Например, в ОГС на основе арсенида галлия на подложку с электронной проводимостью наращивается слой AlxGa1-x As р – типа с более широкой запрещенной зоной, чем у GaAs. Акцепторы, диффундирующие из этого слоя в подложку, образуют активный р – слой в GaAs. При толщине этого слоя около 2 мкм р - р – гетеропереход эффективно влияет на распределение инжектированных электронов, препятствуя их диффузионному растеканию от р - п – перехода. В результате потенциальный барьер в р - р – гетеропереходе ограничивает объем активной области, т.е. создается эффект «электронного ограничения», что снижает пороговую плотность тока при комнатной температуре до ~104 А/см2.
Двусторонняя гетероструктура содержит два гетероперехода: один инжектирующий, другой – ограничивающей диффузионное растекание носителей тока. Активная область заключена между гетеропереходами. Чтобы проиллюстрировать его свойства, на рис.4.5. приведен пример лазерной структуры с двойным гетеропереходом в GaAs.
Рис.4.5. Схема диода п/п лазера с двойным гетеропереходом. Активная область заштрихована. В этом диоде реализованы два перехода между различными материалами [ Al0,3Ga0,7As(р) – GaAs и GaAs – Al0,3Ga0,7As(n) ]. Активная область представляет собой тонкий слой GaAs (0,1- 0,3 мкм). В такой структуре диода пороговую плотность тока при комнатной температуре можно уменьшить примерно на два порядка (т.е. ~103 А/см2) по сравнению с устройством на гомопереходе. Таким образом, становится возможной работа в непрерывном режиме при комнатной температуре. Уменьшению пороговой плотности тока происходит благодаря совместному действию трех следующих факторов: 1) Показатель преломления GaAs (n1
Рис.4.6. а-профиль показателя преломления; б- поперечное сечение пучка; в-зонная структура полупроводника с двойным гетеропереходом, используемом в диодном лазере. 3) Поскольку Еg2 значительно больше, чем Еg1, лазерный пучок с частотой Длина волны излучение лазера с двойным гетеропереходом на GaAs (
Рис.4.7.Ватт-амперная характеристика полупроводникового лазера
Гетероструктуры для создания полупроводниковых инжекционных лазеров были предложены Ж.И. Алферовым, которые были реализованы под его руководством в 1968 году. Для технических применений (лазерное печатающее устройство, лазер для записи на оптический диск, лазер для оптической связи и т.д.) разработаны лазеры специальной конструкции. Самыми распространенными типами являются: 1. Полосковый лазер – полупроводниковый лазер, в котором область генерации выполнена в виде полоски, конструкция которого обеспечивает уменьшение рабочего тока и осуществление селекции поперечных мод. 2. Лазер с распределенной обратной связью (РОС –лазеры)-лазер, в котором вместо резонатора Фабри - Перо используется распределенная обратная связь с периодически изменяющимся показателем преломления вдоль пути света, причем периодическая структура находится в p-n -переходе кристалла. 3. Лазер с распределенным брэгговским отражением, принцип работы которого также как у РОС-лазеров, но отражающая периодическая структура находится вне p-n перехода кристалла. 4. Двухрезонаторный лазер-это полупроводниковый лазер, в котором вокруг активной области полупроводниковой структуры ставится одно или два зеркала. Зеркало совмещает функции дифракционной решетки. Для улучшения обратной связи между зеркалом и активным элементом устанавливается линза.
|
||||||||||||||||
|
Последнее изменение этой страницы: 2016-08-16; просмотров: 995; Нарушение авторского права страницы; Мы поможем в написании вашей работы! infopedia.su Все материалы представленные на сайте исключительно с целью ознакомления читателями и не преследуют коммерческих целей или нарушение авторских прав. Обратная связь - 3.144.48.135 (0.017 с.) |
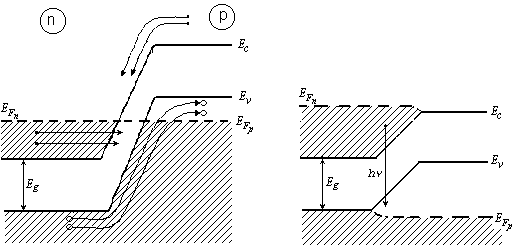
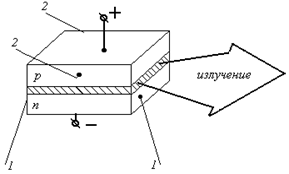

 3,6) значительно больше показателя преломления Al0,3Ga0,7As (n1
3,6) значительно больше показателя преломления Al0,3Ga0,7As (n1 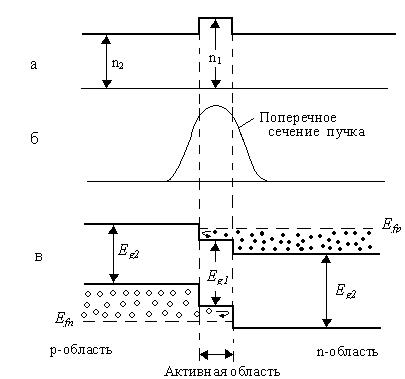
 Еg1 / h почти не поглощается в Al0,3Ga0,7As. Поэтому крылья поперечного профиля пучка, заходящие как в р-, так и в n- области (рис.4.6,б), не испытывают там сильного поглощения.
Еg1 / h почти не поглощается в Al0,3Ga0,7As. Поэтому крылья поперечного профиля пучка, заходящие как в р-, так и в n- области (рис.4.6,б), не испытывают там сильного поглощения. =0,85 мкм) попадает в диапазон, в котором мы имеем минимум потерь в оптическом волокне из плавленого кварца (первое окно пропускания). В настоящее время усиленно разрабатываются лазеры с двойным гетероструктурой, работающие на длине волны либо
=0,85 мкм) попадает в диапазон, в котором мы имеем минимум потерь в оптическом волокне из плавленого кварца (первое окно пропускания). В настоящее время усиленно разрабатываются лазеры с двойным гетероструктурой, работающие на длине волны либо  1,3 мкм, либо
1,3 мкм, либо 



