
Заглавная страница Избранные статьи Случайная статья Познавательные статьи Новые добавления Обратная связь КАТЕГОРИИ: ТОП 10 на сайте Приготовление дезинфицирующих растворов различной концентрацииТехника нижней прямой подачи мяча. Франко-прусская война (причины и последствия) Организация работы процедурного кабинета Смысловое и механическое запоминание, их место и роль в усвоении знаний Коммуникативные барьеры и пути их преодоления Обработка изделий медицинского назначения многократного применения Образцы текста публицистического стиля Четыре типа изменения баланса Задачи с ответами для Всероссийской олимпиады по праву 
Мы поможем в написании ваших работ! ЗНАЕТЕ ЛИ ВЫ?
Влияние общества на человека
Приготовление дезинфицирующих растворов различной концентрации Практические работы по географии для 6 класса Организация работы процедурного кабинета Изменения в неживой природе осенью Уборка процедурного кабинета Сольфеджио. Все правила по сольфеджио Балочные системы. Определение реакций опор и моментов защемления |
Варакторні діоди та діоди Шотткі, характеристики та застосування
Варакторный диод - это полупроводниковый диод с р-п переходом, изготовленный по специальной технологии, в котором имеет место нелинейная зависимость емкости запертого р-п перехода от приложенного к диоду обратного напряжения. Емкость диода зависит от ширины запирающего слоя, который в этом случае можно трактовать как диэлектрик конденсатора. Обкладками конденсатора служат прилегающие к запирающему слою области полупроводника. Если напряжение, смещающее диод в обратном направлении, возрастает, то емкость диода уменьшается. Для типичного диода в интервале отрицательных напряжений от нескольких десятков вольт до нуля емкость изменяется от 10 до 200 пФ. Варакторные диоды, называемые также емкостными диодами или варикапами, находят применение, в частности, как элементы, включаемые в резонансные контуры, которые можно при этом перестраивать, изменяя напряжение смещения на аноде (например, с помощью потенциометра). Такое решение часто используют в радиоприемниках, исключая, таким образом, неудобный и дорогостоящий конденсатор переменной емкости поворотного типа. Регулируемое напряжение подводится к диоду через резистор R, сопротивление которого должно быть настолько большим, чтобы не шунтировать резонансный контур. Зависящее от этого напряжения изменение емкости диода вызывает изменение емкости, подключенной параллельно емкости резонансного контура. Тем самым изменяется результирующая емкость этого контура, а следовательно, и его резонансная частота.
Еквівалентна схема варактора
Конструкційна схема варактрора
3. Легування напівпровідникових матеріалів методом іонної імплантації. Фізичні основи, апаратура та порівняльна характеристика з методом дифузії. Ионное легирование широко используется при создании БИС и СБИС. По сравнению с диффузией оно позволяет создавать слои с субмикронными горизонтальными размерами толщиной менее 0,1 мкм с высокой воспроизводимостью параметров. Ионы элементов, используемых обычно для создания примесной проводимости, внедряясь в кристалл полупроводника занимают в его решетке положение атомов замещения и создают соответствующий тип проводимости. Внедряя ионы III и V групп в монокристалл кремния, можно получить p-n переход в любом месте и на любой площади кристалла.
Возможность легирования полупроводников (doping) из газовой фазы бором, фосфором, арсенидом является важнейшей особенностью ионной имплантации. Такой процесс легирования считается одним из наиболее чистых методов легирования. Имплантированый ион создает в полупроводнике заряд (дырку или электрон), меняя при этом его проводимость, что позволяет создать на поверхности кремния, например, изолирующую поверхность. Имплантированные ионы кислорода окисляют кремний превращающих его в окись кремния, являющегося прекрасным изолятором.
Основными блоками ионно-лучевой установки являются источник ионов(ion source), ионный ускоритель, магнитный сепаратор, система сканирования пучком ионов, и камера, в которой находится бомбардируемый образец (substrate). Ионы имплантируемого материала разгоняются в электростатическом ускорителе и бомбардируют образец. Ионы ускоряются до энергий 10-5000кэВ. Проникновение ионов в глубину образца зависит от их энергии и составляет от нескольких нанометров, до нескольких микрометров. Ионы с энергией 1-10 кэВ не вызывают изменений в структуре образца, тогда как более энергетичные потоки ионов могут значительно его разрушить. Технология ионного имплантирования разрешает внедрить заданное количество практически любого химического элемента на заданную глубину, позволяя таким образом сплавлять металлы, которые в расплавленном состоянии не смешиваются, или легировать одно вещество другим в пропорциях, которые невозможно достичь даже при использовании высоких температур. Возможно создавать композиционные системы с уникальными структурами и свойствами, существенно отличными от свойств основной массы детали. Введение импланта в основную решетку материала возможно без «соблюдения» законов термодинамики, определяющих равновесные процессы, например, диффузию и растворимость. Ионная имплантация приводит к значительному изменению свойств поверхности по глубине: · слой с измененным химическим составом до 1-9 мкм; · слой с измененной дислокационной структурой до 100 мкм.
Сталкиваясь с электронами и ядрами мишени, ионы легирующего вещества на некоторой глубине теряют энергию и останавливаются. Если известны тип и энергия ионов и свойства обрабатываемого материала, то глубина проникновения (или длина пробега) может быть вычислена. Для пучков с типичными энергиями от 10 до 500 кэВ величина пробега достигает одного мкм. Как уже указывалось, вследствие влияния большого числа факторов, эпюра распределения внедренного вещества в поверхность близка по форме гауссовскому распределению. Внедрение ионов в кристаллическую решетку обрабатываемого материала приводит к появлению дефектов структуры. Выбитые из узлов решетки атомы вещества приводят к образованию вакансий и дефектов структуры в виде внедренных межузельных атомов. Эти же дефекты возникают при застревании между узлами решетки ионов. Скопление таких дефектов образует дислокации и целые дислокационные скопления
Екзаменаційний білет № 23 1. Розпізнавання сигналів – переносників у присутності перешкод. 2. Варакторні діоди та діоди Шотткі, характеристики та застосування. 3. Легування напівпровідникових матеріалів методом іонної імплантації. Фізичні основи, апаратура та порівняльна характеристика з методом дифузії.
2. Варакторный диод - это полупроводниковый диод с р-п переходом, изготовленный по специальной технологии, в котором имеет место нелинейная зависимость емкости запертого р-п перехода от приложенного к диоду обратного напряжения. Емкость диода зависит от ширины запирающего слоя, который в этом случае можно трактовать как диэлектрик конденсатора. Обкладками конденсатора служат прилегающие к запирающему слою области полупроводника. Если напряжение, смещающее диод в обратном направлении, возрастает, то емкость диода уменьшается. Для типичного диода в интервале отрицательных напряжений от нескольких десятков вольт до нуля емкость изменяется от 10 до 200 пФ. Варакторные диоды, называемые также емкостными диодами или варикапами, находят применение, в частности, как элементы, включаемые в резонансные контуры, которые можно при этом перестраивать, изменяя напряжение смещения на аноде (например, с помощью потенциометра). Такое решение часто используют в радиоприемниках, исключая, таким образом, неудобный и дорогостоящий конденсатор переменной емкости поворотного типа. Регулируемое напряжение подводится к диоду через резистор R, сопротивление которого должно быть настолько большим, чтобы не шунтировать резонансный контур. Зависящее от этого напряжения изменение емкости диода вызывает изменение емкости, подключенной параллельно емкости резонансного контура. Тем самым изменяется результирующая емкость этого контура, а следовательно, и его резонансная частота. Диод Шоттки — полупроводниковый диод с малым падением напряжения при прямом включении. Назван в честь немецкого физика Вальтера Шоттки. Диоды Шоттки используют переход металл-полупроводник в качестве барьера Шоттки (вместо p-n перехода, как у обычных диодов). Допустимое обратное напряжение промышленно выпускаемых диодов Шоттки ограничено 1200 В (CSD05120 и аналоги), на практике большинство диодов Шоттки применяется в низковольтных цепях при обратном напряжении порядка единиц и нескольких десятков вольт.
Свойства диодов Шоттки: Достоинства
Недостатки
3. Ионная имплантация — способ введения атомов примесей в поверхностный слой пластины или эпитаксиальной пленки путем бомбардировки его поверхности пучком ионов c высокой энергией (10—2000 КэВ).
Широко используется при создании полупроводниковых приборов методом планарной технологии. В этом качестве применяется для образования в приповерхностном слое полупроводника областей с содержанием донорных или акцепторных примесей с целью создания p-n-переходов и гетеропереходов, а также низкоомных контактов. Ионную имплантацию также применяют как метод легирования металлов для изменения их физических и химических свойств (повышения твердости, износостойкости, коррозионной стойкости и т.д.). Принцип работы Основными блоками ионно-лучевой установки являются источник ионов(ion source), ионный ускоритель, магнитный сепаратор, система сканирования пучком ионов, и камера, в которой находится бомбардируемый образец (substrate). Ионы имплантируемого материала разгоняются в электростатическом ускорителе и бомбардируют образец. Ионы ускоряются до энергий 10-5000кэВ. Проникновение ионов в глубину образца зависит от их энергии и составляет от нескольких нанометров, до нескольких микрометров. Ионы с энергией 1-10 кэВ не вызывают изменений в структуре образца, тогда как более энергетичные потоки ионов могут значительно его разрушить. Технология ионного имплантирования разрешает внедрить заданное количество практически любого химического элемента на заданную глубину, позволяя таким образом сплавлять металлы, которые в расплавленном состоянии не смешиваются, или легировать одно вещество другим в пропорциях, которые невозможно достичь даже при использовании высоких температур. Возможно создавать композиционные системы с уникальными структурами и свойствами, существенно отличными от свойств основной массы детали. Введение импланта в основную решетку материала возможно без «соблюдения» законов термодинамики, определяющих равновесные процессы, например, диффузию и растворимость. Ионная имплантация приводит к значительному изменению свойств поверхности по глубине:
Сталкиваясь с электронами и ядрами мишени, ионы легирующего вещества на некоторой глубине теряют энергию и останавливаются. Если известны тип и энергия ионов и свойства обрабатываемого материала, то глубина проникновения (или длина пробега) может быть вычислена. Для пучков с типичными энергиями от 10 до 500 кэВ величина пробега достигает одного мкм. Как уже указывалось, вследствие влияния большого числа факторов, эпюра распределения внедренного вещества в поверхность близка по форме гауссовскому распределению. Внедрение ионов в кристаллическую решетку обрабатываемого материала приводит к появлению дефектов структуры. Выбитые из узлов решетки атомы вещества приводят к образованию вакансий и дефектов структуры в виде внедренных межузельных атомов. Эти же дефекты возникают при застревании между узлами решетки ионов. Скопление таких дефектов образует дислокации и целые дислокационные скопления.
Метод диффузии Сейчас диффузия - основной метод получения p-n переходов. Источником диффузии могут быть жидкость, газ либо твердое вещество которое имеет в своем составе нужную примесь. Например, кремниевые p-n переходы получают диффузией алюминия и бора в кремний n-типа, или диффузией фосфора в кремний p-типа из газовой среды. Диффузия происходит в специальных печах при высокой температуре, при которой обеспечивается нужное значение коэффициента диффузии примеси. Для кремния эта температура равна 1000...1300 по Цельсию. Диффузия может происходить как из постоянного(неограниченного), так и из ограниченного источника. Методом диффузии получают плавные переходы. Ионная имплантация Это легирование полупроводника бомбардированием ионами примеси в специальных установках. Такие установки позволяют ускорять ионы до высоких энергий (10 кВ...10МВ), что в свою очередь обеспечивает их внедрение в полупроводник на глубину до нескольких микрометров. Ионная имплантация позволяет точно дозировать количество примесей полупроводника при относительно низких температурах.
Распределение примесей в полупроводнике. а - при диффузии из неограниченого источника, б - при диффузии из ограниченого источника. Обнаружение сигнала
Допустим, что в принятом сигнале Сформулированная задача обнаружения сигнала является частным случаем общей задачи статистической проверки гипотез [2]. Гипотезу об отсутствии сигнала будем обозначать Если априорные вероятности
где { В этом случае, если априорные вероятности
где E — энергия сигнала, а N — одностороннняя спектральная плотность гауссовского аддитивного белого шума. Если априорные вероятности
Задача обнаружения часто встречается в радиолокации и других областях радиотехники. Билет 24 1. Інженерна реалізація сигналів-переносників. При наборе сигналов для системы связи, кроме его геометрической конфигурации, влияющей на помехоустойчивость системы, учитывается ряд дополнительных факторов: свойства заданной линий передачи: полоса пропускания постоянство парам. во времени, кол-во различных сообщений, которые одновременно необходимо передавать по линии связи. Необходимое совмещения работы нескольких систем передачи в 1 частотном диапазоне с min помехами. Предпочтительность технической реализации генераторов на основе реал. техн. При практ. форм. сигналов перенос 1 или 0 не требуется формально след. Алгоритму (2)
Сигналы обладающий требуемыми свойствами можно получить непосредственно генерированием их формы. Широко используется набор бинарных сигналов в двоичном кодирование при цифровой передаче явл. сигналы в виде отрезков гармон. Колебаний с разными частотами или с различными начальными фазами:
При сохр. неизмн. частоты и измен. только начальной фазы Если же изменять частоту по правилу
Помехоустойчивость при почти ортогональных сигналах будет несколько ниже чем у ортогональных сигналов. В бинарных системах используются также пару сигналов с амплитудной модуляцией
Сложные сигналы:
2. Лавинно-пролітний діод: структура, принцип роботи, характеристики та застосування.
Лавинно-пролетный диод (ЛПД, IMPATT-диод) — диод, основанный на лавинном умножении носителей заряда. Лавинно-пролетные диоды применяются в основном для генерации колебаний в диапазоне СВЧ. Процессы, происходящие в полупроводниковой структуре диода, ведут к тому, что активная составляющая полного комплексного сопротивления на малом переменном сигнале в определенном диапазоне частот отрицательна. На вольт-амперной характеристике лавинно-пролетного диода, в отличие от туннельного диода, отсутствует участок с отрицательным дифференциальным сопротивлением. Рабочей для лавинно-пролетного диода является область лавинного пробоя.
1. Контактный слой 2. Область образования лавины (p-n переходов) 3. Область дрейфа электронов 4. Область дрейфа дырок Для изготовления лавинно-пролетных диодов используют кремний и арсенид галлия. Такие диоды могут иметь различные полупроводниковые структуры: p+-n-n+, p+-n-i-n+, m-n-n+ (m-n — переход металл-полупроводник), n+-n-p-p+ и другие. Распределение концентраций примесей в переходах должно быть как можно ближе к ступенчатому, а сами переходы — максимально плоскими. Принцип работы лавинно-пролетного диода рассмотрим на примере p+-n-n+ структуры. Центральная слаболегированная n-область называется базой. При напряжении, близком к пробивному, обеднённый слой p+—n-перехода распространяется на всю базу. При этом напряжённость электрического поля растет от n-n+-перехода к p+-n переходу, вблизи которого можно выделить тонкую область, в котором напряжённость превышает пробивное значение, и происходит лавинное размножение носителей. Образующиеся при этом дырки утягиваются полем в p+-область, а электроны дрейфуют к n+-области. Эта область называется слоем лавинного размножения. За его пределами дополнительных электронов не возникает. Таким образом, слой лавинного размножения является поставщиком электронов. При подаче на контакты диода переменного напряжения такого, что в течение положительного полупериода напряжение существенно больше, а в течение отрицательного — существенно меньше напряжения пробоя, ток в слое умножения приобретает вид коротких импульсов, максимум которых запаздывает по отношению к максимуму напряжения приблизительно на четверть периода (лавинное запаздывание). Из слоя умножения периодически выходят сгустки электронов, которые движутся через слой дрейфа в течение отрицательного полупериода, когда процесс генерации электронов в слое умножения прекращается. Движущиеся сгустки наводят во внешней цепи ток, почти постоянный в течение времени пролета. Таким образом, ток в диоде имеет вид прямоугольных импульсов. Этот режим работы диода называется пролётным (IMPATT-диоды). КПД этого режима не превышает 0,3. Если амплитуда переменного напряжения на диоде достигает значения, примерно равного пробивному напряжению, то в лавинной области образуется столь плотный объёмный заряд электронов, что напряжённость поля со стороны p+-области понижается практически до нуля, а в области базы повышается до уровня, достаточного для развития процесса ударной ионизации. В результате этого процесса слой лавинного умножения смещается и формируется в области базы на фронте сгустка электронов. Таким образом, в области дрейфа образуется движущаяся в направлении n+-области лавина, которая оставляет за собой большое количество электронов и дырок. В области, заполненной этими носителями, напряжённость поля понижается почти до нуля. Это состояние принято называть компенсированной полупроводниковой плазмой, а режим работы лавинно-пролетного диода — режимом с захваченной плазмой (TRAPATT-диоды). В этом режиме можно выделить три фазы. Первая — образование лавинного ударного фронта, прохождение его через диод, оставляя его заполненным плазмой, захваченной слабым электрическим полем. Ток, текущий через диод в этой фазе, существенно увеличивается из-за дополнительного размножения носителей в базе, а напряжение на диоде за счет образования плазмы снижается почти до нуля. Вторая фаза — период восстановления. База диода в этой фазе наполнена электронно-дырочной плазмой. Дырки из области базы дрейфуют к p+-области, а электроны — к n+-области со скоростью значительно меньшей, чем дрейфовая скорость насыщения. Плазма постепенно рассасывается. Ток в этой фазе остается неизменным. Наступает третья фаза, характеризуемая высоким значением напряжённости поля в диоде и предшествующая новому образованию лавинного ударного фронта. Наибольшую длительность имеет именно третья фаза. Процессы режима с захваченной плазмой протекают заметно дольше, чем процессы пролётного режима. Поэтому при работе в режиме с захваченной плазмой контур настраивают на меньшую частоту. КПД режима с захваченной плазмой при этом заметно выше КПД пролетного режима и превышает 0,5. Существует разновидность лавинно-пролётных диодов, работающих в инжекционно-пролётном режиме (BARITT-диоды). 24 Білет (Керея)
|
|||||||||
|
Последнее изменение этой страницы: 2016-08-16; просмотров: 327; Нарушение авторского права страницы; Мы поможем в написании вашей работы! infopedia.su Все материалы представленные на сайте исключительно с целью ознакомления читателями и не преследуют коммерческих целей или нарушение авторских прав. Обратная связь - 3.144.252.201 (0.061 с.) |
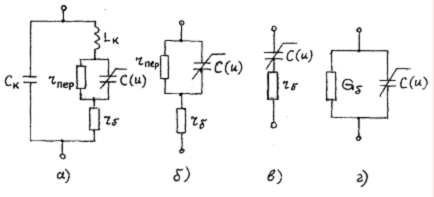






 может присутствовать или отсутствовать сигнал
может присутствовать или отсутствовать сигнал  , то есть принимаемый сигнал
, то есть принимаемый сигнал  , где случайная величина
, где случайная величина  может принимать значения 0 (сигнал отсутствует) или 1 (сигнал присутствует);
может принимать значения 0 (сигнал отсутствует) или 1 (сигнал присутствует); 
 и
и  — могут быть известны или нет.
— могут быть известны или нет. , а гипотезу о наличии сигнала —
, а гипотезу о наличии сигнала —  .
. и
и  известны, то можно использовать критерий минимума среднего риска (байесовский критерий)
известны, то можно использовать критерий минимума среднего риска (байесовский критерий)  :
: ,
, } — матрица потерь, а
} — матрица потерь, а  — функция правдоподобия выборки наблюдаемых данных, если предполагается истинность гипотезы
— функция правдоподобия выборки наблюдаемых данных, если предполагается истинность гипотезы  .
. сравнивается отношение правдоподобия
сравнивается отношение правдоподобия  :
: ,
, и
и  известны, то решение о наличии сигнала принимается на основе сравнения отношения апостериорных вероятностей
известны, то решение о наличии сигнала принимается на основе сравнения отношения апостериорных вероятностей  с некоторым пороговым значением
с некоторым пороговым значением 
 (2)
(2) (19)
(19)





 значительно больше 1. Применение таких сигналов позволяет бороться с помехами: многолучевость, улучшает э/м совместимость, повышает помехоустойчивость. При решение вопроса о выборе типа нужно учитывать среду.
значительно больше 1. Применение таких сигналов позволяет бороться с помехами: многолучевость, улучшает э/м совместимость, повышает помехоустойчивость. При решение вопроса о выборе типа нужно учитывать среду.



