
Заглавная страница Избранные статьи Случайная статья Познавательные статьи Новые добавления Обратная связь КАТЕГОРИИ: ТОП 10 на сайте Приготовление дезинфицирующих растворов различной концентрацииТехника нижней прямой подачи мяча. Франко-прусская война (причины и последствия) Организация работы процедурного кабинета Смысловое и механическое запоминание, их место и роль в усвоении знаний Коммуникативные барьеры и пути их преодоления Обработка изделий медицинского назначения многократного применения Образцы текста публицистического стиля Четыре типа изменения баланса Задачи с ответами для Всероссийской олимпиады по праву 
Мы поможем в написании ваших работ! ЗНАЕТЕ ЛИ ВЫ?
Влияние общества на человека
Приготовление дезинфицирующих растворов различной концентрации Практические работы по географии для 6 класса Организация работы процедурного кабинета Изменения в неживой природе осенью Уборка процедурного кабинета Сольфеджио. Все правила по сольфеджио Балочные системы. Определение реакций опор и моментов защемления |
Описание эффекта туннелирования. ⇐ ПредыдущаяСтр 2 из 2
Туннелирование в полупроводниках обладает рядом очень интересных особенностей, обусловленных в первую очередь тем, что электрические и магнитные свойства полупроводников можно менять в широких пределах, добавляя в них различные примеси. Кроме того, эффективные массы электронов в полупроводниках, как правило, значительно меньше массы свободного электрона, поэтому туннелирование здесь может происходить на более далекие расстояния, чем через вакуум или изолятор. Дело в том, что электроны в кристаллах движутся в периодической решетке ионов, взаимодействуя с ними и друг с другом. Поэтому, когда мы говорим о свободном, движении электрона, имеющего энергию в разрешенной зоне, это не значит, что электрон по-настоящему свободен. Он беспрепятственно переходит от узла кузлу в кристаллической решетке, но не все его характеристики совпа-дают с характеристиками свободного электрона. Так, заряд его остается преж-ним, однако зависимость между кинетической энергией Ек иимпульсом меня-ется. Если у электрона в пустоте Ек = р2 /(2m0), то для электрона в кристалле такая зависимость в общем не обязательна. Там же где она возможна, коэффициентпропорциональности между Ек и р2 равен 1/(2т*). Например, в полупро-воднике GaAs эффективная масса намного меньше массы свободногоэлектрона: m * = 0,066 m 0. Введение в полупроводник примесей приводит к появлению разрешенных уров-ней в запрещенной зоне, и между этими локальными уровнями и зонами кристалл-ла происходит обмен электронами. Примеси, которые приводят к образованию в полупроводнике уровней вблизи нижнего края зоны проводимости, называются донорными. Для кремния и германия донорами являются элементы V группы таб-лицы Менделеева: Р, As, Sb. Эти элементы пятивалентны. При замещенииодного из атомов Si (или Ge) в кристаллической решетке атомом, например As, только четыре из пяти валентных электронов этого атома оказываются связанными в решетке, а пятый электрон остается «лишним». Энергия связи этого электрона вкристалле невелика, и его уровень располагается вблизи нижней зоны границы проводимости (на расстоянии – 0,01 эВ). Вероятность перехода такого электрона в зону проводимости велика уже при обычных температурах, и поэтому полу-проводники с донорными примесями являются полупроводниками n -типа.
Если локальные уровни примесей расположены внизу з апрещенной зоны (вблизи границы валентной зоны), то часть электронов валентной зоны переходят на эти уровни. При этом в валентной зоне появляются дырки и возникает дыроч-ная проводимость – проводимость р -типа. Атомы примесей, вызывающих появле-ние проводимости р -типа, называются акцепторными. Для кремния и германия акцепторами являются элементы III группы - В, Al, Ga, In. У этих атомов не хва-тает одного электрона для образования ковалентной связи счетырьмя бли-жайшими атомами Si (или Ge). Поэтому, например, при замещении одного из атомов Si (или Ge) атомом В, недостающий электрон можно «позаимствовать» у атома Si. Разорванная связь представляет собой дырку, т.к. она отвечает образованию в валентной зоне Si вакантного состояния. Расстояние локальных уровней такого типа от краев запрещенной зоны составляет примерно 0,01 эВ, так что при комнатной температуре, которой соответствует энергия теплового возбуждения 0,025 эВ, происходит как практически полная ионизация донорных уровней, таки заполнение акцепторных уровней. Что произойдет, если очень близко друг к другу поместить р- и п- области полу-проводника с равными концентрациями акцепторов и доноров соответственно? Можно показать, что ширина р-n -перехода d зависит от высоты потенциального барьера eφк (φк. - контактная разность потенциалов) и определяется концент-рацией донорной и акцепторной примеси N (N = nn = pp) - чем больше примесей, тем уже переход:
где ε0 – диэлектрическая проницаемость вакуума; ε – диэлектрическая проницаемость материала полупроводника; е – заряд электрона; φк – контактная разность потенциалов; N – концентрация примесей. В сильно легированных полупроводниках ширина перехода может составлять около 100 Å. При малых уровнях легирования (1014 –1017см-3) полупроводник не вырожден, и уровень Ферми лежит в запрещенной зоне. Когда концентрация примеси превы-шает эффективные плотности состояний, уровень Ферми перемещается в валент-ную зону (в случае акцепторной примеси) либо в зону проводимости (при донор-ной примеси). Такой полупроводник считается вырожденным. Например, в гер-мании и кремнии n -типа вырождение начинается при концентрации доноров по-рядка 2×1019см-3 и 6×I019см-3 соответственно (собственные концентрации носи-телей в чистом германии и кремнии составляют 2,5x1013см-3 и 1,5x1010см3). В туннельном диоде качественно меняется вид электронного спектра полупро-водника (см. рис. 1(а)). У полупроводника n- типа на дне зоны проводимости появилась целая полоса, занятая электронами, а в р– полупроводнике образова-лась полоса свободных состояний у потолка валентной зоны. Сильно легирован-
ный полупроводник стал полуметаллом. У всей системы образовался единый уровень Ферми – единая граница свободных состояний.
В сильно легированных полупроводниках в области узкого р-п- перехода стано-вятся возможными туннельные переходы электронов, поэтому такие диоды называются туннельными (туннельный диод был изобретен в 1957 г. японским физиком Л.Эсаки). Для того, чтобы туннельный ток при небольших напряжениях имел достаточ-ную дляизмерения величину, необходимо, чтобы р-п- переходбыл достаточно узким и с обеих сторон перехода имелись изоэнергетическиеуровни, между кото-рыми возможны туннельные переходы. Для этого как р-, так и n -области диода должны быть вырожденными. Необходимость этих условий становится понятной из рассмотрения энергетической диаграммы туннельного диода при различныхнапряжениях смещения, приведенной на рис. 1. В вырожденном полупроводнике уровень Ферми лежит, как уже отмечалось, в разрешенной зоне, в полупроводнике n -типа - в зоне проводимости, в полупровод-нике p -типа — в валентной зоне. Расстояние от уровня Ферми до краев зон обозначим соответственно через x =EFn - Ec и h=EFp - Еv. Для качественного рассмотрения будем считать, что все состояния, лежащие ниже уровня Ферми, заполнены электронами (на рисунке они заштрихованы), а выше — свободны. При отсутствии внешнего поля на р-n -переходе (рис. 1а) уровни Ферми EFn и EFp лежатна одной горизонтали, перекрытия свободных и занятых уровней в Приложим к туннельному диоду внешнее поле в прямом направлении, т.е. минус к n -области, а плюс к p -области. В этом случае внешнееполе противопо-ложно внутреннемув р-n -переходе. По мере увеличения приложенного напряже-ния смещение зон уменьшается (рис. 1(б)) ичасть занятых состояний в n -области перекрывается с незанятыми состояниями в р -области. Электроны туннелируютиз n -области в р -область, ток возрастает пропорционально как вероятности туннелирования,так и плотности занятых состояний в n -области и незанятых состояний в р -области. При дальнейшемувеличении разности потенциалов перекрытие уровней справа и слева достигает максимума, и ток через диод максимален (рис. 1(б)). Затем часть занятых состояний в n -области начинает перекрываться с запрещенной зоной р -области (рис. 1(в)), для электронов на этих уровнях прямое туннелирова-ние уменьшается, число переходов ограничивается, ток через диод спадает. Нако-нец, дно зоны проводимости справа поднимется настолько, что попадет в область энергий запрещенной зоны слева и электронам некуда переходить
При обратном напряжении на р-n -переходе (рис. 1(е)) уровень Ферми EFp в р -области смещается вверх относительно, уровня EFn в п- области на величину внешнего напряжения, при этом против заселенных состояний в p -области появляются свободные уровни в n -области. Электроны p-полупроводника туннелируют в n -полупроводник, и через р-n -переход течет ток,обусловленный неосновными носителями заряда, в цепи диода пойдет ток в обратном направлении. Так получается вольтамперная характеристика идеального тун-нельного диода, изображенная на рис. 1(ж). Реальная волът-амперная характеристика отличается от изображенной на рис. 1 (ж). Экспериментально полученная характеристика германиевого туннель-ного диода приведена на рис.2. Она характеризуется следующими основными параметрами: 1)величиной напряжения Up, которое соответствует максимуму(пику) тока I p; 2)величиной напряжения U v при минимальной величине тока I V; 3)величиной напряжения Uf (| Uf | > |Uv|), при котором ток через диод равен Iр. Эти параметры используются для выбора режима работы туннельногодиода, в конкретных электрических схемах и обычно приводятся в справочниках. Особенностью реальной характеристики является наличие тока на участке меж-ду туннельной и диффузионной ветвями. Основной причиной существования отличного от нуля тока I v является образование примесных зон из-за большой концентрации донорных центров в п- пoлупроводнике и акцепторных центров в
Параметры вольтамперной характеристики определяются свойствами полу-проводниковых материалов, из которых изготовлен туннельный диод, поэтому сведения о них можно получить, исследуя конкретную вольтамперную характе-ристику. Для этого нужно найти связь между функцией распределения носите-лей заряда в зонах, смещенных под действием приложенного напряжения, и экстремальными точками характеристики. При качественном рассмотрении вольтамперной характеристики (рис.1) мы по-лагали, что выше уровня Ферми электронов нет. В действительности при конеч-ной температуре Т распределение Ферми f(е) размывается на величину порядка тепловой энергии 2кБТ. Кроме того, плотность энергетических состояний g (E)неодинакова в зоне: вблизи границы зоны уровни располагаются реже. Поэтому плотность заполнения носителями заряда уровней энергетической зоны (число частиц на единичный интервал энергии) описывается функцией распределения - n(E)=f(E)g(E). (1)
Если оба полупроводника вырождены одинаково, что практически соответст-вует действительности, то
Напряжение Up соответствует пику тока Iр, при котором смещение энергети-ческих зон должно быть одинаково, чтобы точки а и б на графиках п (Е)и р (Е)оказались на одной горизонтали. Это дает возможность определить, как видно из рис. 3, энергетический промежуток между уровнем Ферми Еп = Еp и максимумом плотности границы зоны проводимости nmax= f (E), отсчитываемым так же, как и E n, от границы зоны проводимости:
Напряжение Uf,характеризующее растр вольтамперной характеристики, опре-деляется в основном шириной запрещенной зоны в полупроводниках диода. Это хорошо видно из вольтамперных характеристик, изображенных на рис. 2: напря-жение Uf для каждого из диодов отличается во столько раз, во сколько раз отличается ширина запрещенной зоны полупроводников. Что примечательного в вольтамперной характеристике туннельного диода? В интервале напряжений от Up до Uv ток падает с увеличением напряжения, т.е. на этом, участке дифференциальное сопротивление d U/ d I отрицательно. Если на диоде поддерживать напряжение между Uf и UV, то диод работает как активный, а не пассивный элемент цепи. Включение в цепь пассивного элемента (элемента с обычным положительным сопротивлением) приводит к затуханию колебаний в цепи, а активный элемент в цепи способствуетраскачке колебаний. Туннельный диод можно сделать очень малых размеров, он мало инерционен и поэтому явля-ется идеальным элементом для микроволновых генераторов.
Особенности эксперимента При снятии вольтамперной характеристики и определении параметров туннельного диода ( рис.4) ток измеряется миллиамперметром, включенным последовательно с туннельным дио-дом, а напряжение на диоде измеряется цифровым вольтметром. Питание схемы осуществляется от источника напряжения с малым внутренним сопро-тивлением. Регулирование тока через диод производится переменным сопротивлением R. Ключи К1, и К2 используются при уточнении основных параметров диода.
Быстрее и нагляднее, но с меньшей точностью можно измерить характеристику диода с помощью осциллографа и мостовой схемы, изображенной на рис. 5.Результаты эксперимента В эксперименте, изучалась вольтамперная характеристика туннельного диода. В качестве исследуемого диода был использован германиевый туннельный диод - ГИ304А.
|
|||||||||||||||
|
Последнее изменение этой страницы: 2016-04-26; просмотров: 130; Нарушение авторского права страницы; Мы поможем в написании вашей работы! infopedia.su Все материалы представленные на сайте исключительно с целью ознакомления читателями и не преследуют коммерческих целей или нарушение авторских прав. Обратная связь - 3.19.31.73 (0.029 с.) |
 ,
,
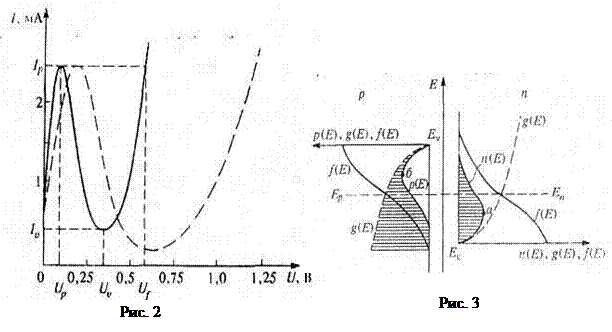 Ее график изображен на рис. 3 как для электронов, так и для дырок. Из приведен-ной схемы видно, что на рисунке отражен случай, когда, уровень Ферми в полу-проводниках отстоит от краев зон на величину EF @ EFn @ EFp @ кБТ. Если на такой
Ее график изображен на рис. 3 как для электронов, так и для дырок. Из приведен-ной схемы видно, что на рисунке отражен случай, когда, уровень Ферми в полу-проводниках отстоит от краев зон на величину EF @ EFn @ EFp @ кБТ. Если на такой  (2)
(2) (3)
(3) (4)
(4)



