
Заглавная страница Избранные статьи Случайная статья Познавательные статьи Новые добавления Обратная связь КАТЕГОРИИ: ТОП 10 на сайте Приготовление дезинфицирующих растворов различной концентрацииТехника нижней прямой подачи мяча. Франко-прусская война (причины и последствия) Организация работы процедурного кабинета Смысловое и механическое запоминание, их место и роль в усвоении знаний Коммуникативные барьеры и пути их преодоления Обработка изделий медицинского назначения многократного применения Образцы текста публицистического стиля Четыре типа изменения баланса Задачи с ответами для Всероссийской олимпиады по праву 
Мы поможем в написании ваших работ! ЗНАЕТЕ ЛИ ВЫ?
Влияние общества на человека
Приготовление дезинфицирующих растворов различной концентрации Практические работы по географии для 6 класса Организация работы процедурного кабинета Изменения в неживой природе осенью Уборка процедурного кабинета Сольфеджио. Все правила по сольфеджио Балочные системы. Определение реакций опор и моментов защемления |
Определение ширины запрещенной зоны полупроводников из измерений температурной зависимости удельной электропроводности
ЛАБОРАТОРНАЯ РАБОТА №1 ОПРЕДЕЛЕНИЕ ШИРИНЫ ЗАПРЕЩЕННОЙ ЗОНЫ ПОЛУПРОВОДНИКОВ ИЗ ИЗМЕРЕНИЙ ТЕМПЕРАТУРНОЙ ЗАВИСИМОСТИ УДЕЛЬНОЙ ЭЛЕКТРОПРОВОДНОСТИ Цель работы 1) Изучение основ зонной теории твердого тела, статистики носителей заряда в полупроводниках и механизмов рассеяния электронов и дырок в полупроводниках. 2) Изучение температурной зависимости удельной электропроводности полупроводников в области собственной проводимости и примыкающей к ней области примесной проводимости (интервал температур 300 K - 490 К). 3) Определение ширины запрещенной зоны полупроводника.
Теоретические сведения Зонная теория твердых тел Энергия Е и импульс
где m — масса свободного электрона; Энергетический спектр электрона в изолированном атоме - дискретный. Состояние электрона в изолированном атоме может быть описано четвёркой квантовых чисел: - главным n, - орбитальным l, - магнитным me, - спиновым ms. Согласно принципу Паули в атоме не может существовать двух или более электронов с одинаковой четвёркой квантовых чисел. Физические свойства твёрдых тел тесно связанны со структурой валентных оболочек атомов. В идеальном кристалле атомы расположены строго в узлах пространственной решетки. При образовании кристалла из изолированных атомов их электронные оболочки перекрываются, что приводит к расщеплению дискретных энергетических уровней в разрешенные энергетические зоны, отделённые друг от друга запрещёнными зонами (рис. 1). Число энергетических уровней в разрешенной зоне для кристаллов с простой кристаллической структурой равно числу атомов в кристалле N. В отличие от свободного электрона у электрона, находящегося в периодическом поле кристалла, скорость и импульс меняются от точки к точке в весьма широких пределах. Однако если учесть периодический характер потенциала, то из закона сохранения энергии вытекает, что среднее значение скорости и импульса сохраняют в отсутствие внешних полей постоянные значения.
Учитывая это, можно для электрона в кристалле ввести по аналогии со свободным электроном понятие квазиимпульса, определив его следующим соотношением.
где Компоненты векторов
где Lx, Ly, Lz – размеры кристалла; nх,nу,nz = 0, ±1, ±2, ±3... -целые числа. Вместе со спином они образуют четвёрку квантовых чисел, характеризующих состояние электрона в кристалле: kx, ky,kz,ms.
Рис.1. Образование энергетических зон в кристалле из атомных энергетических уровней: x - расстояние между соседними атомами a- параметр решетки. Энергия электрона в кристалле определяется его квазиимпульсом. Нахождение зависимости Вблизи экстремумов энергии (у потолка и дна разрешенной зоны) функцию
Выражение (3) можно переписать в виде, подобном выражению(1) для свободного электрона, если ввести понятие эффективной массы
При этом выражение (3) примет вид:
Эффективная масса для одномерного случая является скаляром, а в общем случае - тензором второго ранга. Эффективная масса отражает тот факт, что на электрон в кристалле, кроме внешних сил, действует внутренние силы со стороны периодического потенциала кристаллической решетки. При движении электрона в кристалле может случиться, что его потенциальная энергия уменьшиться, а, следовательно, его кинетическая энергия станет больше работы сил поля (в кинетическую энергию перейдёт часть потенциальной энергии). В этом случае электрон будет вести себя как очень лёгкая частица, т.е. частица с массой, меньше массы свободного электрона. Может быть и так, что увеличение потенциальной энергии будет больше работы внешних сил, то есть в потенциальную энергию перейдет часть кинетической - скорость электрона уменьшится, и он будет вести себя как частица с отрицательной массой. Из сказанного следует, что эффективная масса совершенно не обязательно должна быть равной массе свободного электрона.
Согласно зонной теории проводимость кристаллов определяется структурой и заполнением энергетических зон.
Рис.2 Структура энергетических зон германия, кремния и арсенида галлия. В электрическом поле электрон ускоряется и увеличивает энергию. На энергетической диаграмме это соответствует переходу электрона на более высокий энергетический уровень. Однако если все уровни в зоне будут заполнены электронами, такие переходы запрещаются принципом Паули. Следовательно, электроны полностью заполненной зоны не могут принимать участия в электропроводности. В металлах при любой температуре, в том числе и при температуре абсолютного нуля, самая верхняя разрешенная зона, содержащая электроны, заполнена не полностью. Поэтому материалы являются хорошими проводниками. В полупроводниках и диэлектриках при температуре абсолютного нуля наивысшая зона, содержащая электроны и называемая валентной зоной, полностью заполнена. В этом случае полупроводники и диэлектрики не могут проводить электрический ток.
Рис.3. Схема заполнения энергетических зон в диэлектрике и полупроводнике Следующая за валентностью зона, называется зоной проводимости, при температуре абсолютного нуля пуста. Электроны могут попасть в зону проводимости из валентной зоны только преодолев запрещённую зону шириной D Е = EC - EV (рис. 2, 3). Вероятность такого перехода пропорциональна После ухода электрона из валентной зоны она становится не полностью заполненной и, следовательно, способной участвовать в электропроводности. Оказывается, что поведение всей совокупности электронов валентной зоны с одним удалённым электроном эквивалентно поведению одного положительного заряда, который называется дыркой. Эффективная масса дырки m p положительна и равна эффективной массе электрона, который занимал вакантное место в валентной зоне. Таким образом, проводимость полупроводников обусловлена электронами зоны проводимости и дырками валентной зоны. Собственный полупроводник В собственном полупроводнике электроны и дырки возникают и исчезают всегда парами, поэтому концентрации электронов п и р равны:
где ni -собственная концентрация. Собственная концентрация определяет собственную удельную электропроводность полупроводника при заданной температуре
где е - заряд электрона; mn и mр - подвижности соответственно электронов и дырок, представляющие собой скорости их дрейфа в единичном электрическом поле. В табл. 1 приведены значения ширины запрещенной зоны и собственной концентрации для наиболее важных полупроводников при комнатной температуре. Таблица 1 Ширина запрещённой зоны и собственная концентрация некоторых полупроводников при комнатной температуре
Примесный полупроводник При рассмотрении собственного полупроводника предполагалось, что его кристаллическая структура идеальна, то есть атомы располагаются точно в узлах пространственной решетки. Зонная теория твёрдого тела показывает, что всякое нарушение периодического потенциала решетки кристалла приводит к возникновению локальных энергетических уровней в запрещенной зоне. Таким нарушением кристаллической структуры могут быть атомы примесей, вакансии, дислокации и др.
Полупроводниковые материалы любой степени очистки всегда содержат атомы примеси, которые создают собственные энергетические уровни, получившие название примесных уровней. Они могут располагаться как в разрешенных, так и в запрещенных зонах. Во многих случаях примеси вводят специально, для придания полупроводнику необходимых свойств. Пусть в кристалле кремния один атом полупроводника замещён атомом примеси V-ой группы периодической таблицы Менделеева, например мышьяком (рис.4, а).
Рис.4 а), б). Образование свободных («примесных») электронов проводимости при ионизации донорной примеси в кремнии. Атом мышьяка имеет пять валентных электронов. Четыре из них образуют прочные ковалентные связи с четырьмя ближайшими атомами кремния. Связь пятого валентного электрона с атомом мышьяка существенно ослабляется из-за влияния окружающих атомов кремния. Это приводит к уменьшению энергии, необходимой для отрыва валентного электрона от атома фосфора примерно в 1/ e раз (e - диэлектрическая проницаемость полупроводника). На зонной диаграмме энергетический уровень этого электрона располагается вблизи дна зоны проводимости и называется донорным уровнем ED (рис.4 б). Для ионизации атома мышьяка теперь требуется энергия, равная D ED = ЕC – ED, по порядку величины составляющая сотые доли электрон-вольт. Эта энергия сравнима с величиной средней тепловой энергии решетки при комнатной температуре кТ= 0,025 эВ. Поэтому под действием тепловых колебаний решетки электрон может перейти с донорного уровня в зону проводимости, создавая примесную электронную проводимость. Атомы примеси 3 группы периодической таблицы, например бор, создают на зонной диаграмме акцепторные энергетические уровни ЕA, расположенные вблизи потолка валентной зоны (рис. 4 в). Величина энергии ионизации акцепторной примеси D ЕA = ЕA - EV также составляет сотые доли электрон-вольт, поэтому электроны из валентной зоны могут переходить на акцепторные уровни под действием тепловой ионизации (рис.4 г). Это приводит к образованию свободных дырок в валентной зоны и примесной проводимости.
Рис.4 в), г). Образование свободных («примесных») дырок проводимости при ионизации акцепторной примеси в кремнии. Примеси, создающие донорные уровни в полупроводнике, называются донорами, создающие акцепторные уровни ― акцепторами (табл.2).
Если в полупроводнике преобладает донорная примесь (ND >> NA) концентрация электронов в зоне проводимости оказывается много больше концентрации дырок в валентной зоне: n >> p. Такой полупроводник называется электронным, или полупроводником n –типа проводимости, а его удельная электропроводность определяется следующим соотношением.
Таблица 2 Энергии ионизации наиболее важных примесей в кремнии и германии
В полупроводнике с преобладанием акцепторной примеси, наоборот, p>>n. Такой полупроводник называется дырочным, или полупроводником р-типа проводимости, а его удельная электропроводность равна
Носители, определяющие тип проводимости полупроводника, называются основными, а носители противоположного знака - не основными. Вырожденный и невырожденный полупроводники. В состоянии термодинамического равновесия электронный газ в полупроводнике в общем случае подчиняются статистике Ферми - Дирака. При этом вероятность того, что состояния с энергией Е занято электроном, выражается следующей формулой.
где EF - энергия Ферми, или уровень Ферми. Легко видеть, что при Е = EF величина f = 0,5; следовательно, энергия Ферми - это энергия такого состояния, вероятность заполнения которого равна 0,5 при любой температуре. На рис.5 представлена функция распределения Ферми- Дирака для двух температур.
Рис.5. Функция распределения Ферма - Дирака при T = 0 K и при T >0 K При температуре абсолютного нуля функция Ферми-Дирака равна единице вплоть до энергии EF, после чего она скачком падает до нуля. Это значит, что все состояния с энергиями ниже уровня Ферми заняты, а все состояния с более высокими энергиями свободны, вероятность их заполнения равна нулю. При повышении температуры резкая ступенька около энергии EF начинает «расплываться», притом тем больше, чем выше температура. Размер области размытия dE составляет величину порядка кТ. Как уже упоминалось, общее число уровней в любой из разрешенных зон равно числу атомов в кристалле и составляет примерно 1·1022 см-3. Число же свободных электронов в полупроводниках обычно колеблется в пределах 1·1012 – 1·1018 см-3. Это означает, что доля занятых состояний в зоне проводимости, как правило, ничтожно мала, то есть обычно f <<1. Из формулы (10) следует, что
В этом случае функция распределения Ферми - Дирака переходит в функцию распределения Максвелла - Больцмана:
Электронный газ, подчиняющийся статистике Максвелла - Больцмана, называется невырожденным. Для электронов в зоне проводимости распределение (12) справедливо, если уровень Ферми располагается ниже дна зоны проводимости на величину не менее З кТ. Аналогично можно показать, что дырочный газ не вырожден, если уровень Ферми расположен выше потолка валентной зоны на величину не менее З кТ.
Рис.6. Функция распределения Ферми – Дирака при T >0 K, наложенная на энергетическую диаграмму полупроводника Полупроводник называется не вырожденным, если в нём не вырождены как электронный, так и дырочный газ. Уровень Ферми в таком полупроводнике расположен в запрещенной зоне внутри интеграла энергии от E V+З кТ до ЕC - З кТ. Если уровень Ферми оказался вне этого интервала, функцию распределения Ферми - Дирака уже нельзя заменить функцией распределения Максвелла-Больцмана. Полупроводники называются полностью вырожденными, если уровень Ферми заходит в глубь зоны проводимости (для электронного полупроводника) или в глубь валентной зоны (для дырочного полупроводника) Боле, чем на 5 кТ. На рис.6 функция Ферми - Дирака изображена непосредственно на схеме энергетических уровней полупроводника. Параметр EFпоказывает, как нужно располагать функцию fотносительно энергетических уровней системы. Концентрация электронов и дырок Зная функцию распределения электронов и дырок и плотности квантовых состояний в зоне проводимости и валентной зон, можно вычислить концентрации электронов и дырок. Для невырожденного полупроводника расчёт даёт:
где
Таблица 3
Величины mC и mV называются эффективными массами плотности состояний соответственно электронов и дырок. Они определяются эффективными массами электронов и дырок и структурой энергетических зон полупроводника. Перемножая концентрации электронов (6) и дырок (7), получим
Таким образом, произведение концентраций электронов и дырок в невырожденном полупроводнике есть величина постоянная при данной температуре. Она не зависит от концентрации легирующих примесей и является характеристикой данного полупроводника. Её величину можно найти, рассмотрев частный случай собственного полупроводника. Полагая
Температурная зависимость концентрации носителей Рассмотрим температурную зависимость концентрации основных носителей на примере полупроводника n –типа проводимости. Свободные электроны в полупроводнике п – типа проводимости возникают благодаря их переходам из валентной зоны в зону проводимости, что приводит образованию р свободных дырок, и с уровней донорной примеси, благодаря чему возникает ND+ ионов доноров (рис.7).
При Т > 0 К эти два процесса играют неодинаковую ролью Для перевода электрона из валентной зоны в зону проводимости необходима энергия, равная ширине запрещенной зоны D Е порядка 0,5 - 2,5 эВ, в то время, как для перевода электрона с уровня примеси необходима, энергия равная энергии ионизации примеси ED = ЕC - ED порядка 0,05 эВ. Что значительно меньше ширины запрещенной зоны D Е. Температурная зависимость концентрации электронов представлена на рис.8. Для её изображения выбран наиболее рациональный логарифмический масштаб по оси ординат и обратная температура по оси абсцисс. В таком представлении участки экспериментального изменения концентрации с температурой выглядит прямыми линиями, наклон которых определяется соответствующими энергиями активации. При низких температурах основную роль играют переходы электронов с примесного уровня, переходами электронов из валентной зоны можно пренебречь. Эта область температур называется областью ионизации примеси. Как показывает расчет, в этой области концентрация электронов растёт экспоненциально. Из наклона прямой на этом участке зависимости ln(n) = f(1/T) можно определить энергию активацию примеси ED.
Рис.7. Тепловая генерация носителей заряда в полупроводнике с донорной примесью
Рис.8. Температурная зависимость концентрации электронов в n-германии с концентрацией доноров ND =1.5·1015 см-3. 1 – область ионизации примеси, 2 – область истощения примеси, 3 – область собственной проводимости Рост концентрации электронов продолжается до температуры TS, называемой температурой истощения примеси. По достижении этой температуры вся примесь оказывается полностью ионизированной. В то же время переходами электронов из валентной зоны всё ещё можно пренебречь. Поэтому в области температур от TS до TI, называемой областью истощения примеси, концентрация электронов остаётся постоянной, равной концентрации донорной примеси: n = ND. Температура TI называется температурой перехода к собственной проводимости.
Следует отметить, что концентрация дырок в области истощения примеси не остаётся постоянной, а увеличивается в соответствии с выражениями (16) и (17).
По достижении температуры TI концентрации дырок и электронов сравниваются. При температурах, больших TI, можно пренебречь концентрацией электронов, перешедших с донорных уровней в зону проводимости. Основную роль играют переходы из валентной зоны, и полупроводник становится собственным: n = p = ni и температурная зависимость концентрации в области собственной проводимости описывается выражением (17). Температурная зависимость подвижности носителей заряда В идеальном кристалле электроны и дырки свободно движутся и не сталкиваются друг с другом и с атомами полупроводника. В реальном кристалле всегда имеются нарушения периодичности решетки - центры рассеяния. При взаимодействии с центром рассеяния электроны и дырки изменяют направление движения. После столкновения носители зарядов остаются в той же зон, то есть их концентрация не меняется. Наиболее эффективными центрами рассеяния электронов и дырок в кристаллах являются ионы примесей и тепловые колебания атомов решетки. При низких температурах преобладает рассеяние на ионизированных атомах примеси. Для z - кратно заряженных ионов примеси подвижность следующим образом зависит от температуры.
где mIO – коэффициент При рассеянии на тепловых колебаниях решетки подвижность уменьшается с ростом температуры следующим образом.
где mTO - коэффициент, не зависящий от температуры. Общий вид зависимости, обусловленной комбинациями обоих типов рассеяния, показан на рис.9. Чем больше концентрация заряженных центров в полупроводнике, тем при более высоких температурах происходит переход от рассеяния на ионизированных атомах примеси к рассеянию на тепловых колебаниях решетки. Уже при достаточно низких температурах в полупроводниках начинает преобладать рассеяние носителей на тепловых колебаниях решетки и зависимость подвижности от температуры обратно пропорциональна абсолютной температуре в степени p. Как следует из результатов экспериментальных исследований, у большинства полупроводников показатель степени p не равен теоретическому значению -3/2. В таблице 4 приведены значения показателя p для различных полупроводниковых материалов (m ~ Tp). Отличие показателя p от -3/2 может быть объяснено тем, что в реальных полупроводниках рассеяние носителей заряда происходит не только на акустических фононах. Могут иметь место и другие механизмы рассеяния, такие как рассеяние на оптических фононах, двухфононное рассеяние, рассеяние на носителях заряда.
Рис.9. Типичные температурные зависимости подвижности электронов в кремнии n-типа проводимости; ND1 < ND2 < ND3 Таблица 4
Температурная зависимость удельной электропроводности Зависимость электропроводности полупроводника от температуры s(Т) определяется температурными зависимостями концентрации основных носителей (для определенности, электронов) n(T) (рис.8) и их подвижности m(T) (рис. 9).
В области истощения примеси концентрация электронов постоянна, поэтому ход кривой s(Т) определяется только зависимостью m(T). Если провести достаточно точные измерения температурной зависимости удельной электропроводности в области истощения примеси, то по этой зависимости в некоторых случаях можно определить вид полупроводникового материала. Например, легко можно отличить кремний n-типа проводимости от германия n-типа проводимости. На рис.10 представлены зависимости удельной электропроводности кремния n-типа проводимости от обратной температуры в широком диапазоне температур и в диапазоне температур от комнатной температуры до T =300 ºC. В области собственной проводимости, где концентрация экспоненциально растёт с температурой, можно пренебречь слабой зависимостью m(T). В этой области ход кривых s(Т) и п(Т) различается незначительно, что позволяет использовать температурную зависимость электропроводности в области собственной проводимости для определения ширины запрещенной зоны полупроводника. Используя выражения (3) и (9), электропроводность полупроводника в области собственной проводимости можно записать в виде
где b=mn/mp.
Рис.10. Расчетная зависимость удельной электропроводности n-кремния от обратной температуры Величина (NCNV) 1/2 пропорциональна Т 3/2. Предположим, что зависимости подвижности электронов и дырок от температуры одинаковы. Поскольку в области собственной проводимости преобладает рассеяние на тепловых колебаниях решетки, величина mp пропорциональна Т -3/2. В результате si(T) ; можно записать в виде
где С - некоторая константа. Прологарифмировав обе части уравнения (25) получим линейную зависимость логарифма удельной электропроводности от обратной температуры.
Температурная зависимость ширины запрещенной зоны Величина D Е, вычисленная по формуле (26), даёт истинное значение ширины запрещённой зоны лишь при D Е =const. В действительности D Е зависит от температуры. Эта зависимость определяется сложным комплексом причин, обусловленных статическими и динамическими факторами. К уменьшению ширины запрещенной зоны может приводить рост амплитуды тепловых колебаний атомов кристаллической решетки и увеличение расстояний между атомами при термическом расширении кристалла. Учесть строго эти факторы невозможно, поэтому зависимость ширины запрещенной зоны от температуры находят эмпирически. Ширина запрещенной зоны линейно зависит от температуры при температурах выше комнатной и квадратично при низких температурах (рис.11). Для линейного участка (при температурах выше комнатной) зависимость D Е(Т) можно представить в следующем виде
где D Е0 - ширина запрещенной зоны, полученная экстраполяцией линейной зависимости к абсолютному нулю; g - температурный коэффициент. Величины D Е (З00 K), D Е (0 K) и g для основных полупроводников приведены в табл.3. Подставляя зависимость (27) в выражение (26) получаем
Или
В координатах Ширина запрещённой зоны определяется из значений производной функции ln(si) по 1/ T.
Окончательно ширина запрещённой зоны (в эВ), полученная экстраполяция к абсолютному нулю, равна:
где Для нахождения ширины запрещённой зоны при комнатной температуре необходимо воспользоваться формулой (27).
Рис.11. Температурная зависимость ширины запрещенной зоны германия Наиболее точно ширину запрещённой зоны при любой температуре определяют экспериментально с помощью оптических методов, основанных на исследовании спектральных зависимостей поглощения, фотопроводности и люминесценции.
Экспериментальная часть: Методика выполнения работы 1. Образец для измерений Измерение зависимости s (T)проводят наобразце Ge, который схематично показан на рис.13. Образец представляет собой брусок германия n-типа проводимости. Металлизированные контакты I и IV служат для пропускания тока вдоль образца, контакты II и III - для измерения падения напряжения на участке образца. Размеры образца: c =4 мм, d =4 мм, l =5.5 мм.
2. Описание лабораторной установки Блок-схема макета лабораторной установки для измерения температурной зависимости удельной электропроводности полупроводника представлена на рис.13. Измерения сопротивления образца производится четырехконтактным методом. Макет измерительной установки состоит из следующих блоков. 1. Управляющий компьютер. 2. Источник напряжения постоянного тока Agilent E3434A, служащий для задания тока через резистивный нагреватель в измерительной камере (Н). Источник управляется компьютером через интерфейс PCI – GPIB, NI-488.2 фирмы «National Instruments». 3. Источник напряжения постоянного тока Agilent E3434A, служащий для задания тока через контакты I и IV образца. Источник управляется компьютером через интерфейс PCI – GPIB, NI-488.2 фирмы «National Instruments». 4. Коммутатор, служащий для изменения направления тока через образец и стабилизации его в процессе измерений. Коммутатор управляется компьютером через интерфейс LPT. Резистор R в коммутаторе служит для поддержания тока через образец постоянным в процессе изменения температуры образца. 5. Вольтметр Agilent E34405A, контролирующий падение напряжения на образце (контакты II и III). Вольтметр управляется компьютером через интерфейс USB. 6. Вольтметр Agilent E34405A, контролирующий ток через образец (контакты I и IV). Вольтметр управляется компьютером через интерфейс USB. 7. Вольтметр Agilent E34405A, контролирующий напряжение термопары (ТП). Вольтметр управляется компьютером через интерфейс USB. 8. Термокамера, в которой размещены резистивный нагреватель образца Н и термопара ТП, подключенные к соответствующим выводам. Внутри камеры установлен измеряемый образец, который подключен к четырем выводам из камеры. Спай термопары прижат к поверхности образца.
3. Подготовка к проведению измерений 1) Проверьте по блок-схеме правильность соединения блоков макета установки. 2) Включите вольтметры и источники напряжения и дайте им прогреться в течение примерно 5 мин. Все приборы после включения должны пройти самотестирование. 3) Включите управляющий компьютер. После его включения загружается программа соединения блоков макета установки с компьютером «Agilent Connection Expert». 4) 5) После запуска этой программы на экране видеомонитора появится окно, содержащее главное меню (рис.15). 4. Главное меню служит для выбора одной из четырех опций, которым соответствуют четыре меню первого уровня. 1) Опция «Имитация» предназначена для проведения имитационных измерений зависимости удельной электропроводности в диапазоне температур от комнатной до температуры 470 К обеспечивает следующее: - ввод исходных данных об образце и режиме имитационного измерения температурной зависимости удельной электропроводности; - собственно имитационное измерение; - вывод результатов измерения в графическом виде; - обработку результатов измерения; - запись данных в файл. 2) Опция «Помощь», служит для ознакомления с целью проведения лабораторной работы, основными теоретическими сведениями и методикой проведения измерений. 3) Опция «Измерения» предназначена для проведения реальных измерений удельной электропроводности в диапазоне температур от комнатной температуры до температуры 490 К обеспечивает следующее: - ввод исходных данных об образце и режиме измерения температурной зависимости удельной электропроводности; - температурной зависимости удельной электропроводности; - собственно измерение; - вывод результатов измерения в графическом виде; - обработку результатов измерения; - запись данных в файл.
|
||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
Последнее изменение этой страницы: 2016-04-26; просмотров: 2078; Нарушение авторского права страницы; Мы поможем в написании вашей работы! infopedia.su Все материалы представленные на сайте исключительно с целью ознакомления читателями и не преследуют коммерческих целей или нарушение авторских прав. Обратная связь - 3.147.104.248 (0.112 с.) |
 свободного электрона могут принимать любые значения. В отсутствии внешних сил они сохраняют свою величину, то есть являются интегралами движения. Связь энергии с импульсом определяется следующим выражением.
свободного электрона могут принимать любые значения. В отсутствии внешних сил они сохраняют свою величину, то есть являются интегралами движения. Связь энергии с импульсом определяется следующим выражением. ,
,
 - волновой вектор электрона;
- волновой вектор электрона;  = - постоянная Планка, делённая на 2 p.
= - постоянная Планка, делённая на 2 p. ,
,
 , h =6.62∙10-34 Дж∙с - постоянная Планка,
, h =6.62∙10-34 Дж∙с - постоянная Планка, 



 или
или  является основной задачей зонной теории.
является основной задачей зонной теории. .
.
 , определив её следующим соотношением.
, определив её следующим соотношением. .
.
 .
.


 и поэтому сильно зависит от ширины запрещённой зоны и температуры. Это позволяет к полупроводникам условно относить вещества с D Е < 2,5 эВ, к диэлектрикам с D Е > 2,5 эВ.
и поэтому сильно зависит от ширины запрещённой зоны и температуры. Это позволяет к полупроводникам условно относить вещества с D Е < 2,5 эВ, к диэлектрикам с D Е > 2,5 эВ.







 или
или  .
.



 ,
,
 ,
,  -эффективные плотности состояний соответственно в зоне проводимости и валентной зоне. Численные значения NC, NV для германия, кремния и арсенида галлия при комнатной температуре (300 K) приведены в таблице 3.
-эффективные плотности состояний соответственно в зоне проводимости и валентной зоне. Численные значения NC, NV для германия, кремния и арсенида галлия при комнатной температуре (300 K) приведены в таблице 3.
 , получаем следующую зависимость ni от абсолютной температуры.
, получаем следующую зависимость ni от абсолютной температуры. .
.



 ;
;  .
.
 .
.
 ,
,
 , не зависящий от температуры; NI - концентрация рассеивающих ионов примеси.
, не зависящий от температуры; NI - концентрация рассеивающих ионов примеси. ,
,

 .
.
 ,
,

 ,
,
 .
.
 ,
,
 .
.
 .
.
 выражение (29) представляет собой прямую линию в области собственной проводимости (рис.10).
выражение (29) представляет собой прямую линию в области собственной проводимости (рис.10). .
.
 ,
,
 .
.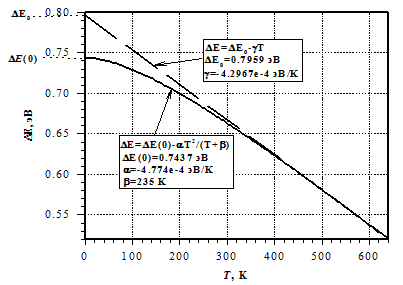


 Запустите на исполнение прикладную программу измерения температурной зависимости удельной электропроводности полупроводника - ярлык «Lab1» (рис.14). Путь к нему: либо Рабочий стол, либо Рабочий стол \ папка «Лаб.работы» \ папка «ФТТ и ПП» \папка «L-1».
Запустите на исполнение прикладную программу измерения температурной зависимости удельной электропроводности полупроводника - ярлык «Lab1» (рис.14). Путь к нему: либо Рабочий стол, либо Рабочий стол \ папка «Лаб.работы» \ папка «ФТТ и ПП» \папка «L-1». Проведение измерений
Проведение измерений


