
Заглавная страница Избранные статьи Случайная статья Познавательные статьи Новые добавления Обратная связь КАТЕГОРИИ: ТОП 10 на сайте Приготовление дезинфицирующих растворов различной концентрацииТехника нижней прямой подачи мяча. Франко-прусская война (причины и последствия) Организация работы процедурного кабинета Смысловое и механическое запоминание, их место и роль в усвоении знаний Коммуникативные барьеры и пути их преодоления Обработка изделий медицинского назначения многократного применения Образцы текста публицистического стиля Четыре типа изменения баланса Задачи с ответами для Всероссийской олимпиады по праву 
Мы поможем в написании ваших работ! ЗНАЕТЕ ЛИ ВЫ?
Влияние общества на человека
Приготовление дезинфицирующих растворов различной концентрации Практические работы по географии для 6 класса Организация работы процедурного кабинета Изменения в неживой природе осенью Уборка процедурного кабинета Сольфеджио. Все правила по сольфеджио Балочные системы. Определение реакций опор и моментов защемления |
Процесс генерации пар зарядов.
Движение дырки в пространстве обусловлено конечной вероятностью замещения разорванной валентной связи в результате хаотических туннельных переходов электронов соседних атомов. Как это видно из рис.3, перемещение электронов последовательно от атома В к атому Б, затем к атому А и т.д., эквивалентно движению дырки в обратном направлении. На энергетической диаграмме, этот процесс как последовательное замещение электронами освобождающихся энергетических уровней в ВЗ и соответствующее противоположное перемещение дырки. Итак, в результате генерации пар зарядов появляются подвижные частицы, способные участвовать в переносе электрических зарядов, т.е. обусловить электропроводность полупроводника.
В процессе хаотического движения свободный электрон может заместить одну из нарушенных валентных связей, т.е. возвратиться из ЗП в ВЗ. Произойдет объединение – рекомбинация свободного электрона и дырки. Пара подвижных зарядов исчезнет. При неизменной температуре число рекомбинации в единицу времени равно числу генераций пар зарядов, причем образовавшиеся подвижные заряды существуют конечный интервал времени t. Поэтому концентрации Ni – электронов и Pi – дырок в данном полупроводнике при T = const остаются неизменными (равновесные концентрации)
Итак, при комнатной температуре в полупроводнике имеется небольшое число носителей заряда: отрицательно заряженных свободных электронов и положительно заряженных дырок. Благодаря этому полупроводник обладает способностью проводить электрический ток. Если к полупроводнику приложить напряжение (рис.4), то под действием электрического поля свободные электроны, совершающие хаотическое тепловое движение в междуатомном пространстве, начнут смещаться (дрейфовать) в сторону положительного электрода. В результате этого в цепи будет протекать электрический ток. Это – обычный электронный ток, такой же, как и в металлических проводниках.
Таким образом, в полупроводнике под действием электрического поля, созданного источником, протекает, так называемый дрейфовый ток, содержащий электронную и дырочную составляющие.
Плотность дрейфового тока в полупроводнике определяется концентрацией носителей заряда, их подвижностью и напряженностью электрического поля:
Примеси в полупроводниках.
На процесс образования свободных электронов и дырок в полупроводнике большое влияние оказывают нарушения правильной структуры кристаллической решетки, а также наличие примесей. Атомы примесей обычно замещают в узлах решетки атомы основного вещества, образуя дефекты замещения. Примесные атомы могут попасть так же в междоузлия и образовать дефекты внедрения. В полупроводники, используемые для изготовления полупроводниковых приборов, предварительно очищенные от случайных примесей, вводят специальные примеси, обеспечивающие преимущественную концентрацию либо свободных электронов, либо дырок. Для получения преимущественной концентрации электронов в качестве примесей используются вещества с валентностью, превосходящей валентность основного полупроводника. Такие примеси называются донорными. Так, для Ge и Si, валентность которых S=4, в качестве донорных примесей используются пятивалентные P или As. Преимущественная концентрация дырок получается за счет примесей с меньшей валентностью – акцепторных примесей. Такими примесями могут служить трехвалентные бор, Al, In и т.д. Электронный полупроводник (n-типа)
Из пространственно – энергетической диаграммы (рис.5,б) видно, что периодическая j-ая функция вблизи атома примеси искажается и пятый валентный электрон, а значит, и атом примеси занимают отдельный локальный энергетический уровень в ЗЗ вблизи дна ЗП. Такое расположение в ЗЗ пятого электрона возможно, потому что он не является свободным электроном, а находится в j-ой яме вблизи своего атома. Естественно, что для отделения этого электрона от атома – перевода его в ЗП – требуется значительно меньше энергии, нежели для перемещения любого валентного электрона из ВЗ в ЗП ∆Eg < ∆Eз. Энергия ∆Ед , требуемая для этого, называется энергией ионизации. При ионизации атома донорной примеси, называемого донором, в зоне проводимости появляется свободный электрон, а сам атом примеси превращается в положительно заряженный ион. В отличие от процесса перехода валентности электрона из валентной зоны в зону проводимости при генерации пар зарядов здесь не появляется дырка, т.к все валентные связи вблизи донорного атома замещены. Таким образом, положительный ион примеси в отличие от дырки – заряд неподвижный, и, следовательно, в процессе ионизации доноров образуются подвижные заряды лишь одного знака – свободные электроны.
Обычно концентрация атомов примеси в полупроводниках составляет 10-6: 10-3 %. Поэтому атомы примеси отстоят друг от друга на расстояния, измеряемые, по меньшей мере, сотнями периодов решётки. Волновые ф-ции этих атомов можно считать неперекрывающимися, а их энергетический уровень не расщепляется в энергетическую зону, а образует единый для всех атомов локальный энергитический уровень, располагающийся на зонной диаграмме вблизи дна зоны проводимости (рис.5,в). Вывод: В полупроводниках с донорными примесями при Т>0°К образуется преимущественная концентрация электронов. Такие полупроводники называются электронными полупроводниками или n-полупроводниками. Дырочный полупроводник (р-типа).
В случае добавления в полупроводник акцепторной примеси одна из валентных связей вблизи атома- акцептора остаётся незаполненной (рис.6,а).
Рис. 6,а. Примесной атом In в кристалле Ge.
Такое состояние нельзя назвать дыркой, т.к. атом акцептора электрически нейтрален. Потенциальная функция вблизи атомов примеси искажается (рис.6,б).
Рис. 6,б. Положение примесного атома In на потенциальной диаграмме.
У края потенциальной ямы акцептора энергитический уровень, лежащий несколько выше потолка валентной зоны, остаётся незаполненным. В результате теплового возбуждения один из валентных электронов соседних атомов может нарушать валентную связь и заместить свободный энергитический уровень (заполнить валентную связь) вблизи атома акцептора. При этом четвёртый электрон связан с акцептором лишь квантомеханическими силами, т.е. его энергетическое состояние окажется выше энергии остальных трёх электронов на величину, примерно равную классической кулоновской энергии. В результате такого перехода вблизи соседнего атома, которому ранее принадлежал рассмотренный электрон, образуется дырка, а атом акцептора превратится в неподвижный отрицательно заряженный ион. Следовательно, в процессе ионизации акцепторов образуется преимущественная концентрация дырок – образуются подвижные носители лишь одного знака. Такие полупроводники называются дырочными или р-полупроводниками. Как и в случае донорных примесей, положение акцепторов в зонной диаграмме характеризуется единым локальным энергетическим уровнем, расположенным вблизи потолка валентной зоны (рис.6,в).
Выводы: В полупроводнике, в отличие от металлического проводника, ток образуется не только за счет направленного движения (дрейфа) отрицательно заряженных свободных электронов, но и за счет дрейфа положительно заряженных дырок.
Типы рекомбинации В зависимости от механизма различают три вида рекомбинации: межзонную рекомбинацию, рекомбинацию через локальные центры и поверхностную рекомбинацию. Межзонная рекомбинация осуществляется при переходе свободного электрона из зоны проводимости в валентную зону, что сопровождается уничтожением свободного электрона и дырки, на месте которой появляется связанный электрон. Этот процесс совершается при соблюдении законов сохранения энергии и импульса. Так как энергия электрона в валентной зоне меньше энергии электрона в зоне проводимости, то процесс межзонной рекомбинации должен сопровождаться выделением энергии ΔE ≈ Eпр – EB (49) В зависимости от того, на что расходуется энергия, различают следующие виды межзонной рекомбинации: Излучательную, при которой энергия ΔЕ излучается в виде кванта света (фотона); безизлучательную, при которой энергия ΔЕ передается кристаллической решетке, то есть расходуется на образование фононов. При излучательной межзонной рекомбинации в соответствии с законом сохранения энергии должен испускаться фотон с энергией hυ ≈ Eпр – EB (50) Вместе с тем из закона сохранения импульса следует, что hυ/С = Pпр –PB (51) Поскольку импульс фотона hυ/С ничтожно мал по сравнению с импульсом электрона, то последнее равенство можно переписать так Pпр –PB ≈ 0 (52) Рассматривая – PB как импульс свободной дырки, приходим к выводу, что при межзонной излучательной рекомбинации возможны лишь такие переходы, при которох электрон зоны проводимости встречается с дыркой валентной зоны, имеющей равный по величине и противоположный по направлению импульс. Несложно показать, что скорость межзонной излучательной рекомбинации увеличивается по мере уменьшения ширины запрещенной зоны полупроводника и увеличение его температуры. Поэтому данный вид рекомбинации может иметь единственное значение лишь для полупроводников с узкой запрещенной зоной и при достаточно высоких температурах.
Опыт, однако, показывает, что с увеличением ширины запрещенной зоны безизлучательная рекомбинация все более преобладает над излучательной. Это противоречие объясняется тем, что по мере увеличения ширины запрещенной зоны более вероятными становятся не прямые переходы через нее, а переходы через локальные уровни, расположенные в запрещенной зоне. Рекомбинация через локальные уровни (центры). Как мы выяснили раньше, наличие дефектов и примесей в полупроводнике приводит к появлению в его энергетической диаграмме локальных энергетических уровней, расположенных в запрещенной зоне. Рассмотрим, какую роль они играют в процессе рекомбинации свободных носителей зарядов. Пусть в запрещенной зоне донорного полупроводника, имеющего значительную концентрацию электронов зоны проводимости, располагается свободный локальный уровень Ел (рис. 8а), наличие которого обусловлено присутствием примесного атома или дефекта решетки. В этом случае рекомбинация проходит в два этапа. Первым этапом является захват электрона зоны проводимости указанным примесным атомом ёёёёёё (или, как горят, захват электрона проводимости локальным уровнем Ел, как показано стрелкой 1 на рис. 8а). Дальнейшее поведении захваченного электрона может быть двояким. Электрон может перейти в валентную зону (стрелка 2) на свободный уровень, что эквивалентно захвату на локальный уровень дырки и ее рекомбинации с электроном. Возможен и показанный стрелкой 3 обратный тепловой переброс электрона в зону проводимости. Этомт процесс препятствует рекомбинации электрона и дырки. Таким образом, интенсивность процесса рекомбинации определяется соотношением вероятностей процессов, указанных стрелками 2 и 3. Если локальные уровни располагаются близко к дну зоны проводимости или к потолку валентной зоны (рис. 8б), то есть являются мелкими, то вероятность протекания через них рекомбинации так же мала, как и вероятность межзонной рекомбинации. Поэтому наличие мелких локальных уровней приводит лишь к энергичному обмену электронами между ними и зоной проводимости (или валентной зоной) и не дает вклада в процесс рекомбинации. Дефекты или примеси, приводящие к появлению таких локальных уровней, называют ловушками захвата или центрами прилипания. Если же локальный уровень глубокий, то вероятность обратного переброса (например, электрона в зону проводимости) незначительна, преобладает процесс захвата дырки, то есть происходит интенсивный процесс рекомбинации. Дефекты или примеси, приводящие к появлению глубоких локальных уровней, на которых протекает процесс рекомбинации свободных электронов и дырок, называют рекомбинационными ловушками или центрами рекомбинации. Высокая интенсивность процесса рекомбинации на рекомбинационных ловушках объясняется тем, что при этом механизме избыточная энергия передается кристаллической решетке в два этапа (двумя примерно равными порциями), то есть на каждом этапе в реакции участвует меньшее число фононов, чем при межзонной рекомбинации. Немаловажное значение имеет также тот факт, что вероятность встречи дырки с неподвижным электроном, локализованным на дефекте, значительно выше вероятности встречи её с подвижным электроном. У примесных акцепторных полупроводников, имеющих значительную концентрацию дырок в валентной зоне, первым этапом рекомбинации является переход дырки из валентной зоны на локальный рекомбинационный уровень, а вторым этапом – захват электрона зоны проводимости и его рекомбинация с дыркой. Обратный тепловой переброс дырки в валентную зону препятствует процессу рекомбинации. Отметим, что интенсивность протекания рекомбинации через рекомбинационные ловушки зависит от степени легирования полупроводника. В собственном полупроводнике она минимальна и увеличивается как по мере добавления донорных, так и по мере добавления акцепторных примесей.
|
||||||||||
|
Последнее изменение этой страницы: 2017-02-19; просмотров: 317; Нарушение авторского права страницы; Мы поможем в написании вашей работы! infopedia.su Все материалы представленные на сайте исключительно с целью ознакомления читателями и не преследуют коммерческих целей или нарушение авторских прав. Обратная связь - 18.188.20.56 (0.035 с.) |
 Вследствие теплового возбуждения при Т>0°К какая – либо валентная связь между двумя атомами может оказаться нарушенной. Один из электронов, участвующих в парноэлектронной связи, может получить энергию, превосходящую по величине энергию ЕВ, запасаемую при ковалентной связи, и стать свободным электроном. На плоской схеме кристаллической решетки (рис.2) этот процесс можно условно изобразить в виде разорванной валентной связи (две точки между атомными остатками Ge) и электрона, свободно перемещающегося в пространстве между узлами кристаллической решетки. На месте ушедшего электрона остается незаполненная валентная связь и нескомпенсированный положительный заряд, равный по величине заряду электрона. Такое состояние принято называть дыркой. Описанный процесс на зонной диаграмме можно показать как переход электрона в ЗП из ВЗ, где освобождается одно из энергетических состояний – появляется дырка (рис.2б). Таким образом, в результате такого перехода электрона образуется обязательно пара зарядов: отрицательный заряд – электрон в ЗП и положительный заряд – дырка в ВЗ. Отсюда и наименование процесса – генерация пар зарядов. Оба образовавшихся заряда – подвижные. Свободный электрон хаотически перемещается между узлами кристаллической решетки подобно свободным электронам в металле.
Вследствие теплового возбуждения при Т>0°К какая – либо валентная связь между двумя атомами может оказаться нарушенной. Один из электронов, участвующих в парноэлектронной связи, может получить энергию, превосходящую по величине энергию ЕВ, запасаемую при ковалентной связи, и стать свободным электроном. На плоской схеме кристаллической решетки (рис.2) этот процесс можно условно изобразить в виде разорванной валентной связи (две точки между атомными остатками Ge) и электрона, свободно перемещающегося в пространстве между узлами кристаллической решетки. На месте ушедшего электрона остается незаполненная валентная связь и нескомпенсированный положительный заряд, равный по величине заряду электрона. Такое состояние принято называть дыркой. Описанный процесс на зонной диаграмме можно показать как переход электрона в ЗП из ВЗ, где освобождается одно из энергетических состояний – появляется дырка (рис.2б). Таким образом, в результате такого перехода электрона образуется обязательно пара зарядов: отрицательный заряд – электрон в ЗП и положительный заряд – дырка в ВЗ. Отсюда и наименование процесса – генерация пар зарядов. Оба образовавшихся заряда – подвижные. Свободный электрон хаотически перемещается между узлами кристаллической решетки подобно свободным электронам в металле. На зонной энергетической диаграмме это движение, сопровождаемое в общем случае взаимодействиями и изменением энергии электрона, можно представить как хаотическое перемещение на свободные энергетические уровни, вниз или вверх в зависимости от уменьшения или увеличения энергии в процессе движения.
На зонной энергетической диаграмме это движение, сопровождаемое в общем случае взаимодействиями и изменением энергии электрона, можно представить как хаотическое перемещение на свободные энергетические уровни, вниз или вверх в зависимости от уменьшения или увеличения энергии в процессе движения. Но в отличие от проводников, в полупроводнике будет протекать еще ток, возникающий в результате перехода валентных электронов с орбиты ковалентной связи одной пары атомов, на орбиту с дыркой ковалентной связи соседней пары атомов, расположенной в направлении положительного электрода. Скорость перемещения валентных электронов примерно в 2 -3 раза меньше скорости перемещения (дрейфа) свободных электронов. Кроме того, валентные электроны обладают меньшей энергией, чем свободные. Для того чтобы различать эти два тока в полупроводнике, ток, образованный перемещением валентных электронов, принято называть дырочным током, т.к. положительно заряженные дырки перемещаются с той же скоростью в противоположном направлении.
Но в отличие от проводников, в полупроводнике будет протекать еще ток, возникающий в результате перехода валентных электронов с орбиты ковалентной связи одной пары атомов, на орбиту с дыркой ковалентной связи соседней пары атомов, расположенной в направлении положительного электрода. Скорость перемещения валентных электронов примерно в 2 -3 раза меньше скорости перемещения (дрейфа) свободных электронов. Кроме того, валентные электроны обладают меньшей энергией, чем свободные. Для того чтобы различать эти два тока в полупроводнике, ток, образованный перемещением валентных электронов, принято называть дырочным током, т.к. положительно заряженные дырки перемещаются с той же скоростью в противоположном направлении.

 На рис.5,а показана часть кристаллической решетки Ge вблизи узла, замещенного примесным атомом Р. Четыре валентных электрона Р образуют с валентными электронами четырех соседних атомов Ge парноэлектронные ковалентные связи. Поскольку ковалентная связь насыщенная, пятый валентный электрон не участвует ни в одной из четырех связей. Он связан с атомом примеси лишь кулоновскими силами и поэтому его энергетическое состояние более высокое, а энергия связи с атомом значительно меньше квантово – механической энергии связи для остальных четырех электронов.
На рис.5,а показана часть кристаллической решетки Ge вблизи узла, замещенного примесным атомом Р. Четыре валентных электрона Р образуют с валентными электронами четырех соседних атомов Ge парноэлектронные ковалентные связи. Поскольку ковалентная связь насыщенная, пятый валентный электрон не участвует ни в одной из четырех связей. Он связан с атомом примеси лишь кулоновскими силами и поэтому его энергетическое состояние более высокое, а энергия связи с атомом значительно меньше квантово – механической энергии связи для остальных четырех электронов.
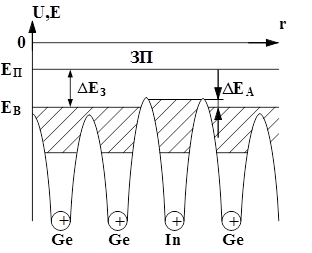
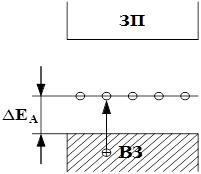 Рис. 6,в. Энергетическая диаграмма р-полупроводника.
Рис. 6,в. Энергетическая диаграмма р-полупроводника.
 При безизлучательной (фононной) рекомбинации избыточная энергия выделяется в виде фононов. Оценки показывают, что максимальная энергия фононов в кристаллах не превышает 0,1 эВ. Это означает, что при рекомбинации через запрещенную зону шириной порядка 1 эВ должно произойти одновременно испускание большого числа фононов. Следовательно, межзонная безизлучательная рекомбинация через относительно широкую запрещенную зону должна быть многофононной. Известно, что вероятность многофононных процессов быстро падает с увеличением числа фононов, участвующих в процессе. Это означает, что в полупроводниках с широкой запрещенной зоной межзонная фононная рекомбинация является также маловероятной.
При безизлучательной (фононной) рекомбинации избыточная энергия выделяется в виде фононов. Оценки показывают, что максимальная энергия фононов в кристаллах не превышает 0,1 эВ. Это означает, что при рекомбинации через запрещенную зону шириной порядка 1 эВ должно произойти одновременно испускание большого числа фононов. Следовательно, межзонная безизлучательная рекомбинация через относительно широкую запрещенную зону должна быть многофононной. Известно, что вероятность многофононных процессов быстро падает с увеличением числа фононов, участвующих в процессе. Это означает, что в полупроводниках с широкой запрещенной зоной межзонная фононная рекомбинация является также маловероятной.


