
Заглавная страница Избранные статьи Случайная статья Познавательные статьи Новые добавления Обратная связь КАТЕГОРИИ: ТОП 10 на сайте Приготовление дезинфицирующих растворов различной концентрацииТехника нижней прямой подачи мяча. Франко-прусская война (причины и последствия) Организация работы процедурного кабинета Смысловое и механическое запоминание, их место и роль в усвоении знаний Коммуникативные барьеры и пути их преодоления Обработка изделий медицинского назначения многократного применения Образцы текста публицистического стиля Четыре типа изменения баланса Задачи с ответами для Всероссийской олимпиады по праву 
Мы поможем в написании ваших работ! ЗНАЕТЕ ЛИ ВЫ?
Влияние общества на человека
Приготовление дезинфицирующих растворов различной концентрации Практические работы по географии для 6 класса Организация работы процедурного кабинета Изменения в неживой природе осенью Уборка процедурного кабинета Сольфеджио. Все правила по сольфеджио Балочные системы. Определение реакций опор и моментов защемления |
Элементы физики фотовозбуждений в твёрдом телеСтр 1 из 5Следующая ⇒
Перенос носителей заряда. Полная плотность тока в полупроводнике складывается из диффузионной и дрейфовой:
Кинетика носителей описывается уравнением непрерывности:
где Na - концентрация акцепторов; Nd - концентрация дефектов; Dn - дрейфовая постоянная; Dp - диффузионная постоянная; e -. Движение электронов и дырок вследствие диффузии и дрейфа взаимосвязано. Носители движутся в виде облака электронов и дырок, внутри которого возникает добавочное электронное поле, тормозящее более быстро диффундирующие носители и ускоряющее более медленные где D и m - коэффициенты биполярной диффузии и биполярная дрейфовая подвижность соответственно. Уравнения баланса частиц, содержащихся в каждом элементе объёма (в стационарном режиме): 1. Усиление фототока где tn, tp - времена пролётов электронов и дырок между электродами при длине образца l и приложенном напряжении U, где G - полная генерация носителей при равномерном поглощении, равная произведению скоростей генерации носителей в единице объёма полупроводника g на его объём,iф-фототок-коэф.усиления:
Физический смысл kф: созданная светом неравновесная проводимость сохраняется до тех пор, пока не рекомбинирует во всём объёме или не уйдут из него через контакты во внешнюю цепь избыточные носители. n и p имеют различные m, поэтому при достаточно больших E (при которых t больше времени жизни) электронов дойдёт до рекомбинации больше, чем один. Если время жизни и подвижность носителей не зависят от E, то Iф должен линейно возрастать с увеличением приложенного напряжения U или с уменьшением l. При t меньших времени жизни быстродействие увеличивается. Нелинейности в зависимостях Iф могут возникнуть из-за возбуждения объёмного заряда в полупроводнике из-за зависимости от E подвижности и времён жизни носителей вследствие их «разогрева», т.е. увеличения их скорости выше тепловой при данной Т.
Фоторезисторы
В схеме деления напряжения ФР является одним из плеч делителя напряжения, и схему используют для непосредственного отсчета сигнала (рис. 24). Значение сопротивления нагрузки (Rн) в схеме деления напряжения: Rн = Rт, где Rт – темновое сопротивление ФР. Мостовые схемы включения ПИ широко распространены в измерительной технике. В неосвещенном состоянии ФР мост должен быть уравновешен с учетом постоянной фоновой засветки.Мостовая схема позволяет измерять малые сигналы от объекта при относительно большом фоне, при этом в диагональ моста можно включить высокочувствительные измерительные приборы, что не допускается при прямых измерениях из-за большого начального тока, обусловленного фоновой засветкой.
Для компенсации действия потока фона на ФР применяют дифференциальную схему их включения с неизменным питающим напряжением каждого контура. Дифференциальную схему используют как непосредственную, а также как схему сравнения. В дифференциальной схеме фототоки от фона от обоих ФР текут в противоположных направлениях и при идентичности контуров постоянный ток от фона в Rн будет равен нулю. Фототок в Rн возникает от излучения объекта, которое поступает на один ФР или на оба в противофазе.
В случае применения трансформаторной схемы включения ФР получают определенный выигрыш в чувствительности по напряжению за счет того, что к ФР подводят почти все напряжение источника питания.Сопротивление Rн разобщено с цепью питания ФР, и его изменение не сказывается на режиме работы ФР. Кроме того, постоянный фототок от фона не дает падения напряжения на Rн, а оно возникает при наличии модулированного излучения объекта. Фототранзисторы- полупроводниковый ПИ на основе использования внутреннего фотоэффекта, совмещающий в себе свойства ФД и усилительного триода. Различают униполярные и биполярные ФТ. Униполярные ФТ создаются на основе МДП-структур. Биполярный фототранзистор- полупроводниковая структура, в которой существует 2 p-n перехода (см. рис. 35). Его можно представить состоящим из фотодиода и транзистора. Фотодиодом является освещаемая часть перехода база-коллектор. Транзистором - часть структуры, расположенная непосредственно под эмиттером. Возможны три схемы включения фотодиода как двухполюсника, когда один из выводов остаётся свободным: со свободным коллектором, со свободным эмиттером и со свободной базой. Первые из двух схем не отличаются от схемы включения p-n-перехода в фотодиодном режиме. Ток во всех участках равен поэтому
При IКБО<<IФ где h21Э - коэффициент передачи базы: 19. Фотодиоды - полупроводниковые приборы, основанные на внутреннем фотоэффекте, использующие одностороннюю проводимость р - n перехода, при освещении которого появляется э. д. с. (фотогальванический режим) или (при наличии питания) изменяется значение При работе ФД в фотодиодном режиме к нему прикладывают обратное напряжение. В этом случае в отсутствии освещения через р - п переход и сопротивление нагрузки протекает обратный дырочный ток Is. При освещении же n-области через р - n переход и сопротивление нагрузки будет протекать дополнительный дырочный фототок неосновных носителей Iф. Суммарный ток в цепи будет определяться их суммой. Выражение для вольт-амперной характеристики
где V - напряжение внешнего источника, e – заряд электрона, k - постоянная Больцмана, Т – температура. Схема включения ФД в фотодиодном режиме приведена на рис. 28, а вольт-амперные характеристики соответствуют области I на рис. 29.
. (Если RH = ∞, то ток во внешней цепи I = 0, а вместо VR в (3) можно подставить значение VХ.Х. - напряжения холостого хода (фото-э. д. с.), тогда . Напряжение холостого хода Vx.x ФД в фотогальваническом режиме изменяется с ростом светового потока по логарифмическому закону и в пределе достигает значения, равного контактной разности потенциалов р - n - перехода. Оптимальное значение нагрузочного сопротивления также как и в случае фотодиодного режима определяется интенсивностью светового потока: Постоянная времени ФД τФД определяется временем пролета носителей от места их генерации под действием освещенности (в тонком поверхностном слое) до р-п перехода, где они рекомбинируют, и постоянной времени схемной релаксации τр (RC- цепочка ФД). Время пролета зависит от структуры ФД и механизма переноса неосновных носителей, образующих фототок.
Полевой фототранзистор. Прибор с p-n-переходом, в функциональном отношении основан на управлении размерами токопроводящей области посредством управления размерами изменения напряжённости поперечного приложенного электрического поля и освещения перехода. Состоит из полупроводникового бруска с омическими контактами на торцах и p-n-переходом на боковой грани - рис. 36.. Боковой p-n-переход (затвор) включается в обратном направлении. Так, между омическими контактами (n- сток, С - исток) протекает по каналу, остающемуся между областями объёмного заряда и противоположной гранью бруска. При изменении отрицательного напряжения UЗ (входная цепь) ширина области объёмного заряда также изменяется. Соответственно изменяется и ток входной цепи.Высокое входное сопротивление (порядка Мом) и p-n-переход включён в обратном направлении. Очень слаба температурная зависимость и велика радиационная стойкость за счёт малой зависимости tp,n, mp,n. Велика предельная частота, т.к. отсутствует инжекция и мала электрическая ёмкость на входе (постоянная времени ~10-7 с). В качестве затвора может быть использован барьер Шотки, который обладает высокой фоточувствительностью в соответствующих областях спектра и обеспечивает высокое быстродействие. Недостатки: нелинейность его энергетических характеристик, так как при больших уровнях потока излучения потенциал затвора становится столь малым, что его изменение уже не влияет на ток стока, который близок к максимальному значению.
U1-2- алгепбраической суммой напряжений на всех участках резистивной цепочки. Тогда 21. Многоэлементные фотоприёмники (МПИ ), работающие без накопления сигнала- называют приемниками «мгновенного действия», имея в виду, что в выходных цепях регистрируются установившиеся значения сигнальных токов и напряжений. МПИ мгновенного действия можно подразделить на две группы: с параллельным и последовательным опросом элементов. МПИ с параллельным опросом. При использовании таких МПИ обеспечивается одновременное подключение всех рабочих элементов к своим каналам усиления,наиболее эффективны в быстродействующих оптико-электронных приборах и системах, например в системах оптической пеленгации. Однако необходимость одновременно подключать все элементы весьма затрудняет реализацию МПИ с большим числом элементов при малом шаге пространственной структуры. В рамках данной группы МПИ наиболее распространены четырехэлементные фотодиоды, которые с успехом используются в качестве быстродействующих координатно-чувствительных фотоприемников в различных оптико-электронных измерительных системах. Такой фотодиод представляет собой четырехэлементный фотоприемник, реализованный на одной подложке. Рабочая площадка фотодиода состоит из четырех квадратных элементов (А, В, С, D). Приборная система координат обычно совмещается с центром рабочей площадки. Чтобы обеспечить условия независимого измерения смещений по двум направлениям, изображение марки целесообразно формировать квадратной формы со стороной, равной стороне одного элемента фотодиода. При этом координаты центра изображения Δх и Δy (отклонения центра марки от центра координат)вычисляют простейшими арифметическими операциями - сложением и вычитанием сигналов, снимаемых с элементарных площадок. МПИ с накоплением сигнала
Общий недостаток всех рассмотренных выше МПИ - необходимость раздельно выполнять фоточувствительные элементы и схемы коммутации. Это предопределяет сравнительно большие габаритные размеры и потребляемую мощность фотоприемных устройств на их основе, а также высокий уровень внутренних шумов в проектируемых оптико-электронных приборах. Элементы физики фотовозбуждений в твёрдом теле Прохождение света через полупроводниковый образец толщиной d характеризуется пропусканием Т:
1. Собственное (фундаментальное) поглощение - поглощение, при котором электроны приобретая дополнительную энергию переходят из валентной зоны в a) б) Рис. 15 Конфигурации энергетических зон: Прямых (InSb, a) и не прямых (Ge,б)
зону проводимости. Отличают два основных вида конфигураций зон. В первой волновой вектор kmin в минимуме энергии зоны проводимости совпадает с kmax при максимуме энергии валентной зоны - рис. 15 Пример- полупроводник InSb, а конфигурация называется прямозонной. У второй конфигурации Минимальная энергия кванта для совершения непрямого перехода
Температура и давление оказывают существенное влияние на спектр собственного поглощения полупроводника, поскольку DW зависит от них. При повышении температуры DW, как правило, уменьшается из-за изменения характера взаимодействия электрона с решёткой. При увеличении давления обе зоны сужаются (например в германии), DW растёт, край собственного поглощения смещается в область коротких длин волн. 2. Примесное поглощение. При наличии в запрещённой зоне энергетических уровней примесей обмен носителями заряда между ними и собственными разрешёнными зонами осуществляется при участии фотонов с энергией меньше DW. Полосы примесного поглощения располагаются за длинноволновым краем собственного поглощения. Примесные атомы с малой энергией ионизации при комнатной температуре почти все ионизованы в результате термического возбуждения. Поэтому селективное поглощение можно наблюдать лишь при низких температурах. Глубокими примесными уровнями называют те, вероятность термической ионизации которых при комнатных температурах мала. Появление глубоких уровней у примесных центров и дефектов структуры происходит в процессе рекомбинации неравновесных носителей с определёнными скоростями в условиях определённой спектральной фоточувствительности. Глубокие примесные уровни определяют во многом свойства полупроводниковых фотоприемников. Коэффициент примесного поглощения для hn»Wa(энергия активации примесного уровня, эВ): где N - концентрация примеси, см-3, n - показатель преломления, mn*-. Примесные центры могут быть многозарядными. 3. Поглощение собственными носителями заряда. За краем фундаментальной полосы поглощения при достаточной концентрации носителей тока в полупроводнике наблюдается неселективное поглощение за счёт электронного поглощения внутри разрешённой зоны. Это наблюдается в Ge, Si, In, Sb и др. При большом удалении от фундаментального края где n - концентрация электронов mn - подвижность носителей, см2В-1с-1, m0 -, l (мкм). Характерной особенностью этого типа поглощения является зависимость a пропорциональна l2. 4. Экситонное и решёточное поглощения. Электрон и дырка могут посредством решётки образовывать связанную систему - экситон. В некоторых полупроводниках (например, CdS,Cu2O) они могут быть ответственны за ещё один канал поглощения. Упрощенно экситон может быть представлен композитом, связанным кулоновским взаимодействием. Энергия возбуждённого экситона оказывается меньше DW и его поглощение в спектре проявляется в виде тонкой структуры у края фундаментального поглощения. Экситонное поглощение не даёт вклада в фотопроводимость, поэтому это лишь фактор снижения фотоэлектронных свойств полупроводника. 12.Фотопроводимость полупроводника. Участвующие в электропроводности полупроводника свободные носители находятся в термодинамическом равновесии с решёткой, обеспечиваемом термическими процессами. Они равновесны, и соответствующая проводимость тоже. Но носители могут появляться и и по другим причинам. В частности, в связи с оптическим поглощением. Это носители уже по своему смыслу неравновесные. При поглощении фотона электрон-дырочная пара получает избыточную энергию и квазиимпульс. Равновесное распределение носителей устанавливается за время меньшее времени нахождения в соответствующих зонах. Поэтому они успевают «термализоваться». Тогда Dn и Dp - неравновесные их концентрации. Т.о. фотопроводимость Кроме генерации носителей засветка вызывает их рекомбинацию, причём с ростом неравновесной доли она усиливается. При стационарном облучении, в конце концов, устанавливается стационарная проводимость.для фотопроводимост Времена жизни регулируются процессами захвата. Это или центры прилипания, или рекомбинации.. В результате примесные уровни при слабом возбуждении, и играющие роль центров прилипания, становятся центрами рекомбинации. Выделяющаяся за счёт рекомбинации энергия уносится по нескольким путям: 1. Излучательная рекомбинация (ИР). Уносится фотонами. Рекомбинационное излучение обуславливается как прямыми, так и непрямыми переходами. Доля ИР при малых уровнях инжекции велика у полупроводников с узкой запрещённой зоной (например, InSb). Для межзонной ИР может быть излучение (???) за счёт переходов носителей на локальные уровни дефектов и примесей. 2. Безизлучательная рекомбинация сопровождается выделением энергии которая, в конечном счете, превращается в тепловую энергию кристалла. Наиболее важным её механизмом при невысоких концентрациях носителей является рекомбинация через промежуточные состояния в запрещенной зоне, локализованные около примесей или дефектов. Сначала один из носителей захватывается примесью а затем та же примесь захватывает носитель с зарядом противоположного знака. В результате оба захваченных носителя исчезают, а примесный центр возвращается в первоначальное состояние. Поверхностная рекомбинация имеет тот же механизм, что и рекомбинация на примесях, но центры, через которые идёт рекомбинация, связаны не с примесями, а с поверхностью кристалла. Из других механизмов безызлучательной рекомбинации следует упомянуть процесс, когда электрон и дырка, рекомбинируя, отдают выделяемую энергию третьему носителю (Оже рекомбинация). Этот процесс заметен лишь при очень больших концентрациях свободных носителей, т.к. для него требуется столкновение трёх носителей, т. е. их одновременное попадание в область размером порядка элементарной ячейки кристалла. 3. Плазменная рекомбинация характеризуется передачей энергии всей системе свободных носителей. Перенос носителей заряда. Полная плотность тока в полупроводнике складывается из диффузионной и дрейфовой:
Кинетика носителей описывается уравнением непрерывности:
где Na - концентрация акцепторов; Nd - концентрация дефектов; Dn - дрейфовая постоянная; Dp - диффузионная постоянная; e -. Движение электронов и дырок вследствие диффузии и дрейфа взаимосвязано. Носители движутся в виде облака электронов и дырок, внутри которого возникает добавочное электронное поле, тормозящее более быстро диффундирующие носители и ускоряющее более медленные где D и m - коэффициенты биполярной диффузии и биполярная дрейфовая подвижность соответственно. Уравнения баланса частиц, содержащихся в каждом элементе объёма (в стационарном режиме): 1. Усиление фототока где tn, tp - времена пролётов электронов и дырок между электродами при длине образца l и приложенном напряжении U, где G - полная генерация носителей при равномерном поглощении, равная произведению скоростей генерации носителей в единице объёма полупроводника g на его объём,iф-фототок-коэф.усиления:
Физический смысл kф: созданная светом неравновесная проводимость сохраняется до тех пор, пока не рекомбинирует во всём объёме или не уйдут из него через контакты во внешнюю цепь избыточные носители. n и p имеют различные m, поэтому при достаточно больших E (при которых t больше времени жизни) электронов дойдёт до рекомбинации больше, чем один. Если время жизни и подвижность носителей не зависят от E, то Iф должен линейно возрастать с увеличением приложенного напряжения U или с уменьшением l. При t меньших времени жизни быстродействие увеличивается. Нелинейности в зависимостях Iф могут возникнуть из-за возбуждения объёмного заряда в полупроводнике из-за зависимости от E подвижности и времён жизни носителей вследствие их «разогрева», т.е. увеличения их скорости выше тепловой при данной Т.
|
|||||||||
|
Последнее изменение этой страницы: 2016-12-30; просмотров: 247; Нарушение авторского права страницы; Мы поможем в написании вашей работы! infopedia.su Все материалы представленные на сайте исключительно с целью ознакомления читателями и не преследуют коммерческих целей или нарушение авторских прав. Обратная связь - 3.142.98.108 (0.065 с.) |
 .
. . Объёмную плотность заряда r связывает с e уравнение Пуассона:
. Объёмную плотность заряда r связывает с e уравнение Пуассона: 

 где r(n,p) - скорость рекомбинации.
где r(n,p) - скорость рекомбинации. ,
,  . (
. (
 - характерное время- время релаксации фотопроводимости sф. В стационарном состоянии фотопроводимость:
- характерное время- время релаксации фотопроводимости sф. В стационарном состоянии фотопроводимость:  .чем выше tф, тем больше фотопроводимость и больше время установления стационарного состояния, т.е. тем больше инерционность фотоприёмного устройства и меньше полоса пропускания сигнала Df. Качество фотоприемника оценивается его добротностью Q=kфDf.
.чем выше tф, тем больше фотопроводимость и больше время установления стационарного состояния, т.е. тем больше инерционность фотоприёмного устройства и меньше полоса пропускания сигнала Df. Качество фотоприемника оценивается его добротностью Q=kфDf. Являются наиболее простым типом приёмников излучения. Их действие основано на изменении фотопроводимости полупроводникового элемента. Изготавливаются в виде поликристалличесикх плёнок, спечённых (опрессованных) таблеток, монокристаллических пластинок. Используется фоточувствительность как в области собственного поглощения, так и в примесной области.. Высокая селективность присуща монокристаллическим фотоприёмникамСхемы включения ФР разнообразны, но можно выделить основные: схему деления напряжения, мостовую, дифференциальную, трансформаторную, импульсную.
Являются наиболее простым типом приёмников излучения. Их действие основано на изменении фотопроводимости полупроводникового элемента. Изготавливаются в виде поликристалличесикх плёнок, спечённых (опрессованных) таблеток, монокристаллических пластинок. Используется фоточувствительность как в области собственного поглощения, так и в примесной области.. Высокая селективность присуща монокристаллическим фотоприёмникамСхемы включения ФР разнообразны, но можно выделить основные: схему деления напряжения, мостовую, дифференциальную, трансформаторную, импульсную.  Чтобы устранить зависимость градуировки измерительной шкалы от потока излучения фона, включают в, разные плечи моста одновременно два ФР.В этом случае возможно освещение одного ФР только фоном, а второго — излучением фона и объекта вместе. Если же оба ФР освещать одновременно излучением фона и объекта, то это дает двойное увеличение чувствительности схемы, однако необходимо учитывать, что компенсация постоянной засветки в этом случае обеспечивается корректировкой фазы излучения падающего на второй ФР либо постановкой последнего в противоположное плечо моста.
Чтобы устранить зависимость градуировки измерительной шкалы от потока излучения фона, включают в, разные плечи моста одновременно два ФР.В этом случае возможно освещение одного ФР только фоном, а второго — излучением фона и объекта вместе. Если же оба ФР освещать одновременно излучением фона и объекта, то это дает двойное увеличение чувствительности схемы, однако необходимо учитывать, что компенсация постоянной засветки в этом случае обеспечивается корректировкой фазы излучения падающего на второй ФР либо постановкой последнего в противоположное плечо моста. h21Б - коэффициент передачи (усиления) эмиттерного тока.При освещении базы фототок увеличивает обратный ток коллекторного перехода, включённого в обратном направлении, т.к. фототок суммируется с коллекторным током. Тогда вместо тока IКБОÞIКБО+IФ;
h21Б - коэффициент передачи (усиления) эмиттерного тока.При освещении базы фототок увеличивает обратный ток коллекторного перехода, включённого в обратном направлении, т.к. фототок суммируется с коллекторным током. Тогда вместо тока IКБОÞIКБО+IФ; .
. ,
, ток в фототранзисторе усиливается в h21Э раз сравнению с фотодиодом. Соответственно во столько же раз увеличивается и интегральная чувствительность. Недостатки: нестабильность параметров при изменении температуры; неравномерность чувствительности по полю из-за экранирования освещаемой базы коллектором (при освещении базы со стороны коллектора) или эмиттером (при освещении базы со стороны эмиттера); увеличенный по сравнению с ФД порог чувствительности из-за значительных шумов; большую постоянную времени (10-4 – 10-6 с).
ток в фототранзисторе усиливается в h21Э раз сравнению с фотодиодом. Соответственно во столько же раз увеличивается и интегральная чувствительность. Недостатки: нестабильность параметров при изменении температуры; неравномерность чувствительности по полю из-за экранирования освещаемой базы коллектором (при освещении базы со стороны коллектора) или эмиттером (при освещении базы со стороны эмиттера); увеличенный по сравнению с ФД порог чувствительности из-за значительных шумов; большую постоянную времени (10-4 – 10-6 с). обратного тока (фотодиодный режим)..
обратного тока (фотодиодный режим).. ,
,
 Для повышения вольтовой чувствительности, необходимо увеличить сопротивление нагрузки RH. Максимальное его значение связано с максимальным потоком излучения:
Для повышения вольтовой чувствительности, необходимо увеличить сопротивление нагрузки RH. Максимальное его значение связано с максимальным потоком излучения:  где SI – токовая чувствительность ФД. При этом точка пересечения прямой нагрузки с вольт-амперной характеристикой, соответствующей максимальному потоку Фmax излучения, должна лежать в области диодного режима.
где SI – токовая чувствительность ФД. При этом точка пересечения прямой нагрузки с вольт-амперной характеристикой, соответствующей максимальному потоку Фmax излучения, должна лежать в области диодного режима. Схема включения ФД в фотогальваническом режиме приведена на рис. 30. При подключении к контактам фотодиода нагрузки RН и отсутствии освещения через р -n-переход и нагрузочное сопротивление потечет ток термически генерированных неосновных носителей IS, называемый темновым током. При освещении появляется дополнительный фототок неосновных носителей IФ = SIФ. Соответствующие вольт-амперные характеристики соответствуют области II на рис. 29. Общий ток в цепи ФД в фотогальваническом режиме
Схема включения ФД в фотогальваническом режиме приведена на рис. 30. При подключении к контактам фотодиода нагрузки RН и отсутствии освещения через р -n-переход и нагрузочное сопротивление потечет ток термически генерированных неосновных носителей IS, называемый темновым током. При освещении появляется дополнительный фототок неосновных носителей IФ = SIФ. Соответствующие вольт-амперные характеристики соответствуют области II на рис. 29. Общий ток в цепи ФД в фотогальваническом режиме 


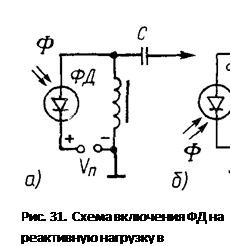 Форма частотной характеристики и fгр зависит от параметров самого ФД, от приложенного обратного напряжения питания, от спектрального состава падающего на ФД излучения (меняется глубина проникновения излучения), от формы модуляции излучения и т. д. Высокочастотные фотодиоды Для того чтобы уменьшить постоянную времени ФД, уменьшают толщину базы, чтобы образовавшиеся на поверхности носители быстрее дошли до р - n перехода и там рекомбинировали. Расширяют р - n переход за счет подачи высокого обратного напряжения, чтобы излучение в большей степени поглощалось в нем. Делают базу прозрачной для регистрируемого излучения с тем, чтобы излучение поглощалось в самом р - n переходе. В настоящее время высокочастотные ФД изготавливают на основе гетеропереходов, барьеров Шоттки, поверхностного барьера, создаваемого ионным легированием, и на основе р - i - n -структур.У поверхностно-барьерных ФД (ПБФД) контактный барьер располагается на поверхности полупроводника. Их изготавливают на основе эффекта Шоттки или специальной обработкой, когда поверхностный слой полупроводника в отличие от объемного приобретает иной знак. На рис. 32показано схематическое устройство ПБДФ на эффекте ШотткиУвеличить ширину потенциального барьера можно в ФД р - i - n типа, представляющих собой собственный полупроводник i с большим удельным сопротивлением (в 106- 107 раз более высоким, чем п- и р -области), ограниченный с двух сторон сильно легированными слоями п- и р -типов (рис. 33 ). На п- и р-области наносят контакты. В таких ФДпри приложении к контактам напряжения смещения сильное равномерное внутреннее электрическое поле электронно-дырочного перехода сосредоточено в i -области. Лавинные фотодиоды (ЛФД) позволяют реализовать внутреннее усиление фототока за счет электрического пробоя р - n перехода и образования лавинного процесса размножения поступающих в р - n переход неосновных носителей. В ЛФД используются либо широкий р - n переход, либо р - i - n -переход, либо поверхностный барьер Шоттки. Так как дырки имеют больший коэффициент ударной ионизации, освещаемая область становится n -типа.
Форма частотной характеристики и fгр зависит от параметров самого ФД, от приложенного обратного напряжения питания, от спектрального состава падающего на ФД излучения (меняется глубина проникновения излучения), от формы модуляции излучения и т. д. Высокочастотные фотодиоды Для того чтобы уменьшить постоянную времени ФД, уменьшают толщину базы, чтобы образовавшиеся на поверхности носители быстрее дошли до р - n перехода и там рекомбинировали. Расширяют р - n переход за счет подачи высокого обратного напряжения, чтобы излучение в большей степени поглощалось в нем. Делают базу прозрачной для регистрируемого излучения с тем, чтобы излучение поглощалось в самом р - n переходе. В настоящее время высокочастотные ФД изготавливают на основе гетеропереходов, барьеров Шоттки, поверхностного барьера, создаваемого ионным легированием, и на основе р - i - n -структур.У поверхностно-барьерных ФД (ПБФД) контактный барьер располагается на поверхности полупроводника. Их изготавливают на основе эффекта Шоттки или специальной обработкой, когда поверхностный слой полупроводника в отличие от объемного приобретает иной знак. На рис. 32показано схематическое устройство ПБДФ на эффекте ШотткиУвеличить ширину потенциального барьера можно в ФД р - i - n типа, представляющих собой собственный полупроводник i с большим удельным сопротивлением (в 106- 107 раз более высоким, чем п- и р -области), ограниченный с двух сторон сильно легированными слоями п- и р -типов (рис. 33 ). На п- и р-области наносят контакты. В таких ФДпри приложении к контактам напряжения смещения сильное равномерное внутреннее электрическое поле электронно-дырочного перехода сосредоточено в i -области. Лавинные фотодиоды (ЛФД) позволяют реализовать внутреннее усиление фототока за счет электрического пробоя р - n перехода и образования лавинного процесса размножения поступающих в р - n переход неосновных носителей. В ЛФД используются либо широкий р - n переход, либо р - i - n -переход, либо поверхностный барьер Шоттки. Так как дырки имеют больший коэффициент ударной ионизации, освещаемая область становится n -типа. 20. Координатно-чувствительные фотоприёмники.- фотоприёмники, в которых входной сигнал зависит от местоположения облучённого участка светочувствительной поверхности. В такой класс включают датчики для определения местоположения светящихся объектов в пространстве используются в приборах измерения деформации, в качестве преобразователей колебаний в двух координатах, в автоматизированных спектральных комплексах и др.
20. Координатно-чувствительные фотоприёмники.- фотоприёмники, в которых входной сигнал зависит от местоположения облучённого участка светочувствительной поверхности. В такой класс включают датчики для определения местоположения светящихся объектов в пространстве используются в приборах измерения деформации, в качестве преобразователей колебаний в двух координатах, в автоматизированных спектральных комплексах и др.  Он содержит p-n-переход за счёт низкоомной подложки p-типа и высокоомный слой n-типа. Фотонапряжение Uф снимается с контактов 1-2 n-области. Принцип действия: удельные сопротивления rn >>rp и толщины слоёв dn<<dp. Тогда p-область является эвипотенциальной поверхностью, а n-база - поверхностью, на которой распределены диоды и резисторы согласно эквивалентной схеме.
Он содержит p-n-переход за счёт низкоомной подложки p-типа и высокоомный слой n-типа. Фотонапряжение Uф снимается с контактов 1-2 n-области. Принцип действия: удельные сопротивления rn >>rp и толщины слоёв dn<<dp. Тогда p-область является эвипотенциальной поверхностью, а n-база - поверхностью, на которой распределены диоды и резисторы согласно эквивалентной схеме. .При перемещении луча в точку с резисторами R2 и R3 слагаемое i2R2 будет с отрицательным знаком и U12 уменьшается. При перемещении луча в центр пластины (x=0) число положительных и отрицательных членов в (2-29) станет одинаковым и U12=0. При дальнейшем смещении в сторону контакта 2 знак U12 изменяется на противоположный. «Крутизна характеристики перемещения» при заданном уровне засветки возрастает с ростом rn и уменьшением толщины базы dn. U12 всегда меньше значения фотоЭДС диода за счёт рекомбинационных и других потерь. Чувствительность прибора с продольным фотоэффектом - до 1 - 1,5 мВ/мВт.мм. Недостаток - температурный дрейф координатной точки U12.
.При перемещении луча в точку с резисторами R2 и R3 слагаемое i2R2 будет с отрицательным знаком и U12 уменьшается. При перемещении луча в центр пластины (x=0) число положительных и отрицательных членов в (2-29) станет одинаковым и U12=0. При дальнейшем смещении в сторону контакта 2 знак U12 изменяется на противоположный. «Крутизна характеристики перемещения» при заданном уровне засветки возрастает с ростом rn и уменьшением толщины базы dn. U12 всегда меньше значения фотоЭДС диода за счёт рекомбинационных и других потерь. Чувствительность прибора с продольным фотоэффектом - до 1 - 1,5 мВ/мВт.мм. Недостаток - температурный дрейф координатной точки U12. На рис. 30 приведена схема типичного МПИ с накопительными ячейками, эквивалентная схема которых показана на рис. 31. Каждая ячейка состоит из фоточувствительного элемента - фотодиода V2 (или фоторезистора), разрядного ключа сброса на МДП-транзисторе V1 и предварительного усилителя на МДП-транзисторах V3 - V4. После замыкания ключа сброса на емкости Ci накопительного элемента устанавливается напряжение, близкое к напряжению питания. После размыкания ключа происходит разряд Ci через Ri. При этом Сi представляет собой собственную емкость фотодиода и параллельно подключенную входную емкость усилителя, a Ri - внутреннее сопротивление фотодиода в запертом состоянии, которое зависит от потока оптического излучения, воздействующего на данный элемент. В данном случае Rt является нелинейным сопротивлением, таким образом, разряд Ct происходит практически с постоянной скоростью. Полезный сигнал определяется степенью разряда Ci за фиксированное время накопления tн. Считывание напряжения на Сi осуществляется в момент замыкания ключа выборки Квыб. В матричных МПИ сигналы считываются посредством выбора строки и столбца. Для этого на один из входов Yi подается импульс отпирающего напряжения, поступающий на затвор соответствующего транзистора V4. Кроме того, коммутируется один из выходов Xj. В результате выходная цепь транзистора V4 нужной ячейки подключается к нагрузочному сопротивлению.
На рис. 30 приведена схема типичного МПИ с накопительными ячейками, эквивалентная схема которых показана на рис. 31. Каждая ячейка состоит из фоточувствительного элемента - фотодиода V2 (или фоторезистора), разрядного ключа сброса на МДП-транзисторе V1 и предварительного усилителя на МДП-транзисторах V3 - V4. После замыкания ключа сброса на емкости Ci накопительного элемента устанавливается напряжение, близкое к напряжению питания. После размыкания ключа происходит разряд Ci через Ri. При этом Сi представляет собой собственную емкость фотодиода и параллельно подключенную входную емкость усилителя, a Ri - внутреннее сопротивление фотодиода в запертом состоянии, которое зависит от потока оптического излучения, воздействующего на данный элемент. В данном случае Rt является нелинейным сопротивлением, таким образом, разряд Ct происходит практически с постоянной скоростью. Полезный сигнал определяется степенью разряда Ci за фиксированное время накопления tн. Считывание напряжения на Сi осуществляется в момент замыкания ключа выборки Квыб. В матричных МПИ сигналы считываются посредством выбора строки и столбца. Для этого на один из входов Yi подается импульс отпирающего напряжения, поступающий на затвор соответствующего транзистора V4. Кроме того, коммутируется один из выходов Xj. В результате выходная цепь транзистора V4 нужной ячейки подключается к нагрузочному сопротивлению. где a - показатель ослабления света при прохождении образца. Дефицит в балансе энергии определяет поглощённую долю излучения. В полупроводнике различают пять основных типов поглощения: собственное, примесное, поглощение собственными носителями, экситонное и поглощённое решёткой.
где a - показатель ослабления света при прохождении образца. Дефицит в балансе энергии определяет поглощённую долю излучения. В полупроводнике различают пять основных типов поглощения: собственное, примесное, поглощение собственными носителями, экситонное и поглощённое решёткой.
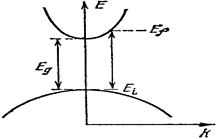
 . К полупроводникам с непрямой зоной относится Ge.Спектральные зависимости Si и Ge показывают быстрый рост поглощения в первом при энергии кванта, достаточной для межзонного перехода, т.к.
. К полупроводникам с непрямой зоной относится Ge.Спектральные зависимости Si и Ge показывают быстрый рост поглощения в первом при энергии кванта, достаточной для межзонного перехода, т.к.  и переброс электрона в зону проводимости происходит с изменением его квазиимпульса. Переходы с участием третьей частицы и называют непрямыми. Но при увеличении энергии фотона начинается такое возбуждение, электронов, при котором происходит и прямой (вертикальный) переход. Для параболической зоны проводимости для разрешенных прямых переходов при k=0 у края собственного поглощени
и переброс электрона в зону проводимости происходит с изменением его квазиимпульса. Переходы с участием третьей частицы и называют непрямыми. Но при увеличении энергии фотона начинается такое возбуждение, электронов, при котором происходит и прямой (вертикальный) переход. Для параболической зоны проводимости для разрешенных прямых переходов при k=0 у края собственного поглощени  в Ge и Si прямые переходы согласноправилам отбора запрещены и
в Ge и Si прямые переходы согласноправилам отбора запрещены и 
 .
. (Еф - энергия поглощённого фотона) в случае поглощённого фонона и
(Еф - энергия поглощённого фотона) в случае поглощённого фонона и  для перехода с испусканием фонона. Это проявляется в появлении слагаемого для непрямых переходов:
для перехода с испусканием фонона. Это проявляется в появлении слагаемого для непрямых переходов: , А’’- постоянная, прямо не зависящая от температуры.
, А’’- постоянная, прямо не зависящая от температуры.

 .При энергии фотона hn³DW концентрация носителей пропорциональна скорости их оптической генерации g=aY(l)Nф, где Nф - поток фотонов, проникающих через поверхность внутрь полупроводника, см-2с-1; Y(l) - квантовый выход фотоионизации (число электрон-дырочных пар, образуемых одним фотоном).
.При энергии фотона hn³DW концентрация носителей пропорциональна скорости их оптической генерации g=aY(l)Nф, где Nф - поток фотонов, проникающих через поверхность внутрь полупроводника, см-2с-1; Y(l) - квантовый выход фотоионизации (число электрон-дырочных пар, образуемых одним фотоном). . Внутри полупроводника интенсивность спадает как
. Внутри полупроводника интенсивность спадает как  где Nф - поток на поверхность полупроводника; r(l) - спектральный коэффициент отражения. Объёмная скорость генерации носителей в плоскости на расстоянии x от освещённой поверхности.
где Nф - поток на поверхность полупроводника; r(l) - спектральный коэффициент отражения. Объёмная скорость генерации носителей в плоскости на расстоянии x от освещённой поверхности.  13.Процессы рекомбинации.
13.Процессы рекомбинации.


